Содержание
- 2. Базовыми элементами большинства полупроводниковых ИС (ППИС) являются биполярные и униполярные (полевые) транзисторы. На основе их структуры
- 3. Элементы ППИМ: а – биполярный транзистор; б – диффузионный резистор; в – полевой (МДП) транзистор; г–
- 4. Оксидирование кремния На поверхности кремниевых подложек создаются пленки SiO2 толщиной от десятых долей мкм до 1
- 5. Локальное изменение типа проводимости кремния: а – окисление поверхности; б – фотолитография; в – внедрение примеси;
- 6. Диффузия Процесс переноса легирующих примесей из областей с боль-шей концентрацией в области с меньшей концентрацией. Процесс
- 7. Схемы установок термического окисления кремния (а) и диффузии из газообразных источников примеси (б): 1 - вентили;
- 8. Эпитаксия Эпитаксией называют процесс наращивания слоев с упоря-доченной кристаллической структурой путем использования ориен-тирующего действия подложки (повторения
- 9. Схема установки эпитаксиального наращивания из парогазовой фазы с вертикальным реактором: 1 – реактор; 2 – держатель
- 10. Ионное легирование Ионное легирование (или ионная имплантация) – способ получения p-n переходов путем введения примеси в
- 11. Схемы установки (а) и рабочей камеры (б) ионного легирования: 1 – источник ионов; 2 – магнитный
- 12. Литографические процессы в производстве ППИС При изготовлении ППИС применяют (в зависимости от размеров элементов) различные виды
- 13. Электроно – лучевая литография В основе электроно – лучевой литографии (ЭЛЛ) лежит избирательное экспонирование потоком электронов
- 14. Установка РЛ (а) и схема экспонирования (б): 1 – мишень; 2 – вакуумная камера; 3 –
- 15. а) Схема проекционной ЭЛЛ: 1 –УФ излучение; 2 – шаблон-фотокатод; 3 – магнитная система; 4 –
- 16. EUV (Extreme Ultra Violet) – литография, использующая излучение с длиной волны порядка 13 нм. Схема EUV-
- 18. Скачать презентацию

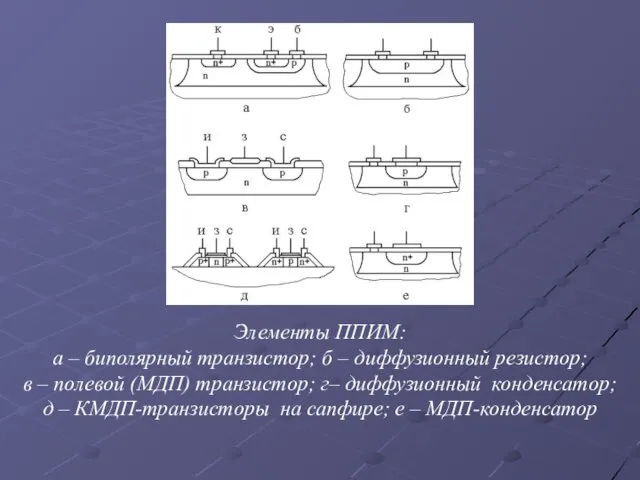



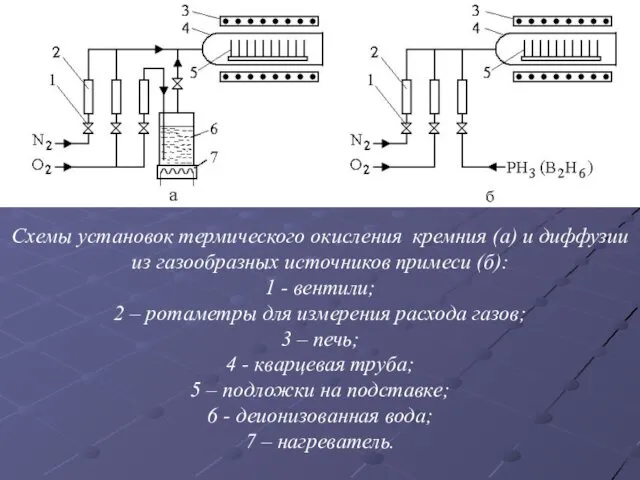



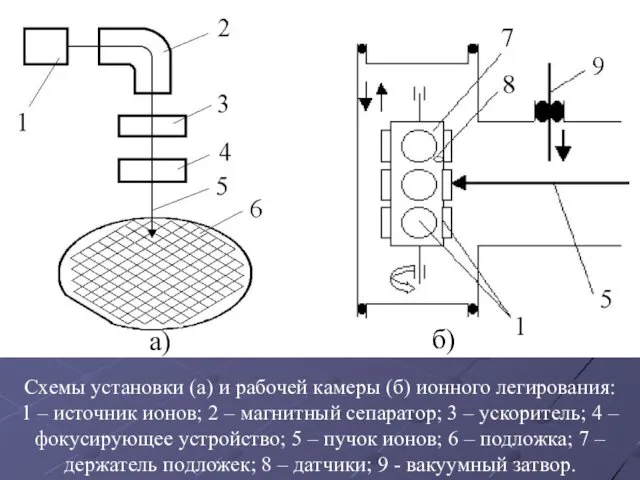


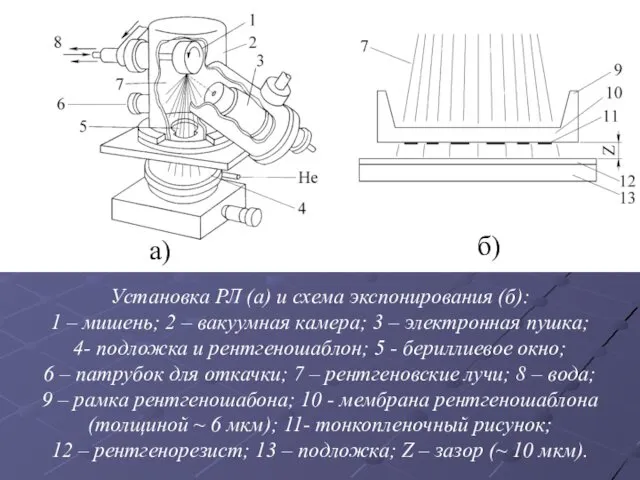

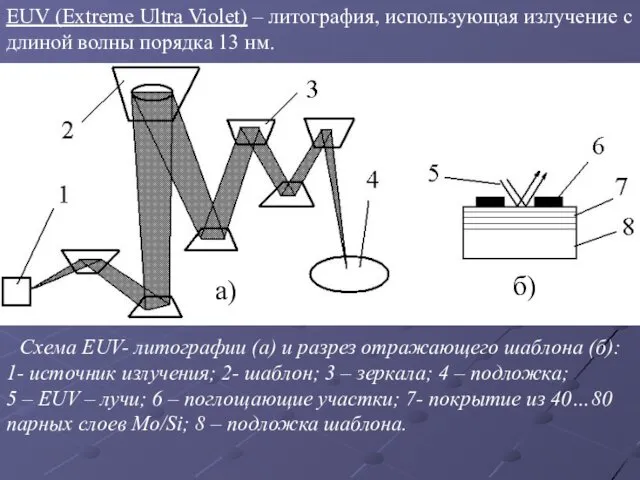
 Презентация Организация образовательной деятельности в соответствии с ФГОСв средней группе
Презентация Организация образовательной деятельности в соответствии с ФГОСв средней группе Пример физического проектирования БД
Пример физического проектирования БД Бораттарды алу
Бораттарды алу Напряжём мозги *цитаты великих людей
Напряжём мозги *цитаты великих людей презентация Исправление диффектов смягчения
презентация Исправление диффектов смягчения Изображение глиняной игрушки разными промысловыми центрами
Изображение глиняной игрушки разными промысловыми центрами Искусство домоуправления. Идентификация проблемы
Искусство домоуправления. Идентификация проблемы Презентация Кабинет кубановедения
Презентация Кабинет кубановедения 20 лет спустя
20 лет спустя молоко (2)
молоко (2) Четвертый и пятый члены Символа веры
Четвертый и пятый члены Символа веры Pest-Анализ Фгбоу во Российского экономического университета имени Г. В. Плеханова
Pest-Анализ Фгбоу во Российского экономического университета имени Г. В. Плеханова Презентация Муравьи
Презентация Муравьи Конструкции паровых котельных агрегатов
Конструкции паровых котельных агрегатов Особо охраняемые территории Московской области
Особо охраняемые территории Московской области Принципы лечения взрослых в амбулаторных условиях. Составление плана лечения пациента
Принципы лечения взрослых в амбулаторных условиях. Составление плана лечения пациента Методические основы проектирования ИС управления экономической деятельностью
Методические основы проектирования ИС управления экономической деятельностью Мягкие лекарственные формы
Мягкие лекарственные формы Тәуелсіздік жылдарындағы мәдени жетістіктер
Тәуелсіздік жылдарындағы мәдени жетістіктер Текст и предложение
Текст и предложение Презентация Культура речи и средства эффективного общения
Презентация Культура речи и средства эффективного общения Понятие, значение и виды трудовых договоров
Понятие, значение и виды трудовых договоров История медицины Древнего Египта
История медицины Древнего Египта Эдуард Асадов. Жизнь и творчество
Эдуард Асадов. Жизнь и творчество Презентация к родительскому собранию во 2 классе Урок родителям часть 1
Презентация к родительскому собранию во 2 классе Урок родителям часть 1 Железобетонные бункера
Железобетонные бункера Подготовка к ГИА (часть В). Умение оценивать количественные параметры информационных объектов
Подготовка к ГИА (часть В). Умение оценивать количественные параметры информационных объектов Автоматика ограничения снижения частоты АОСЧ
Автоматика ограничения снижения частоты АОСЧ