КНИ-структуры (продолжение)
Способы создания КНИ-структур:
Ионная имплантация - бомбардировки поверхности пластины ионами кислорода
с последующим отжигом при высокой температуре.
Сращивание пластин - очистка и активация плазменной обработкой поверхности пластин Si и SiO2, сжатие и отжиг, в результате химических реакций на поверхности происходят соединение пластин.
Управляемый скол. Используют две кремниевые пластины. Первая термически окисляется, затем верхняя поверхность подвергается насыщению ионами водорода методом ионной имплантации, в результате чего в пластине создается область скола. Затем эта пластина сращивается с другой, после чего происходит отделение тонкого слоя первой пластины от второй пластины.
Эпитаксия - поверхностный слой образуется за счет выращивания пленки Si на поверхности SiO2 (технологические проблемы).
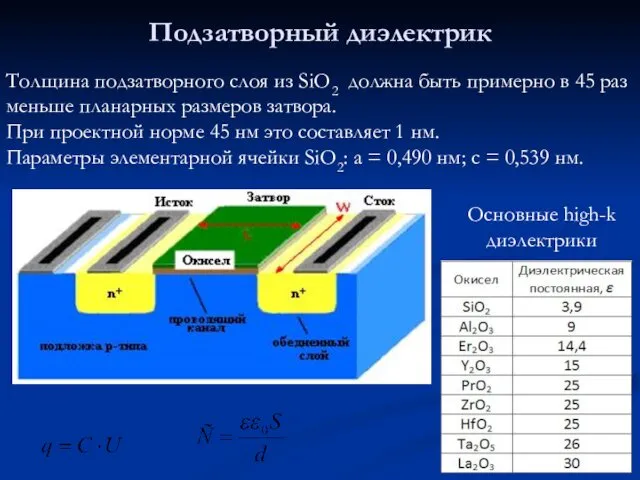

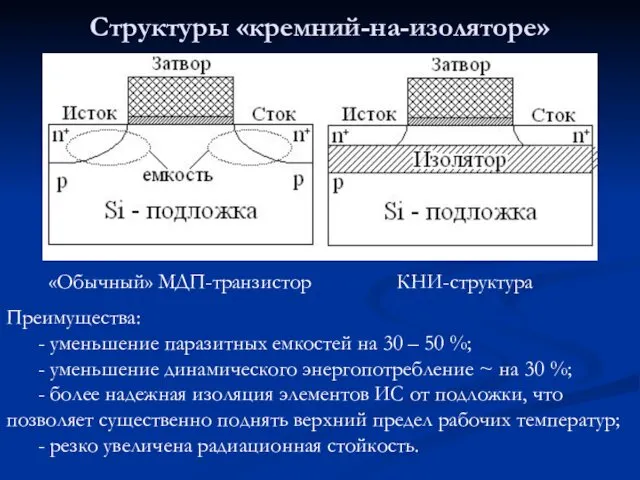

 Начало распада Османской империи
Начало распада Османской империи Химия глин и принципы ингибирования глинистых пород
Химия глин и принципы ингибирования глинистых пород Взаимодействие общества и природы
Взаимодействие общества и природы Подводный транспорт
Подводный транспорт Свойства ленты Мебиуса
Свойства ленты Мебиуса Средневековое государство и право в Англии
Средневековое государство и право в Англии Перспективный план по безопасному поведению детей старшего возраста в детском саду
Перспективный план по безопасному поведению детей старшего возраста в детском саду Город Москва
Город Москва Гипогонадизм. Причины гипогонадизма
Гипогонадизм. Причины гипогонадизма Дорога и её элементы
Дорога и её элементы Русские традиции Для ценителей настоящего
Русские традиции Для ценителей настоящего костюм Древнегреческого актера
костюм Древнегреческого актера Учебная презентация по теме Знакомимся с Коломной
Учебная презентация по теме Знакомимся с Коломной презентация алалия
презентация алалия Образование времени Екатерины II
Образование времени Екатерины II Основные функциональные блоки мозга человека. Сенсорные системы: принципы организации, разнообразие рецепторов и органов чувств
Основные функциональные блоки мозга человека. Сенсорные системы: принципы организации, разнообразие рецепторов и органов чувств Изготовление декоративного изделия 3D ручкой like
Изготовление декоративного изделия 3D ручкой like Портфолио учителя математики Перемышленниковой Е.В.
Портфолио учителя математики Перемышленниковой Е.В. Система впорскування палива
Система впорскування палива Сознание и его нарушения
Сознание и его нарушения Zastosowania diod półprzewodnikowych
Zastosowania diod półprzewodnikowych Расчет суточной нормы кормления и обоснование цены
Расчет суточной нормы кормления и обоснование цены По дорогам доброты (внеклассное мероприятие, 4 класс)
По дорогам доброты (внеклассное мероприятие, 4 класс) Разработка системы контроля процесса очистки сточных вод в условиях в ООО ОМС МРегион
Разработка системы контроля процесса очистки сточных вод в условиях в ООО ОМС МРегион Из опыта работы по формированию у дошкольников представлений о правилах дорожного движения (презентация)
Из опыта работы по формированию у дошкольников представлений о правилах дорожного движения (презентация) Жүрек аритмиясы – жүректің қалыпты ырғағының бұзылыстары
Жүрек аритмиясы – жүректің қалыпты ырғағының бұзылыстары Общие сведения о технологическом оборудовании
Общие сведения о технологическом оборудовании Химические свойства алкадиенов. Каучук. Резина. (презентация)
Химические свойства алкадиенов. Каучук. Резина. (презентация)