Содержание
- 2. Эпитаксия Процесс кристаллографически ориентированного наращивания монокристаллического слоя на монокристаллической подложке, при котором новая фаза закономерно продолжает
- 3. Классификация эпитаксиальных процессов По природе взаимодействий «подлодка – растущая кристаллическая фаза»: – автоэпитаксия; – гетероэпитаксия; –
- 4. Автоэпитаксия (гомоэпитаксия) Процесс ориентированного наращивания кристаллического вещества, одинакового по структуре и не отличающегося (или незначительно тличающегося)
- 5. Гетероэпuтакcuя процесс ориентированного наращивания вещества, отличающегося по химическому составу от вещества подложки. Путём образования гетероэпитаксиальных слоев
- 6. Хемоэпuтаксuя процесс ориентированного наращивания, в результате которого образование новой кристаллической фазы – хемоэпитаксиального слоя – происходит
- 7. Классификация эпитаксиальных процессов по химическому состоянию вещества В зависимости от химического состава исходной фазы при переносе
- 8. ППрямые процессы ППри процессах данного типа вещество переносится к подложке без промежуточных реакций. ХХимический состав вещества
- 9. Непрямые процессы В процессах данного типа при переносе вещества от источника к подложке происходят химические превращения:
- 10. Классификация эпитаксиальных процессов по агрегатному состоянию исходной фазы – эпитаксия из газовой фазы; – эпитаксия в
- 11. Газофазная (парофазная) эпитаксия. В прямых процессах данного типа осаждаемое вещество в исходной среде находится в виде
- 12. Эпитаксия в жидкой фазе. В данном случае осаждаемое вещество находится в виде раствора (раствора – расплава).
- 13. Эпитаксия в системе пар – жидкость – кристалл В данном случае рост эпитаксиального слоя происходит путём
- 14. Эпитаксия при твердофазном взаимодействии Данный метод представляет собой перекристаллизацию вещества в поверхностном слое твердой фазы или
- 15. Этапы процесса эпитаксии из газовой фазы Доставка: объёмная транспортировка реагентов к поверхности подложки; диффузия газообразных реагентов
- 16. Схема реакций этапов процесса эпитаксии из газовой фазы 1 – объёмная транспортировка реагентов к зоне реакции;
- 17. Кинетика процесса эпитаксии Необходимое условие роста новой фазы - пресыщение реагирующей фазы осаждаемым компонентом. 1. Формирование
- 18. Центры образования зародышей на поверхности подложки 1 – адсорбированные атомы двухатомного соединения; 2 – адсорбированный атом
- 19. Лимитирующие стадии процесса эпитаксии Скорость эпитаксиального роста лимитируется скоростью самой медленной стадии. Если скорость роста ограничивается
- 20. Факторы, определяющие процесс эпитаксии Детальное описание процесса эпитаксиального роста включает рассмотрение: - термодинамики; - кинетики химических
- 21. Течение газового потока в реакторе При подаче в реактор потока парогазовой смеси над подложкодержателем и стенками
- 22. Образование пограничного слоя в эпитаксиальном реакторе C – распределение концентрации; V – распределение скорости потока; Т
- 23. Влияние лимитирующей стадии на совершенство структуры Наиболее совершенные эпитаксиальные слои с гладкой однородной поверхностью получают в
- 24. Автоэпитаксиальные слои кремния Структуры данного типа формируют, как правило, осаждением кремния из газовой фазы в реакторе,
- 25. Схема установки наращивания кремния осаждением из газовой фазы 1– реактор; 2– пьедестал; 3– ВЧ–индуктор; 4– питатели
- 26. Реагенты для автоэпитаксиального наращивания кремния Могут использоваться четыре ремнийсодержащих компонента: - тетрахлорид кремния (SiCl4), - трихлорсилан
- 27. Зависимость скорости роста от температуры 27 А – кинетический контроль, В – диффузионный контроль
- 28. Жидкостное легирование эпитаксиальных слоёв Для легирования эпитаксиальных плёнок кремния в газовую смесь намеренно вводят соединения легирующих
- 29. Газовое легирование В данном случаем в газовую смесь вводят гидриды легирующих элементов, такие как: - арсин
- 30. Процессы, происходящие при легировании во время роста эпитаксиальной плёнки кремния – адсорбция молекул гидрида примесного элемента
- 31. Зависимость концентрации бора и фосфора в эпитаксиальном слое от концентрации диборана (B2H6) и фосфина (PH3)
- 32. Влияние скорости роста на концентрацию легирующей примеси (As) в эпитаксиальном слое
- 33. Зависимость уровня легирования эпитаксиального слоя от температуры процесса
- 34. Автолегирование Кроме намеренно вводимой примеси в эпитаксиальный слой входят также неконтролируемые примеси из подложки. Данный эффект
- 35. Источники примесей при эпитаксиальном росте подложки; 5 – подложкодержатель; 6 – реактор; 7 – специально вводимая
- 36. Обобщённый профиль легирования эпитаксиального слоя
- 37. Автолегирование проявляется в виде увеличения ширины переходной области между эпитаксиальным слоем и подложкой. Форма кривой распределения
- 38. Типовой цикл эпитаксиального осаждения
- 39. Контроль параметров эпитаксиальных слоёв Контролируют: - Толщину ЭС; - Удельное сопротивление ЭС; - Дефектность ЭС.
- 40. Контроль толщины ЭС Разрушающие методы: - метод косого шлифа; - метод сферического шлифа; Неразрущающий метод: -
- 41. Метод косого шлифа
- 42. Метод сферического шлифа
- 43. Принцип интерференционной спектроскопии
- 44. Схема ИК-Фурье спектрометра
- 45. Интерферограммы различных спектров
- 46. Схема четырёхзондового метода конт-роля поверхностного сопротивления 1, 2, 3, 4 –зонды; 5 – источник тока; 6
- 47. Четырёхзондовый метод расчётные соотношения K=4.53 для расположения зондов в линию
- 48. Гетероэпитаксиальные слои кремния Нашли применение в структурах кремний на сапфире (КНС), а также в многослойных структурах
- 49. Псевдоморфный гетероэпитаксиальный слой
- 50. Релаксированный гетероэпитаксиальный слой
- 51. Гетероэпитаксия кремния на сапфире осуществляется, как правило, силановым методом, при температуре 1000 – 1050 С: SiH4
- 52. Формирование гетероэпитаксиальных слоёв КНС - тщательная механическая полировка (удаление нарушенного слоя 8 – 10 мкм); -
- 53. Эпитаксиальные соотношения в гетероэпитаксиальных слоях кремния на сапфире _ _ _ _
- 54. Молекулярно-лучевая эпитаксия (МЛЭ) Метод МЛЭ представляет собой процесс эпитаксиального роста, основанного на взаимодействии одного или нескольких
- 55. Сравнительные характеристики МЛЭ Достоинства: - в отличие от методов ГФЭ и ЖФЭ, МЛЭ обеспечивает исключительно точное
- 56. Схема установки МЛЭ 1 – флуоресцент- ный экран; 2 – зас- лонки эффузионных ячеек; 3 –
- 57. Очистка подложек при проведении МЛЭ Проводят откачку системы МЛЭ, охлаждение экрана (4) жидким азотом и вывод
- 58. Нанесение слоёв МЛЭ Открывают заслонки (2) соответствующих эффузионных ячеек - происходит рост эпитаксиального слоя. Кинетика процесса
- 60. Скачать презентацию
















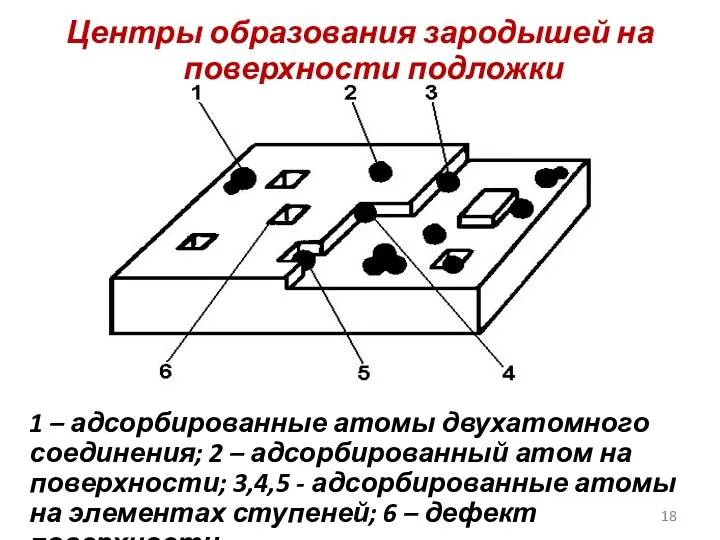














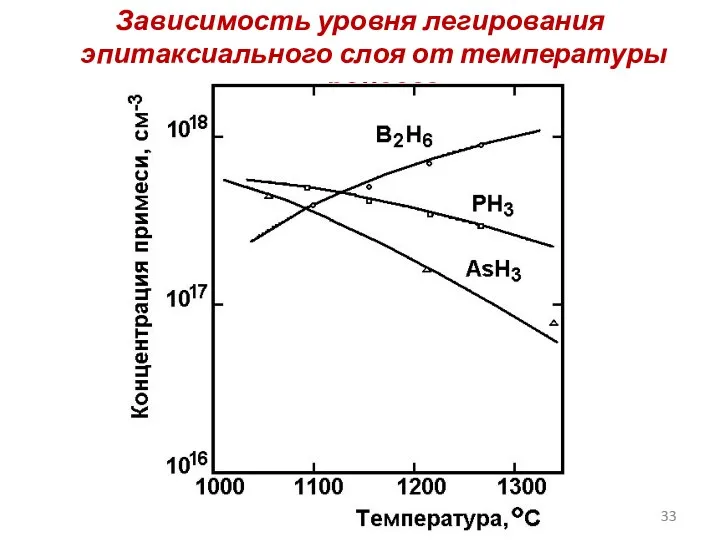










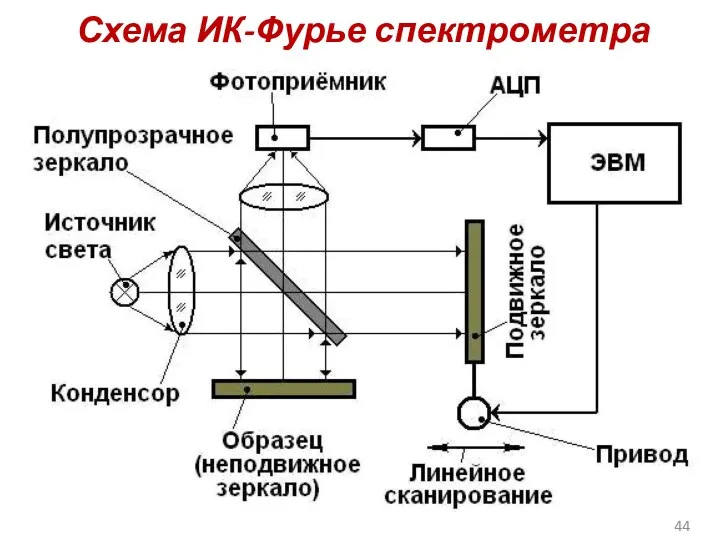

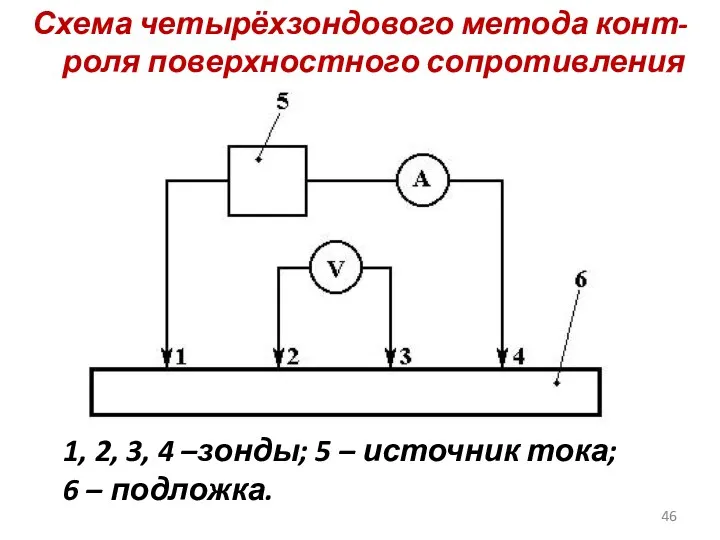












 Електричний струм у напівпровідниках
Електричний струм у напівпровідниках Электромагнитные колебания
Электромагнитные колебания Сила. Что такое сила?
Сила. Что такое сила? Закон сохранения импульса
Закон сохранения импульса Квантовые системы. Распределение электронов в атоме. Квантовые числа. Принцип Паули. Спонтанное и вынужденное излучение. Лазеры
Квантовые системы. Распределение электронов в атоме. Квантовые числа. Принцип Паули. Спонтанное и вынужденное излучение. Лазеры Abrasive materials. Classification, structure, properties and applications
Abrasive materials. Classification, structure, properties and applications Давление газа. Уравнение состояния идеального газа. Изопроцессы
Давление газа. Уравнение состояния идеального газа. Изопроцессы Жылу мөлшері. Заттың меншікті жылусыйымдылығы
Жылу мөлшері. Заттың меншікті жылусыйымдылығы Конструкция автосцепного устройства
Конструкция автосцепного устройства Лекция №1. Взаимодействие излучения с атомами
Лекция №1. Взаимодействие излучения с атомами Знатоки физики
Знатоки физики Давление. Единицы давления
Давление. Единицы давления Топлива, применяемые на воздушных судах и наземной технике. Эксплуатационные свойства топлив. (Тема 2.1)
Топлива, применяемые на воздушных судах и наземной технике. Эксплуатационные свойства топлив. (Тема 2.1) Действие электрического тока. 8 кл.
Действие электрического тока. 8 кл. Кіріспе. Типтік өнеркәсіптік механизмдердің классификациясы, жалпы ұғым және анықтама
Кіріспе. Типтік өнеркәсіптік механизмдердің классификациясы, жалпы ұғым және анықтама Частотный метод синтеза корректирующего звена по ЛАЧХ разомкнутой системы
Частотный метод синтеза корректирующего звена по ЛАЧХ разомкнутой системы Электрическая прочность диэлектриков
Электрическая прочность диэлектриков Механические передачи. Планетарные и волновые передачи. (Лекция 8)
Механические передачи. Планетарные и волновые передачи. (Лекция 8) Диапазон частот
Диапазон частот Оборудование для ремонта рам, кузовов и кабин автомобилей
Оборудование для ремонта рам, кузовов и кабин автомобилей Мультимедийный тест по теме Сила упругости
Мультимедийный тест по теме Сила упругости Управляемость автомобиля. Лекция № 11
Управляемость автомобиля. Лекция № 11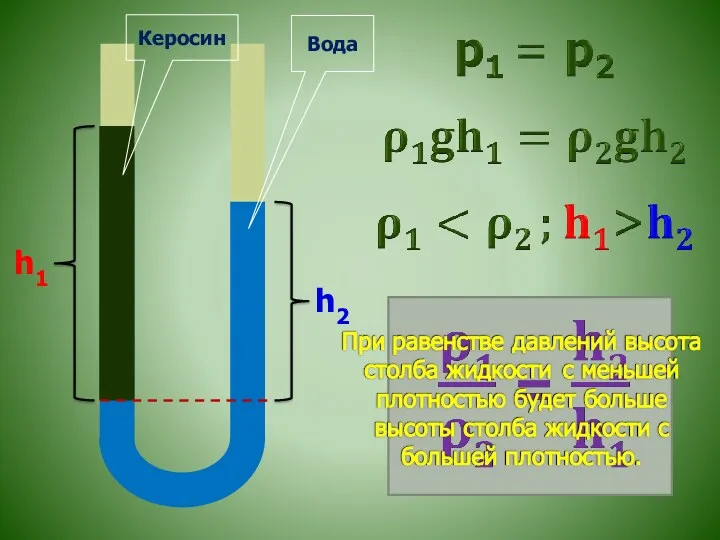 Сообщающиеся сосуды
Сообщающиеся сосуды Программа элективного курса по физике 9 класс
Программа элективного курса по физике 9 класс Проблемы прочности в технике
Проблемы прочности в технике Лазеры и их применение
Лазеры и их применение Основы молекулярной физики и термодинамики
Основы молекулярной физики и термодинамики Прямолинейное равноускоренное движение: мгновенная скорость, ускорение, перемещение
Прямолинейное равноускоренное движение: мгновенная скорость, ускорение, перемещение