Микроскопия. Микроскопы, их устройство и возможности для изучения поверхности на микро- и наноуровне презентация
Содержание
- 2. Московкий технологический университет Кафедра коллоидной химии им. С.С. Воюцкого Виды микроскопии. Оптическая микроскопия – на индивидуальную
- 3. Методы исследования поверхности Сканирующая зондовая микроскопия
- 4. Открытие сканирующей зондовой микроскопии Сканирующий микроскоп – Герд Биннинг и Генрих Рорер (1982 г.) Нобелевская премия
- 5. Виды сканирующей зондовой микроскопии (СЗМ) Сканирующая туннельная микроскопия Атомно–силовая микроскопия СТМ (англ. STM — scanning tunneling
- 6. Принцип сканирующей зондовой микроскопии Регистрация неизлучательной компоненты электромагнитного поля – основной принцип сканирующей зондовой микроскопии. Отличительной
- 7. Основные задачи, которые решает СЗМ Определение размеров частиц Исследование активных центров на поверхности твердого тела Изучение
- 8. Сканирующий зондовый микроскоп
- 9. Сканирующая туннельная микроскопия 1. Физический принцип - туннельный эффект 2. Регистрируемый сигнал – величина туннельного тока,
- 10. Атомно – силовая микроскопия 1. Физический принцип – измерение силы, которая возникает при перемещении зонда по
- 11. Атомно-силовой микроскоп
- 12. Типы сканирующих зондовых микроскопов Лазерный силовой микроскоп Микроскоп магнитных сил Микроскоп электростатических сил Оптический микроскоп ближнего
- 13. Схематическое изображение зондового датчика
- 14. Изображения, получаемые методом СЗМ https://www.uantwerpen.be/en/rg/bams/service/s-sims---afm-surface/atomic-force-microsc/
- 15. Возможности метода сканирующей зондовой микроскопии
- 16. Преимущества метода сканирующей зондовой микроскопии Получение изображений проводящих и непроводящих поверхностей Информация о конкретной части поверхности
- 17. Методы зондирования поверхности заряженными частицами Спектроскопия ионного рассеяния Вторичная ионная масс-спектроскопия
- 18. Взаимодействие ионов с поверхностью твердого тела при использовании метода СИР E, M1 E0, M1 Первичный ион
- 19. Физический принцип вторичной-ионной масс-спектроскопии Взаимодействие ионов высоких энергий >20 кЭВ с поверхностью твердого тела Разрушение поверхностных
- 20. Взаимодействие ионов с поверхностью твердого тела при использовании метода ВИМС hν 0 ± e- Поверхность ~1нм
- 21. Литература Миронов В.Л. Основы сканирующей зондовой микроскопии. – М.: Техносфера, 2004, 143 с. https://koltovoi.nethouse.ru/page/941254 Электронный микроскоп
- 23. Скачать презентацию






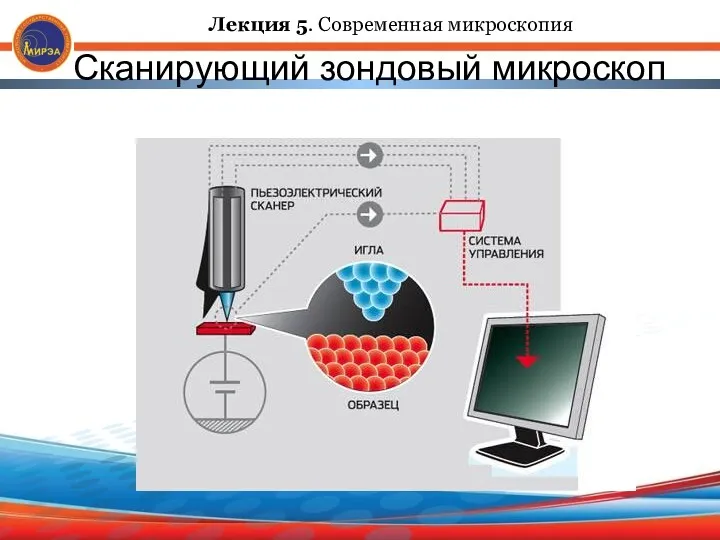


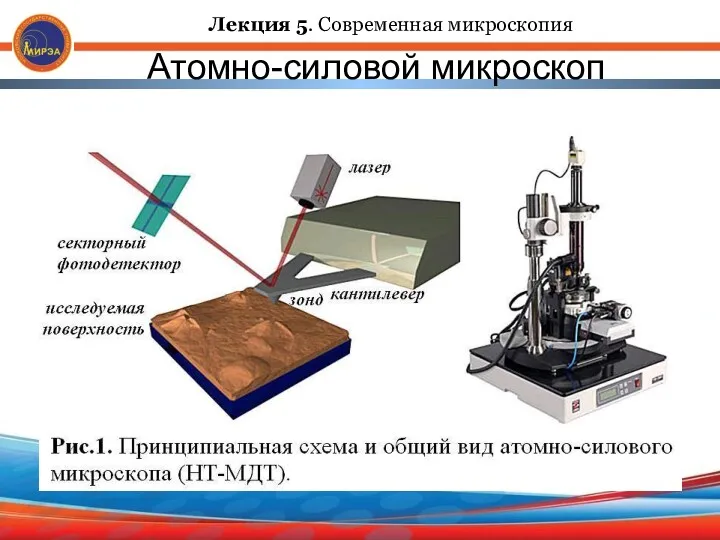






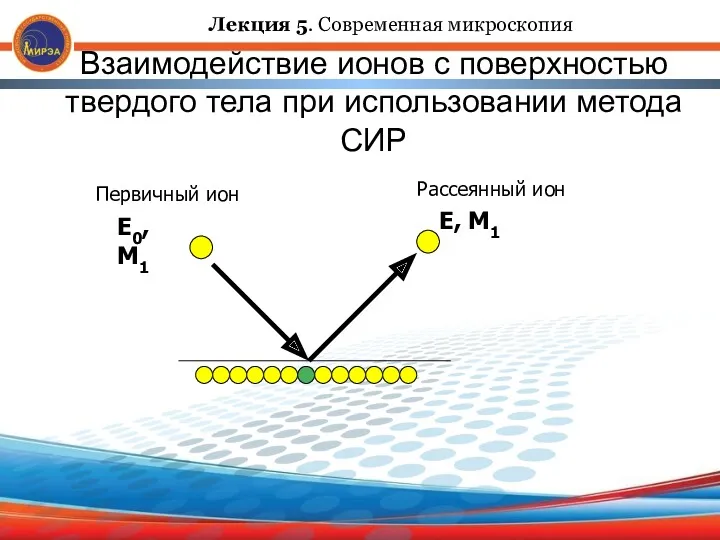

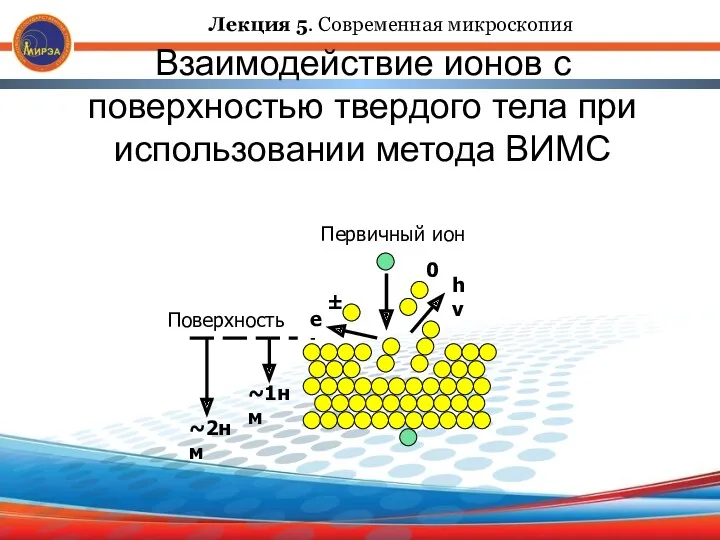

 Geschichte der Eisenbahn
Geschichte der Eisenbahn Принципы радиосвязи и телевидения
Принципы радиосвязи и телевидения Лекция № 8. Тема: Физические механизмы переноса веществ через мембрану
Лекция № 8. Тема: Физические механизмы переноса веществ через мембрану Кривошипно-шатунный механизм
Кривошипно-шатунный механизм Системно-деятельностный подход
Системно-деятельностный подход Люмінесценція і її застосування. (Тема 1)
Люмінесценція і її застосування. (Тема 1) Радиационные эффекты и уровни радиации
Радиационные эффекты и уровни радиации Явище люмінесценції
Явище люмінесценції Радиоволны. Частотные диапазоны радиоволн
Радиоволны. Частотные диапазоны радиоволн Методы обработки зубьев зубчатых колес
Методы обработки зубьев зубчатых колес Молекулярная физика
Молекулярная физика 03.21г. Типы спектров. Спектральный анализ
03.21г. Типы спектров. Спектральный анализ Основы технического обслуживания и ремонта. (Занятие 1)
Основы технического обслуживания и ремонта. (Занятие 1) Силы и моменты, действущие в КШМ. Динамика КШМ, часть 2. Лекция №3
Силы и моменты, действущие в КШМ. Динамика КШМ, часть 2. Лекция №3 Постоянный электрический ток. (Лекция 6)
Постоянный электрический ток. (Лекция 6) Физическая технология топлива. Требования, предъявляемые к дизельным топливам
Физическая технология топлива. Требования, предъявляемые к дизельным топливам Внеклассное мероприятие Физика и кошка
Внеклассное мероприятие Физика и кошка Электродинамика и распространение радиоволн. Лекция 5. Распространение ионосферных радиоволн
Электродинамика и распространение радиоволн. Лекция 5. Распространение ионосферных радиоволн презентация к внеклассному мероприятию Знатоки физики
презентация к внеклассному мероприятию Знатоки физики Physics basics (Unit 1)
Physics basics (Unit 1) Инерция. Масса – мера инертности тела. Плотность вещества
Инерция. Масса – мера инертности тела. Плотность вещества Техническая термодинамика
Техническая термодинамика Электронная спектроскопия
Электронная спектроскопия Что изучает физика. Физические термины. 7 класс
Что изучает физика. Физические термины. 7 класс презентация: использование ядерной энергии 3
презентация: использование ядерной энергии 3 Катушки со сталью в цепи синусоидального тока
Катушки со сталью в цепи синусоидального тока что вы знаете о лампочке Яблочкова...
что вы знаете о лампочке Яблочкова... Квантовая оптика. Тепловое излучение
Квантовая оптика. Тепловое излучение