Содержание
- 2. Литография Литографией (греч. lithos - камень), приме- няемой в производстве ИИЭ, называют про- цесс формирования геометрического
- 3. Получение топологического рисунка На первой стадии процесса изготовления ИС после завершения испытаний или моделирования с помощью
- 4. Формирование ИС Законченные ИС получают последователь- ным переносом топологического рисунка с каждого шаблона, уровень за уровнем
- 5. Процесс литографического переноса изображения
- 6. Фотошаблоны. Основные термины Фотошаблон является основным инструментом литографии в планарной технологии. Для изготовления каждой ИС требует-
- 7. Фотошаблоны. Основные термины Маска – плоская пластина или плёнка, содержащая рисунок в виде сквозных окошек и
- 8. Генерация изображения методом микрофотонабора Полученная в результате проекти- рования ИС информация о топологии в цифровом виде
- 9. Схема генератора изображения 1 – источник излучения; 2 – затвор; 3 – конденсор; 4 – блок
- 10. Работа генератора изображения Пучок света от источника направлен сверху вниз. Установка работает с остановками стола в
- 11. САПР 1 ЦНИ 2 Электронно-лучевая установка М1:1 3 Генератор изображения М1:10 (1:5) Комплект промежуточных фотошаблонов 5
- 12. Маршруты изготовления фотошаблонов Маршрут изготовления фотошаблонов выбирают ис- ходя из степени сложности ИС. Чем короче маршрут
- 13. Разновидности фотошаблонов По технологии изготовления фотошаблоны де- лятся на: - металлизированные – в качестве непрозрачных участков
- 14. Фигуры совмещения
- 15. Фоторезисты Фоторезисты – светочувствительные по- лимерные композиции, в которых под дейст- вием света протекают необратимые хими-
- 16. Характеристики экспонирования резистов
- 17. Кинетика фотохимических реакций Особенностью фотохимических реакций явля- ется то, что фотон действует селективно, возбуждая одну молекулу
- 18. Реакции, протекающие в резистах 1. Фотолиз – возбуждение молекулы и её распад под действием света: 2.
- 19. Реакции, протекающие в резистах 3. Фотоприсоединение – присоединение активиро- ванной молекулой другой молекулы или молекул. 4.
- 20. Требования к фоторезистам 1. Высокая светочувствительность в требуемом диапазо-не длин волн. 2. Высокая разрешающая способность (на
- 21. Схема технологического процесса фотолитографии Фоторезист Нанесение слоя фоторезиста Обработка подложки Подложка Сушка фоторезиста Совмещение и экспонирование
- 22. Обработка пластин Обработка подложек производится с целью: 1. Очистки подложек от загрязнений; 2. Повышения адгезии фоторезиста.
- 23. Удаление поверхностных загрязнений Поверхностные загрязнения удаляют: - механическим способом с помощью кис- тей и щёток под
- 24. Гидромеханическая отмывка Цилиндрической щёткой Коническими щётками 1 – форсунка, 2 – щётки, 3 - подложка
- 25. Обработка поверхности слоёв кремния SiO2 и Si3N4 Данные слои не обладают высокой химической ак- тивностью. Как
- 26. Обработка поверхности металла В технологии ИС для металлизированной разводки, как правило, используют алюминий и его сплавы
- 27. Обработка поверхности фосфоросиликатного стекла ФСС также обладает высокой химической активностью, особенно к щелочным средам. Скорость травления
- 28. Адгезия для фотолитографических процессов Адгезия – способность фоторезиста препят- ствовать проникновению травителя к подлож- ке по
- 29. Проникновение травителя под маску резиста
- 30. Обработка, повышающая адгезию фоторезиста Сразу после термического окисления плёнка SiO2 гид- рофобна. Через некоторое время на
- 31. Нанесение фоторезиста Операция представляет собой процесс создания на поверхности подложки однородного слоя толщиной 1 – 3
- 32. Схема нанесения центрифугированием 1 – дозатор; 2 – подложка; 3 – вакуумный столик; 4 – кожух
- 33. Сушка фоторезиста Способствует окончательному формированию струк- туры слоя фоторезиста. В процессе сушки из фоторе- зиста удаляется
- 34. Методы совмещения и экспонирования Совмещение и экспонирование Контактная фотолитография Бесконтактная фотолитография Фотолитография на микрозазоре Проекционная фотолитография
- 35. Контактная фотолитография схема совмещения 1 - предметный сто-лик; 2 - подложка; 3 - слой фоторезиста; 4
- 36. Контактная фотолитография схема экспонирования 1 - предметный сто-лик; 2 – подложка; 3 - слой фоторезис-та; 4
- 37. Фотолитография на микрозазоре 1 - предметный сто-лик; 2 – подложка; 3 - слой фоторезис-та; 4 –
- 38. Схема проекционного экспонирования со сканированием 1 - осветитель; 2 -дугообразная щель; 3 - фотошаблон; 4 -зеркало;
- 39. Проекционная фотолитография без изменения масштаба
- 40. Схема пошаговой мультипликации с уменьшением масштаба УФ 1 - фотошаблон; 2 – проекционный объектив: 3 –
- 41. Проявление фоторезиста Служит для окончательного формирования изображе-ния схемы в плёнке фоторезиста. При этом в зависимос-ти от
- 42. 1 - форсунка суш-ки; 2 –пневмати-ческие форсунки проявления и от-мывки; 3 – плат-форма; 4 – съем-ная
- 43. Задубливание Проводят при более высокой температуре, чем сушка. Задубливание обеспечивает: - повышение стойкости маски ФР к
- 44. Пути повышения разрешающей способности фотолитографии Минимальные размеры элементов современных ИИЭ составляют 32 – 65 нм. При
- 45. Эволюция источников УФ излучения
- 46. Фотолитография с фазосдвигающей маской Стекло Хром Фазосдвигающее покрытие На маске На подложке В фото-резисте
- 47. Схема иммерсионной фотолитографии
- 49. Скачать презентацию



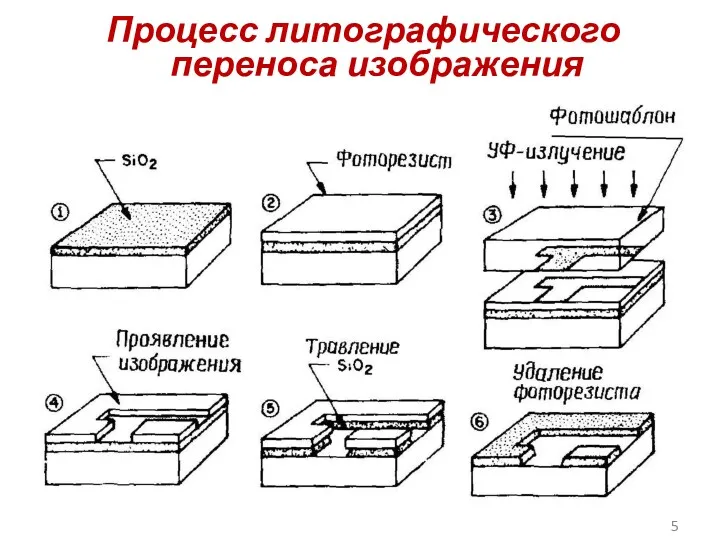



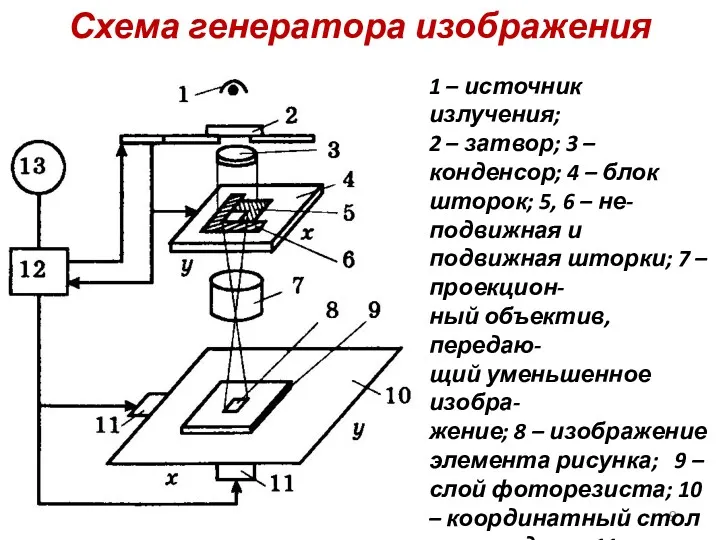






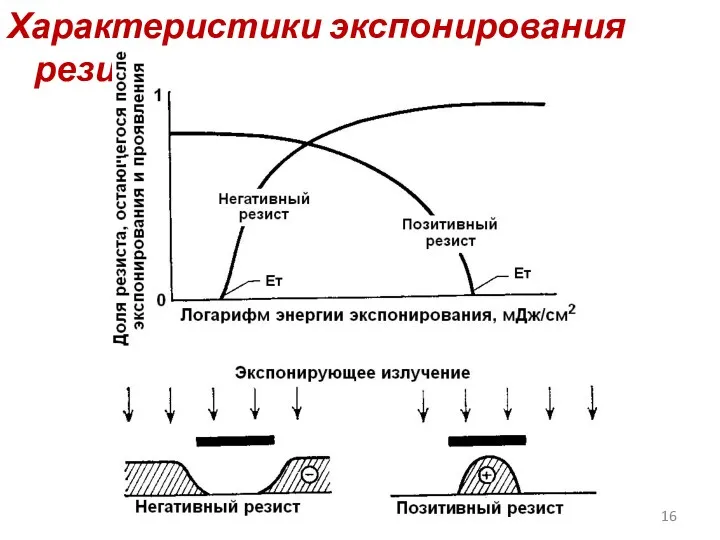


















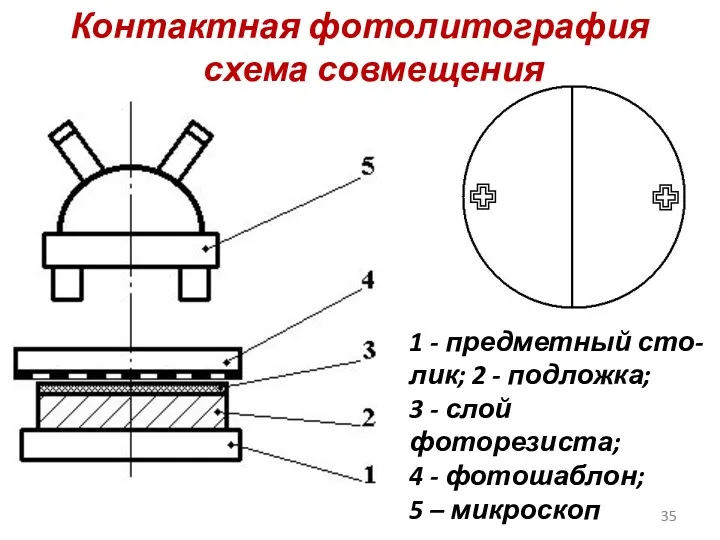




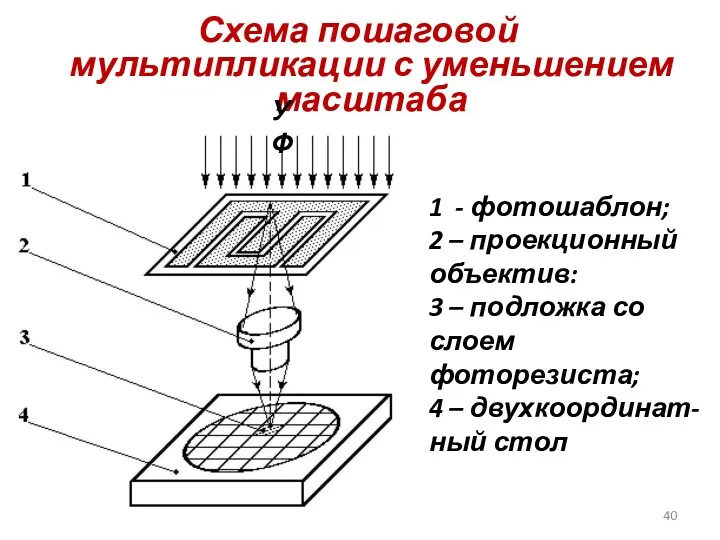





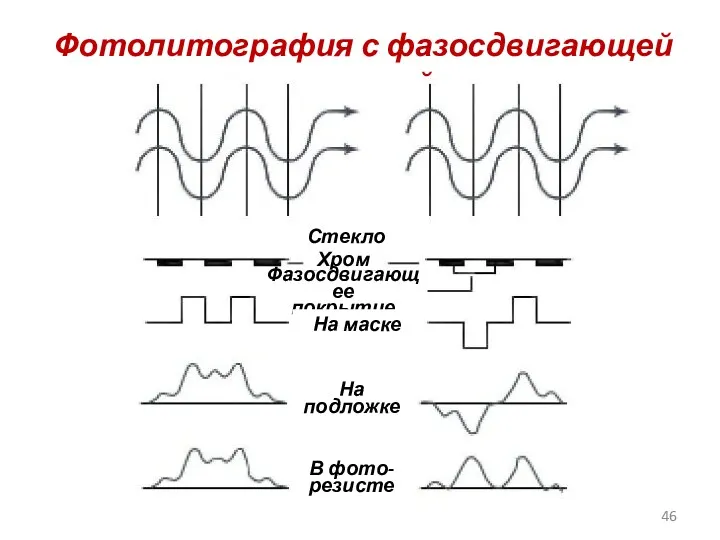

 Властивості поверхні рідини. Поверхневий натяг рідини
Властивості поверхні рідини. Поверхневий натяг рідини Потенціал електростатичного поля
Потенціал електростатичного поля Презентация к уроку по теме Внутренняя энергия и способы ее изменения 8класс
Презентация к уроку по теме Внутренняя энергия и способы ее изменения 8класс Законы постоянного тока
Законы постоянного тока Fluorescence lyman-alpha stratospheric hygrometer (flash): application on meteorological balloons, long duration balloons
Fluorescence lyman-alpha stratospheric hygrometer (flash): application on meteorological balloons, long duration balloons Организация а технологического процесса обслуживания и ремонта кривошипно-шатунного механизма двигателя автомобиля Kalina1119
Организация а технологического процесса обслуживания и ремонта кривошипно-шатунного механизма двигателя автомобиля Kalina1119 Виды теплообмена. Теплопроводность. Конвекция. Лучистый теплообмен
Виды теплообмена. Теплопроводность. Конвекция. Лучистый теплообмен Действие магнитного поля на проводник с током. Электрический двигатель
Действие магнитного поля на проводник с током. Электрический двигатель Параметри електричних ланцюгів змінного струму
Параметри електричних ланцюгів змінного струму Summary of effective use 6
Summary of effective use 6 Общие сведения о зубчатых передачах
Общие сведения о зубчатых передачах Открытие нейтрона и протона
Открытие нейтрона и протона Пара сил и момент силы относительно точки
Пара сил и момент силы относительно точки Отчет по практике. Подготовка машин, механизмов, установок, приспособлений к работе, комплектование сборочных единиц
Отчет по практике. Подготовка машин, механизмов, установок, приспособлений к работе, комплектование сборочных единиц Команда Пятый Элемент. Почему для полетов в космосе всегда используются ракеты
Команда Пятый Элемент. Почему для полетов в космосе всегда используются ракеты Общие свойства и характеристики волновых процессов
Общие свойства и характеристики волновых процессов Дифракция света. Опыт Юнга
Дифракция света. Опыт Юнга Масса тела
Масса тела Презентация Спектры (качественные задачи по теме Излучения и спектры)
Презентация Спектры (качественные задачи по теме Излучения и спектры) Транспортная энергетика (часть II). Электрические машины
Транспортная энергетика (часть II). Электрические машины Поисково-исследовательский метод используемый на уроках физики
Поисково-исследовательский метод используемый на уроках физики Применение законов сохранения импульса и энергии
Применение законов сохранения импульса и энергии Diamond DA42 Twin Star — лёгкий многоцелевой самолёт
Diamond DA42 Twin Star — лёгкий многоцелевой самолёт Металлорежущие станки и станочные комплексы. Общие сведения и механизмы станков. (Темы 1 и 2)
Металлорежущие станки и станочные комплексы. Общие сведения и механизмы станков. (Темы 1 и 2) Совершенствование средств контроля и диагностики вагонов
Совершенствование средств контроля и диагностики вагонов Mohr circles. Equivalent stress definition and computation (1). 7 lesson
Mohr circles. Equivalent stress definition and computation (1). 7 lesson Прикладная голография. Техника голографического эксперимента. (Лекция 7)
Прикладная голография. Техника голографического эксперимента. (Лекция 7) Явления переноса. Понятие о физической кинетике
Явления переноса. Понятие о физической кинетике