Содержание
- 2. Если скорость травления лимитируется процессами поступления травителя или отвода продуктов реакции – травление изотропное сглаживание поверхности.
- 3. Получение V-образных канавок в (100) Si Поверхность (100) пересекается четырьмя плоскостями (111)
- 4. Формирование мембраны p++ SiO2 Si SiO2
- 5. получение U-образных канавок в (110) Si Поверхность пересекается шестью плоскостями (111) (четыре под углом 90о, две
- 6. Схема химико-динамического травления
- 7. Методы сухого травления Ионно-лучевое травление Ионно-плазменное травление Травление по механизму физического распыления Реактивное ионное травление Плазменное
- 8. Анизотропия: A = 1 – vб / vв Селективность: Sfm = vпл / vмаск Sfs =
- 9. Профиль края элемента
- 12. Процессы создания ионов и радикалов в газовом разряде Простая ионизация: Ar + e → Ar+ +
- 13. Энергия ионов ≥500 эВ Рабочее давление 0,133 – 13,3 Па
- 14. Плотность пучка ионов ≈ 1 мА /см Приклады-ваемое напряжение 500 В
- 15. Рабочее давление 13,3 – 1330 Па
- 16. Схема вакуумной камеры для радикального плазмохимического травления
- 17. Газы, применяемые для сухого травления Фоторезист O2
- 18. Механизмы влияния ионного облучения Обеспечивает диссоциацию молекул травящих газов Создает дефекты на поверхности, катализирующие хемосорбцию или
- 19. Ионно-ускоряемая реакция Энергия ионов 450 эВ Атомарный F Травление Si
- 20. Ионно-возбуждаемая реакция Энергия ионов 450 эВ Атомарный Cl Травление Si
- 21. CF4 → F + CFX CFX + O2 → COF2, CO, CO2 2F + H2 →
- 22. Для уменьшения бокового травления добавляют C2F6 в Cl2 e + Cl2 → 2Cl + e ионизация
- 23. «Загрузочный эффект»
- 24. Побочные эффекты Повторное осаждение Осаждение полимеров Радиационные повреждения Загрязнения материалом маски и т. д.
- 26. Скачать презентацию


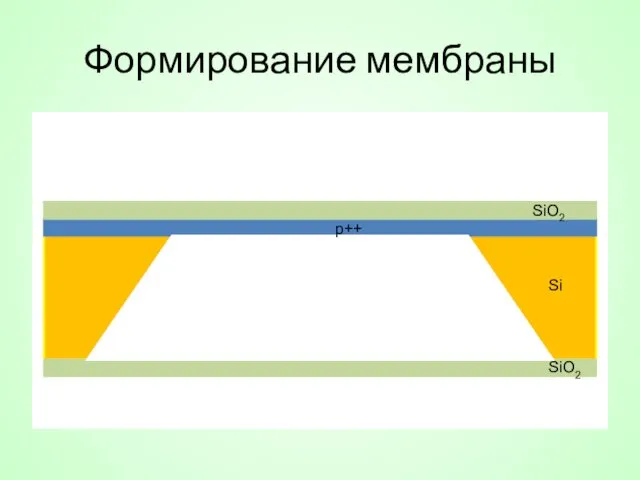
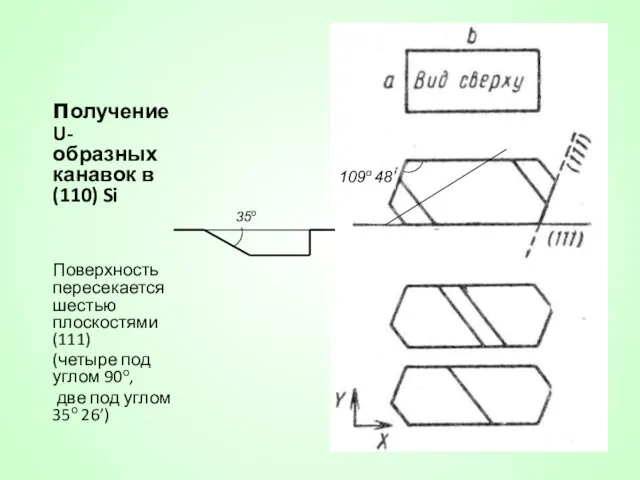


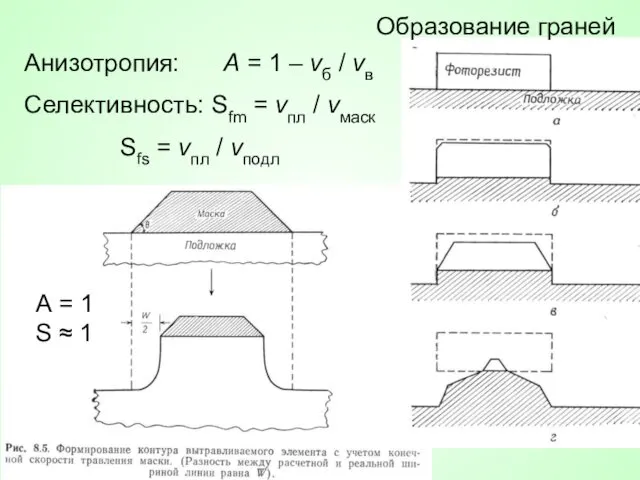
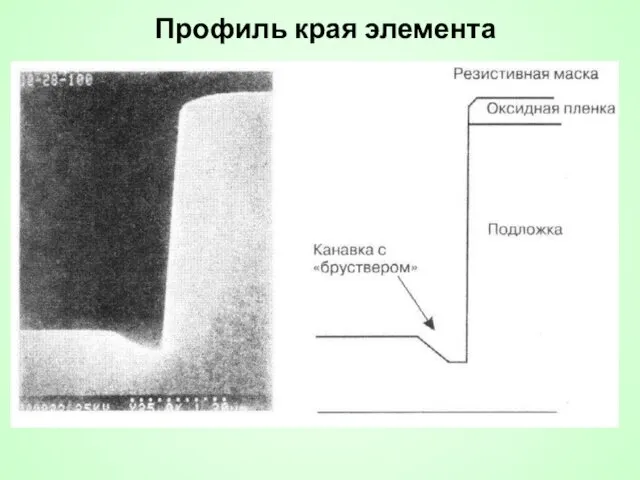

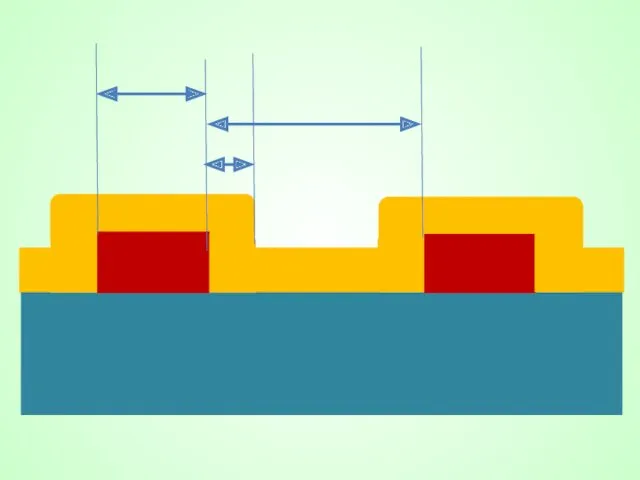


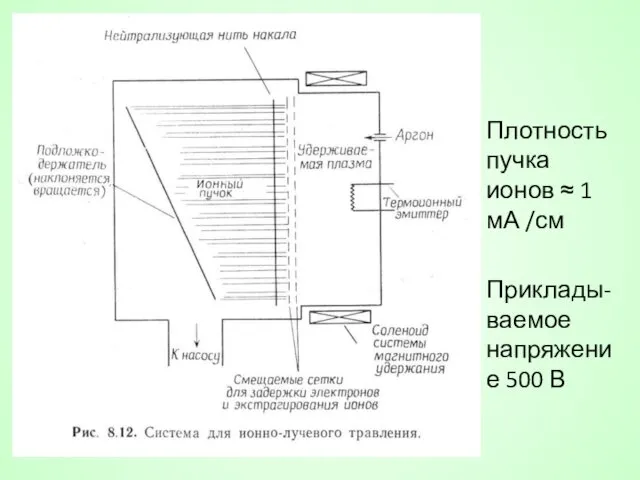










 Язык Паскаль (разветвляющий, циклический алгоритмы)
Язык Паскаль (разветвляющий, циклический алгоритмы) Роль семейных традиций в воспитании ребёнка
Роль семейных традиций в воспитании ребёнка Теория психологической (реалистической) школы государства и права
Теория психологической (реалистической) школы государства и права Stunde Zukunft
Stunde Zukunft урок-игра Российское сафари 8 класс
урок-игра Российское сафари 8 класс Визуальное равновесие фигур на плоскости
Визуальное равновесие фигур на плоскости Нарезание наружной резьбы
Нарезание наружной резьбы Развитие речи детей в условиях семьи и детского сада
Развитие речи детей в условиях семьи и детского сада Дослідження застосування вогнеметних підрозділів в локальних війнах і збройних конфліктах
Дослідження застосування вогнеметних підрозділів в локальних війнах і збройних конфліктах Классный час Как зимой помочь птицам
Классный час Как зимой помочь птицам презентация к тематическому классному часу, посвященному 100-летию Первой мировой войны
презентация к тематическому классному часу, посвященному 100-летию Первой мировой войны родительское собрание Не хочу делать уроки
родительское собрание Не хочу делать уроки проект по географии Демографическая ситуация села как зеркало демографии страны
проект по географии Демографическая ситуация села как зеркало демографии страны Зажимные механизмы и элементы приспособлений
Зажимные механизмы и элементы приспособлений Электрқондырғылардың істен шығуы
Электрқондырғылардың істен шығуы Влияние революционных идей в Европе в XIX веке. Какие политические идеи сформировали революции 1848 года в Европе
Влияние революционных идей в Европе в XIX веке. Какие политические идеи сформировали революции 1848 года в Европе Экологические факторы, условия и ресурсы среды
Экологические факторы, условия и ресурсы среды Презентация к семинару Современный урок
Презентация к семинару Современный урок Типы ландшафтов суши
Типы ландшафтов суши Космонавт
Космонавт Мой дом, моя семья- разработка занятия по духовно - нравственному воспитанию
Мой дом, моя семья- разработка занятия по духовно - нравственному воспитанию Презентация Развитие интеллекта старших дошкольников методами кинезиологии А.Л.Сиротюк
Презентация Развитие интеллекта старших дошкольников методами кинезиологии А.Л.Сиротюк Georgios Papanikolaou
Georgios Papanikolaou Роль декоративного искусства в жизни человека и общества. Обобщающий урок
Роль декоративного искусства в жизни человека и общества. Обобщающий урок Подбор игроков для команды Динамо (Санкт-Петербург)
Подбор игроков для команды Динамо (Санкт-Петербург) MDI tech. Комплекс услуг по проектированию и мелкосерийному производству различных видов продукции
MDI tech. Комплекс услуг по проектированию и мелкосерийному производству различных видов продукции Скрипты продаж для мебели
Скрипты продаж для мебели Развитие фонематических процессов
Развитие фонематических процессов