Содержание
- 2. Создание скрытого коллекторного слоя Обработка поверхности пластины кремния p -типа Окисление Фотолитография – формирование рисунка в
- 3. Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из источника неограниченной мощности) Окисление с разгонкой
- 4. Создание глубокого коллектора Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из источника неограниченной мощности)
- 5. Создание пассивной базы Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из источника неограниченной мощности)
- 6. Создание активной базы Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из источника неограниченной мощности)
- 7. Создание эмиттера Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из источника неограниченной мощности) Окисление
- 8. Создание металлизации Фотолитография – вскрытие окон в оксиде для создания контактов к областям Напыление алюминия с
- 9. Изготовление биполярной ИС с изопланарной изоляцией транзисторов
- 10. Локальное окисление кремния
- 11. Создание скрытого коллекторного слоя Обработка поверхности пластины кремния p -типа Окисление Фотолитография – формирование рисунка в
- 12. Создание изолирующих областей Нанесение нитрида кремния химическим осаждением из газовой фазы Фотолитография – формирование рисунка в
- 13. Создание глубокого коллектора Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из источника неограниченной мощности)
- 14. Создание пассивной базы Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из источника неограниченной мощности)
- 15. Создание активной базы Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из источника неограниченной мощности)
- 16. Создание эмиттера Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из источника неограниченной мощности) Окисление
- 17. Создание металлизации Фотолитография – вскрытие окон в оксиде для создания контактов к областям Напыление алюминия с
- 18. Изготовление биполярной ИС с щелевой изоляцией транзисторов
- 20. Создание скрытого коллекторного слоя Обработка поверхности пластины кремния p -типа Загонка мышьяка (диффузия из источника неограниченной
- 21. Создание изолирующих областей Фотолитография – формирование рисунка в оксиде Ионное травление канавок до глубины средней канавки
- 22. Создание глубокого коллектора Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из источника неограниченной мощности)
- 23. Создание пассивной базы Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из источника неограниченной мощности)
- 24. Создание активной базы Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из источника неограниченной мощности)
- 25. Создание эмиттера Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из источника неограниченной мощности) Окисление
- 27. Скачать презентацию



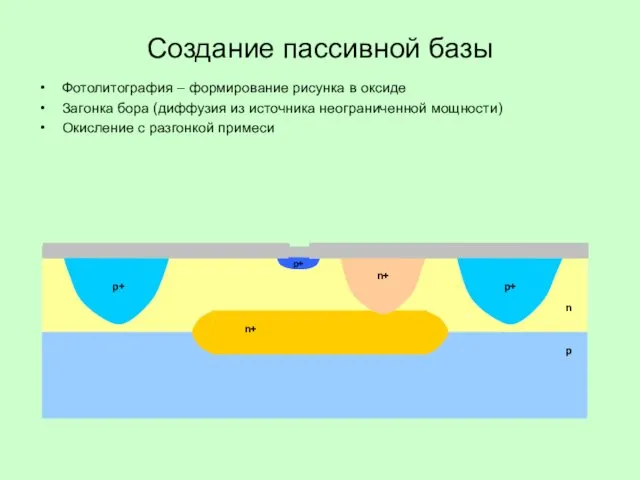


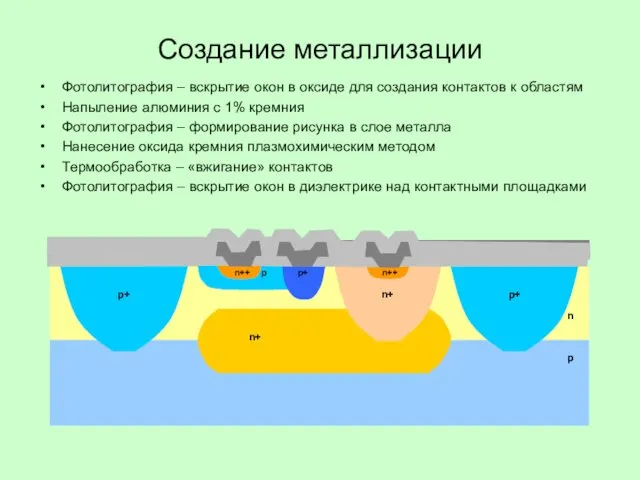



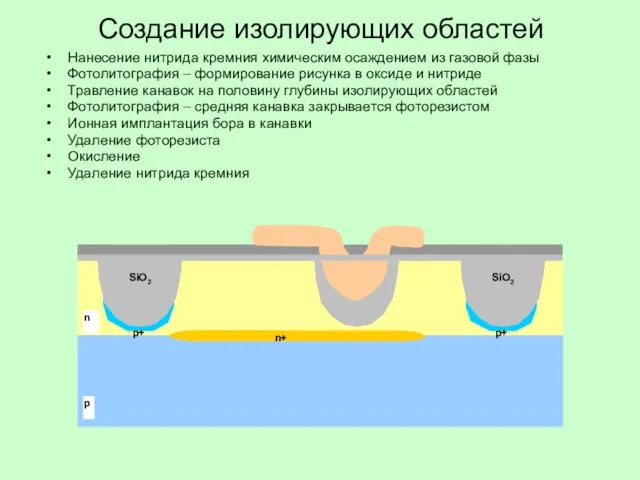




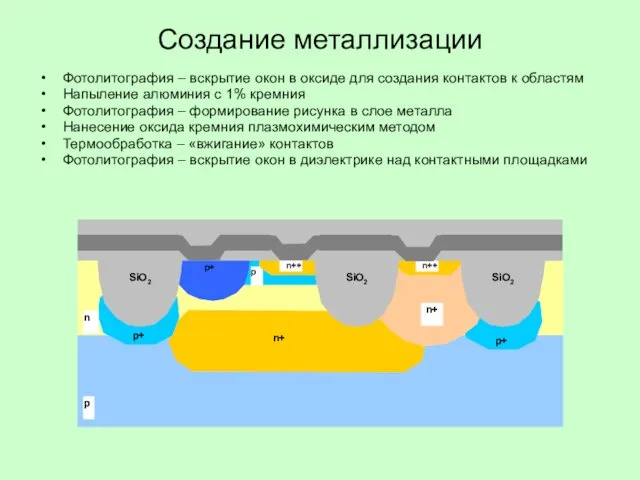








 презентация работа с родителями по фгос
презентация работа с родителями по фгос Дискриминация и права человека. Лекция 2
Дискриминация и права человека. Лекция 2 Общие вопросы ВИЧ\СПИД
Общие вопросы ВИЧ\СПИД Питательные среды. Методы культивирования микробов и аппаратура. Учет результатов анализа воздуха
Питательные среды. Методы культивирования микробов и аппаратура. Учет результатов анализа воздуха Благоустройство набережной р. Охты (Муниципальный округ Малая Охта)
Благоустройство набережной р. Охты (Муниципальный округ Малая Охта) Балаларда ерін аурулары
Балаларда ерін аурулары Порядок оборудования и содержания мостовой переправы зимой (для подразделений инженерных войск)
Порядок оборудования и содержания мостовой переправы зимой (для подразделений инженерных войск) Открытое занятие для детей подготовительной группы Дружба начинается с улыбки.
Открытое занятие для детей подготовительной группы Дружба начинается с улыбки. Теория государства и права
Теория государства и права Япония (1)
Япония (1) Внеурочное занятие по курсу Уроки нравственности по теме Золотое правило нравственности
Внеурочное занятие по курсу Уроки нравственности по теме Золотое правило нравственности Технология устройства кровельных покрытий
Технология устройства кровельных покрытий Загадки по правилам дорожного движения для 1 класса
Загадки по правилам дорожного движения для 1 класса М.И. Глинка. Опера Руслан и Людмила
М.И. Глинка. Опера Руслан и Людмила Права ребенка
Права ребенка Сүйек. Эктопиялық дамуы
Сүйек. Эктопиялық дамуы Первая помощь при повреждении грудной клетки и живота
Первая помощь при повреждении грудной клетки и живота Эксплуатация трансформаторов
Эксплуатация трансформаторов Многоуровневые подвесные потолки
Многоуровневые подвесные потолки Модернизированная переносная станция наземной разведки ПСНР-8М
Модернизированная переносная станция наземной разведки ПСНР-8М ковид
ковид Somebody That I Used To Know
Somebody That I Used To Know Международный день коренных народов мира
Международный день коренных народов мира Башкортостан - жемчужина Урала
Башкортостан - жемчужина Урала Укусы ядовитых змей и насекомых
Укусы ядовитых змей и насекомых Напряженность электростатического поля
Напряженность электростатического поля Специальное образование в меняющемся мире. Россия
Специальное образование в меняющемся мире. Россия Как мы весело живем!
Как мы весело живем!