Содержание
- 2. В базовых технологических маршрутах оптической нанолитографии можно выделить два микромаршрута: создание защитной маски (фоторезистивной или из
- 3. Классификация процессов размерного травления материалов
- 4. Плазмой называют квазинейтральный газ заряженных и нейтральных частиц, концентрация которых достаточна для того, чтобы создаваемый ими
- 5. Низкотемпературная газоразрядная плазма (НГП). НГП – это слабо ионизированный газ при давлении 13·10-2 - 13·102 Па
- 6. В зависимости от вида плазмообразующего газа и природы поверхности твёрдого тела в каждом из трёх случаев
- 8. По физико-химическому механизму взаимодействия частиц НГП с поверхностью обрабатываемого материала (образца) процессы травления можно разделить на
- 9. ПТ и РИПТ происходят в плазме химически активных газов, и в них поверхность обрабатываемого материала подвергается
- 10. Процессы травления должны обеспечивать: воспроизводимость, скорость, селективность, степень анизотропии, равномерность и высокую производительность. Указанные характеристики зависят
- 11. Основные выходные параметры процесса травления: Скорость травления Селективность травления Анизотропия травления Профиль травления Уровень внесенных радиационных
- 12. В системах вакуумного плазменного травления (ВПТ) диапазон давлений рабочего газа определяется условиями существования рабочих разрядов. В
- 15. Sisolid + 4F SiF4gas
- 16. Транспорт частиц в микроструктуре
- 18. Номенклатура специальных газов
- 22. Скорость травления поликристаллического кремния для газовых смесей, основанных на HBr- и Cl2,- от расхода смеси
- 23. Зависимость скорости травления слоев проводника от соотношения газовых потоков в смеси.
- 27. Несмотря на большое разнообразие все процессы вакуумного газоплазменного травления (ВГПТ) по механизму взаимодействия с обрабатываемым материалом
- 28. Классификация процессов вакуумного газо-плазменного травления (ВГПТ) по механизму взаимодействия с обрабатываемым материалом спонтанное химическое травление физическое
- 29. Спонтанное химическое травление материалов. В процессах спонтанного химического травления (spontaneous chemical etching - SC etching) основной
- 30. Из-за отсутствия данных по температурам испарения многих соединений, летучесть продуктов реакций, образующихся в процессах спонтанного химического
- 31. Если материал ФС не образует летучих двухкомпонентных соединений с ХАЧ (атомами и радикалами), то необходимо рассмотреть
- 32. Характеристики процесса спонтанного травления во фторуглеродных газах существенно зависят от относительного содержания фтора и углерода. В
- 33. Добавка кислорода в диапазоне (20 – 40) % при спонтанном травлении материалов в плазме фторуглеродных газов
- 34. В механизме спонтанного химического гетерогенного травления можно выделить следующие основные стадии: - доставка химически активных частиц
- 35. Скорость спонтанного травления материала ФС в результате химической реакции (spontaneous chemical etching - SC etching) в
- 36. По своему механизму процессы спонтанного химического травления материалов потоками атомов и радикалов должны быть изотропными, также
- 37. . Ионное травление материалов физическим распылением В процессах ионного травления физическим распылением (ion etching by physical
- 38. Процесс физического распыления материалов количественно характеризуется коэффициентом распыления (КР) (sputtering yield), который определяется как число атомов,
- 39. Значение КР материалов ионами инертных газов зависит от следующих факторов: 1. Массы бомбардирующих ионов mi. КР
- 40. 3. От атомного номера распыляемого материала za. Наблюдается сложная периодическая зависимость КР от атомного номера распыляемого
- 41. Эволюция профиля ионного травления подложки через защитную маску: a – профиль маски и подложки до проведения
- 42. Влияние эффекта переосаждения распыленного материала (sputtered material) подложки (substrate) на профиль ионного травления структуры через фоторезистивную
- 43. Влияние на профиль получаемой при ионном травлении структуры (etched film) эффекта отражения ионов от боковых стенок
- 44. Применительно к процессам травления материалов физическим распылением, следует отметить два важных аспекта: 1. Существующие теории физического
- 45. Ионное травление химически модифицированным физическим распылением материалов. При ионном травлении химически модифицированным физическим распылением (ion etching
- 46. Скорость травления химически модифицированных поверхностных слоев материала за счет физического распыления может быть как больше, так
- 47. Радиационно-стимулированное химическое травление материалов. При радиационно-стимулированном химическом травлении (radiation assisted chemical etching - RAC etching) спонтанные
- 48. Скорость радиационно-стимулированного химического травления (radiation assisted chemical etching - RAC etching) материала определяется выражением: Где -
- 49. Сравнивая выражение для радиационно-стимулированного химического травления с формулой для спонтанного травления, его можно представить в виде:
- 50. Типичный профиль ионно-стимулированного газового или радикального травления Coburn J.W., Winters H.F. Plasma etching - a discussion
- 51. Соотношение между плотностью потока молекул, атомов или радикалов рабочего газа и плотностью тока пучка ионов инертного
- 52. Радиационно-возбуждаемое химическое травление материалов. При радиационно-возбуждаемом химическом травлении (radiation excited chemical etching - REC etching) спонтанные
- 53. В этом случае радиационное воздействие (РВ) само возбуждает химические реакции, и его параметры (вид, энергия, интенсивность,
- 54. В процессах ионно-возбуждаемого газового и радикального травления (ИВГТ и ИВРТ), когда возбуждение химической реакции травления материала
- 55. Типичные зависимости скорости травления материалов для спонтанного химического травления vSCet, радиационно-стимулированного химического травления vRACet и радиационно-возбуждаемого
- 56. При проведении процессов травления в условиях плазмы (низкотемпературной неравновесной газоразрядной плазмы - ННГП) процессы взаимодействия различных
- 57. Повышение концентрации электронов, например, за счет увеличения мощности, вкладываемой в плазму, автоматически изменит концентрацию и энергию
- 58. Сравнительные технологические характеристики процессов вакуумного газоплазменного травления
- 60. Состав и параметры оборудования вакуумного газоплазменного травления функциональных слоев. Оборудование вакуумного газоплазменного травления (ВГПТ) материалов функциональных
- 61. 5. Системы термостатирования электродов, стенок камеры, подложкодержателей, испарителей жидких реагентов, участков газовых каналов и откачных магистралей,
- 62. Состав оборудования ВГПТ материалов ФС определяет перечень операционных (целенаправленно выставляемых режимных) параметров, к которым относятся: 1.
- 63. Способ крепления пластины к охлаждаемому подложкодержателю и обеспечения ее хорошего теплового контакта в оборудовании вакуумного газоплазменного
- 64. Изображение ICP системы для травления. Электростатический экран между катушкой и диэлектрическим окном (кварцевая труба) обеспечивает индуктивное
- 65. Схема форвакуумного насоса
- 66. Диффузионный насос
- 67. Турбомолекулярный насос
- 68. Схема криогенного насоса
- 71. а – эмиссионный спектр ВЧ-разряда на смеси 92% CF4 – 8% O2; б – эмиссионный спектр
- 73. Основные системы размерного вакуумного газоплазменного травления функциональных слоев ИС первого поколения: a - цилиндрический реактор (barrel
- 75. Основные системы размерного вакуумного газоплазменного травления функциональных слоев ИС второго поколения: a - планарная система магнитно-стимулированного
- 76. Основные системы размерного вакуумного газоплазменного травления функциональных слоев ИС третьего поколения: a - система с индукционно-связанной
- 84. Для большинства применений плазменных процессов в микро- и наноэлектронике важно знать как распределено падение потенциала в
- 88. 1) первая катодная темная область; 2) первое катодное свечение; 3) вторая катодная темная область; 4) второе
- 91. Схема РИТ
- 93. Основные факторы при травлении в плазме элементов с малыми размерами и высоким аспектным соотношением: зарядка диэлектрических
- 94. Четыре основных механизма снижения анизотропии и задержки РИТ Ионное затенение. Рассеивание и зарядовый обмен в ОПЗ
- 95. а- «идеальный» профиль, b - осаждение полимера на боковые стенки формируемой структуры, с - проявляется химическая
- 96. На рисунке а) показан профиль травления, который во многих случаях можно считать «идеальным». В этом случае
- 97. На рисунке е) показан профиль, который формируется, если боковые стенки профиля окна маски имеют наклон. В
- 98. В силу своей природы плазма содержит заряженные частицы – положительно зараженные ионы и отрицательно заряженные электроны.
- 109. Transmission electron microscopy cross-sections of nanowire structure. (Reprinted from Yang, F.-L., Lee, D.-H., Chen, H.-Y., Chang,
- 111. Микрофотография профиля щелевой структуры с осажденными тонкими слоями TaN/Ta/Cu.
- 112. Возможные поврежденияструктур, присущие плазменным процессам.
- 116. Поперечное сечение нижней части канавки с подтравом, вызванным переотражением ионов от заряженных стенок.
- 123. Селективное плазменное травление нитрида для формирования нитридного спейсера.
- 124. Микрофотография самосовмещенного контакта, вытравленного в системе высокоплотной плазмы, иллюстрирующая низкую селективность на углах структуры при понижении
- 125. Микроснимок поперечного сечения щелей различной ширины, протравленных в DRM системе в течение восьми минут. Наблюдается снижение
- 127. Схематичное изображение щелевого конденсатора, используемого в 256 Мгб ДОЗУ.
- 128. Вариации формы канавки для различных поколений ДОЗУ, приводящие к 10% изменениям площади конденсатора, вызываемым отклонением параметров
- 129. SF6/O2 крио процесс с использованием наноимпринт литографии. Суб-20 нм область.
- 130. 26 нм элемент поликремния, протравленный с высокой селективностью по отношению к подзатворному окислу. 3 стадии травления:
- 131. 27 нм линии в кремнии глубиной 450 нм.
- 132. 1 мкм переходные контактные отверстия в окисле кремния
- 133. 110 нм линии хрома.
- 134. 100 нм линии. Аспектное отношение 10:1.
- 135. 50 мкм элемент кремния.
- 136. 50 мкм травление кремния с использованием Bosch Process при изготовлении микромеханических устройств
- 137. Травление кремния по РИТ технологии в анизотропно-изотропном процессе для формирования кантиливеров АСМ
- 138. 75 мкм травление кремния
- 139. 400 мкм отверстие в кремнии, полученное по технологии криогенного РИТ
- 140. Микрофотография поперечного сечения с трансмиссионного электронного микроскопа (TEM) Al(Cu) проводника после травления Cl2/HCl плазмой, сопровождаемой удалением
- 141. Фотография полости в проводнике ("укус мыши") вызванной коррозией проводника из Al(Cu).
- 142. Микрофотографии изотропных профилей травления Si*: а) - W = 90 Вт, P = 45 Па, QSF6
- 143. Микрофотографии нанопроволочной кремниевой структуры (а) и чувствительного виброрезонансного наноэлемента для атомных весов (б).
- 144. Зависимости скоростей травления Si*, SiO2 и Si3N4 от операционных параметров процесса: а) - от ВЧ-мощности; б)
- 145. Зависимости селективностей травления Si*/SiO2 и Si*/Si3N4 от операционных параметров процесса: а) от ВЧ-мощности; б) – от
- 150. Линии шириной 22 нм протравленные в кремнии через электронно-лучевой резист. Аспектное отношение 7:1
- 153. Темы для рефератов: Физико-химические свойства низкотемпературной плазмы. Методы диагностики. Физико-химическое воздействие НГП на обрабатываемую поверхность. Методы
- 155. Скачать презентацию












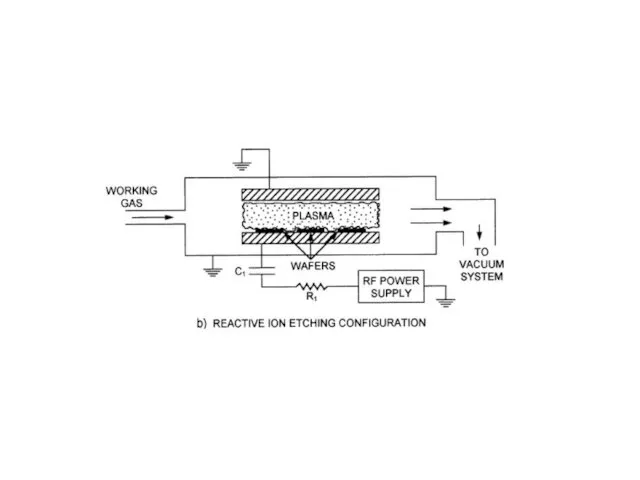
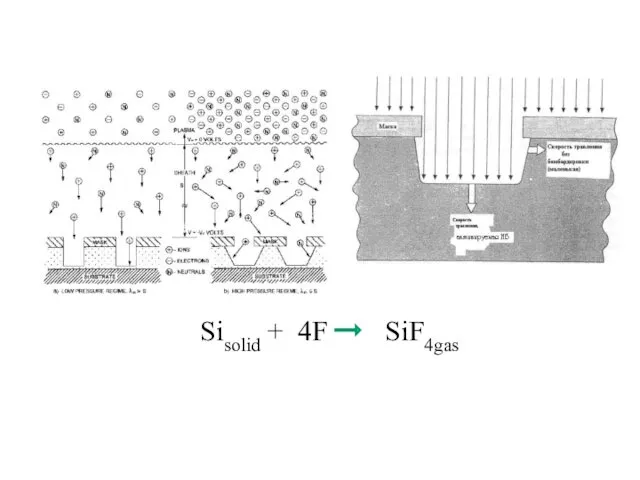









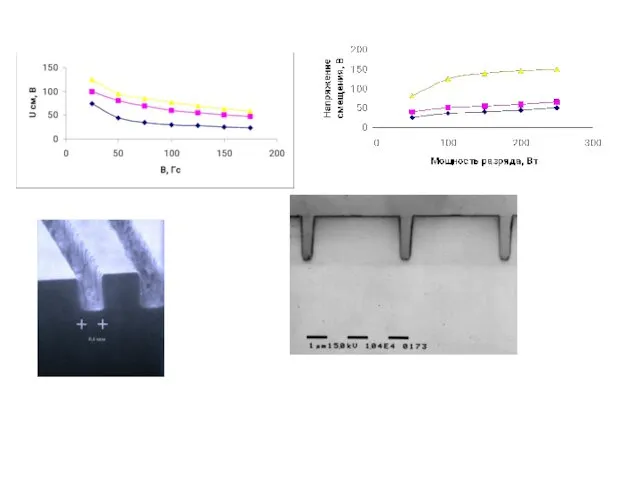















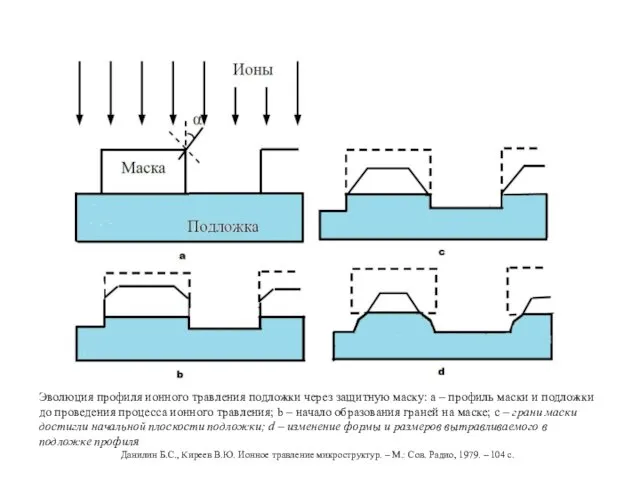
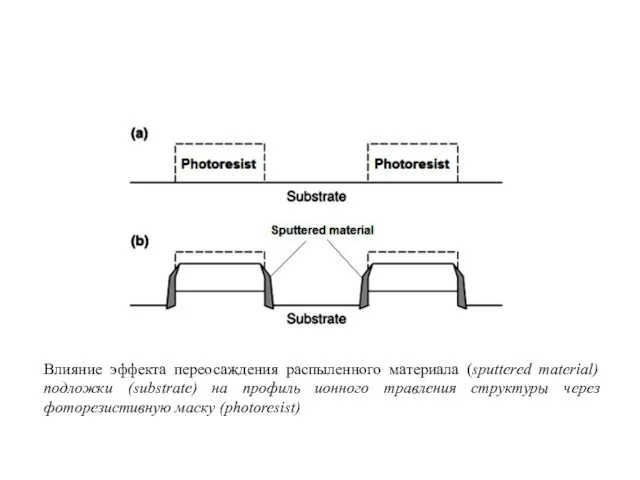
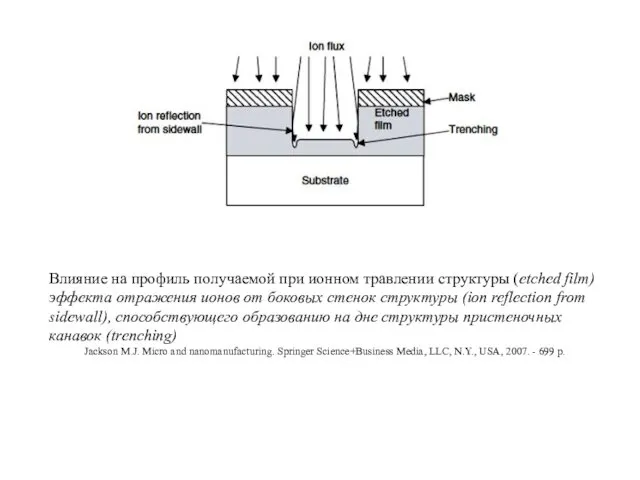






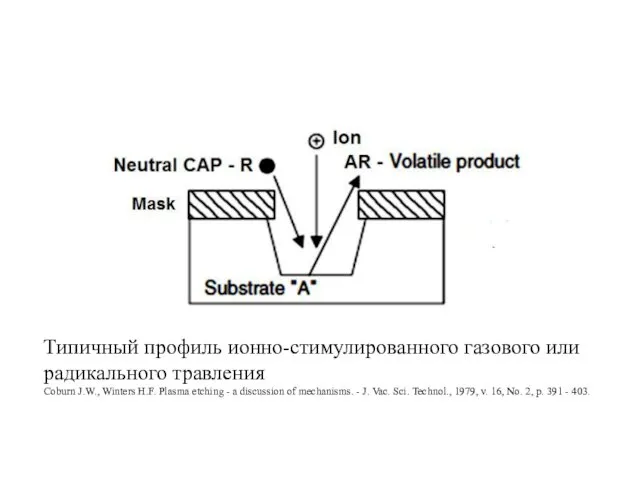








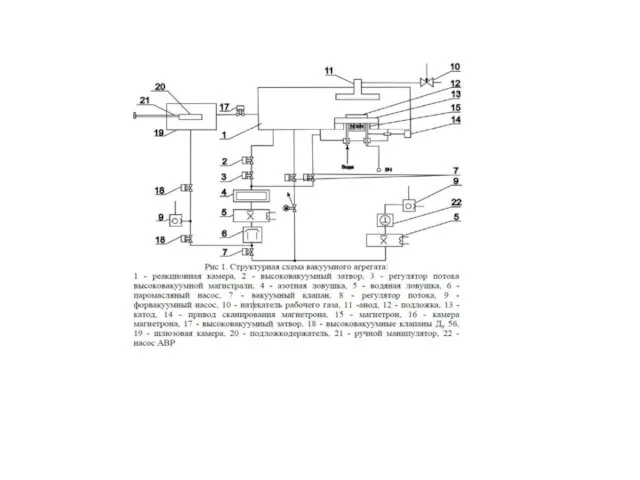



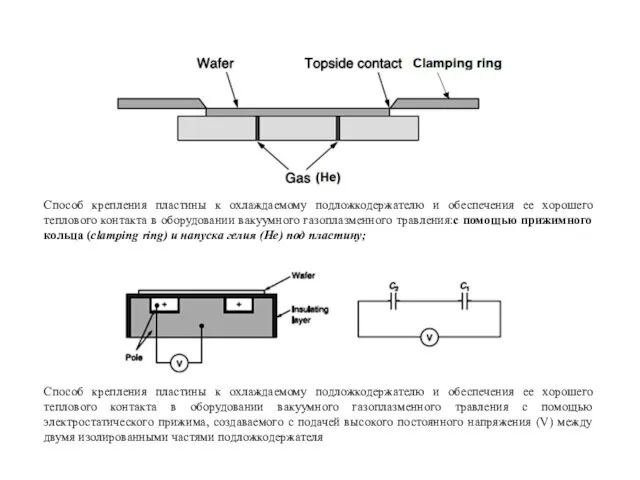
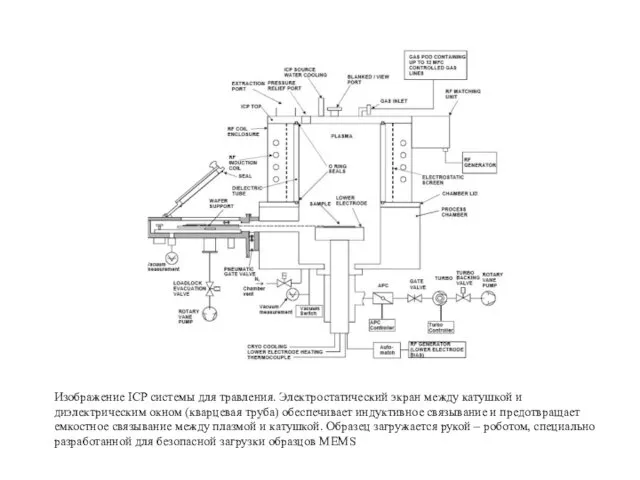


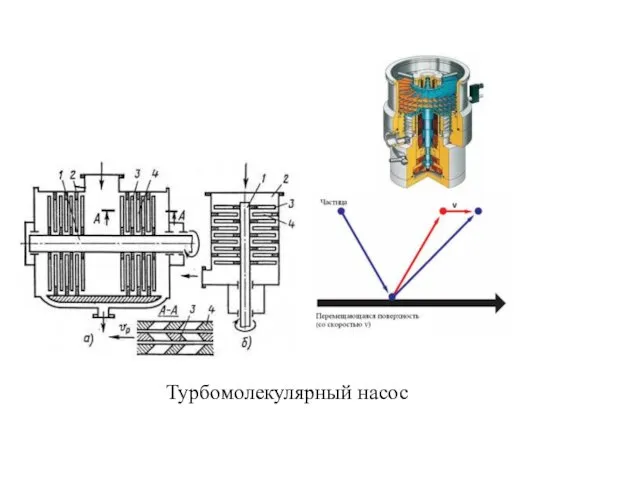

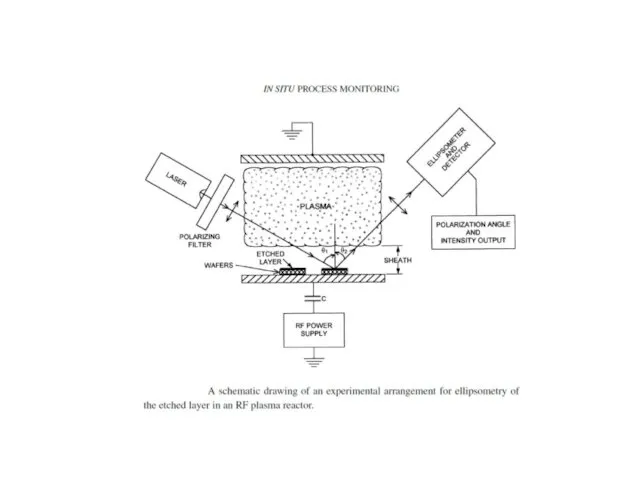



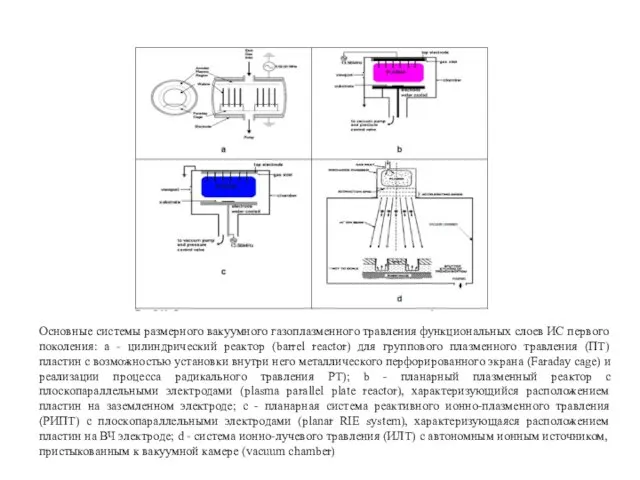
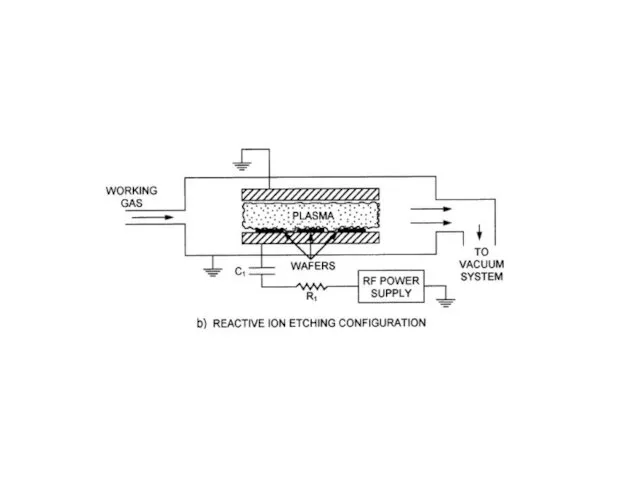

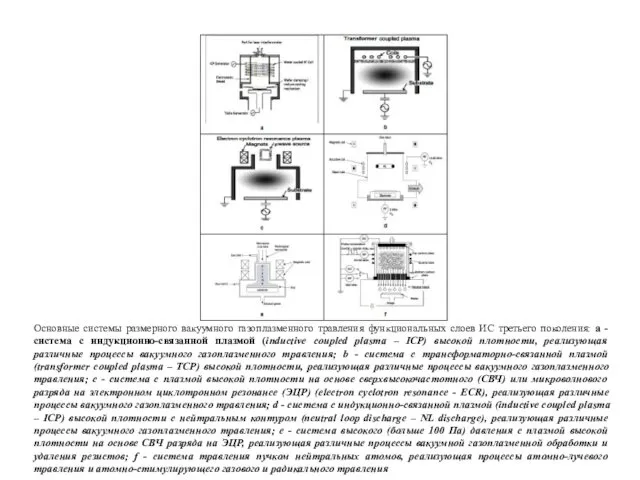

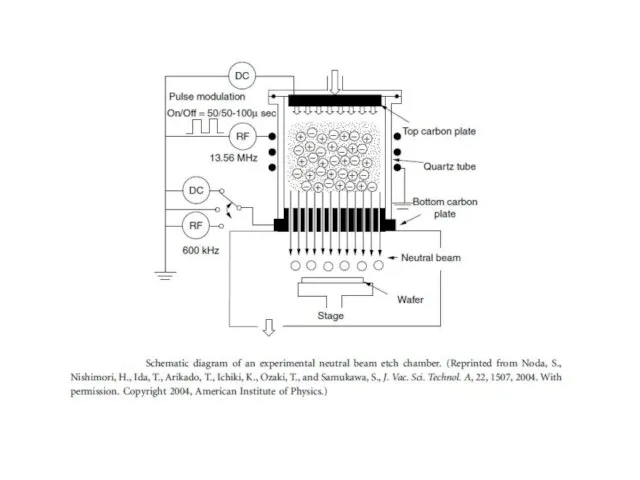
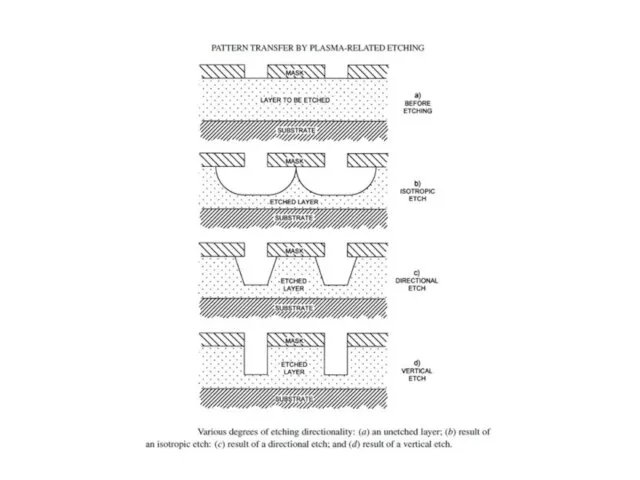


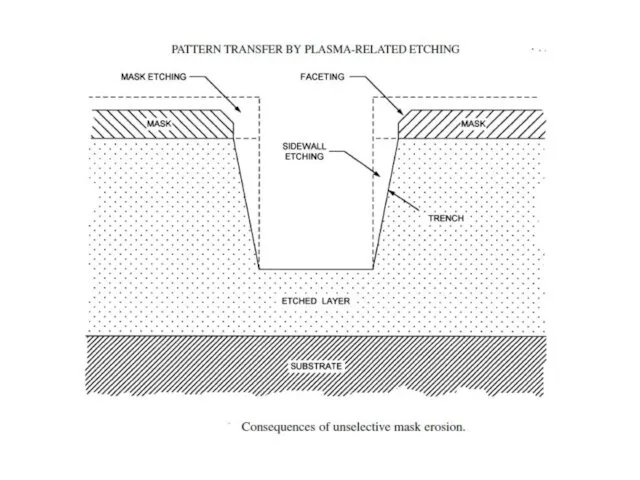
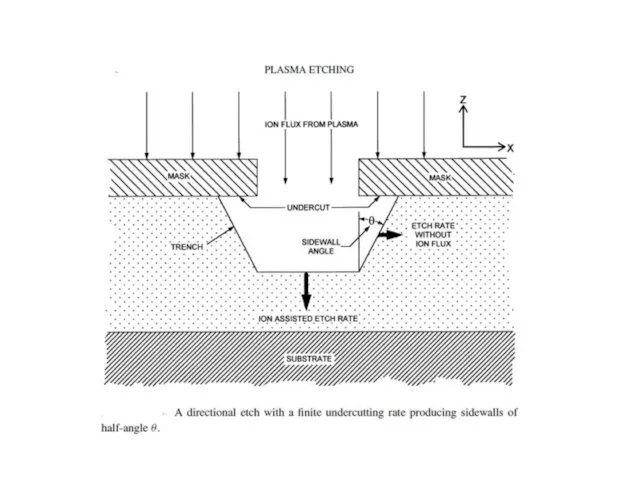






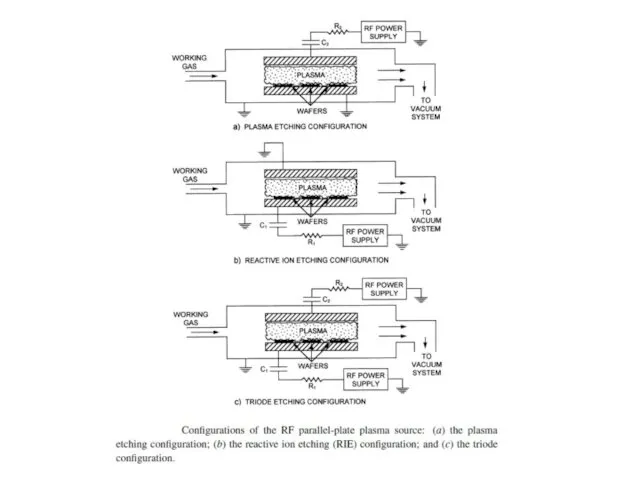
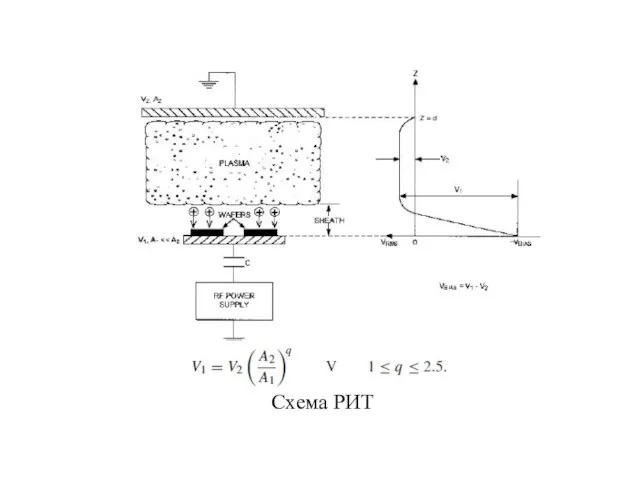








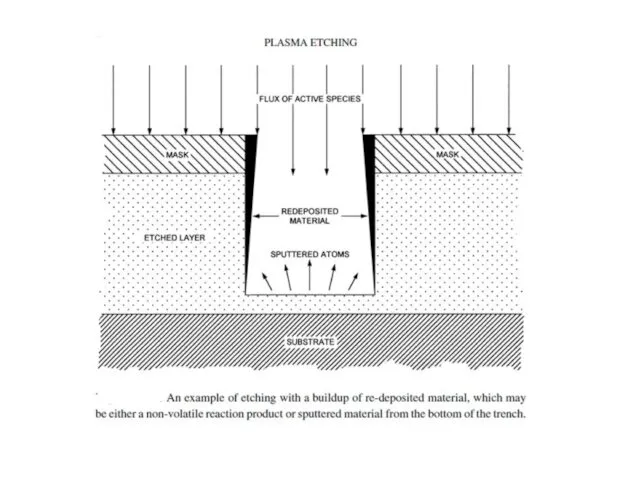
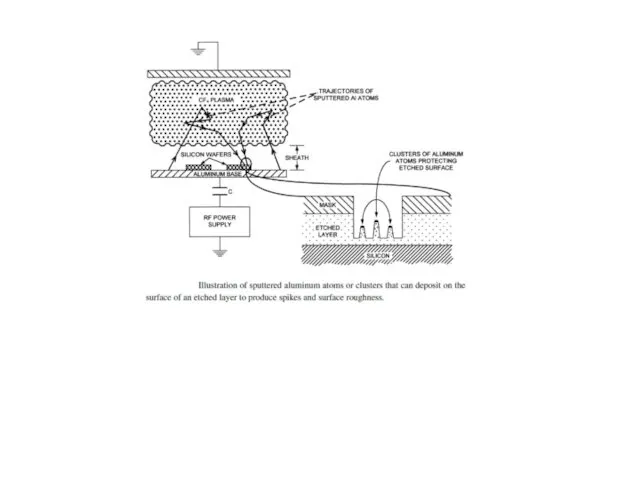
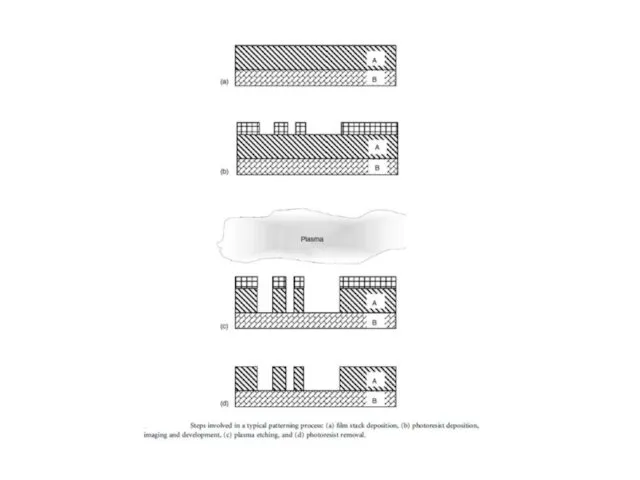
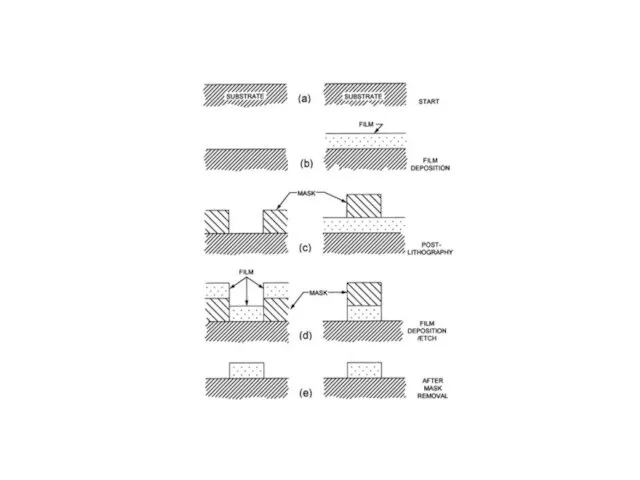
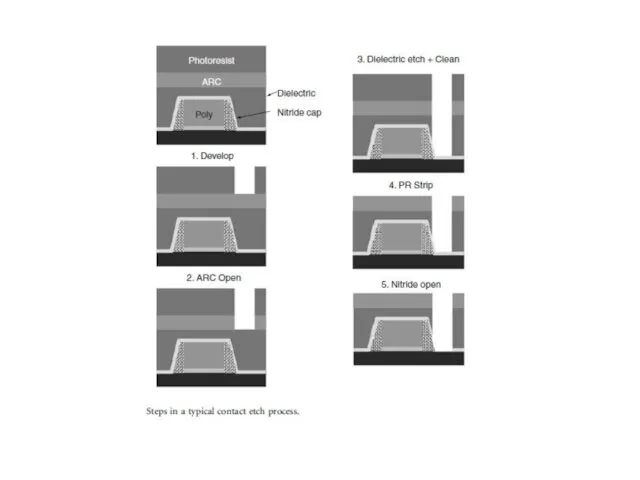
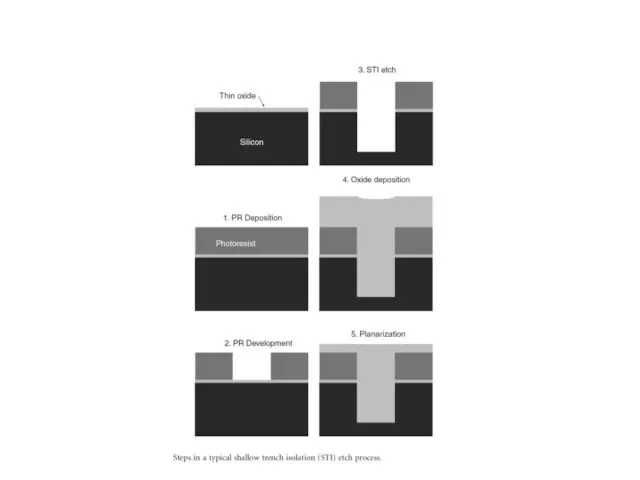
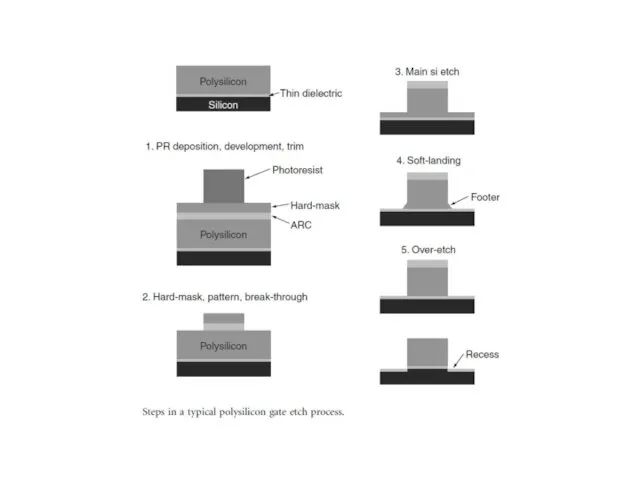
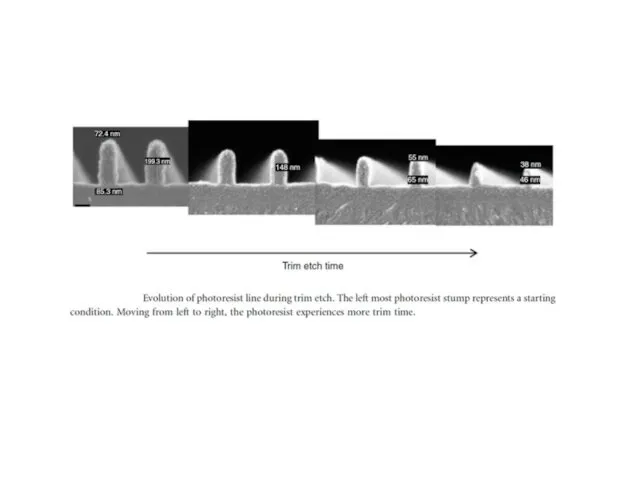

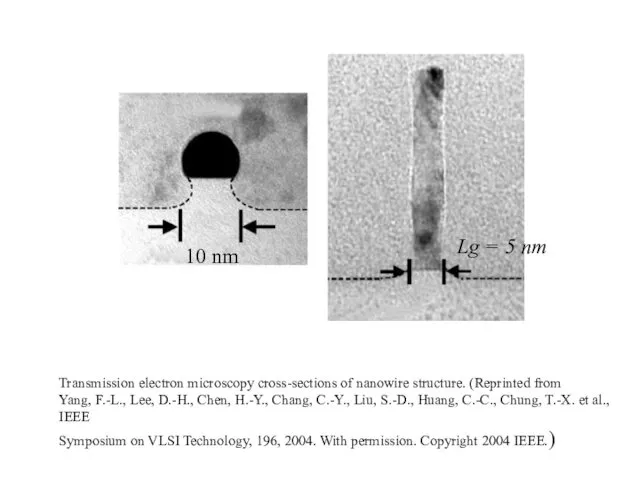








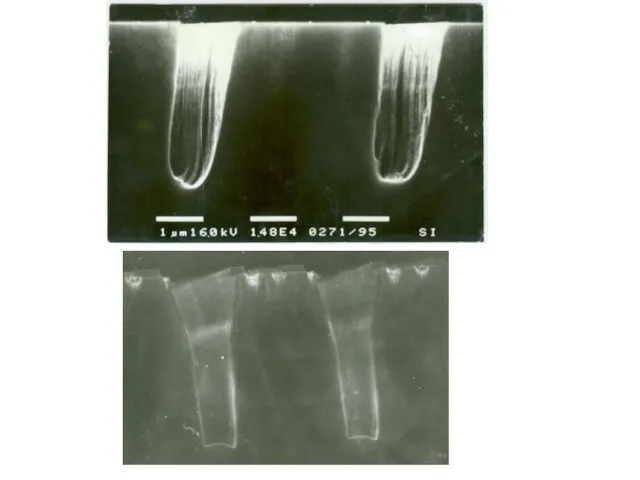

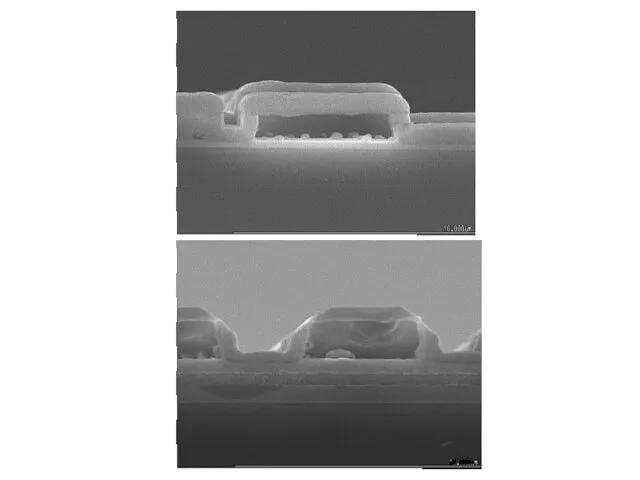
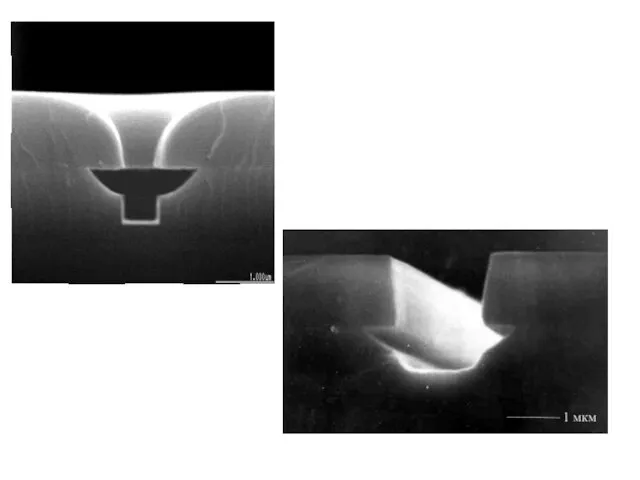



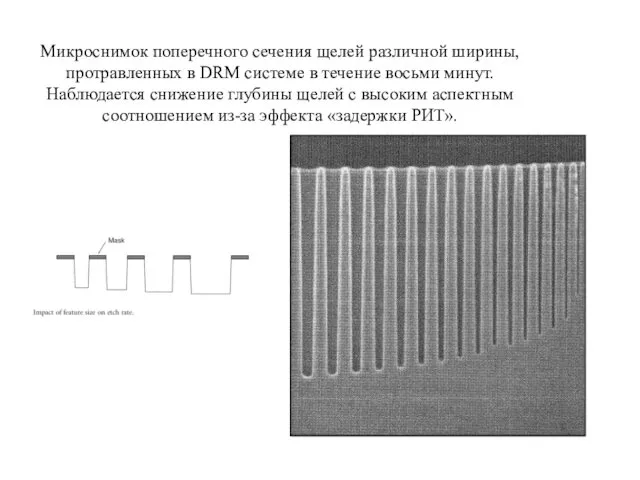




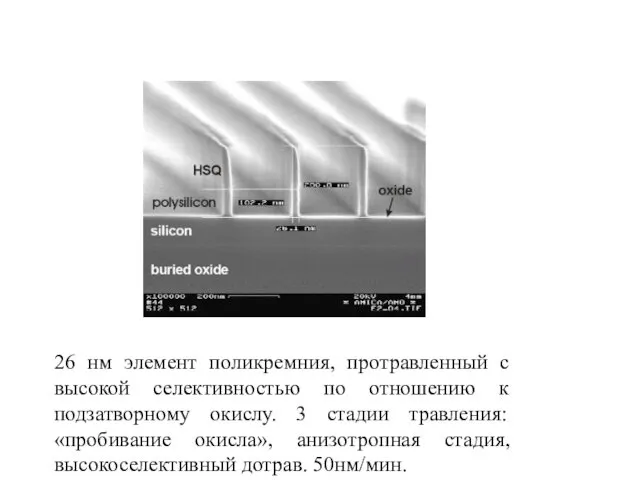


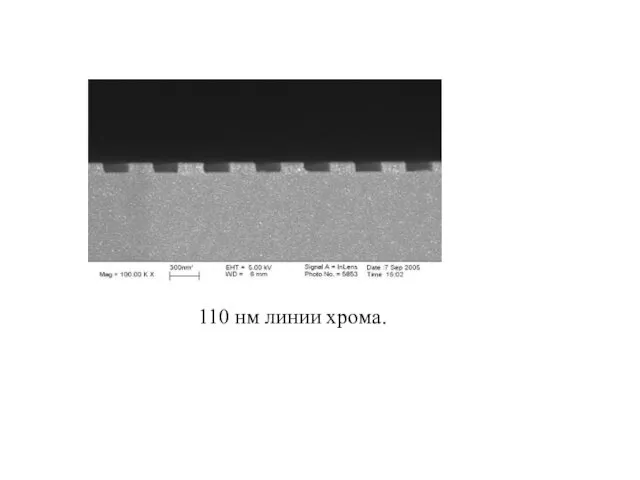


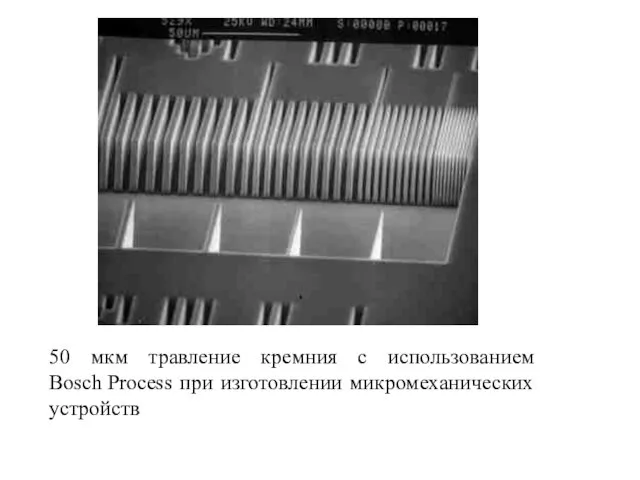
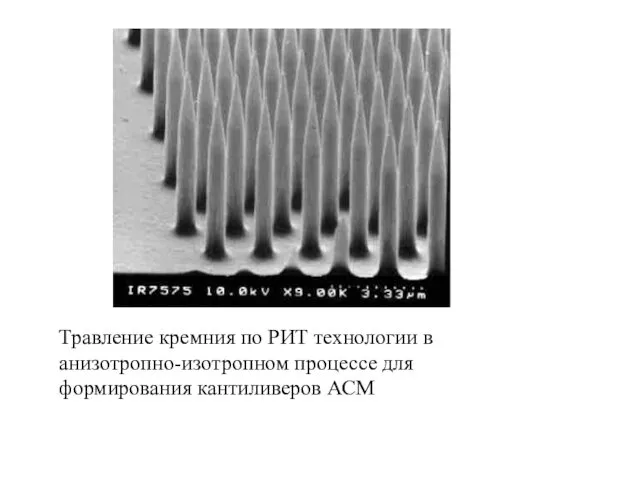


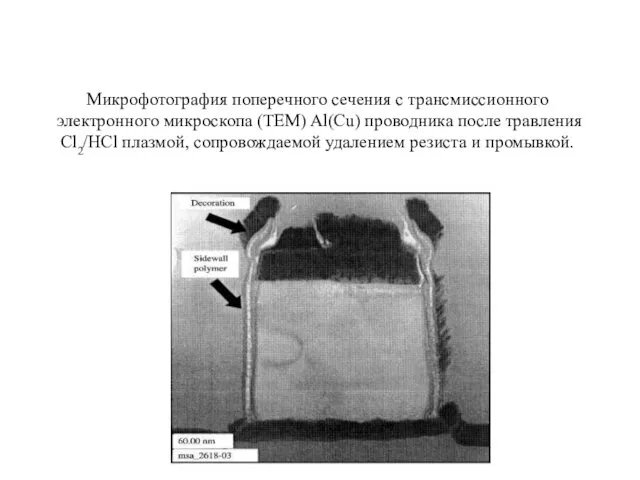
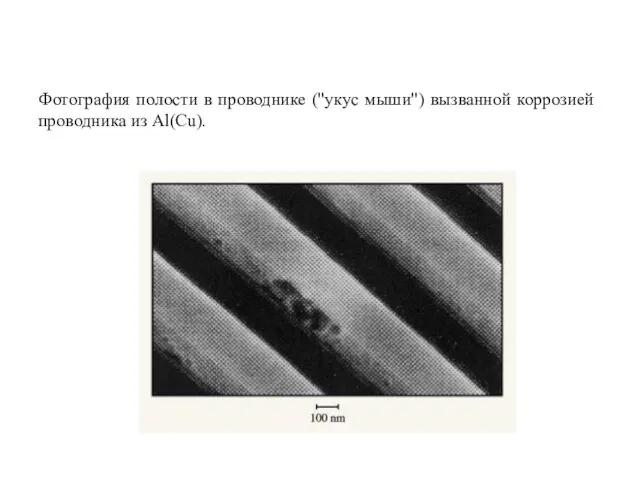
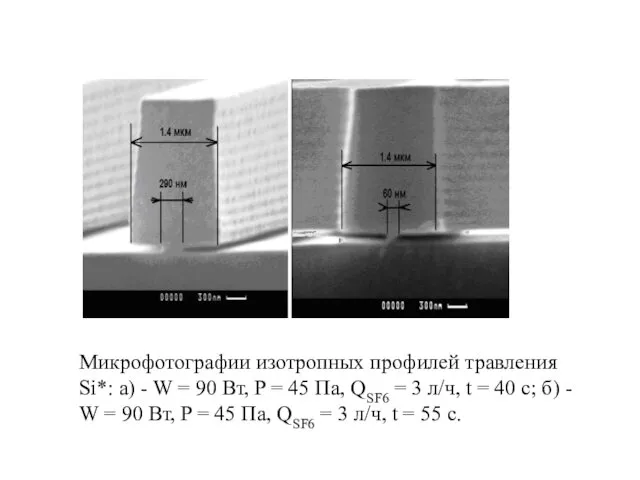
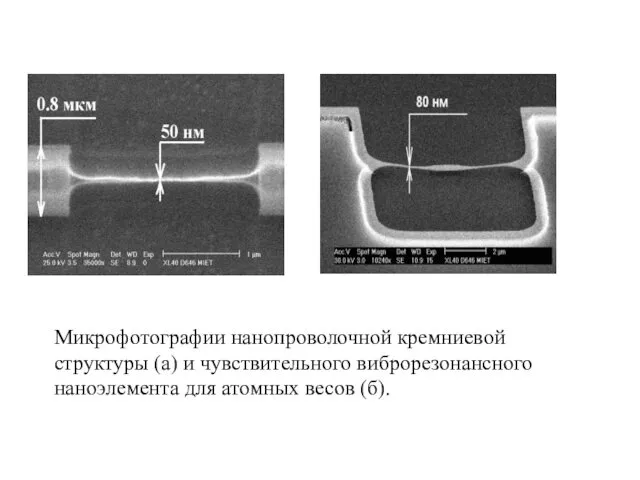

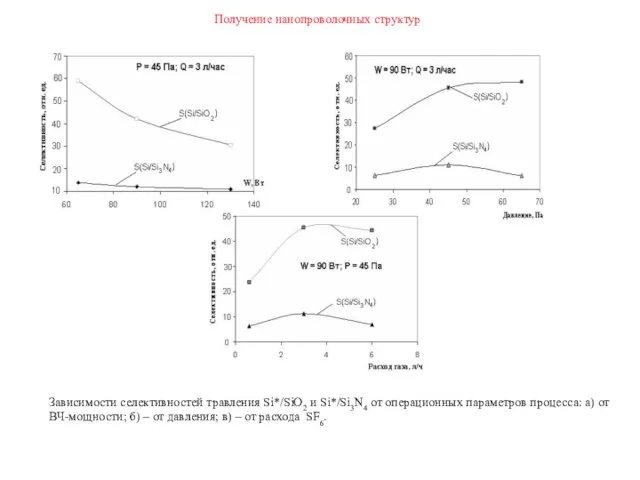




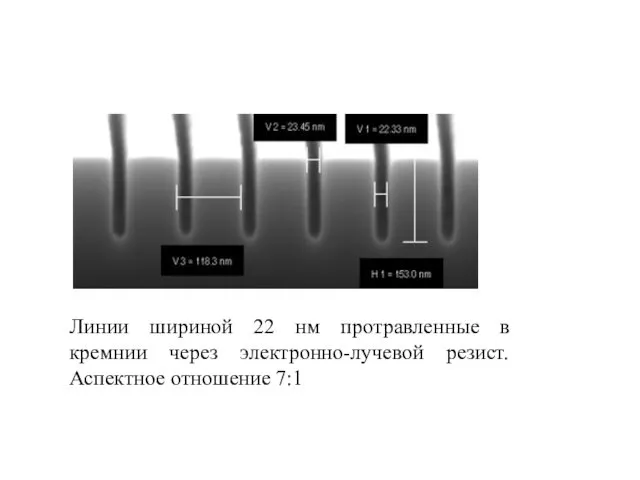
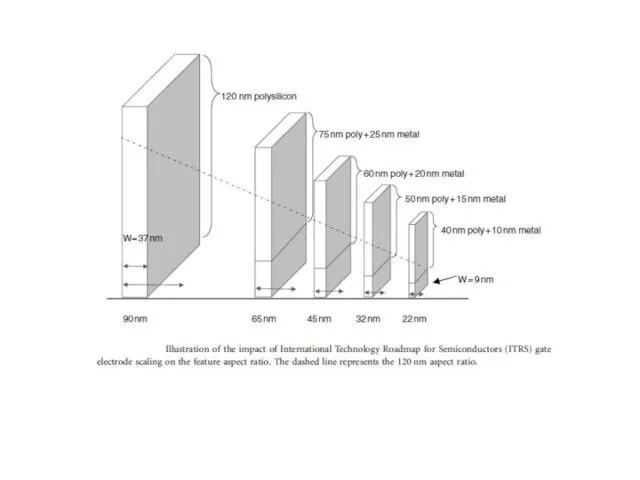
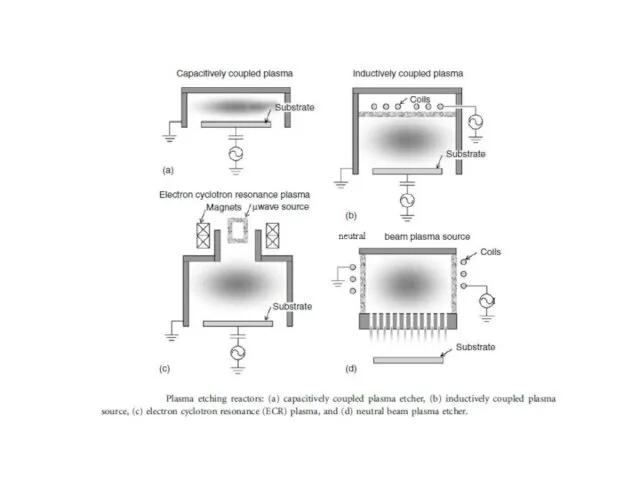

 Крокодилы
Крокодилы Конденсаторы. Обозначения и виды конденсаторов
Конденсаторы. Обозначения и виды конденсаторов Комплексная помощь детям с ОВЗ
Комплексная помощь детям с ОВЗ Анализ стихотворения Н. М. Рубцова Ласточка
Анализ стихотворения Н. М. Рубцова Ласточка Логика
Логика Богдинско-Баскунчакский заповедник
Богдинско-Баскунчакский заповедник презентация Лесные животные
презентация Лесные животные Муса Джалиль - поэт-воин, поэт-герой
Муса Джалиль - поэт-воин, поэт-герой Старший школьный (подростковый, пубертатный) период
Старший школьный (подростковый, пубертатный) период Повреждения трансформаторов
Повреждения трансформаторов Аммиак
Аммиак Виденин Иван Васильевич. Семейные реликвии
Виденин Иван Васильевич. Семейные реликвии Повышение интереса к профессии сварщик
Повышение интереса к профессии сварщик Сірке қышқылын алу технологиясы
Сірке қышқылын алу технологиясы Борис Заходер детям.
Борис Заходер детям. Полевые транзисторы
Полевые транзисторы Введение в курс Общей биологии 10 класс. 3
Введение в курс Общей биологии 10 класс. 3 Удосконалення транспортно-експедиційного обслуговування населення у місті Луцьку
Удосконалення транспортно-експедиційного обслуговування населення у місті Луцьку Шуточные загадки по химии
Шуточные загадки по химии Организация внеурочной деятельности кружка Волшебная кисточка для учеников 1-2 классов за 1 полугодие 2013-2014 уч.г.
Организация внеурочной деятельности кружка Волшебная кисточка для учеников 1-2 классов за 1 полугодие 2013-2014 уч.г. презентация по теме Гидролиз
презентация по теме Гидролиз Конструирование швейных изделий
Конструирование швейных изделий Электрохимические методы анализа: потенциометрия. Потенциометрическое титрование
Электрохимические методы анализа: потенциометрия. Потенциометрическое титрование Учитель мой
Учитель мой Фандрайзинг – привлечение средств на социальные проекты. Молодежное движение Миротворец
Фандрайзинг – привлечение средств на социальные проекты. Молодежное движение Миротворец Портальная гипертензия
Портальная гипертензия Розы из кленовых листьев
Розы из кленовых листьев Проект Белоусова
Проект Белоусова