Содержание
- 2. Главным направлением при производстве электронных модулей остается снижение себестоимости сборки и монтажа ПП при поддержании стабильно
- 3. Производство ПП на стадии сборочно-монтажных операций включает в себя следующие основные этапы: - подготовка компонентов и
- 4. Выполнил: студент кафедры РЭТЭМ Студенков Н.О. Компоненты для установки на печатных платах 3
- 5. Известны два основных варианта конструкций узлов на ПП: С использованием монтажных отверстий на ПП для установки
- 6. Основные группы компонентов В зависимости от конструкции корпуса компонента и формы выводов можно выделить три основных
- 7. Поверхностно монтируемые компоненты (Surface Mount Device - SMD) К этой группе относятся пассивные (резисторы, конденсаторы, индуктивности)
- 8. Выводные компоненты (Pin Through Hole – PTH): Традиционные пассивные и активные компоненты с осевыми и радиальными
- 9. Нестандартные компоненты (Odd Form Component-OFC): 8 Соединители; Трансформаторы; Разъемы; Колодки; Держатели; Экраны и т.д.
- 10. Пассивные компоненты для SMD монтажа 9 Изготавливаются в двух модификациях: в виде цилиндра (тип MELF –
- 11. Пассивные компоненты для SMD монтажа 10 Стандартное обозначение пассивных чип-компонентов состоит из 3 и 4 цифр,
- 12. Пассивные компоненты для SMD монтажа 11 Керамические чип-конденсаторы представляют собой структуру из чередующихся диэлектрических слоев керамики
- 13. Можно выделить 4 типа корпусов у ИМ: С вертикальными выводами, расположенными перпендикулярно плоскости корпуса ИМ (DIP,
- 14. Конструкция корпусов ИМ первой группы 13 Характерна для традиционного монтажа, поскольку требует наличия на плате установочных
- 15. Конструкция корпусов ИМ второй группы 14 Самая распространенная и имеет много подвидов. Особенно отмечаются три разновидности:
- 16. Конструкция корпусов ИМ второй группы 15 TAB – кремниевые кристаллы крепятся к полимерной ленте, на которую
- 17. Конструкция корпусов ИМ третьей группы 16 LCCC - безвыводные керамические или пластиковые кристаллоносители. Выполняется корпус из
- 18. Конструкция корпусов ИМ четвертой группы 17 Отличительной чертой корпусов ИМ четвёртой группы является наличие контактов на
- 19. Конструкция корпусов ИМ четвертой группы 18 Недостатком корпусов типа BGA является затрудненный контроль операции пайки и
- 20. Конструкция корпусов ИМ четвертой группы 19 CSP (Chip-Scale Packages) - обычно определяется как компонент, размером не
- 21. Конструкция корпусов ИМ четвертой группы 20 Технология flip-chip представляет собой Si-кристалл, непосредственно устанавливаемый на коммутационную подложку
- 22. 21 Достоинства технологии flip-chip: 1) экономия места на ПП; 2) малые габариты и вес узла с
- 23. 22 Недостатки технологии flip-chip: 1) дороговизна технологии формирования шариковых выводов у кристалла; 2) чрезвычайно плотная разводка
- 24. Нестандартные и выводные компоненты 23 Автоматизация сборки на платы нестандартных компонентов весьма дорога из-за их малого
- 25. Нестандартные и выводные компоненты 23 В современной технологии сборки выводных компонентов можно отметить следующие тенденции: она
- 27. Скачать презентацию








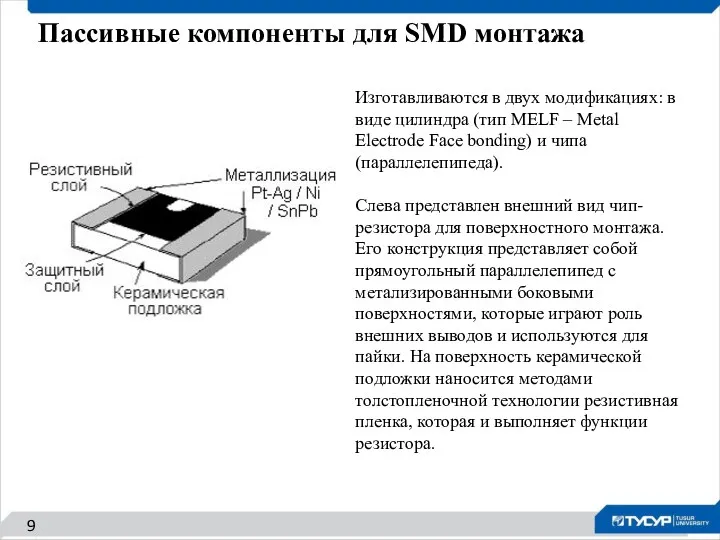


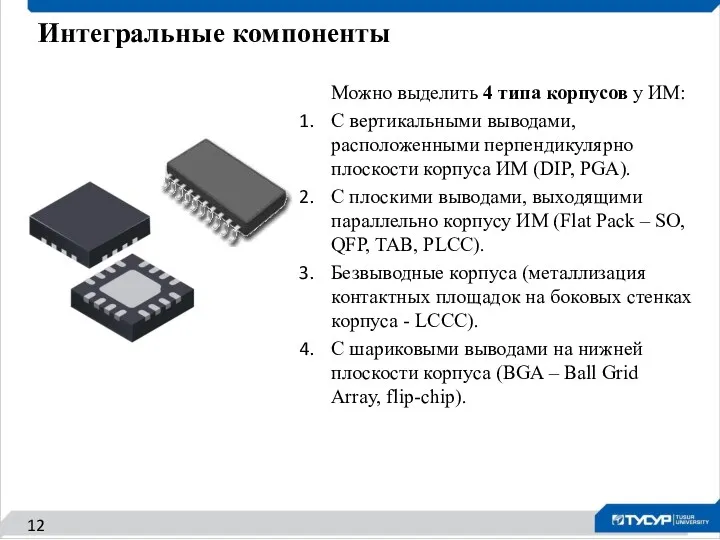
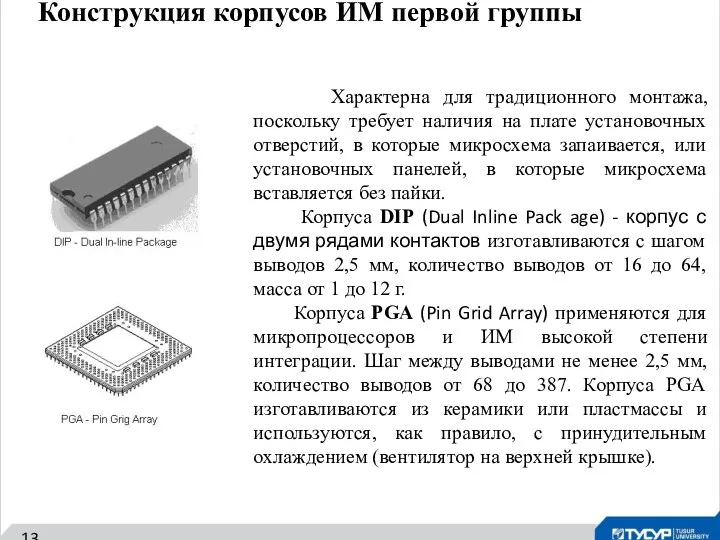
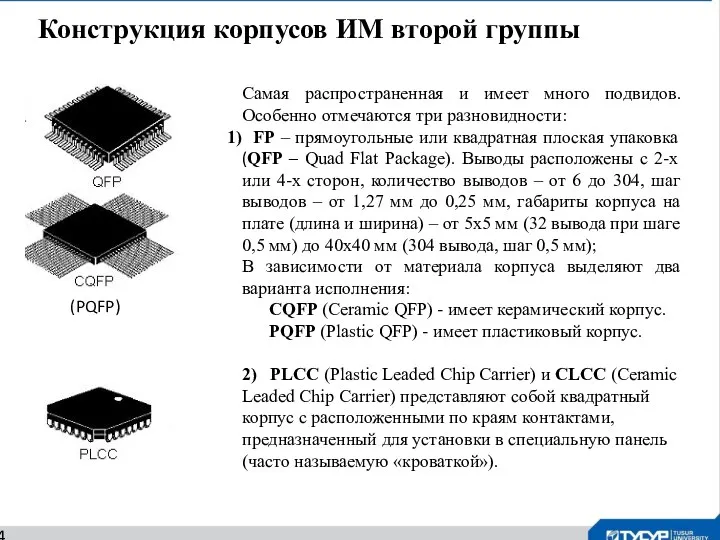


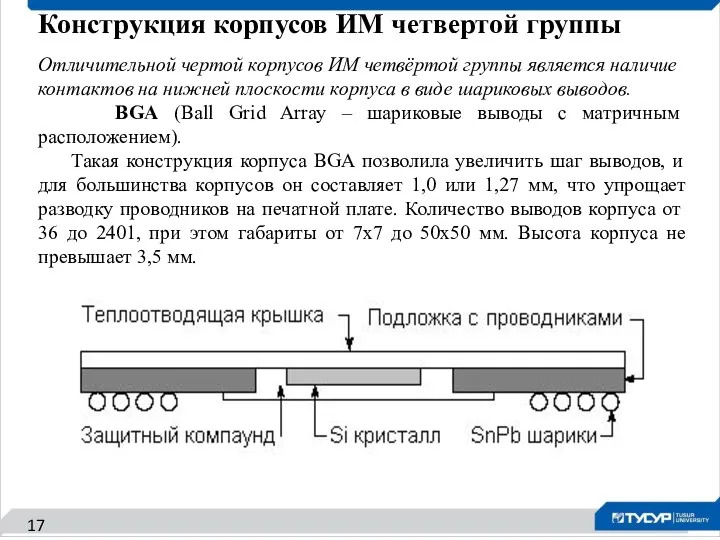







 Биологические науки. Интерактивный кроссворд
Биологические науки. Интерактивный кроссворд ТБ на летних каникулах
ТБ на летних каникулах Кремнийорганикалық қосылыстар
Кремнийорганикалық қосылыстар Арифметические и логические основы работы компьютера
Арифметические и логические основы работы компьютера Верховино 1917-1920
Верховино 1917-1920 Дополнительная общеобразовательная программа Малая тимирязевка
Дополнительная общеобразовательная программа Малая тимирязевка Элементы IА-группы и их соединения
Элементы IА-группы и их соединения География 6 класс Изображение на плане неровностей земной поверхности
География 6 класс Изображение на плане неровностей земной поверхности Мышечная ткань. Мышцы частей тела
Мышечная ткань. Мышцы частей тела 200 лет Царскосельскому лицею
200 лет Царскосельскому лицею Избирательная система
Избирательная система Избирательное право. Избирательные системы их виды
Избирательное право. Избирательные системы их виды Ко Дню Защитника Отечества.
Ко Дню Защитника Отечества. История медиа. Наскальные рисунки индейцев
История медиа. Наскальные рисунки индейцев Презентация Рефлексия
Презентация Рефлексия Цветная металлургия
Цветная металлургия Осложнения в процессе бурения скважин
Осложнения в процессе бурения скважин Человекообразные обезьяны
Человекообразные обезьяны Managementul integrat al pacienților cu diaree
Managementul integrat al pacienților cu diaree презентация на тему Метод проектов в ДОУ
презентация на тему Метод проектов в ДОУ Презентация конкурса Мамочка милая, мама моя!
Презентация конкурса Мамочка милая, мама моя! Презентация Пасхальная викторина
Презентация Пасхальная викторина Проект Аты-баты, шли солдаты в подготовительной к школе группе
Проект Аты-баты, шли солдаты в подготовительной к школе группе Конструкции элементов полупроводниковых ИС на МДП-транзисторах
Конструкции элементов полупроводниковых ИС на МДП-транзисторах X областной кинофестиваль для детей, юношества и семьи
X областной кинофестиваль для детей, юношества и семьи презентация по химии Техника безопасности
презентация по химии Техника безопасности Производство конструкционных материалов
Производство конструкционных материалов Меры безопасности при переходе железной дороги и автомобильных дорог
Меры безопасности при переходе железной дороги и автомобильных дорог