Содержание
- 2. Диффузия в прямоугольное окно
- 3. Источники диффузанта Бор (В) В2Н6 (диборан); смесь (порядка 5%) с Ar БСС (nB2O3∙mSiO2), В2О3 2 B2O3
- 4. Выбор легирующей примеси Система энергетических уровней, создаваемых данной группой примесей в запрещенной зоне полупроводника. Все основные
- 5. Ge Si
- 6. ИОННАЯ ИМПЛАНТАЦИЯ
- 7. Достоинства ионного легирования точная дозировка примеси (теоретически – 1%, практически – 5%); высокая чистота; расширенная возможность
- 8. Схема установки ионного легирования Энергия ионов от десятков килоэлектронвольт до единиц мегаэлектронвольт вакуум порядка 10-4 Па
- 9. Оборудование ионной имплантации
- 10. Основные параметры ионного легирования Энергия ускоренных ионов. Ион с зарядом q [Кл], под действием разности потенциалов
- 11. источники с поверхностной термической ионизацией – нагреватель (вольфрамовая лента) на него насыпается соль металла – KJ,
- 12. Пробеги и дисперсии пробегов ионов
- 13. Распределение пробегов ионов
- 14. Теория Линдхарда, Шарфа и Шиотта Механизмы потерь энергии иона при его торможении в мишени независимы друг
- 15. Потери энергии иона при торможении
- 16. Проецированная длина (а) и рассеяние (б) пробега ионов а б
- 17. Каналирование ионов
- 20. Приближение Пирсона
- 22. Фронт р-п перехода при ионном (а) и диффузионном (б) локальном легировании Маскирование производится пленками окиси кремния;
- 23. Профили распределения дефектов и атомов бора дефекты Френкеля – вакансии и атомы в междуузлиях дефекты смещений
- 24. Структура нарушенных слоев
- 25. Дозы аморфизации кремния и германия (а) и температурные зависимости доз аморфизации кремния (б) критическая температура аморфизации
- 26. Влияние термообработки на распределение фосфора, внедренного в кремний
- 27. Импульсная термообработка Восстановление кристаллической структуры слоев практически без изменения профиля распределения примеси. Такая возможность обеспечивается за
- 28. Оказывается возможной рекристаллизация полностью аморфизированных и даже поликристаллических слоев. Может проводиться как при однородном нагреве всей
- 29. Импульсная термообработка Восстановление кристаллической структуры после ионной имплантации. Снижение плотности дислокаций на 2-3 порядка величины и
- 30. Применение ионного легирования 1. Введение примеси Загонка примеси с точной дозировкой Создание профиля с максимумом на
- 31. Гетерирование - удаление нежелательных примесей и дефектов. Высвобождение примесей или разложение протяженных дефектов на составные части.
- 34. Скачать презентацию













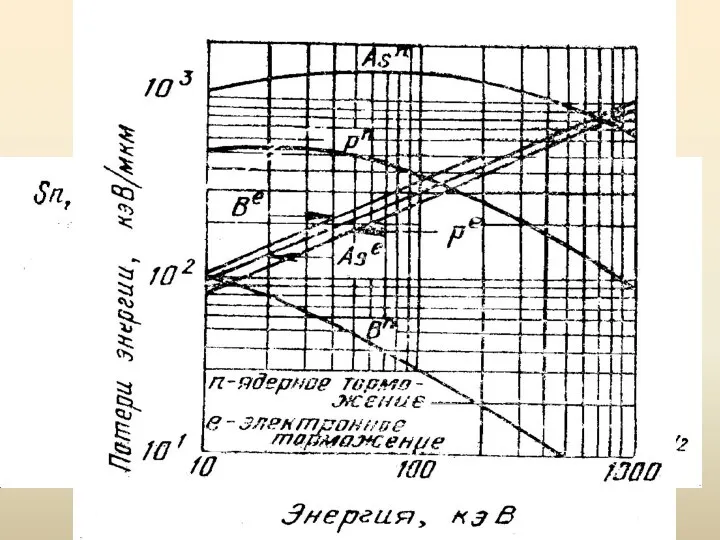



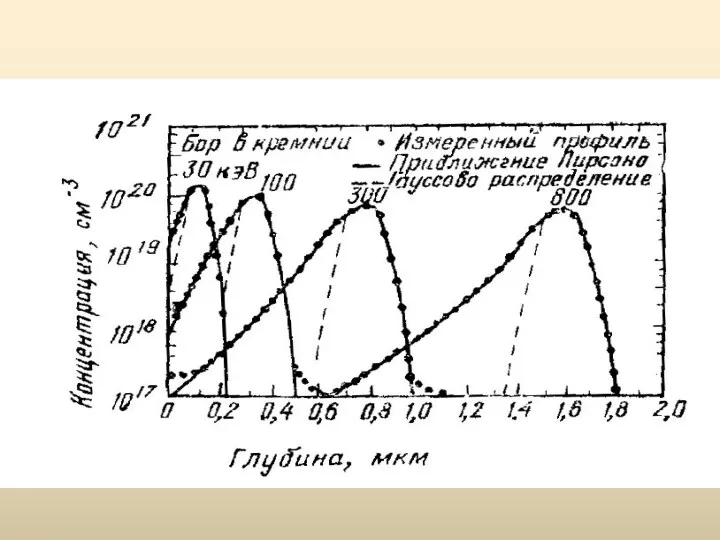













 Статически неопределимые системы. Лекция №5
Статически неопределимые системы. Лекция №5 Урок Линзы - 8 класс
Урок Линзы - 8 класс Экзотические и перспективные виды электростанций
Экзотические и перспективные виды электростанций Излучение систем источников. Лекция № 8. АФУ
Излучение систем источников. Лекция № 8. АФУ Удельная теплоёмкость
Удельная теплоёмкость Деталі машин. (Лекція 1)
Деталі машин. (Лекція 1) Диэлектрики в электростатическом поле
Диэлектрики в электростатическом поле Гидромеханика центробежного насоса и центробежно-вихревого насоса
Гидромеханика центробежного насоса и центробежно-вихревого насоса Биологическое действие радиации
Биологическое действие радиации Колебательный контур. Свободные электромагнитные колебания. Формула Томсона
Колебательный контур. Свободные электромагнитные колебания. Формула Томсона Перфорационные очки - чудо или реальность
Перфорационные очки - чудо или реальность Дифракция света
Дифракция света Презентация Физика в загадках
Презентация Физика в загадках Презентация к уроку на тему Кристаллические тела и их применение
Презентация к уроку на тему Кристаллические тела и их применение Световые явления. Распространение света
Световые явления. Распространение света метод разработка мех колебания
метод разработка мех колебания Аппараты высокого давления
Аппараты высокого давления Ball mill internals
Ball mill internals Werkstoffkunde
Werkstoffkunde Гидростатика
Гидростатика Электромагнитные поля и излучения
Электромагнитные поля и излучения Объяснение электрических явлений
Объяснение электрических явлений презентация к открытому уроку по физике
презентация к открытому уроку по физике Методы измерения газопроницаемости
Методы измерения газопроницаемости Расчёт массы и объёма тела по его плотности
Расчёт массы и объёма тела по его плотности Техническое обслуживание и ремонт трансмиссии автомобиля
Техническое обслуживание и ремонт трансмиссии автомобиля Сила тока. Плотность тока. Закон Ома. Электрическое сопротивление. Электродвижущая сила
Сила тока. Плотность тока. Закон Ома. Электрическое сопротивление. Электродвижущая сила Презентация к уроку по физике на тему Физические величины. Измерение физических величин.
Презентация к уроку по физике на тему Физические величины. Измерение физических величин.