Содержание
- 2. Фоторезист меняет свои химические свойства под действием излучения Фоторезист состоит из смолы, легко испаряющегося растворителя и
- 3. Негативный резист Позитивный резист
- 4. Подготовка подложек Нанесение ФР Сушка ФР Совмещение и экспонирование Проявление и отмывка Задубливание Травление и отмывка
- 6. Обратная (взрывная) литография ФР
- 7. Характеристики фоторезистов Светочувствительность S = 1 / H = 1 / I t (H [Вт·с /см2]
- 8. Нанесение слоя резиста центрифугированием
- 9. Нанесение слоя резиста распылением 1 – сопло форсунки; 2 – диспергированный резист; 3 – подложка; 4
- 10. Нанесение слоя резиста окунанием 1 – полложка; 2 – слой резиста; 3 -- ванна; 4 –
- 11. Нанесение слоя резиста накаткой 1 – пленочный резист; 2 – пленка на подложке 3; 4 –
- 13. Методы оптической литографии а – контактный, б –бесконтактный, в – проекционный
- 14. Дифракция Контактное экспонирование: разрешение пропорционально (λg)1/2 λ — длина волны падающего света; g — ширина зазора
- 15. Интерференция
- 16. Ртутные газоразрядные лампы (436, 405 или 365 нм) Эксимерный лазер 248 (KrF), 193 (ArF) и 157
- 17. Иммерсионная литография улучшает разрешение на 30–40% ввиду большего коэффициента преломления жидкости
- 18. Фотохимические реакции Фотораспад (фотолиз) A-B → [A-B]*→ A·+B· A-B → [A-B]*→ A++B- Фотоперегруппировка H O O-H
- 19. Негативные резисты на основе каучуков на основе поливинилциннамата (ПВЦ) циклокаучук бис-азид разрыв двойной связи С=С (200-250
- 20. Позитивные резисты Сенсибилизаторами являются производные диазокетонов или хинондиазидов R1–O–R2, где R1 и R2 – светочувствительная и
- 21. Фотошаблоны покрытие CrxOy (Si3N4) Cr (Fe2O3, VO3, Eu2O3) ~ 0,1 мкм кварц или сапфир Диффузионный ФШ
- 22. Фазоповорачивающее покрытие
- 23. Как сделать первый фотошаблон?
- 24. Достоинства электронно-лучевой литографии: Отсутствие дифракции (высокая разрешающая способность ). При ускоряющих напряжениях от 102 до 104
- 25. Схема вакуумной установки для сканирующей ЭЛГ 1 – вакуумная камера; 2– электронная пушка; 3–квадратная диафрагма; 4
- 26. Схема растрового (а) и векторного (б) сканирования луча Ограничения: ток φ ~ j 3/2; время пролета
- 27. Rp энергия мала энергия велика 10-4 – 10-6 Кул/см2 Рассеяние электронов I x
- 29. Достоинства рентгеновской литографии Применение излучения с малой длиной волны уменьшает дифракцию и позволяет получать малый размер
- 30. сложное оборудование (рентгеновский источник, защита оператора от излучения), отсутствие оптики, фокусирующей рентгеновские лучи, сложность изготовления рентгеношаблонов;
- 31. Источники рентгеновского излучения Стандартный источник РИ – металлическая мишень, бомбардируемая ускоренными до 10... 20 кэВ электронами.
- 32. Схема установки для рентгеновской литографии
- 33. Шаблон для РЛГ
- 34. Ионно-лучевая литография Преимуществами этого метода являются меньшее рассеивание ионов вследствие их массы и следовательно большее разрешение
- 35. Фотолитография, Электронная литография, жидкостное проявление плазменное проявление (кислородная плазма) Q Форма края фоторезиста Проблема при плазменном
- 36. Многослойные резисты DNQ-новолак ПММА Верхний слой является маской (ФШ) при экспонировании нижнего
- 37. Многослойные резисты SiO2 или Si3N4 не экспонируется Неорганический слой является маской при травлении нижнего слоя
- 38. Негативные двухслойные резисты с кремнием Верхний слой содержит Si, который в кислородной плазме превращается в SiO2
- 39. Силилирование селективное внедрение кремния в участки скрытого изображения в резисте непосредственно в процессе или после завершения
- 40. Изотропное травление
- 41. Клин травления а при передаче рисунка с фотомаски на пленку SiO2
- 42. Реактивное ионное травление ZnSe Анизотропное травление
- 43. GeSe ~0,2мкм раствор AgNO3 Неорганические резисты Полупроводниковые халькогенидные стекла (нанесение в вакууме) Ag
- 45. Скачать презентацию

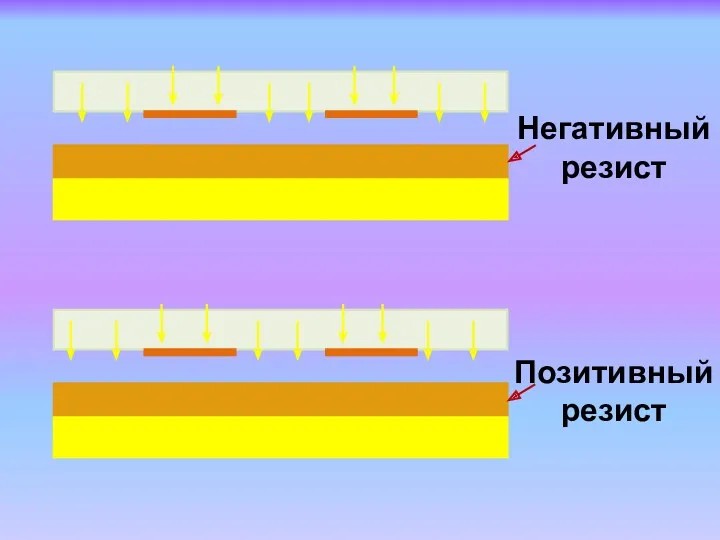
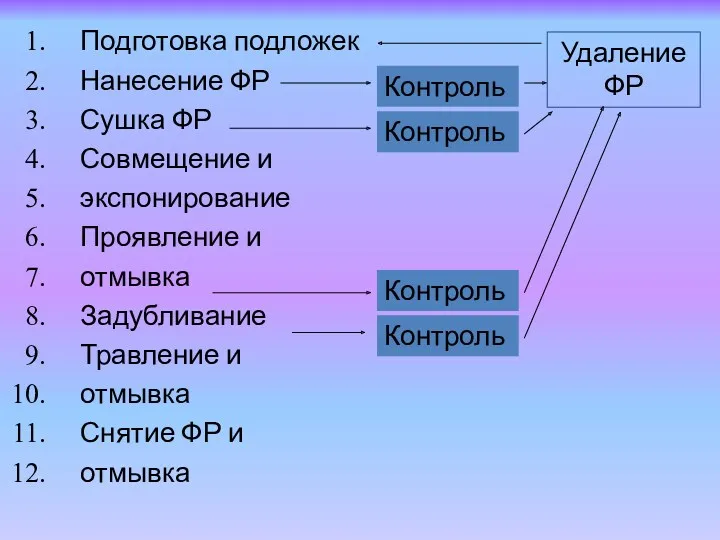
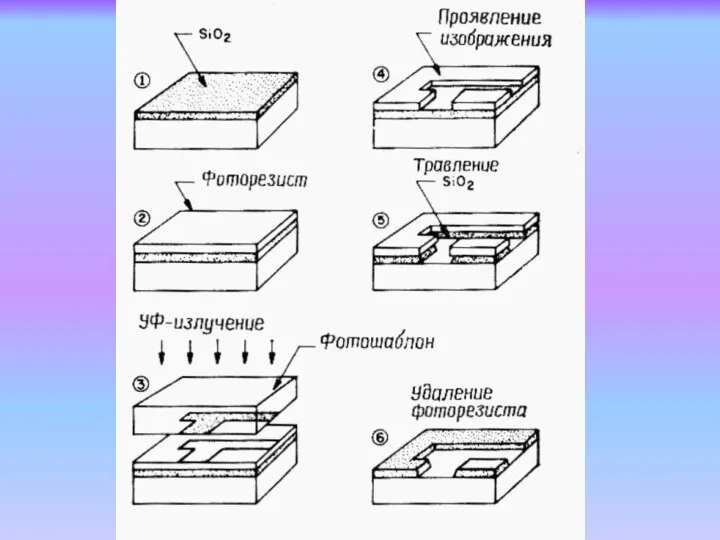
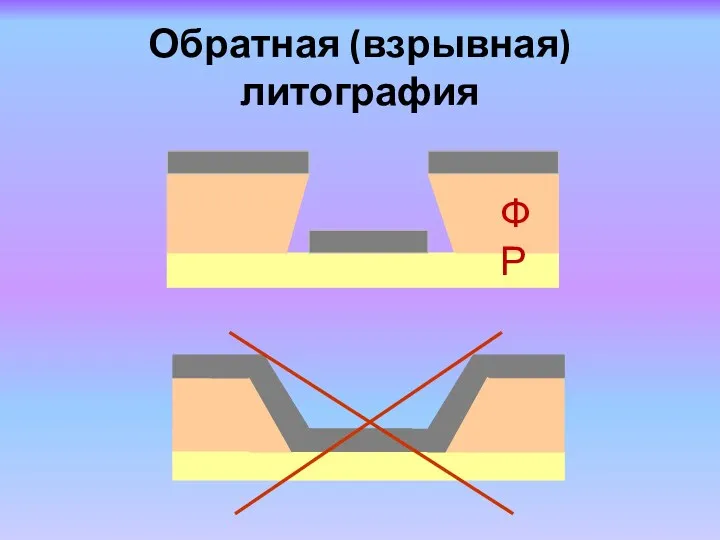






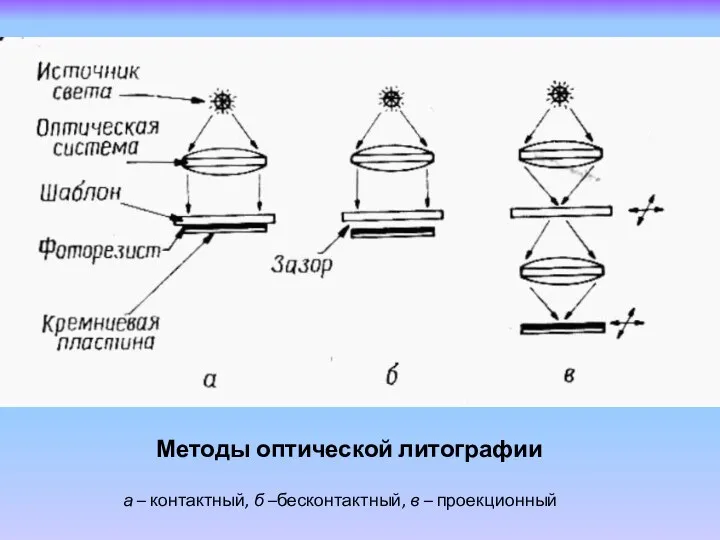



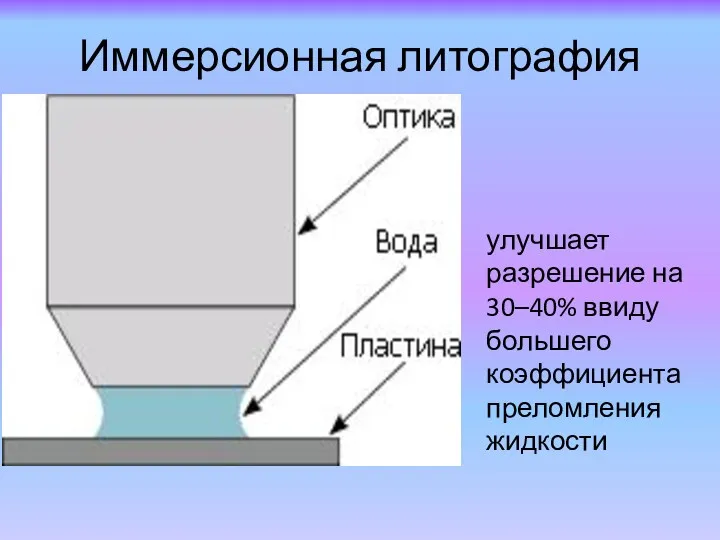
![Фотохимические реакции Фотораспад (фотолиз) A-B → [A-B]*→ A·+B· A-B →](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/410862/slide-17.jpg)
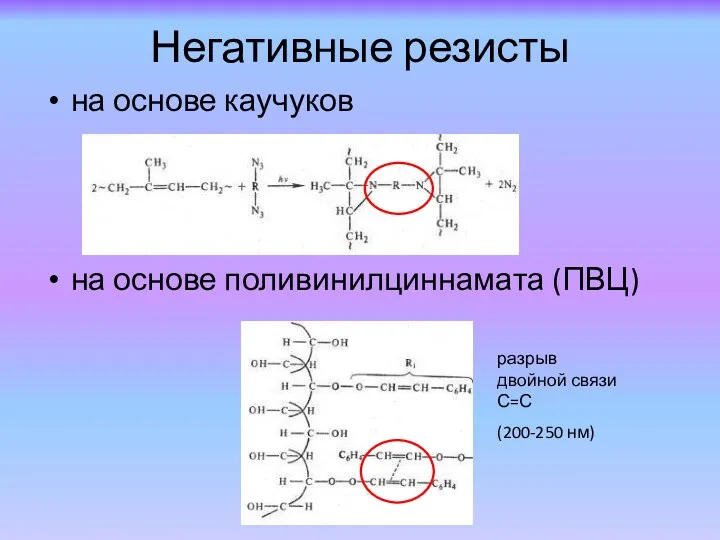

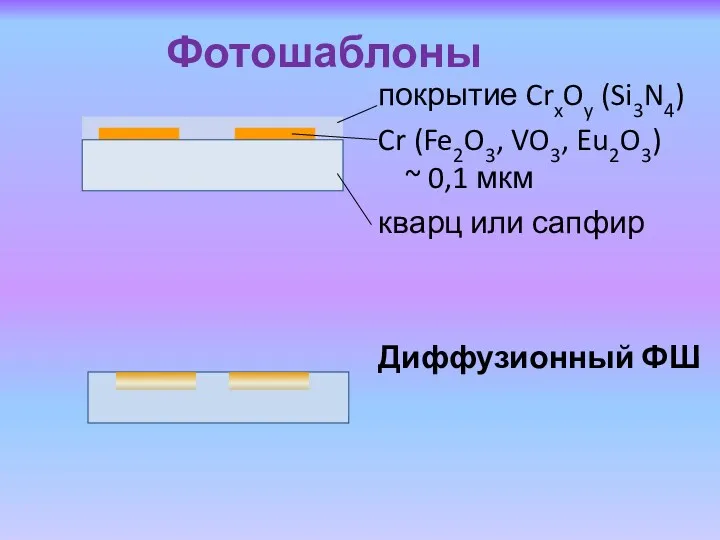
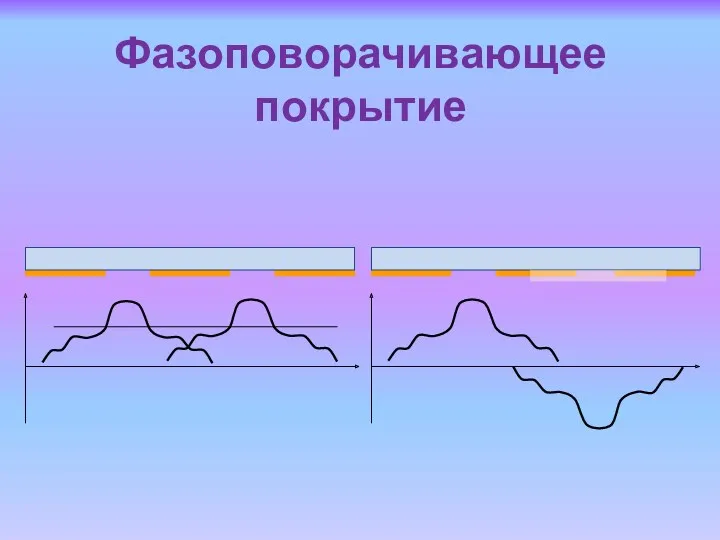




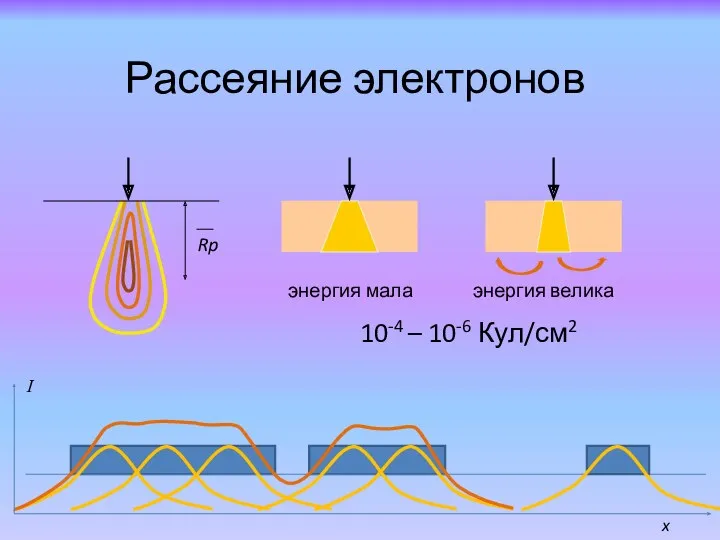
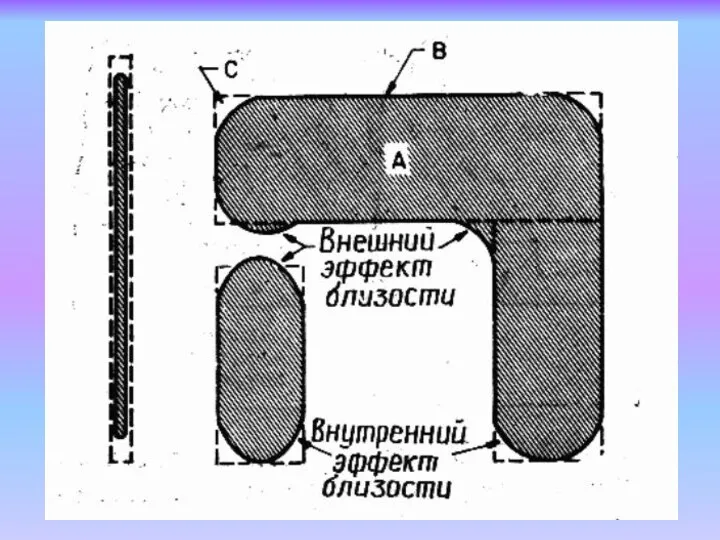




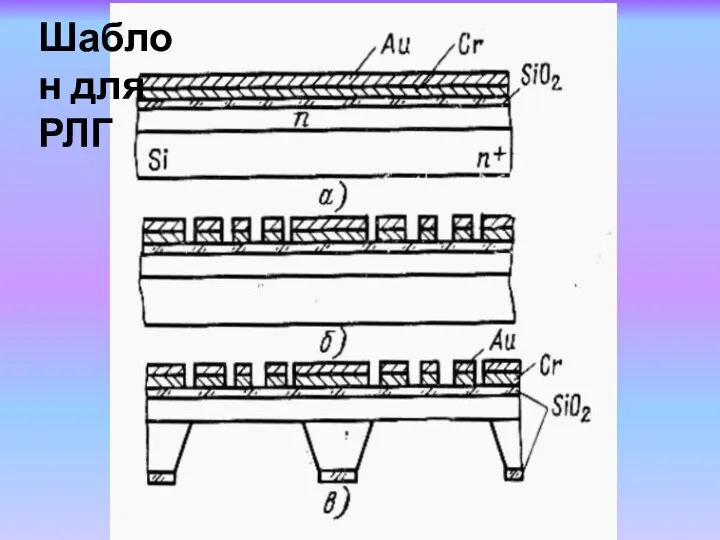


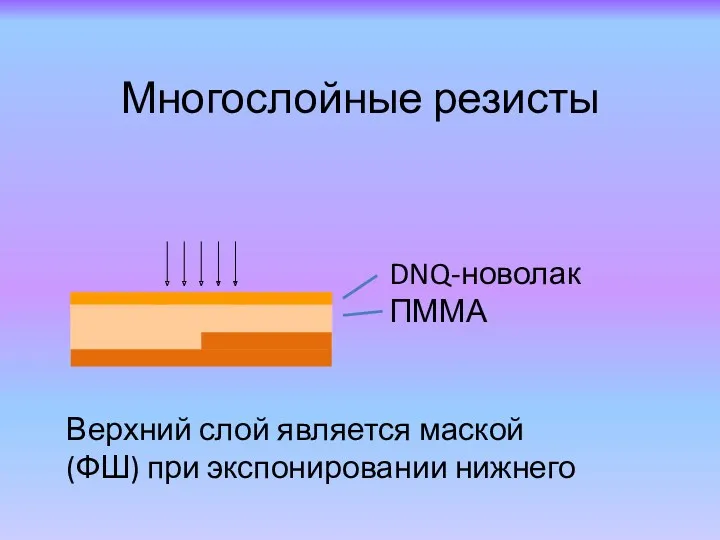
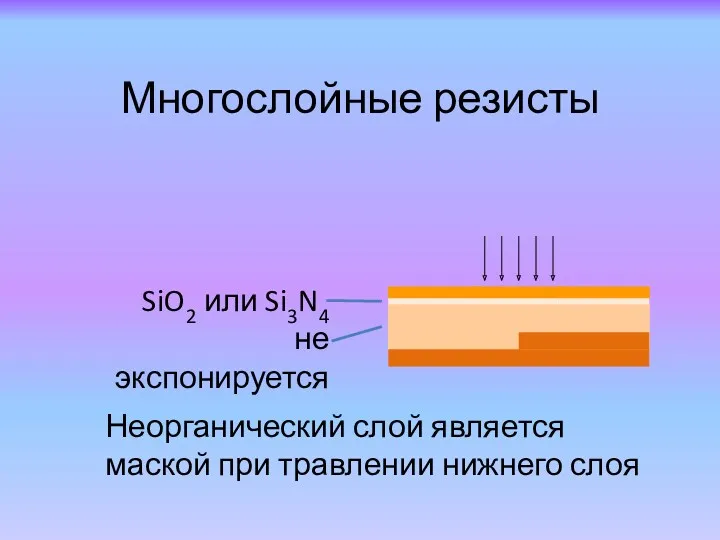


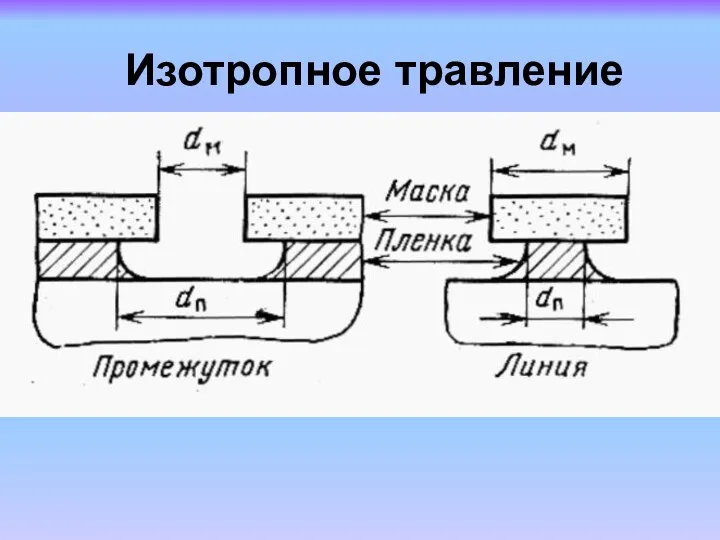


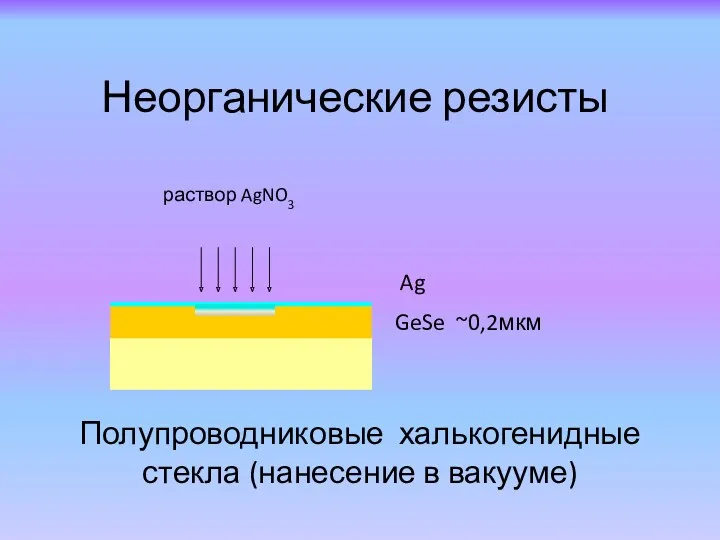
 Тасымалдау құбылысы. Нақты газдар
Тасымалдау құбылысы. Нақты газдар История создания электрической лампы
История создания электрической лампы Електричний струм у металах, рідинах і газах. (Лекція 11)
Електричний струм у металах, рідинах і газах. (Лекція 11) Стартовая презентация к проекту Зрение и компьютер
Стартовая презентация к проекту Зрение и компьютер Громкость звука. 9 класс
Громкость звука. 9 класс Реализация компетентностного подхода как условие повышения качества образования по физике
Реализация компетентностного подхода как условие повышения качества образования по физике Основные положения по организации и технологии войскового ремонта машин
Основные положения по организации и технологии войскового ремонта машин Ультразвуковые колебания. Ультразвук и инфразвук
Ультразвуковые колебания. Ультразвук и инфразвук презентация на тему Сообщающиеся сосуды
презентация на тему Сообщающиеся сосуды Физика в системе естественных наук. Кинематика поступательного движения. (Лекция 1)
Физика в системе естественных наук. Кинематика поступательного движения. (Лекция 1) презентация к уроку на тему: Основные положения МКТ
презентация к уроку на тему: Основные положения МКТ презентацияВоздухоплавание
презентацияВоздухоплавание ЖРД. Устройство и принцип действия, внутрикамерные процессы. (Лекция 2)
ЖРД. Устройство и принцип действия, внутрикамерные процессы. (Лекция 2) Основные параметры и характеристики передающих антенн
Основные параметры и характеристики передающих антенн Сложное движение твердого тела
Сложное движение твердого тела Повторение по теме Электромагнитная индукция
Повторение по теме Электромагнитная индукция Открытие электрической лампочки
Открытие электрической лампочки Виды излучений
Виды излучений Electric Vehicles 101
Electric Vehicles 101 Сұйықтар мен газдар механикасының негізгі ұғымдары
Сұйықтар мен газдар механикасының негізгі ұғымдары Движение заряженной частицы в электрическом и магнитном полях. Лекция 6
Движение заряженной частицы в электрическом и магнитном полях. Лекция 6 Техника изготовления и особенности конструирования съемных ортодонтических аппаратов
Техника изготовления и особенности конструирования съемных ортодонтических аппаратов Измерение размеров малых тел. Взаимное притяжение молекул
Измерение размеров малых тел. Взаимное притяжение молекул Электротехника и электроника
Электротехника и электроника Устройство доменной печи. (Лекция 4)
Устройство доменной печи. (Лекция 4) Линзы. Оптическая сила линзы
Линзы. Оптическая сила линзы Линзы. Оптическая сила линзы
Линзы. Оптическая сила линзы Of steering
Of steering