Содержание
- 2. “It was the best of times, it was the worst of times, it was the age
- 3. Устройства памяти 35 Xe atoms
- 4. Оптическая система. Optical system. Photograph of a Fresnel microlens on an adjustable platform made of five
- 5. Photograph of the NovaSensor NPP-301, a premolded plastic, surface mount (SOIC-type) and absolute pressure sensor. (Courtesy
- 6. Photograph of a disposable blood pressure sensor for arterial-line measurement in intensive care units. The die
- 7. Преимущества Si как базового материала НЭМС Advantages of Si in NEMS/MEMS Дешевизна. Cheap. Высокое кристаллическое совершенство.
- 8. Формы и содинения кремния. Si forms and compounds. Crystalline silicon is a hard and brittle material
- 9. Физические свойства некоторых материалов НЭМС
- 10. Тонкие пленки металлов в НЭМС
- 11. Оптическое отражение от кремния и некоторых металлов Reflectivity of Si and some metals
- 12. Области применения различных материалов в НЭМС. Application areas of MEMS materials.
- 13. Базовый цикл создания НЭМС. Base cycle of NEMS formation.
- 14. Маркировка пластин полупроводников. Marking of wafers. (a) Illustration showing the primary and secondary flats of {100}
- 15. Эпитаксия кремния – молекулярно-лучевая или газофазная Epitaxy of Si – MBE and VPE Массовое промышленное производство
- 16. CVD Химическое осаждение из газовой фазы. Chemical vapor deposition Temperature > 300 °C. Growth rate from
- 17. Термическое окисление. Thermal oxidation Атмосфера кислорода, oxygen flux, 850-1150 °С. Аморфный SiO2, толщина зависит от температуры,
- 18. Распыление Sputtering Бомбардировка ионами, возможно в присутствии внешних полей: СВЧ, магнетронное, и др. Bombardment of target
- 19. Испарение Evaporation Термическое, лазерное, электронное Thermal, laser, electron-beam heating Источник испаряется в вакуумной камере и осаждается
- 20. Spin-On Methods Жидкий раствор напыляется из сопла на середину пластины, которая раскручивается со скоростью от 500
- 21. Литография Litogrophy Нанесение резиста Deposition of resist. Перенесение изображения маски на резист. Imaging mask on resist
- 22. Фотолитография. Photolithography.
- 23. Lift-off метод Ппенка напыляется на профиль резиста. Резист удаляется вместе с нанесенной на него сверху пленкой.
- 24. Фотолитография. Photolithography. Проекционная фотолитография позволяет получить разрешение λ/2. Diffraction limit of resolution is λ/2. Используется УФ
- 25. Использование ближнего поля для улучшения разрешения Near-field techniques to improve resolution
- 26. Нанесение резиста и литография для поверхности с глубоким профилем Deposition of resist on a surface with
- 27. Двусторонняя литография. Double side lithography. Double-sided alignment scheme for the SUSS MA-6 alignment system: (a) the
- 28. Литография с помощью электронных пучков Electron beam lithography Холодная полевая эмиссия электронов Шоттки. Cold field emission.
- 29. Сфокусированные ионные пучки Focused ion beams Альтернатива электронной литографии Alternative to electron beam lithography Нет маски
- 30. Scanned-Probe Lithography AFM and STM Resolution 1-100 nm No mask Limited writing rate
- 31. Наноштамповка Nanoimprint Nanoimprint lithography: (a) press hard mold into resist coating; (b) remove mold; and (c)
- 32. Штамповка литографической маски Microcontact printing: (a) create master; (b) form PDMS stamp and peel off; (c)
- 33. Заключение Conclusion Базовым материалом НЭМС является кремний Si is the material of choice for majority of
- 35. Скачать презентацию

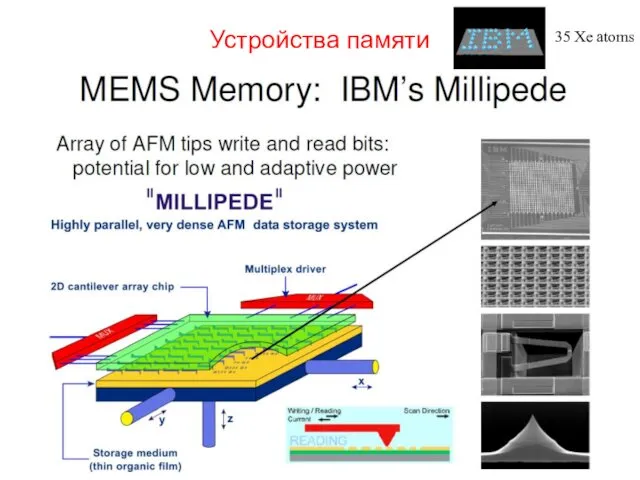
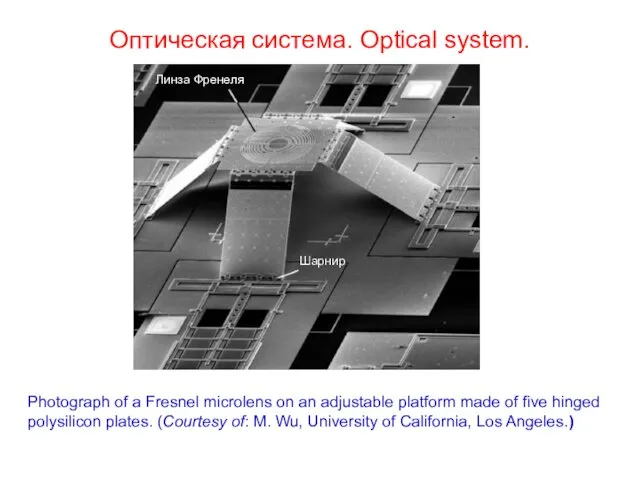
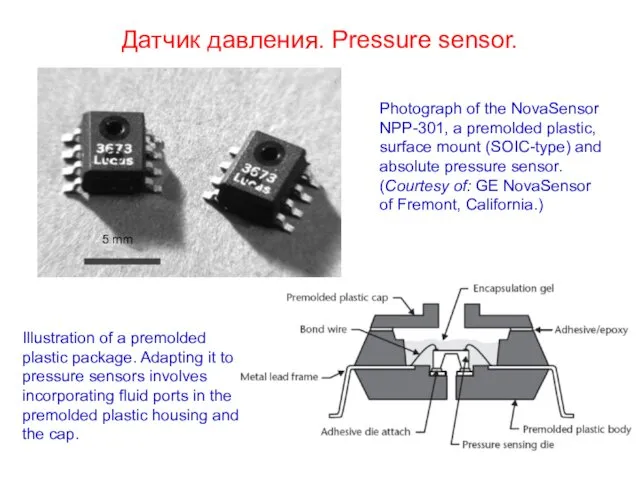







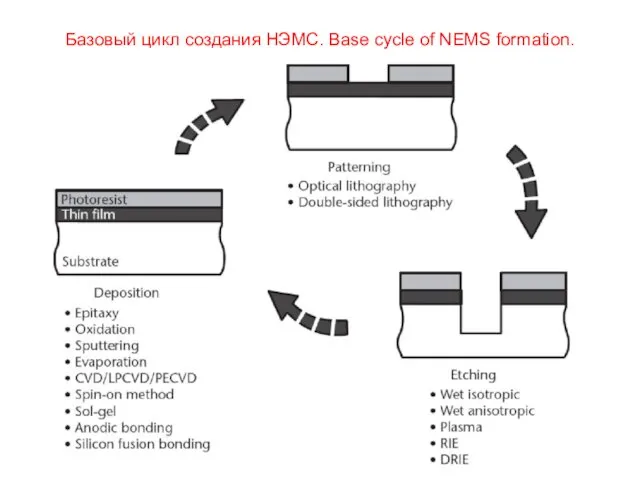

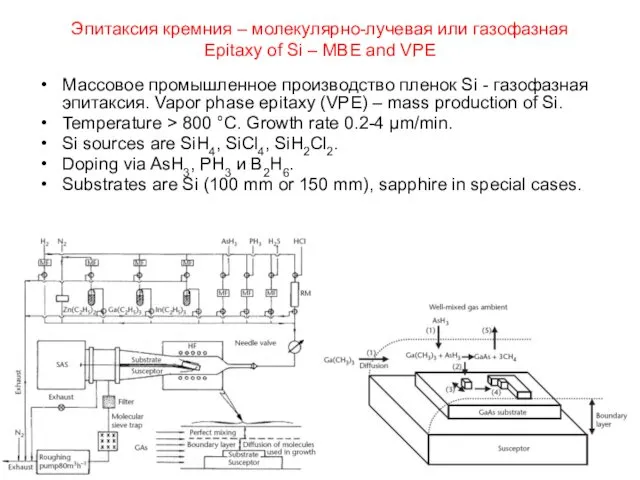
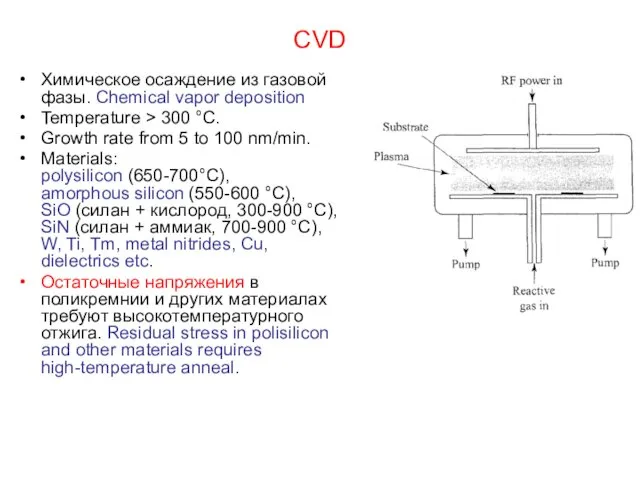
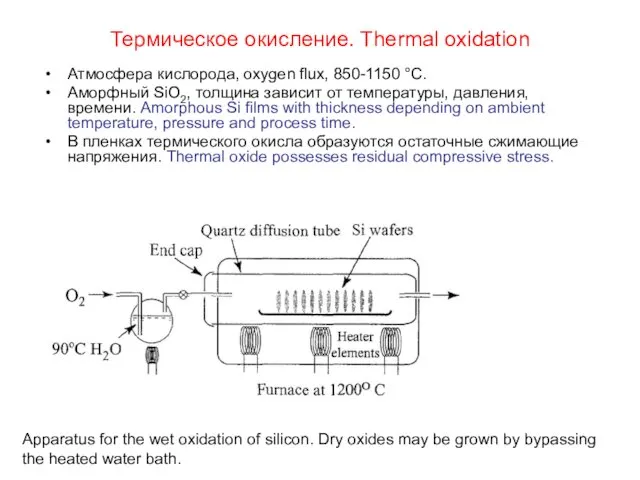
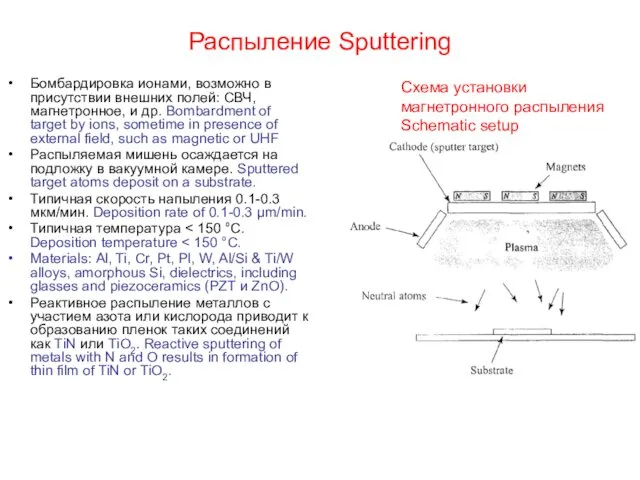
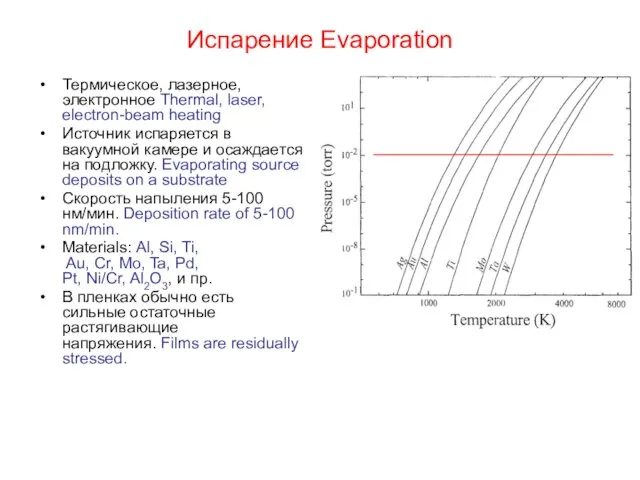
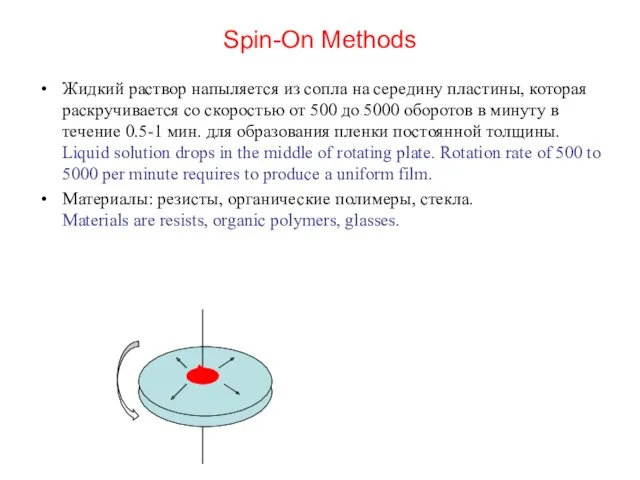

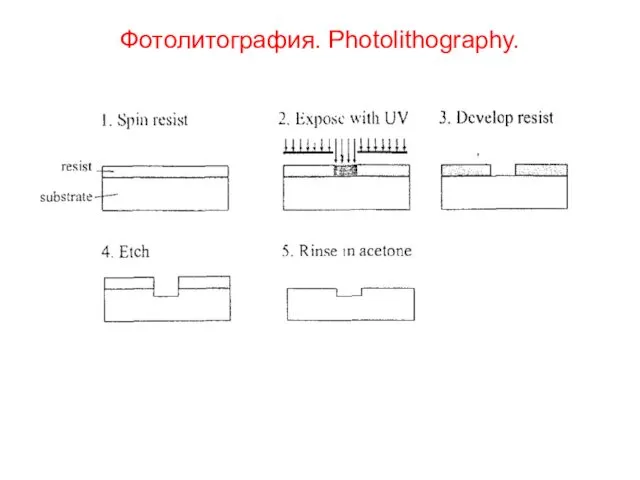
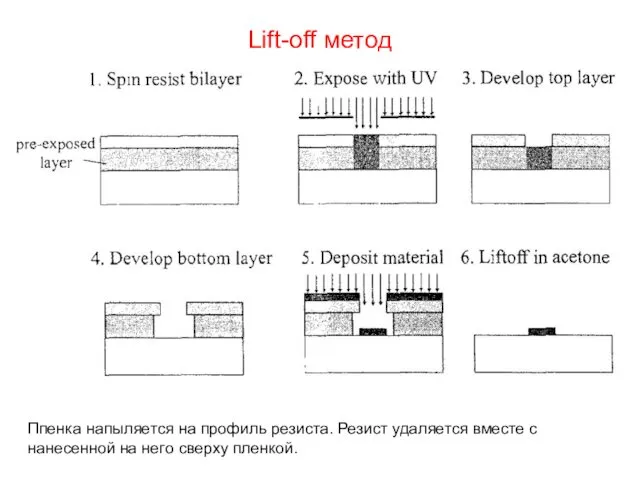

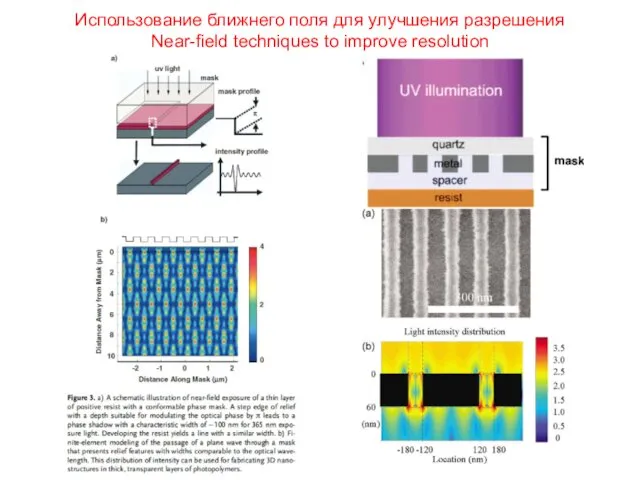
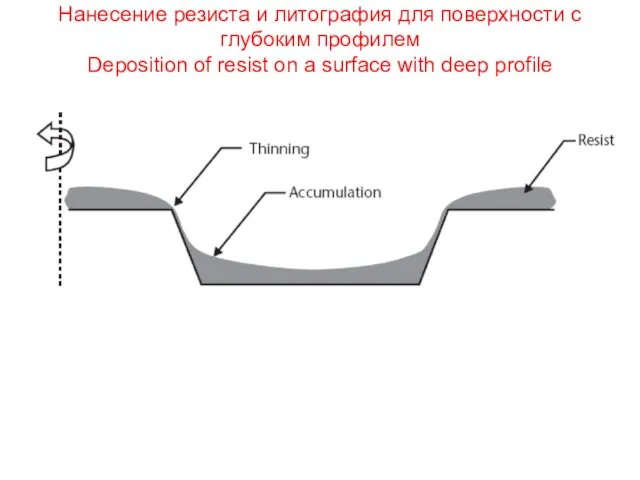
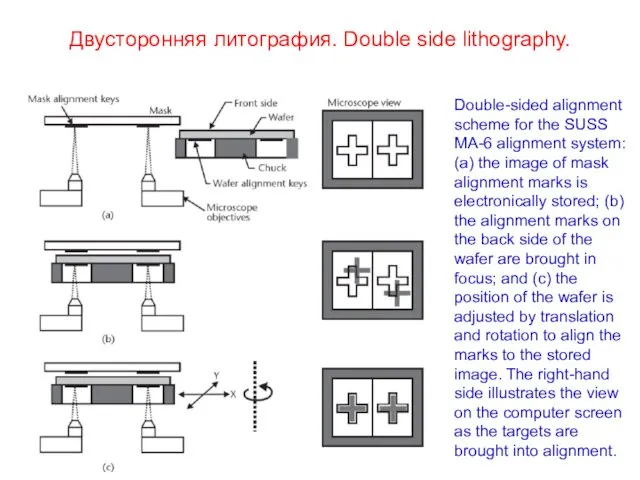



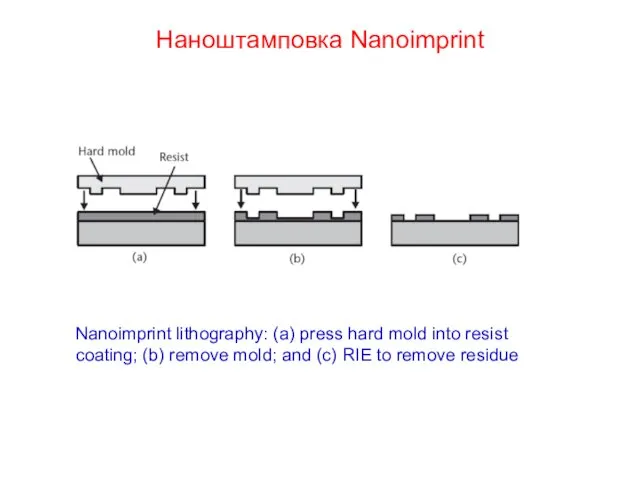
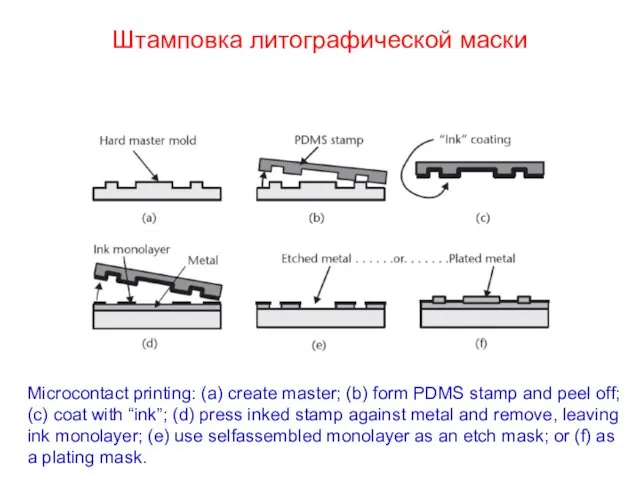

 Транспортная энергетика (часть II). Электрическое освещение
Транспортная энергетика (часть II). Электрическое освещение использование интерактивного обордования на роках физики
использование интерактивного обордования на роках физики Викторина на тему: Дисперсия света
Викторина на тему: Дисперсия света Изучение явления электромагнитной индукции. Лабораторная работа № 12
Изучение явления электромагнитной индукции. Лабораторная работа № 12 Процессы переноса
Процессы переноса Электростатика. Электродинамика
Электростатика. Электродинамика Материальная точка. Система отсчета
Материальная точка. Система отсчета Механизмы нитепритягивателя челночных швейных машин
Механизмы нитепритягивателя челночных швейных машин Закон Джоуля - Ленца
Закон Джоуля - Ленца Методика проведения фронтального опроса по физике Диск
Методика проведения фронтального опроса по физике Диск ТО системи пуску двигунів автомобілів. ТО акумуляторних батарей. ТО генераторів та реле-регуляторів
ТО системи пуску двигунів автомобілів. ТО акумуляторних батарей. ТО генераторів та реле-регуляторів Электромагнитные переходные процессы в электроэнергетических системах
Электромагнитные переходные процессы в электроэнергетических системах Спектр атома водорода. (Лекция 7а)
Спектр атома водорода. (Лекция 7а) UravneniaMaxvellaEMV2122
UravneniaMaxvellaEMV2122 Давление в жидкостях и газах. Закон Паскаля (7 класс)
Давление в жидкостях и газах. Закон Паскаля (7 класс) Картины мира
Картины мира Линзы
Линзы Электромагнитные колебания
Электромагнитные колебания Магнитооптические материалы. Магнитооптические эффекты
Магнитооптические материалы. Магнитооптические эффекты Фото-вопросы по теме Плотность вещества
Фото-вопросы по теме Плотность вещества В мире звуков
В мире звуков Nieinercjalne układy odniesienia
Nieinercjalne układy odniesienia презентация к уроку по физике простые механизмы
презентация к уроку по физике простые механизмы Законы постоянного тока Тема урока: Электрический ток. Сила тока.
Законы постоянного тока Тема урока: Электрический ток. Сила тока. Двигатель внутреннего сгорания
Двигатель внутреннего сгорания Классификация строительных машин
Классификация строительных машин Биологическое действие радиоактивных излучений
Биологическое действие радиоактивных излучений Закон Ома для участка цепи
Закон Ома для участка цепи