Содержание
- 2. Содержание Кристаллическая структура кремния. Химическая обработка подложек кремния: очистка в растворителях, травление. Химическое анизотропное травление. Контроль
- 3. Кристаллическая структура Кристаллическая решётка кремния кубическая гранецентрированная типа алмаза, параметр а = 0,54307 нм, но из-за
- 4. Кристаллическая решетка кремния Объемная структура (можно изобразить плоской). Большими кружками показаны ионы кремния или германия. Ядра
- 5. Изменение минимального размера элементов и объема динамической памяти (от килобайт до гигабайт) электронных элементов во времени
- 6. Характеристики ИС
- 7. Классификация загрязнений Органических загрязнения (фоторезист, жиры, смазки, масла); Наличие примесей металлов (алюминий, железо, медь, серебро, золото);
- 8. Источники загрязнений Рабочий персонал (метод ламинарного потока сверху вниз, который может быстро удалять пыль). Окружающая среда
- 9. Требования к газам, воздушным средам, воде, химическим реактивам
- 10. Механические загрязнения влияют на: Надежность ИС; Качество ИС; Процент выхода годных ИС. Через: Фотолитографию (механические загрязнения
- 11. Металлические загрязнения Me растворяются в SiO2 -> изменяется время жизни носителей, образуются энергетические уровни в запрещенной
- 12. Микронеровности поверхности Появляются после операций обработки, травления и очистки поверхности; Влияют на качество диэлектрика (особенно при
- 13. Кристаллические дефекты Окислительные дефекты упаковки (ОДУ) снижают плотность тока; Преципитаты кислорода (кластеры SiO2) приводят к внутреннему
- 14. Удаление загрязнений с поверхности пластин в процессах химической обработки «Жидкостная» химическая очистка - использование растворов с
- 15. Удаление загрязнений с поверхности пластин в процессах химической обработки На поверхности Si-пластин в процессе изготовления ИС
- 16. Очистка поверхности подложек в перекисно-аммиачном растворе Удаление механических загрязнений с поверхности полупроводниковых пластин в основном используется
- 17. Изменение скорости травления поверхности кремниевой пластины при изменении концентрации компонентов в процессе аэрозольно-капельного распыления раствора NH4OH/H2O2/H2O
- 18. Методы анализа частиц на поверхности пластин Бесконтактные методы (анализ отраженного сканирующего лазерного луча и микроскопия); Микроскопические
- 19. Методы анализа органических загрязнений на поверхности пластин Методы, основанные на смачиваемости поверхности пластин жидкостями, позволяют фиксировать
- 20. Методы анализа металлических загрязнений на поверхности пластин Электрохимические методы – для анализа жидких технологических сред и
- 21. Методы исследования рельефа поверхности подложек Методом сканирующей зондовой микроскопии (СЗМ) исследуют свойства поверхностей материалов в диапазоне
- 22. "Жидкостная" химическая обработка Химическая обработка в растворах RCA (последовательно выполняемые операции): H2SO4/H2O2 (7:3) при 120 °C
- 23. Методы проведения "жидкостной" химической обработки Погружение в растворы. Мегазвуковая обработка. Ультразвуковая обработка. Обработка струей жидкости высокого
- 24. Зависимость уровня остаточных загрязнений на поверхности Si пластин диаметром 150 мм от количества циклов обработки различными
- 25. Поверхность исходной Si пластины: а – внешний вид поверхности образца; б – профиль шероховатости поверхности подложки;
- 26. Поверхность Si пластины после обработки в буферном растворе: а – внешний вид поверхности образца; б –
- 27. Поверхность Si пластины после обработки методом погружения по стандартной методике в растворы H2SO4/H2O2, NH4OH/H2O2/H2O: а –
- 28. Поверхность Si пластины после обработки аэрозольно-капельным распылением растворов H2SO4/H2O2; H2O/HF; NH4OH/H2O2/H2O; HCl/H2O2/H2O: а – внешний вид
- 29. Контрольные вопросы по первой теме: Расскажите о кристаллической решетке кремния (тип, связь атомов, постоянная решетки, состояние
- 30. Список источников литературы по теме: 1. Королев М.А. Технология, конструкции и методы моделирования кремниевых интегральных микросхем:
- 32. Скачать презентацию






















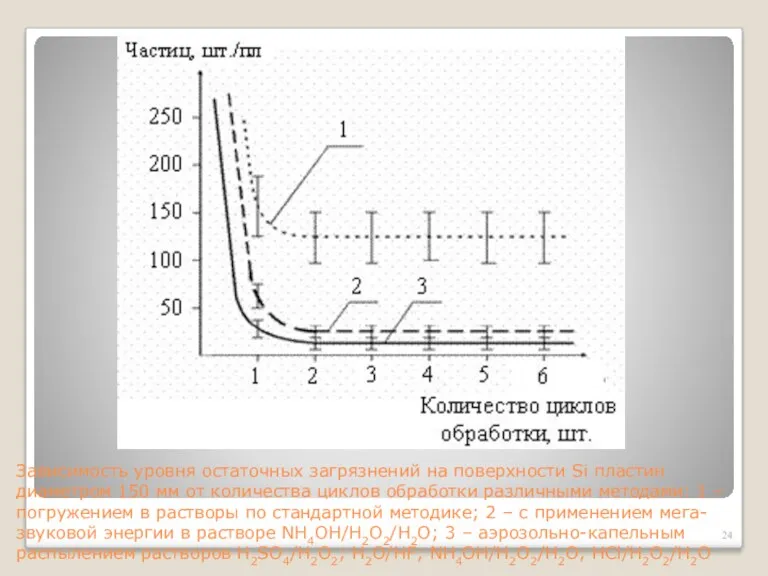






 Отношение сигнал-шум на выходе приёмника ЧМ сигнала
Отношение сигнал-шум на выходе приёмника ЧМ сигнала Электродинамика. Оптика
Электродинамика. Оптика Общее устройство автомобилей
Общее устройство автомобилей Аэродинамика автомобиля
Аэродинамика автомобиля Электроснабжение коттеджнего поселка” Заречный” в Ленинградской области
Электроснабжение коттеджнего поселка” Заречный” в Ленинградской области Вес воздуха. Атмосферное давление
Вес воздуха. Атмосферное давление Механічні та електромагнітні хвилі
Механічні та електромагнітні хвилі Обработка металлов давлением. Лекция №22
Обработка металлов давлением. Лекция №22 Электроразведка. Методы профилирования
Электроразведка. Методы профилирования Оборудование и технология наноматериалов механическим измельчением и механохимическим воздействием
Оборудование и технология наноматериалов механическим измельчением и механохимическим воздействием Термоядерный синтез
Термоядерный синтез Относительность механического движения и покоя(I). Тест 4
Относительность механического движения и покоя(I). Тест 4 Тірі ағзалар термодинамикасы
Тірі ағзалар термодинамикасы Контактные явления. Контакт металл - полупроводник
Контактные явления. Контакт металл - полупроводник Электроразведка естественными постоянными электрическими полями (ЕП)
Электроразведка естественными постоянными электрическими полями (ЕП) Теплота сгорания топлива
Теплота сгорания топлива Постоянные магниты 9 класс.
Постоянные магниты 9 класс. Лекция 7. Свободные затухающие колебания
Лекция 7. Свободные затухающие колебания Механика. Основные понятия кинематики
Механика. Основные понятия кинематики Магнит өрісі. Тұрақты магниттер. Тогы бар катушка мен токтың магнит өріс. Электромагниттер
Магнит өрісі. Тұрақты магниттер. Тогы бар катушка мен токтың магнит өріс. Электромагниттер Педагогический проект урока по физике 8 класс по теме: Параллельное и последовательное соединения проводников.
Педагогический проект урока по физике 8 класс по теме: Параллельное и последовательное соединения проводников. Магнитное поле
Магнитное поле Презентация по физике по теме Плавание тел для 7 кл.
Презентация по физике по теме Плавание тел для 7 кл. Явления переноса (продолжение). Реальные газы
Явления переноса (продолжение). Реальные газы Работа силы. Значения слова работа
Работа силы. Значения слова работа РАБОТА. МОЩНОСТЬ. ЭНЕРГИЯ.ЗАКОН СОХРАНЕНИЯ ЭНЕРГИИ.
РАБОТА. МОЩНОСТЬ. ЭНЕРГИЯ.ЗАКОН СОХРАНЕНИЯ ЭНЕРГИИ. Многоэлектронные атомы и молекулы
Многоэлектронные атомы и молекулы Термодинамика. Теплота
Термодинамика. Теплота