Содержание
- 2. Цель процесса диффузии Внедрение атомов легирующего элемента в крис- таллическую решётку полупроводника для образо- вания области
- 3. Образование p-n-перехода Концентрация введённой примеси монотонно убы- вает в направлении от поверхности, через которую происходит диффузия,
- 4. Особенности формирования конфигу-рации диффузионных областей 1. Размеры диффузионных областей в плане опре- деляются размерами окна в
- 5. Термины и определения Диффузия в полупроводниках – процесс после- довательного перемещения атомов примеси в кристаллической решётке,
- 6. Диффузия в технологии ИИЭ Для формирования p-n-переходов исполь- зуется химическая диффузия примесных (растворенных) атомов, которые вводят-
- 7. Модель диффузии При повышенной температуре атомы в узлах решётки колеблются вблизи равновесного поло- жения. Перемещение примеси
- 8. Диффузия по вакансиям Механизм диффузии, при котором мигрирующий атом (примесный или собственный) перемещает- ся на место
- 9. Диффузия по междоузлиям Данный механизм сопровождается переходом ми- грирующего атома (как правило примесного) из од- ного
- 10. Эстафетный механизм В отличие от междоузельного механизма диффу- зии, примесные атомы внедряются в узлы крис- таллической
- 11. Краудионный механизм диффузии Данный механизм тесно связан с эстафетным. При этом междоузельный атом, расположенный посередине меж-ду
- 12. Диссоциативный механизм диффузии Данный механизм связан с распадом комп- лексов молекул и диффузией составляю- щих их
- 13. Количественные закономерности диффузии В связи с малой толщиной диффузионных областей по сравнению с размерами в плане
- 14. Уравнение Аррениуса D = D0 exp(–Ea/kT) k = 1,38×10-23 Дж/К – постоянная Больцмана; Т – абсолютная
- 15. Диффузионные параметры различных элементов в кремнии
- 16. Второй закон Фика Описывает изменение концентрации растворенного вещества во времени 1. При низкой концентрации примеси и
- 17. Диффузия из неограниченного источника Начальные условия: С(x, 0) = 0. Граничные условия: С(0, t) = С0;
- 18. Нормированное распределение дополнительной функции ошибок
- 19. Распределение примеси при диффузии из бесконечного источника
- 20. Зависимость предельной растворимос- ти некоторых элементов в кремнии в твердой фазе от температуры
- 21. Диффузия из ограниченного источника Начальные условия: С(x, 0) = 0. Граничные условия: C(x,∞)=0 Решение 2 закона
- 22. Распределение примеси при диффузии из ограниченного источника
- 23. Особенности применения чистых легирующих элементов Использовать чистые легирующие элемен- ты в качестве источников примеси в про-
- 24. Способы диффузионного легирования В качестве источников примеси применяют различные соединения (ангидриды, галогени- ды, гидриды легирующего элемента
- 25. Диффузия из жидкого источника Жидкие источники: BBr3 ; PBr3 ; PCl3 .
- 26. Диффузия из газообразного источника Источником примеси является баллон со сжатым газом (B2H6, PH3).
- 27. Особенности диффузии из газообразных источников Метод характеризуется высокой техноло- гичностью, воспроизводимостью и легкос- тью управления концентрацией
- 28. Диффузия из твёрдого источника Твёрдый планарный источник (ТПИ) – пласти- на, содержащая твёрдый диффузант (B2O3 или
- 29. Акцепторные ТПИ Представляют собой кремниевую пласти- ну с нанесенным слоем B2O3 либо пластину нитрида бора, обработанную
- 30. Донорные ТПИ Примером может служить пластина ме- тафосфата алюминия, который в диапа- зоне температур 700 –
- 31. Технология диффузии из внешнего источника 1 – источник жидкого диффузанта, 2 – вен- тиль, 3 –
- 32. Особенности устройства реактора Диффузия проводится в кварцевой трубе, снабженной резистивным нагревателем; В зоне диффузии длиной 40
- 33. Загрузка - выгрузка пластин Для групповой загрузки пластин применяют кассе- ты из кварцевого стекла или карбида
- 34. Загрузка – выгрузка в вертикальном реакторе
- 35. Подача диффузанта Для насыщения парами диффузанта транспортирующий газ (N2, Ar) пропускает- ся над жидкостью либо барботируется
- 36. Технологические процесс загонки примеси Перед загонкой примеси стенки трубы и пустые кассеты насыщают примесью при температуре
- 37. Температурно-временная диаграмма процесса диффузии ТПИ
- 38. Влияние окисляющей среды на процесс диффузии Растущая в процессе диффузии плёнка SiO2 предохраняет по- верхность кремния
- 39. Легирование без добавления кислорода Коэффициент диффузии ангидрида в окисле крайне мал. Поэтому при достижении плёнкой SiO2
- 40. Диффузия из примесных покрытий Подложка с маской SiO2 Нанесение при- месного покры-тия (БСС) Диффузия из примесного
- 41. Особенности диффузии из примесных покрытий Концентрация примеси в кремнии зависит от: - концентрации примеси в покрытии;
- 42. Достоинства диффузии из поверхностных источников Пределы поверхностной концентрации в пределах от 1016 до 1020 см-3; Высокая
- 43. Технология разгонки примеси 1. Загрузка кассеты с пластинами в реактор, нагре- тый до температуры 850 °С,
- 44. Эволюция структуры Структура после фотолитографии Загонка бора Снятие БСС Разгонка бора: I стадия: Диффузия бора II
- 46. Скачать презентацию







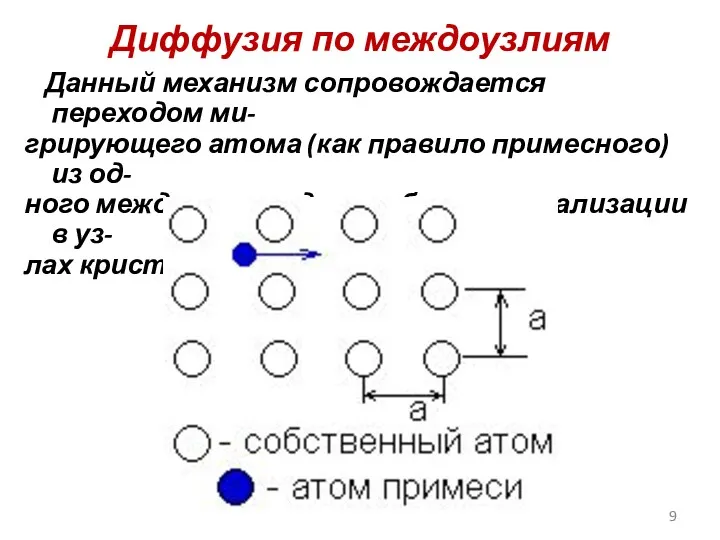
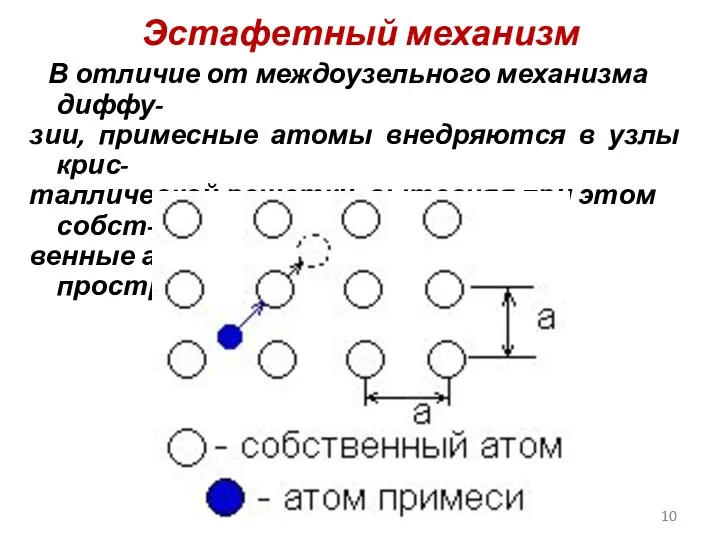

















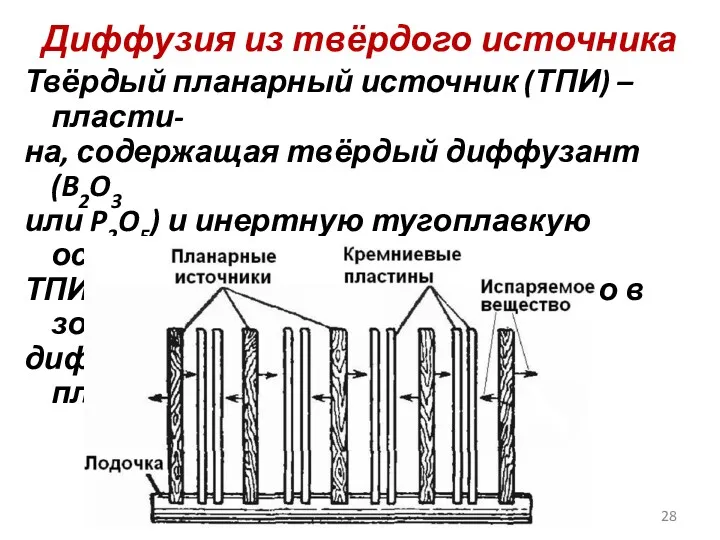











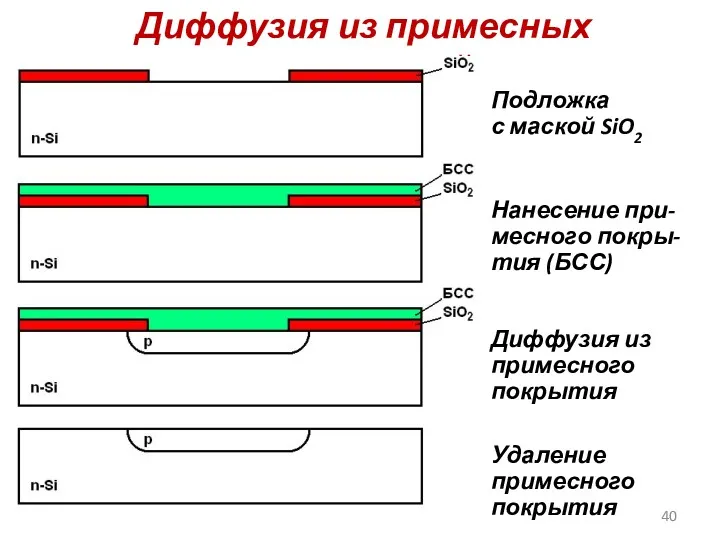



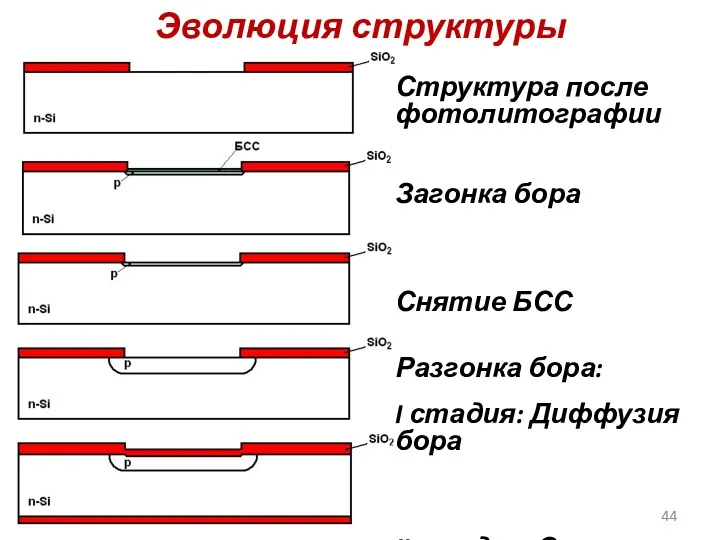
 Конденсированное состояние вещества. Жидкости. (Лекция 3)
Конденсированное состояние вещества. Жидкости. (Лекция 3) Заломлення світла на межі поділу двох середовищ. Закон заломлення світла
Заломлення світла на межі поділу двох середовищ. Закон заломлення світла Колебательно– вращательные спектры двухатомных молекул. Классическая теория
Колебательно– вращательные спектры двухатомных молекул. Классическая теория Простые механизмы
Простые механизмы Жидкостная хроматография
Жидкостная хроматография Общее устройство и работа двигателя
Общее устройство и работа двигателя Геометрическая оптика
Геометрическая оптика Электрические явления. Законы постоянного тока
Электрические явления. Законы постоянного тока Зонная теория твёрдых тел
Зонная теория твёрдых тел Опыт Юнга
Опыт Юнга Изнашивание неметаллических материалов
Изнашивание неметаллических материалов Введение в Физику
Введение в Физику Движение тела под действием силы трения
Движение тела под действием силы трения Подшипники качения
Подшипники качения Действие магнитного поля на движущийся заряд. 9 класс
Действие магнитного поля на движущийся заряд. 9 класс Структура оптического волокна
Структура оптического волокна През.ЮА.МС11-21
През.ЮА.МС11-21 Радиоактивность. Альфа-, гамма- и бета- излучения
Радиоактивность. Альфа-, гамма- и бета- излучения Все оборудование на предприятиях общественного питания
Все оборудование на предприятиях общественного питания Физика минералов и их аналогов
Физика минералов и их аналогов Простые механизмы
Простые механизмы презентация по физике 9 класс
презентация по физике 9 класс Закон сохранения теплоты
Закон сохранения теплоты Электромагнитные колебания.
Электромагнитные колебания. Понятие материального баланса процесса горения. Расход воздуха на горение
Понятие материального баланса процесса горения. Расход воздуха на горение Механические колебания
Механические колебания Звук. Джерела звуків
Звук. Джерела звуків Дифракция света. Опыт Юнга
Дифракция света. Опыт Юнга