Содержание
- 2. Создание скрытого коллекторного слоя Обработка поверхности пластины кремния p -типа Окисление Фотолитография – формирование рисунка в
- 3. Создание изолирующих областей Нанесение нитрида кремния химическим осаждением из газовой фазы Фотолитография – формирование рисунка в
- 4. Создание глубокого коллектора Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из неограниченного источника) Окисление
- 5. Создание пассивной базы Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из неограниченного источника) Окисление
- 6. Создание активной базы Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из неограниченного источника) Окисление
- 7. Создание эмиттера Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из неограниченного источника) Окисление с
- 8. Создание металлизации Фотолитография – вскрытие окон в оксиде для создания контактов к областям Напыление алюминия с
- 9. Изменения кремниевой структуры со скрытыми слоями при формировании полупроводниковых микросхем по эпипланарной технологии
- 10. Изготовление биполярной ИС с щелевой изоляцией транзисторов
- 11. Создание скрытого коллекторного слоя Обработка поверхности пластины кремния p -типа Загонка мышьяка (диффузия из неограниченного источника)
- 12. Создание изолирующих областей Фотолитография – формирование рисунка в оксиде Ионное травление канавок до глубины средней канавки
- 13. Создание глубокого коллектора Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из неограниченного источника) Окисление
- 14. Создание пассивной базы Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из неограниченного источника) Окисление
- 15. Создание активной базы Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из неограниченного источника) Окисление
- 16. Создание эмиттера Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из неограниченного источника) Окисление с
- 17. Создание металлизации Фотолитография – вскрытие окон в оксиде для создания контактов к областям Напыление алюминия с
- 18. ЭПИК-процесс Диэлектрическая изоляция элементов
- 19. Формирование скрытого коллекторного слоя n+
- 20. Анизотропное травление, канавки заполняются поликремнием n+
- 21. Кремний сошлифовывается
- 22. Формирование базы и эмиттера n+ p+ n+ n+
- 23. Схема изготовления КМОП-КНС-ИМ
- 25. Кремний на сапфире Рис. 30 - 32 биполярный МДП
- 26. Гибридная ИС Рис. 3 Совмещенная ИС Рис. 2
- 27. Дискретные транзисторы биполярный МДП ПТУП Рис. 25 - 28
- 28. МДП Рис. 33 Рис. 34
- 29. Изопланар Изоляция V-образными канавками Рис. 23 Рис. 24
- 30. Рис. 19 Рис. 20
- 31. Рис. 10 Рис. 11
- 33. Скачать презентацию



















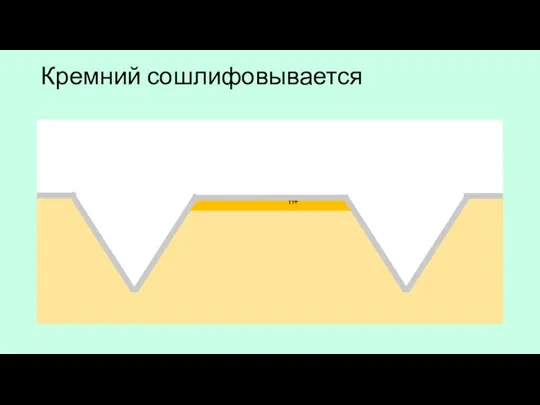



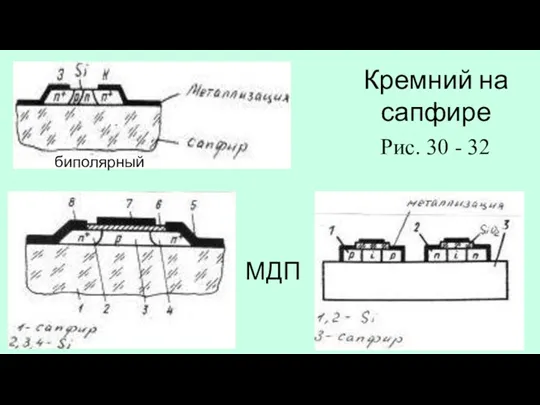
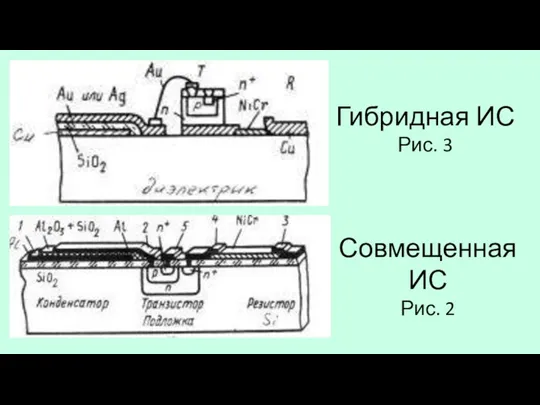
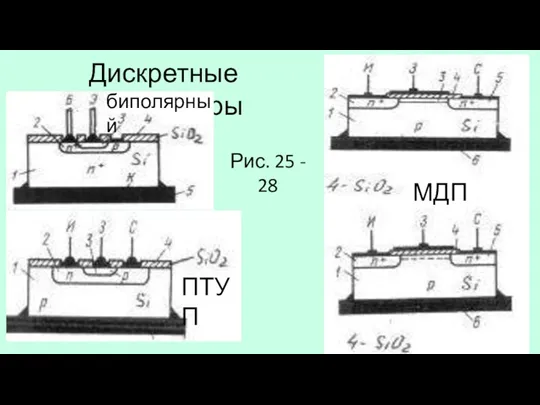
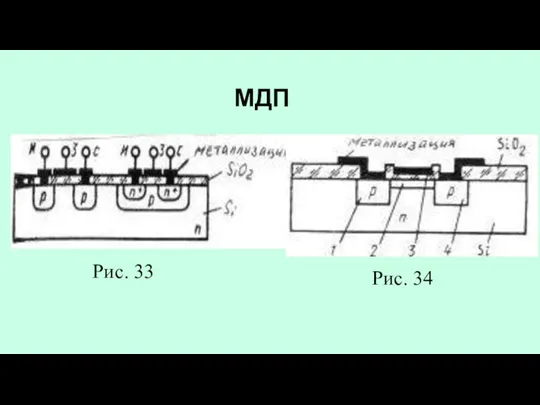
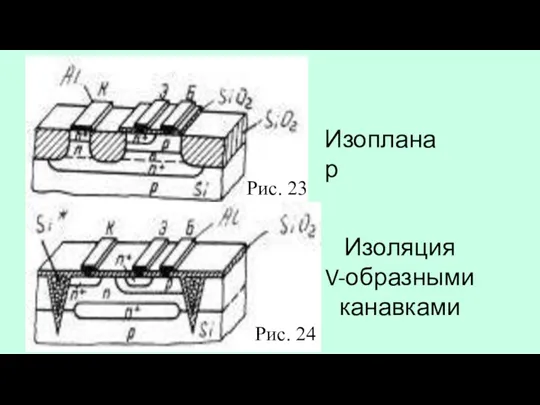


 Ас қорыту мүшелері гистологиясының балалардағы ерекшеліктері
Ас қорыту мүшелері гистологиясының балалардағы ерекшеліктері Реформы Цинь Ши-хуанди
Реформы Цинь Ши-хуанди Бджільництво
Бджільництво Современная эволюционная теория Факторы эволюции
Современная эволюционная теория Факторы эволюции История фармакологии
История фармакологии Аминогликозиды. Хинолоны
Аминогликозиды. Хинолоны Visual Insight web slides - Solution Detail V2 (1)
Visual Insight web slides - Solution Detail V2 (1) Презентация История открытки
Презентация История открытки Зачет по теме: Периодический закон. Периодическая система.Строение атома
Зачет по теме: Периодический закон. Периодическая система.Строение атома Сервистiк қызмет көрсету орталықтары
Сервистiк қызмет көрсету орталықтары Цветы в технике холодного батика
Цветы в технике холодного батика Молодежная программа Ты – предприниматель
Молодежная программа Ты – предприниматель Российское общество и культура в вихре революционных перемен (1917 - 1920-е годы)
Российское общество и культура в вихре революционных перемен (1917 - 1920-е годы) Теория психологической (реалистической) школы государства и права
Теория психологической (реалистической) школы государства и права Туберкулез и хронические неспецифические заболевания легких
Туберкулез и хронические неспецифические заболевания легких Ет өндірісінің жаңа технологиясы
Ет өндірісінің жаңа технологиясы класс 03.02.22
класс 03.02.22 Урок-игра. Планета рыб
Урок-игра. Планета рыб презентация -дидактическая игра Что полезно, а что вредно для зубов
презентация -дидактическая игра Что полезно, а что вредно для зубов Development of transportation
Development of transportation Самые невероятные места отдыха в России
Самые невероятные места отдыха в России Оборудование для добычи нефти и газа. Оборудование для эксплуатации скважин фонтанным и газлифтным способами
Оборудование для добычи нефти и газа. Оборудование для эксплуатации скважин фонтанным и газлифтным способами Слагаемые профессионального имиджа педагога
Слагаемые профессионального имиджа педагога Искусство модернизма
Искусство модернизма Профилактика гриппа и ОРВИ
Профилактика гриппа и ОРВИ Популяція біології. Вплив вітамінів на організм людини
Популяція біології. Вплив вітамінів на організм людини Презетация Физминутка
Презетация Физминутка Тормоза поездов и локомотивов
Тормоза поездов и локомотивов