Содержание
- 2. Униполярные транзисторы Различают два вида полевых транзисторов: с управляющим pn-переходом со структурой металл-диэлектрик-полупроводник (МДП- транзисторы)
- 3. Полевой транзистор с управляющим p-n-переходом (ПТУП) С помощью pn-перехода, включенного в обратном направлении, возможно в объеме
- 4. СТРУКТУРА ТРАНЗИСТОРА С УПРАВЛЯЮЩИМ P-N-ПЕРЕХОДОМ
- 5. В ПТУП область затвора отделена от объема канала p-n-переходом, смещенным в обратном направлении. При отсутствии напряжения
- 6. На управляющий pn-переход можно подавать только обратное напряжение, и поэтому ПТУП работает в режиме обеднения канала
- 7. В отличие от биполярных транзисторов в данном случае управление осуществляется потоком основных носителей заряда. Поэтому принципиально
- 8. При подаче обратного смещения на затвор относительно истока (Uзи) ОПЗ расширяется, соответственно, толщина проводящего канала уменьшается,
- 9. ОБОЗНАЧЕНИЕ И СХЕМА ВКЛЮЧЕНИЯ
- 10. При некотором значении Uзи ОПЗ занимает весь канал ( ) – происходит так называемая отсечка канала.
- 11. ФОРМА КАНАЛА ПРИ РАЗЛИЧНЫХ ЗНАЧЕНИЯХ НАПРЯЖЕНИЙ НА ЗАТВОРЕ И СТОКЕ
- 12. Вольт-амперные характеристики ПТУП Входная характеристика ПТУП соответствует вольт-амперной характеристике pn-перехода. Она представляет ВАХ диода затвор-исток. Выходные
- 13. ВЫХОДНАЯ ХАРАКТЕРИСТИКА ПТУП
- 14. ПЕРЕДАТОЧНАЯ ХАРАКТЕРИСТИКА ПТУП Чем круче эти характеристики, тем большее усиление можно получить в полевом транзисторе.
- 15. РАСЧЕТ ХАРАКТЕРИСТИК ПТУП
- 16. Влияние температуры на параметры транзистора с управляющим переходом Изменение ВАХ ПТУП с температурой определяется температурной зависимостью
- 17. С ростом напряжения затвора крутизна для полевого транзистора с управляющим pn-переходом падает. С увеличением температуры контактная
- 18. В настоящее время разработаны ПТУП на основе GaAs, SiC, Ge, однако наибольшее распространение получили приборы на
- 19. ВАРИАНТЫ КОНСТРУКЦИИ ПТУП
- 20. ИЗМЕНЕНИЕ ФОРМЫ КАНАЛА ПРИ РАЗНЫХ НАПРЯЖЕНИЯХ ЗАТВОРА И СТОКА
- 21. Идеальная МДП–структура Если на окисел, покрывающий поверхность кристалла, нанести металлический электрод (затвор), то, изменяя его потенциал
- 22. МДП-СТРУКТУРА
- 23. На границе металл-диэлектрик, диэлектрик-полупроводник, а в отсутствии диэлектрика на границе металл-полупроводник возникает контактная разность потенциалов:
- 24. ОБОГАЩЕНИЕ n-тип
- 25. ОБЕДНЕНИЕ n-тип p-тип
- 26. ИНВЕРСИЯ n-тип p-тип
- 27. Допущения для «идеальной» МДП-структуры Разность работ выхода между металлом затвора и диэлектриком, диэлектриком и полупроводником, равна
- 28. РАСЧЕТ ПАРАМЕТРОВ МДП-СТРУКТУРЫ
- 29. МДП-структура
- 30. Для характеристики изгиба будем использовать понятие поверхностного потенциала φs Пороговое напряжение:
- 31. Заряды в окисле
- 32. К расчету МДП-структуры (4.6) (4.7) (4.8) (4.9) (4.10) (4.11) (4.12)
- 33. Емкость МДП-структуры
- 34. МДП-транзистор МДП-транзистор называют также транзистором с изолированным затвором, так как в отличие от ПТУП затвор от
- 35. Условные обозначения МДП-транзисторов С индуцированным каналом Со встроенным каналом n-канальный p-канальный p-канальный n-канальный
- 36. СТРУКТУРЫ И ОБОЗНАЧЕНИЯ МДП-ТРАНЗИСТОРОВ а, б – с индуцированным каналом в, г – со встроенным каналом
- 37. МДП-ТРАНЗИСТОР СО ВСТРОЕННЫМ КАНАЛОМ
- 38. МДП-транзистор с индуцированным n-каналом
- 39. ЗАКРЫТИЕ ВСТРОЕННОГО КАНАЛА
- 40. Сделаем следующие основные допущения: одномерное приближение, т.е. концентрации носителей и потенциалы по сечению канала постоянны; на
- 41. РАСЧЕТ ХАРАКТЕРИСТИК МДП-ТРАНЗИСТОРА
- 42. ВЫХОДНАЯ ВАХ МДП-ТРАНЗИСТОРА С ИНДУЦИРОВАННЫМ КАНАЛОМ
- 43. три основные рабочие области на выходной характеристике МДП-транзистора 1 – область отсечки выходного тока: транзистор заперт
- 44. В области 1 МДП-транзистор, как и биполярный, работающий в ключевом режиме, заперт. В области 3 транзистор
- 45. ПЕРЕДАТОЧНАЯ Х-КА МДП-ТРАНЗИСТОРА С ИНДУЦИРОВАННЫМ КАНАЛОМ
- 46. МДП-ТРАНЗИСТОР СО ВСТРОЕННЫМ КАНАЛОМ
- 47. ПЕРЕДАТОЧНАЯ Х-КА МДП-ТРАНЗИСТОРА СО ВСТРОЕННЫМ КАНАЛОМ
- 48. ВАРИАНТЫ ВКЛЮЧЕНИЯ ПОЛЕВОГО ТРАНЗИСТОРА
- 49. Преимущества МДП-транзисторов по сравнению с биполярными Высокое входное сопротивление, которое определяется только сопротивлением утечки диэлектрика и
- 50. Полевые транзисторы
- 51. До 70-х годов XX века в качестве силовых полупроводниковых приборов, помимо тиристора, использовались биполярные транзисторы. Их
- 52. С появлением полевых транзисторов в 80-х годах, выполненных по технологии МОП, ситуация изменилась. В отличие от
- 53. Первые мощные полевые транзисторы были созданы в СССР в НИИ «Пульсар» (разработчик ‒ В. В. Бачурин)
- 54. В настоящее время существует несколько базовых структур силовых МОП ПТ. В области коммутируемых токов до 50
- 55. По своей внутренней структуре БТИЗ представляет собой каскадное включение двух электронных ключей: входной ключ на полевом
- 56. Такое составное включение ПТ и БТ позволяет сочетать в одном устройстве достоинства обоих типов полупроводниковых приборов.
- 57. Горизонтальная структура первых советских мощных МДП-транзисторов
- 58. МДП- транзистор с V-образной структурой
- 59. Структура V-МОП
- 60. МДП- транзистор с U -образной структурой
- 61. Структура D-МОП База Дрейфовая область + Эмиттер
- 62. Так как во всех мощных МОП-транзисторах р-эмиттер соединен накоротко с истоком, положительное напряжение стока смещает переход
- 63. Работа при обратном напряжении силового МДП ПТ закрытый канал (биполярный ток) Vз +Исток -Сток
- 64. Работа при обратном напряжении силового МДП ПТ открытый канал и малое отрицательное напряжение VСИ (полевой ток)
- 65. Работа при обратном напряжении силового МДП ПТ открытый канал и большое отрицательное напряжение VСИ (комбинированный ток)
- 66. Силовой MOSFET во включенном состоянии -Исток +Сток
- 67. В рабочем режиме (затвор – Gate – открыт, на сток – Drain относительно истока – Source
- 68. Основная выходная характеристика силового транзисторного модуля Закрытое состояние
- 69. Работа при обратном напряжении При обратном напряжении (третий квадрант) характеристика МДП ПТ эквивалентна диодной при VЗС
- 70. Включенное состояние Прямое включенное состояние при положительном напряжении сток-исток VСИ и прямой ток IС могут быть
- 71. Выходные (а) и передаточные (б) характеристики ПТИЗ с индуцированным каналом для схемы с ОИ
- 72. Чтобы перевести МОП-транзистор в закрытое состояние необходимо уменьшить напряжение смещения затвора, электроны перестают индуцироваться в канале,
- 73. Структура U-образного МОП-транзистора
- 74. Устройство и особенности работы IGBT
- 75. IGBT – полностью управляемый полупроводниковый прибор, в основе которого трехслойная структура. Его включение и выключение осуществляются
- 76. Для IGBT с номинальным напряжением в диапазоне 600-4000 В в полностью включённом состоянии прямое падение напряжения,
- 77. Структуры IGBT а) планарного типа; б) изготовленная по технологии «trench-gate» ("утопленного" канала)
- 78. Структура IGBT планарного типа IGBT содержит p+‒проводящую область с соединением к коллектору ниже n‒зоны
- 79. Биполярный транзистор образован слоями p+ (эмиттер), n (база), p (коллектор); полевой ‒ слоями n (исток), n+
- 80. СТРУКТУРА IGBT -Исток +Сток Инжекция дырок
- 81. ВАХ IGBT ток отсечки
- 82. При превышении определенного максимального напряжения коллектор-эмиттер V(BR)CES, происходит лавинный пробой перехода р+‒область/n-‒дрейфовая зона/n+‒эпитаксиальный слой (напряжение пробоя
- 83. Область насыщения Область насыщения (крутой подъем кривой выходной характеристики), также называемая открытым состоянием при переключении. Характер
- 85. Скачать презентацию


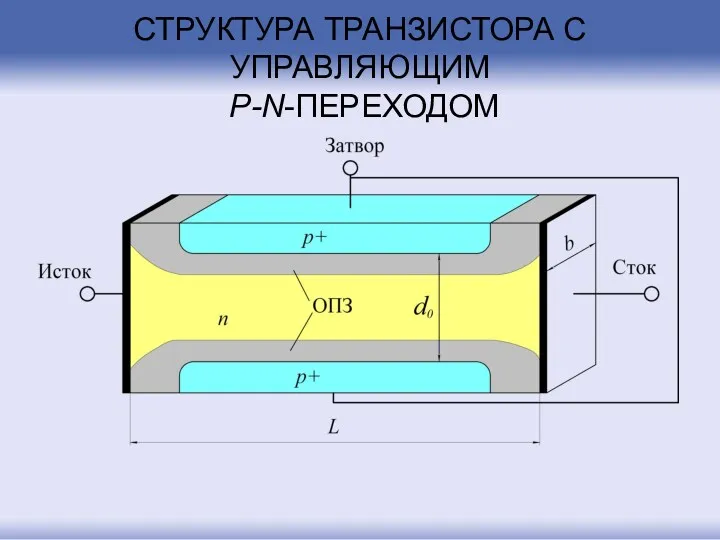




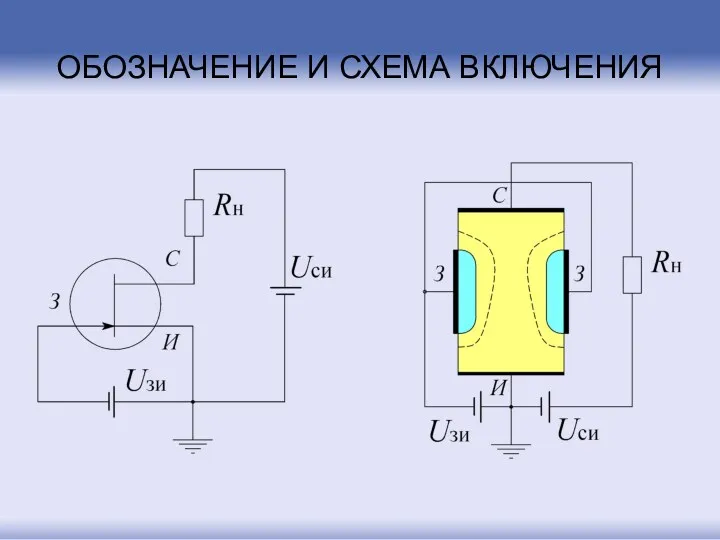

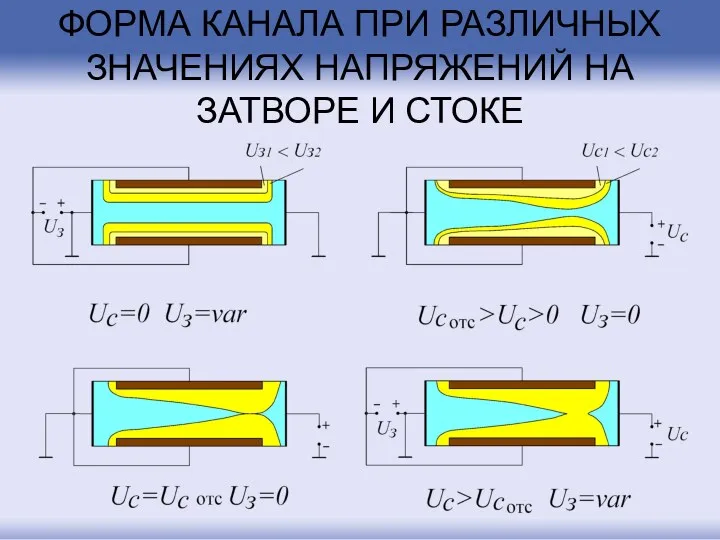







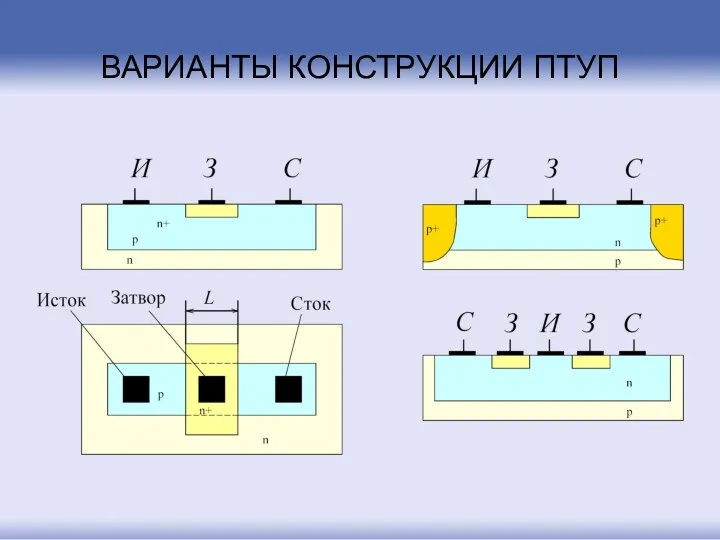


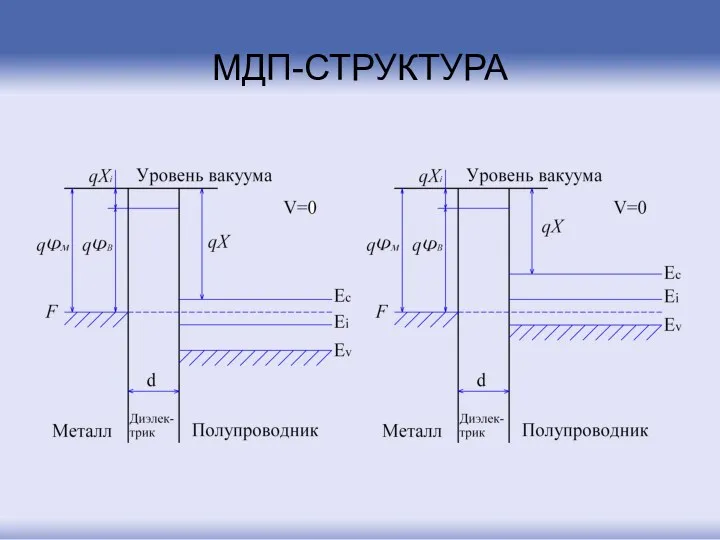

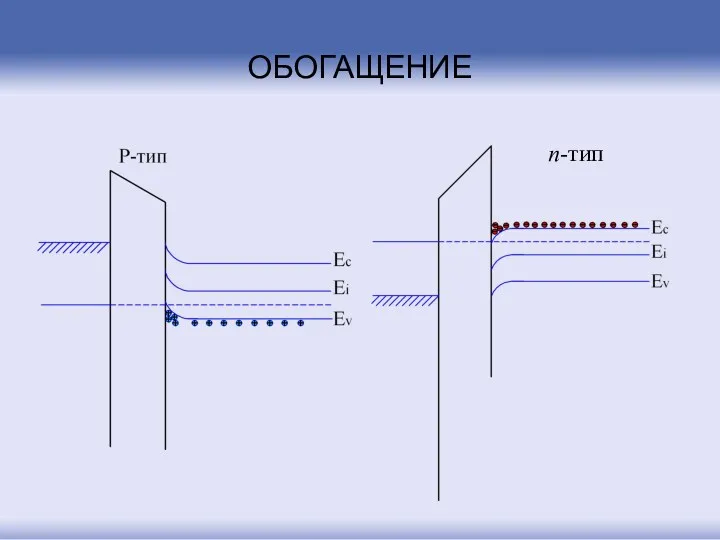
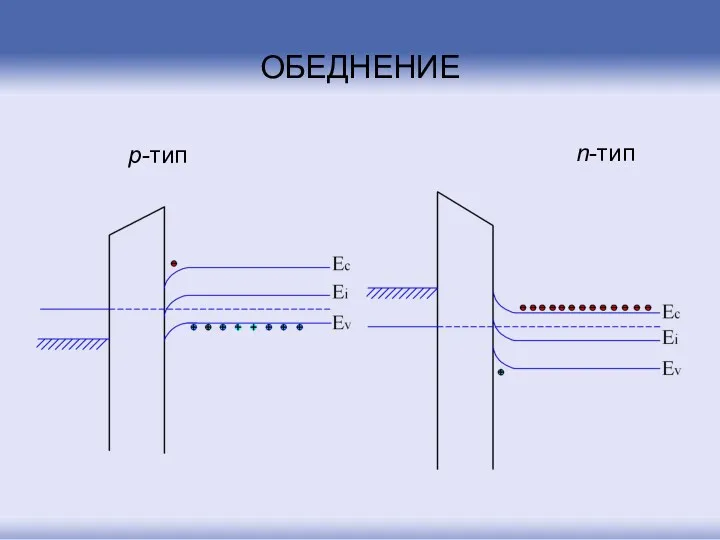
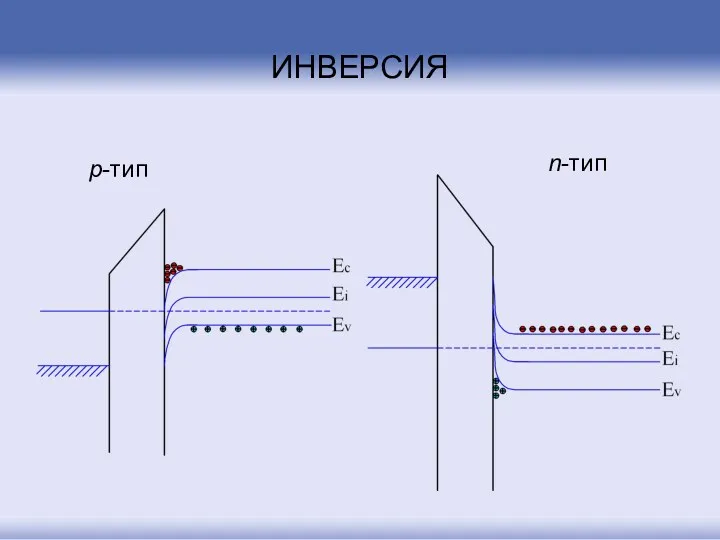


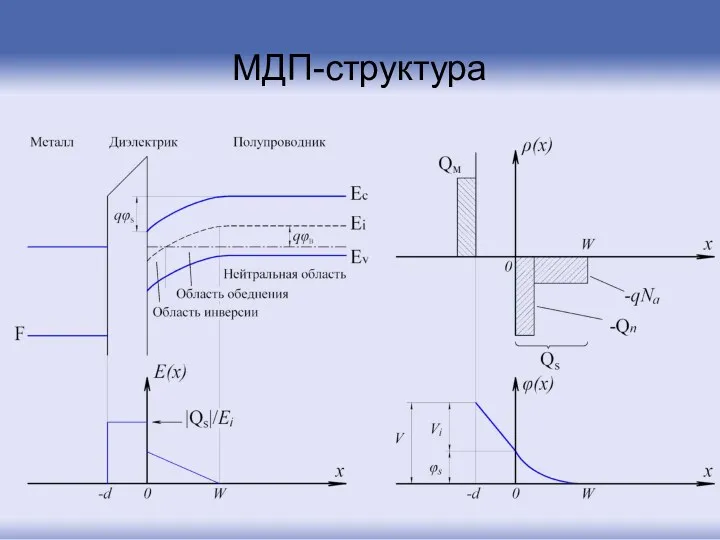



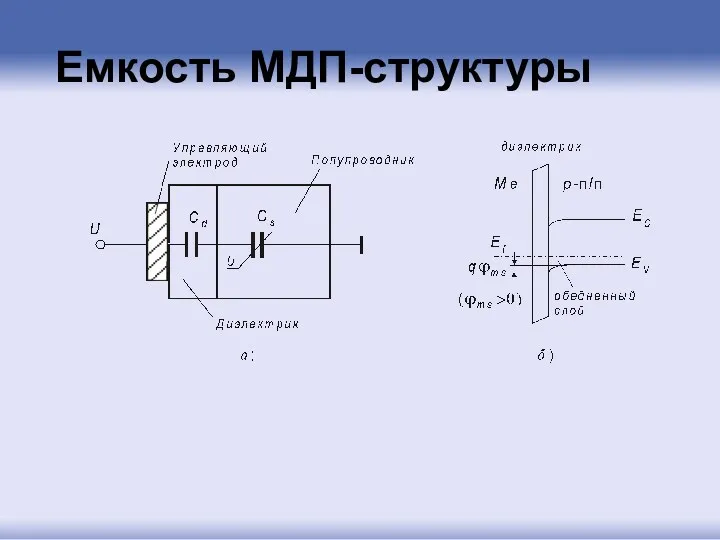


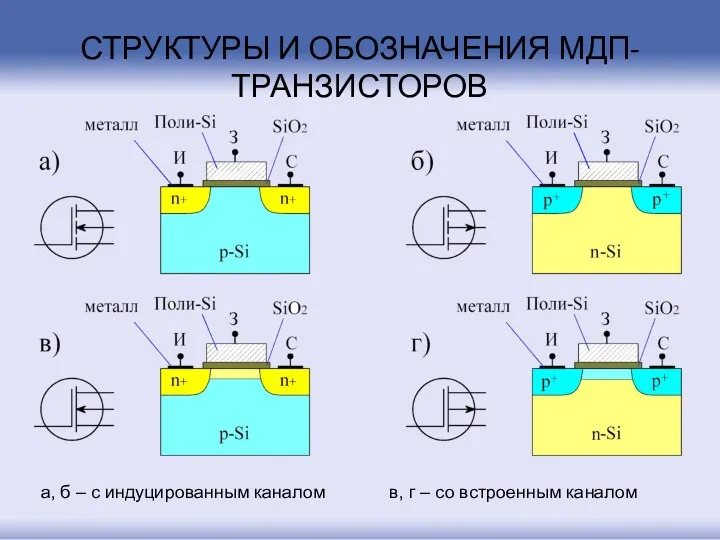
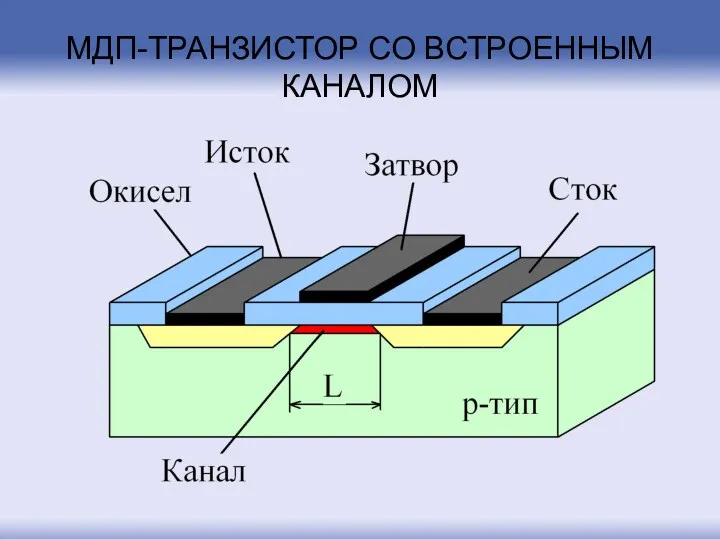
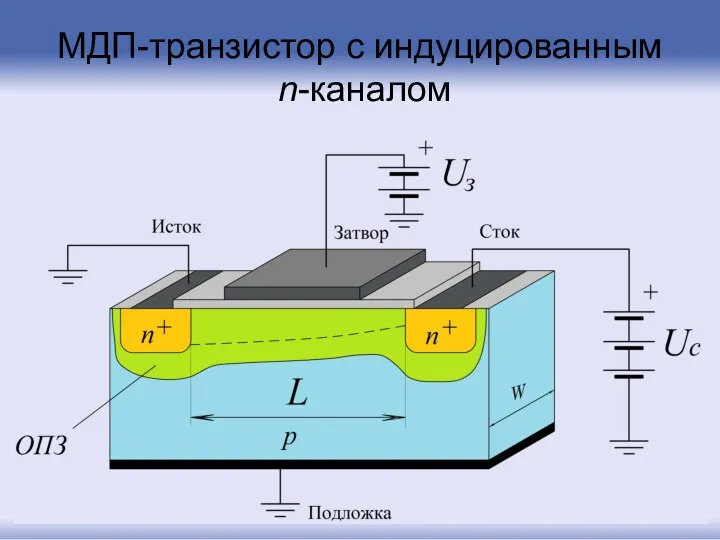
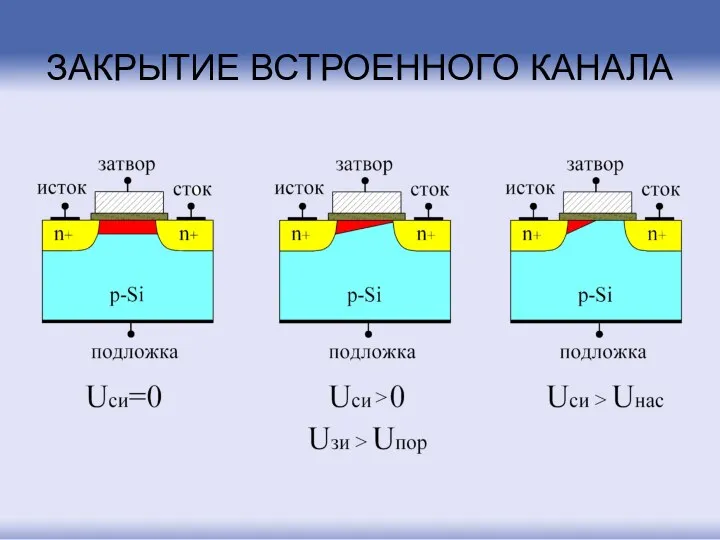


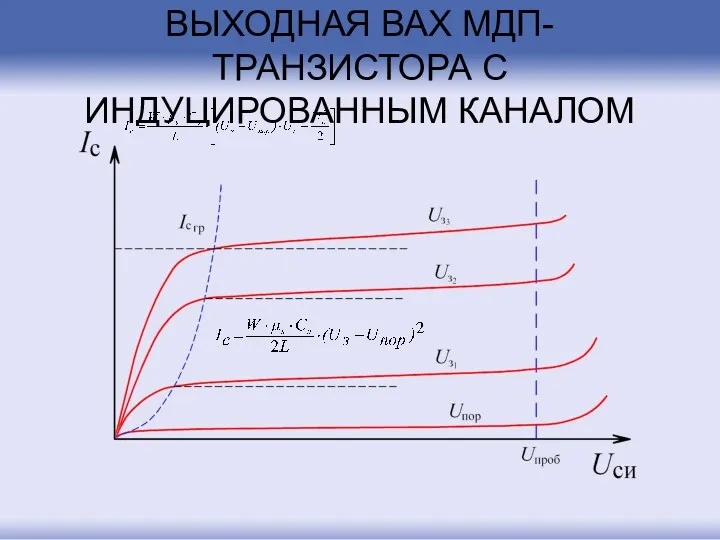














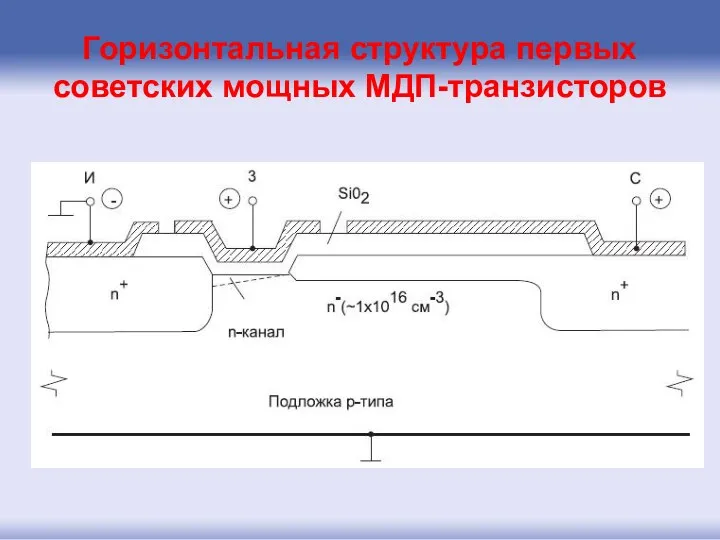
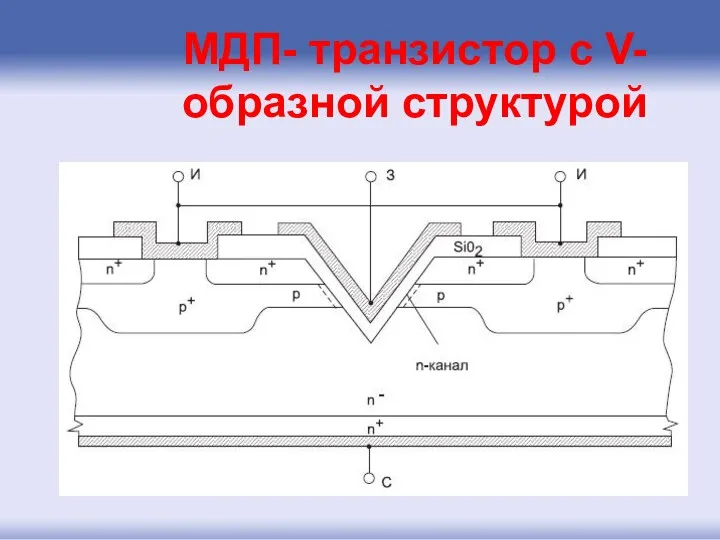
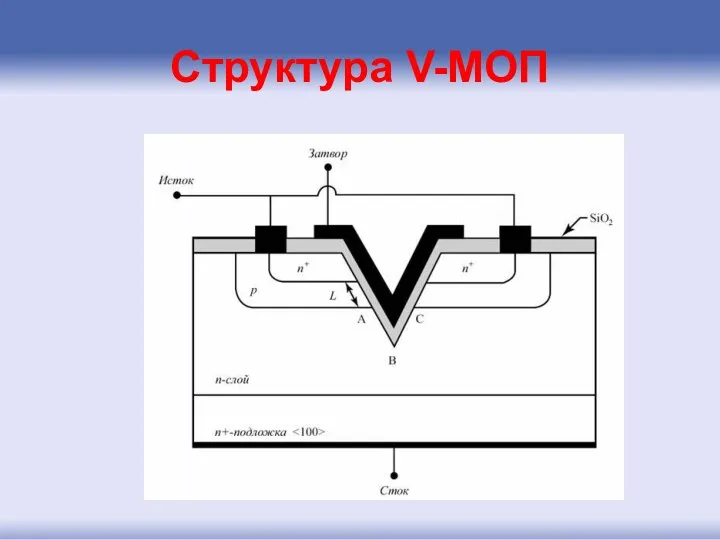
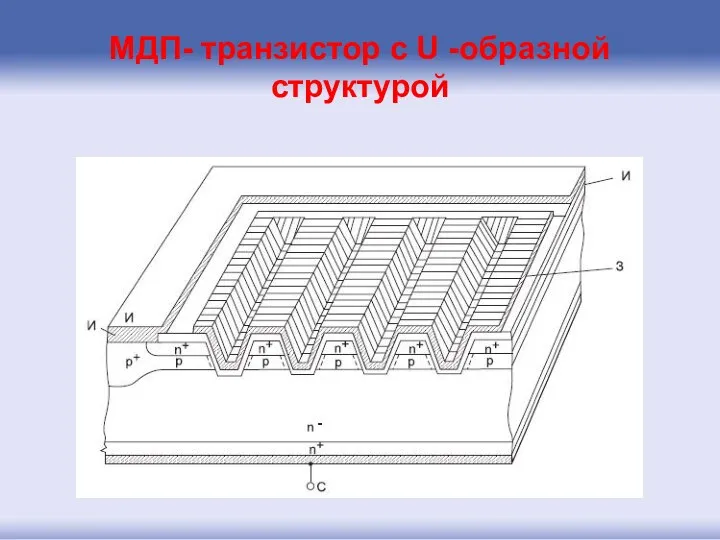
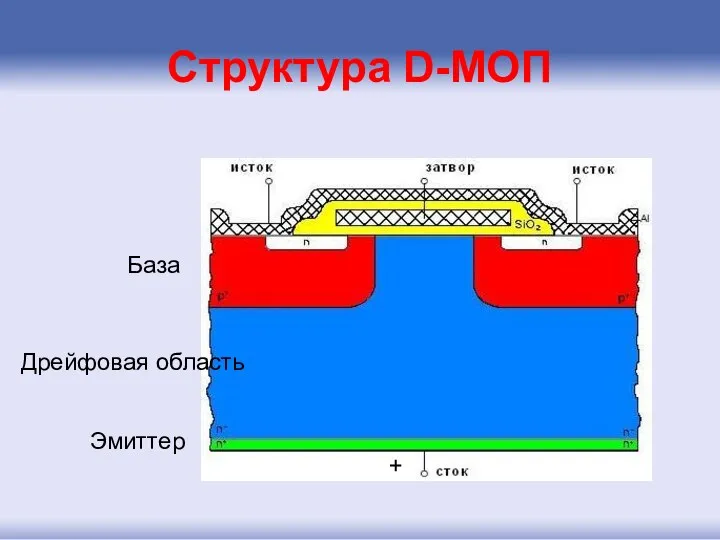

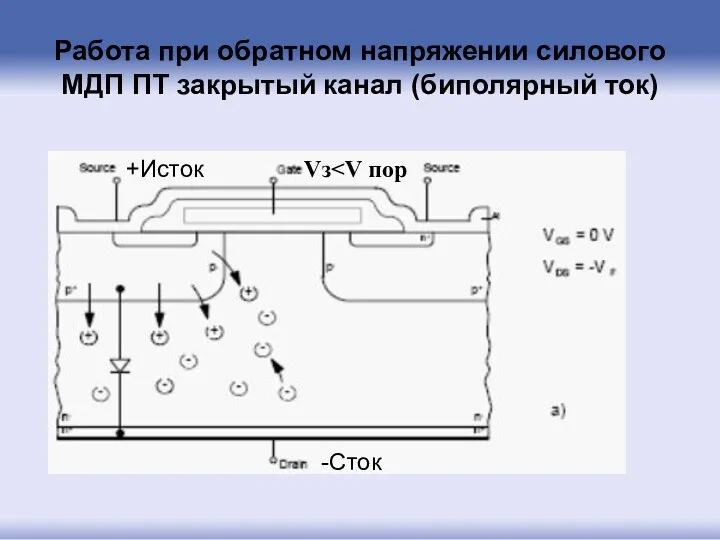
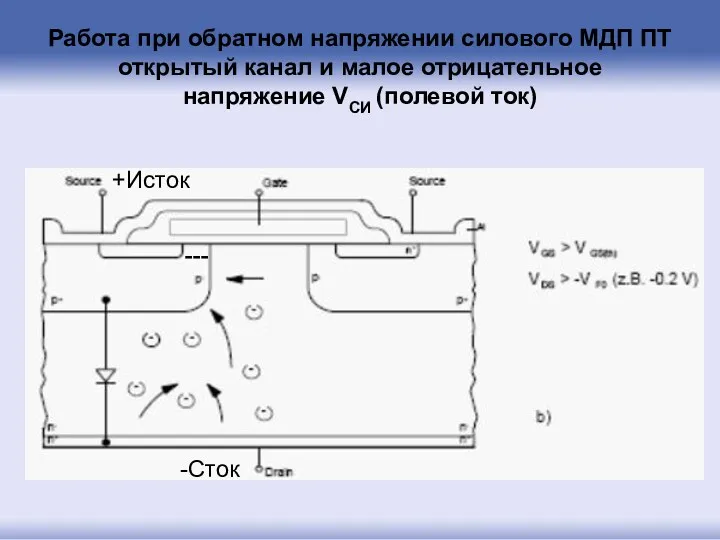
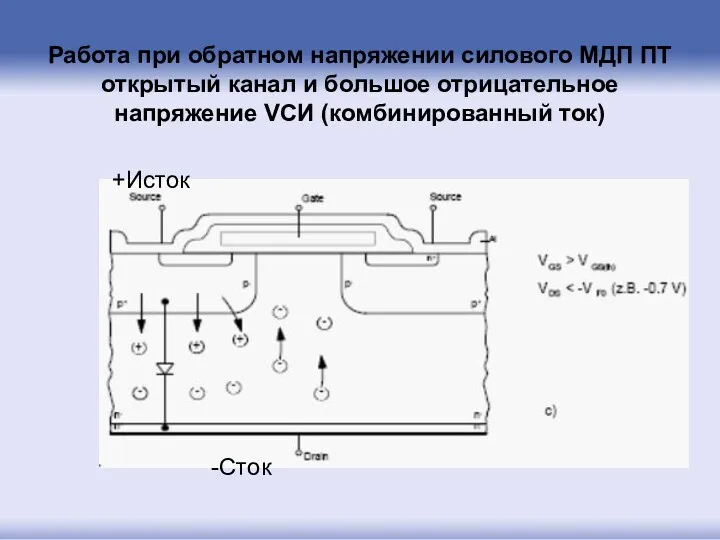
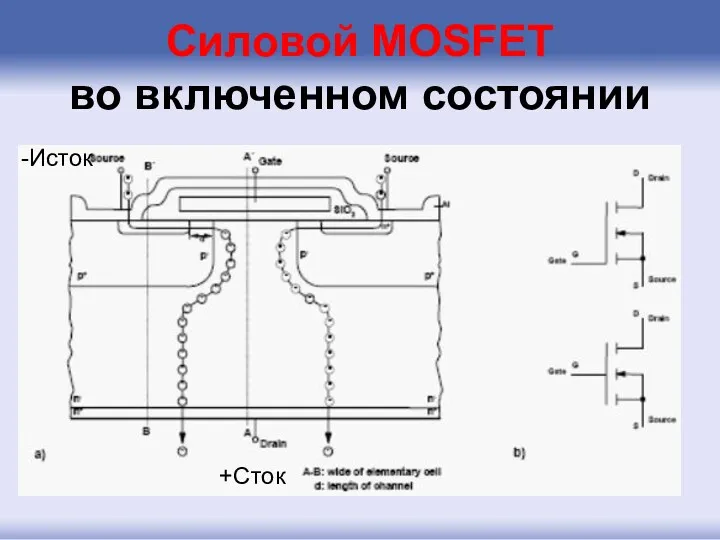






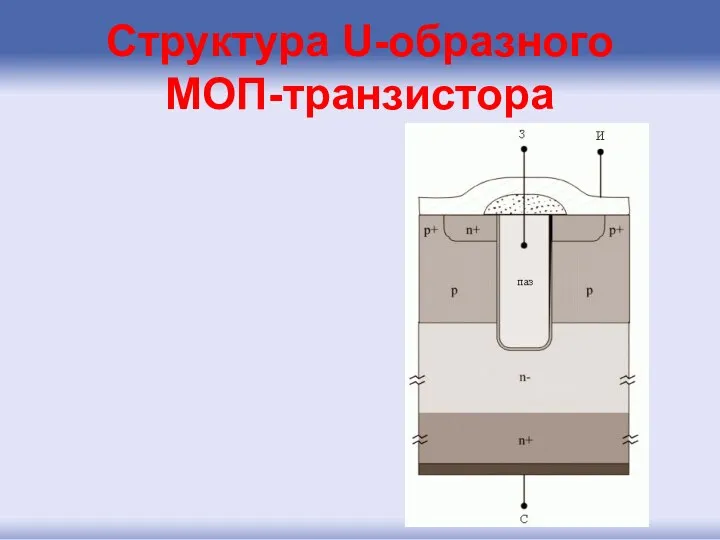



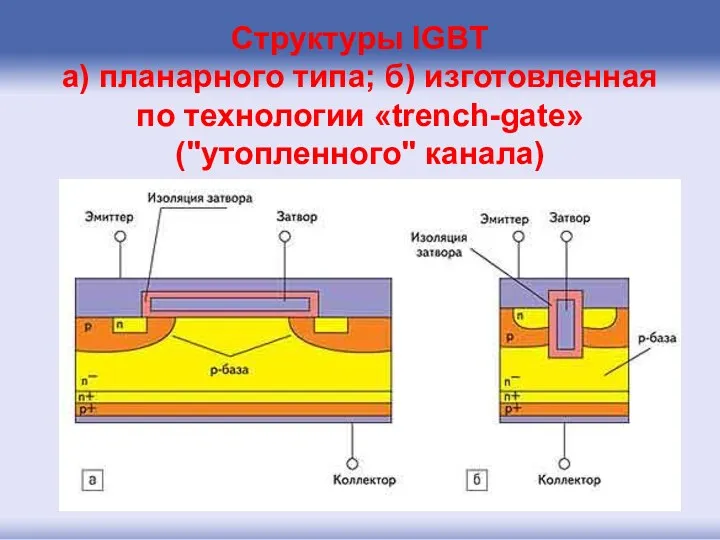
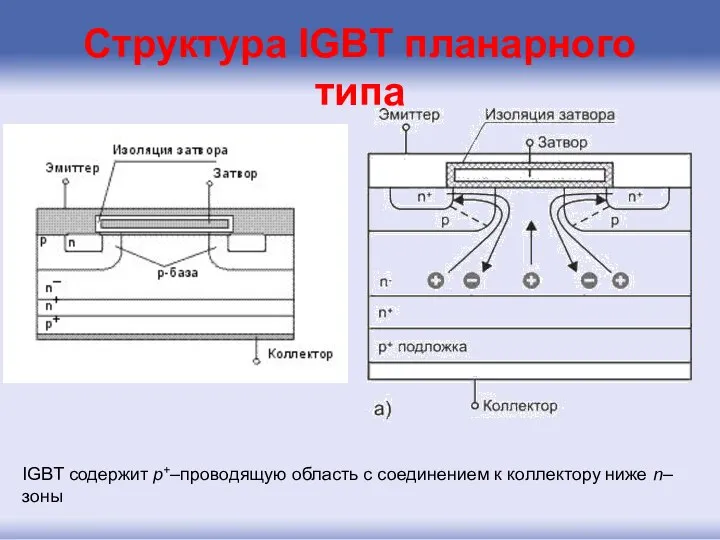

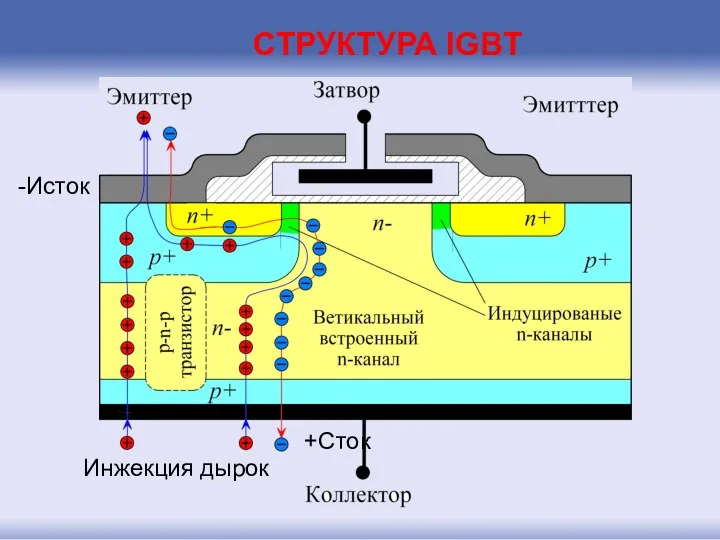
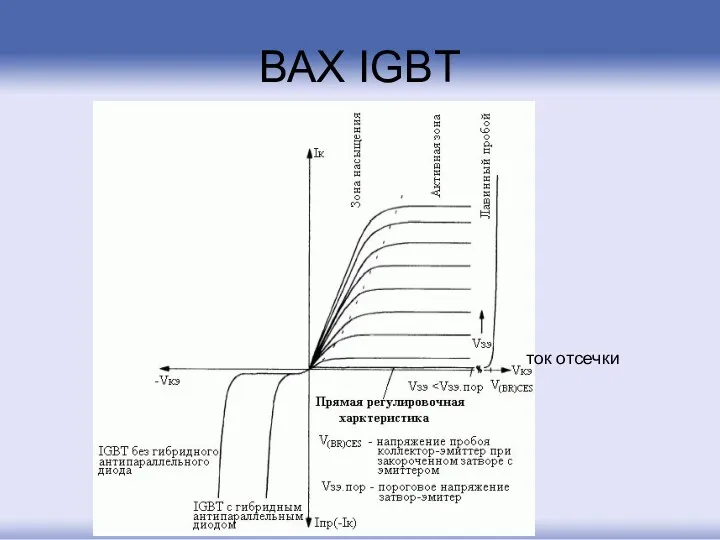


 6.1 Назначение и классификация выпрямителей
6.1 Назначение и классификация выпрямителей Современный ребенок: контуры психологического портрета
Современный ребенок: контуры психологического портрета Подготовка к сочинению по картине В.М.Васнецова Богатыри
Подготовка к сочинению по картине В.М.Васнецова Богатыри Кожевенное производство в России
Кожевенное производство в России Презентация-сопровождение к артикуляционной гимнастике
Презентация-сопровождение к артикуляционной гимнастике Презентация Широкая масленица
Презентация Широкая масленица СССР в середине 1960 - начале 1980 г.г. Эпоха застоя
СССР в середине 1960 - начале 1980 г.г. Эпоха застоя С Амадеем по Европе Диск
С Амадеем по Европе Диск Патологии сердца
Патологии сердца Реклама програми Power Point
Реклама програми Power Point Бейнеу лицейінің тәрбие жүйесі
Бейнеу лицейінің тәрбие жүйесі Структура сайта фитнес-клуба
Структура сайта фитнес-клуба 778707c921d149829edea95ead1ad0aa
778707c921d149829edea95ead1ad0aa Чудо-книжки – чудо-детям. Книжки Холли Вебб
Чудо-книжки – чудо-детям. Книжки Холли Вебб Профориентация в начальной школе Диск
Профориентация в начальной школе Диск презентация Жемчужина Сибири-Байкал
презентация Жемчужина Сибири-Байкал Синхронное плавание - грации России
Синхронное плавание - грации России Презентация Профилактика нарушений голоса
Презентация Профилактика нарушений голоса Портфолио ученика начальных классов. Презентация.
Портфолио ученика начальных классов. Презентация. Симметрия вокруг нас
Симметрия вокруг нас Международная конференция: Российское судостроение
Международная конференция: Российское судостроение Автотрансформаторы
Автотрансформаторы Процесс технического обслуживания и ремонта системы электроснабжения автомобилей марки Peugeot
Процесс технического обслуживания и ремонта системы электроснабжения автомобилей марки Peugeot Кинетика ферментативного катализа. (Лекция 5)
Кинетика ферментативного катализа. (Лекция 5) Презентация Что изучает география
Презентация Что изучает география Ощущения с поверхности тела
Ощущения с поверхности тела шаншаров-фарм жшс кәсіпорнында сасықшөп тұндырмасын ұйымдастыру үрдісін қарқындату
шаншаров-фарм жшс кәсіпорнында сасықшөп тұндырмасын ұйымдастыру үрдісін қарқындату Учебный стенд Система головного освещения автомобиля для проведения лабораторно-практических работ
Учебный стенд Система головного освещения автомобиля для проведения лабораторно-практических работ