Содержание
- 2. МДП-СТРУКТУРЫ
- 3. Идеальная МДП–структура Если на окисел, покрывающий поверхность кристалла, нанести металлический электрод (затвор), то, изменяя его потенциал
- 4. ИДЕАЛЬНАЯ МДП-СТРУКТУРА На границе металл-диэлектрик (изолятор), диэлектрик-полупроводник возникает контактная разность потенциалов:
- 5. Допущения для «идеальной» МДП-структуры Диэлектрик является идеальным изолятором. В диэлектрике и на границах раздела металл-диэлектрик и
- 6. Если к МДП-структуре приложить эл. напряжение, то его обкладки зарядятся. В зависимости от знака и величины
- 7. ОБЕДНЕНИЕ n-тип p-тип Режим обеднения дырки е-ны
- 8. ИНВЕРСИЯ n-тип p-тип Инверсия типа проводимости е-ны дырки
- 9. МДП-структура, инверсия типа проводимости
- 10. Для характеристики изгиба зон будем использовать понятие поверхностного потенциала φs. Рассмотрим п/п-к p-типа. – условие инверсии
- 11. Емкость реальной МДП-структуры где εd – диэлектрическая проницаемость материала диэлектрика; S – площадь управляющего электрода; δd
- 12. С-V-характеристики идеальной МДП-структуры Режимы МДП-структуры: обогащения (φs 2 φB) инверсий. низкочастотная ВЧ неравновесная ВЧ
- 13. Из всех МДП-структур наиболее важными являются структуры металл –SiO2–Si (МОП). Отличие характеристик реальных МОП-структур от соответствующих
- 14. МДП-транзистор МДП-транзистор называют также транзистором с изолированным затвором, так как в отличие от ПТУП затвор от
- 15. СТРУКТУРЫ И ОБОЗНАЧЕНИЯ МДП-ТРАНЗИСТОРОВ а, б – с индуцированным каналом в, г – со встроенным каналом
- 16. МДП-транзистор с индуцированным n-каналом
- 17. ЗАКРЫТИЕ КАНАЛА
- 18. Сделаем следующие основные допущения: одномерное приближение, т.е. концентрации НЗ и потенциалы по сечению канала постоянны; на
- 19. РАСЧЕТ ХАРАКТЕРИСТИК МДП-ТРАНЗИСТОРА UЗИ UЗИ UЗИ UЗИ UЗИ UЗИ
- 20. ВЫХОДНАЯ ВАХ МДП-ТРАНЗИСТОРА С ИНДУЦИРОВАННЫМ КАНАЛОМ 1 - отсечка 2 - активная область 3 - область
- 21. три основные рабочие области на выходной характеристике МДП-транзистора 1 – область отсечки выходного тока: транзистор заперт
- 22. ПЕРЕДАТОЧНАЯ Х-КА МДП-ТРАНЗИСТОРА С ИНДУЦИРОВАННЫМ КАНАЛОМ UЗпор
- 23. МДП-ТРАНЗИСТОР СО ВСТРОЕННЫМ КАНАЛОМ
- 24. МДП-ТРАНЗИСТОР СО ВСТРОЕННЫМ КАНАЛОМ
- 25. ПЕРЕДАТОЧНАЯ Х-КА МДП-ТРАНЗИСТОРА СО ВСТРОЕННЫМ КАНАЛОМ
- 26. ВАРИАНТЫ ВКЛЮЧЕНИЯ ПОЛЕВОГО ТРАНЗИСТОРА
- 27. Преимущества МДП-транзисторов по сравнению с БТ Высокое rвх, которое определяется только сопротивлением утечки диэлектрика и достигает
- 28. СИЛОВЫЕ ПРИБОРЫ
- 29. До 70-х годов XX века в качестве силовых п/п-ковых приборов, помимо тиристора, использовались БТ. Их эффективность
- 30. С появлением ПТ в 80-х годах, выполненных по технологии МОП, ситуация изменилась. В отличие от БТ,
- 31. Первые мощные ПТ были созданы в СССР в НИИ «Пульсар» (разработчик ‒ В. В. Бачурин) в
- 32. В настоящее время существует несколько базовых структур силовых МОП ПТ. В области коммутируемых токов до 50
- 33. Управляющий электрод называется затвором, как у ПТ, два других электрода ‒ Э и К, как у
- 34. Горизонтальная структура первых советских мощных МДП-транзисторов
- 35. МДП- транзистор с V-образной структурой
- 36. Структура V-МОП
- 37. МДП- транзистор с U -образной структурой
- 38. Силовой MOSFET. Структура D-МОП Коллектор Дрейфовая область Эмиттер Земля Обр. смещ.
- 39. р-коллектор соединен накоротко с истоком, положительное напряжение стока смещает переход р-коллектор – п-дрейфовая область в обратном
- 40. Силовой MOSFET во включенном состоянии Исток Сток Земля
- 41. Основная выходная характеристика силового транзисторного модуля Закрытое состояние IDSS Насыщение, активная зона ВАХ
- 42. При прямом смещении (I квадрант) Закрытое состояние При VСИ(пор) > VСИ>0 между стоком и истоком будет
- 43. Включенное состояние Прямое включенное состояние при положительном напряжении сток-исток VСИ и прямой ток IС могут быть
- 44. + - VЗ + VЗ>Vпор + - - -- VЗ>Vпор ОПЗ + -
- 45. Работа при обратном напряжении При обратном напряжении (III квадрант) характеристика МДП ПТ эквивалентна диодной при VЗС
- 46. Работа при обратном напряжении силового МДП ПТ, закрытый канал (биполярный ток) VЗ Исток Сток Эмиттер паразитный
- 47. Работа при обратном напряжении силового МДП ПТ открытый канал и малое отрицательное напряжение VСИ (полевой ток)
- 48. Работа при обратном напряжении силового МДП ПТ, открытый канал и большое отрицательное напряжение VСИ (комбинированный ток)
- 49. Выходные (а) и передаточные (б) характеристики ПТИЗ с индуцированным каналом для схемы с ОИ
- 50. Чтобы перевести МОП-транзистор в закрытое состояние необходимо ↓ VЗС, е-ны перестают индуцироваться в канале, путь от
- 51. Структура U-образного МОП-транзистора
- 52. Устройство и особенности работы IGBT
- 53. По своей внутренней структуре БТИЗ представляет собой каскадное включение двух электронных ключей: входной ключ на ПТ
- 54. IGBT – полностью управляемый п/п-ковый прибор, в основе которого трехслойная структура. Его включение и выключение осуществляются
- 55. Для IGBT с номинальным напряжением в диапазоне 600-4000 В в полностью включённом состоянии прямое падение напряжения,
- 56. Область применения IGBT
- 57. Структуры IGBT а) планарного типа; б) изготовленная по технологии «trench-gate» ("утопленного" канала)
- 58. Структура IGBT планарного типа IGBT содержит p+‒проводящую область с соединением к коллектору ниже n‒зоны
- 59. СТРУКТУРА IGBT Исток Сток Инжекция дырок паразитный тр-тор VЗ>Vпор
- 60. БТ образован слоями p+ (коллектор), n - (база), p + (эмиттер); ПТ ‒ слоями n +
- 61. ВАХ IGBT ток отсечки
- 62. При превышении определенного максимального напряжения К-Э V(BR)CES, происходит лавинный пробой перехода р+‒область/n-‒дрейфовая зона/n+‒эпитаксиальный слой (напряжение пробоя
- 63. Область насыщения (крутой подъем кривой выходной характеристики), также называемая открытым состоянием при переключении. Характер изменения кривой
- 64. Дальнейшее развитие IGBT связано с требованиями рынка и будет идти по пути: ↑ диапазона предельных коммутируемых
- 67. Скачать презентацию




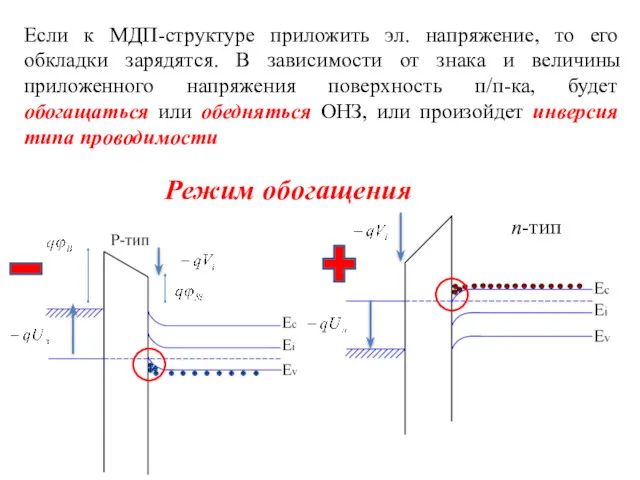
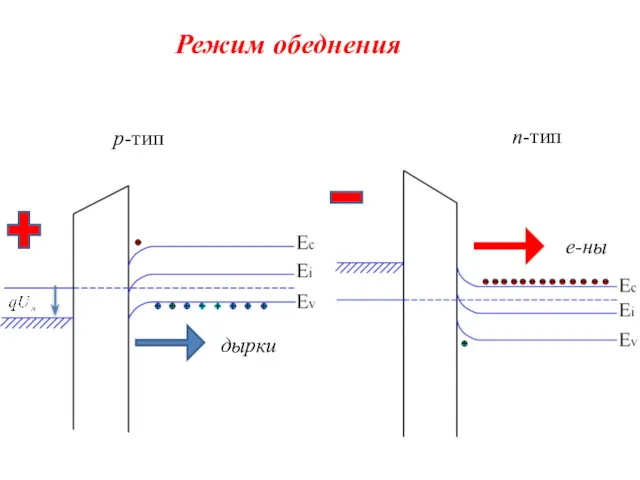
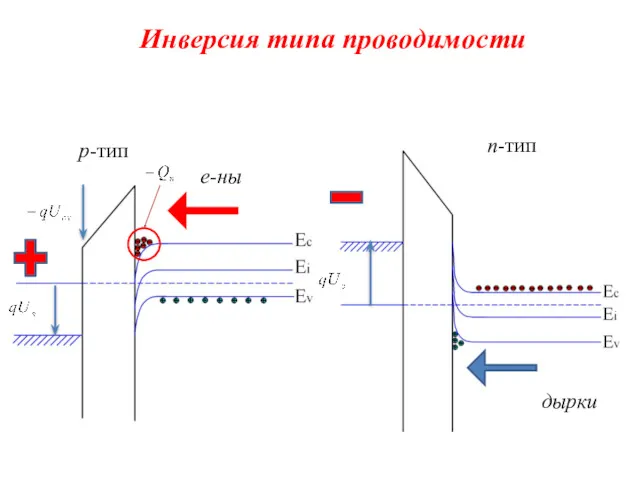





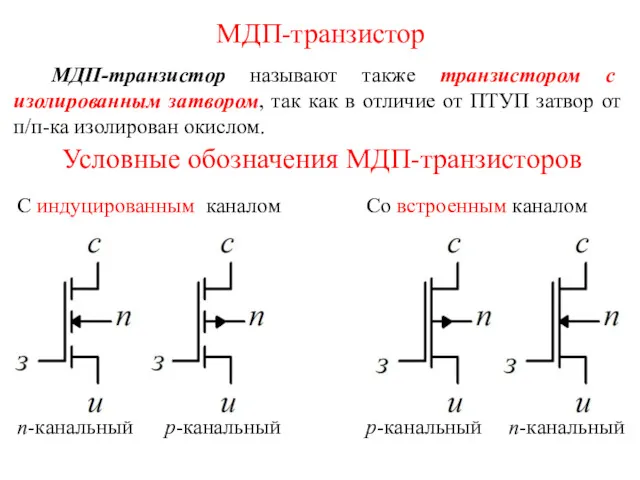


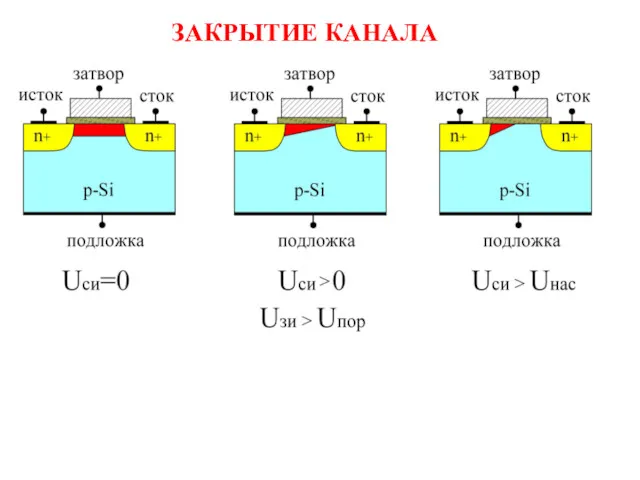





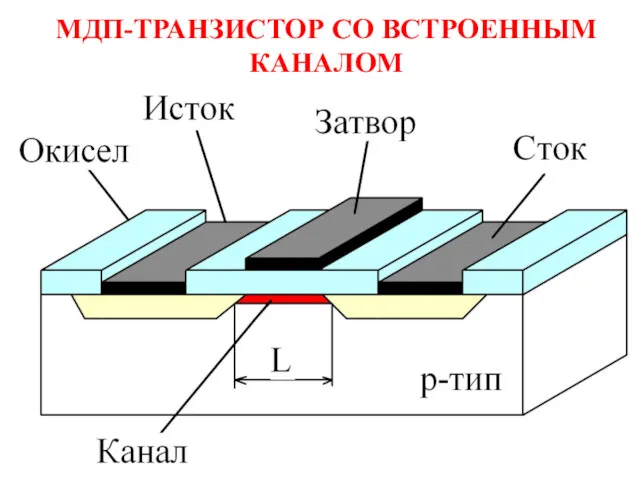


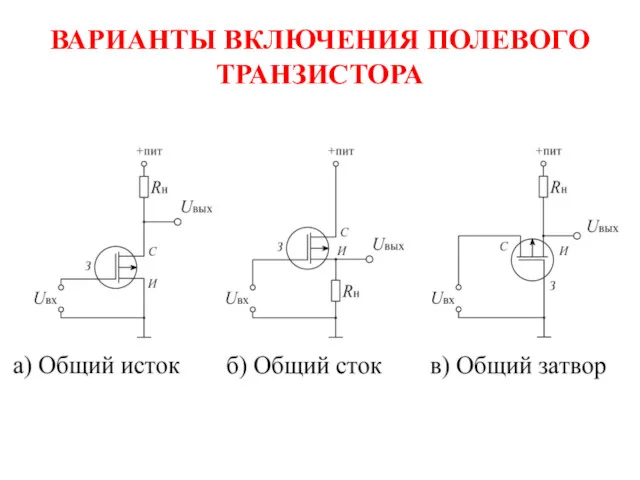







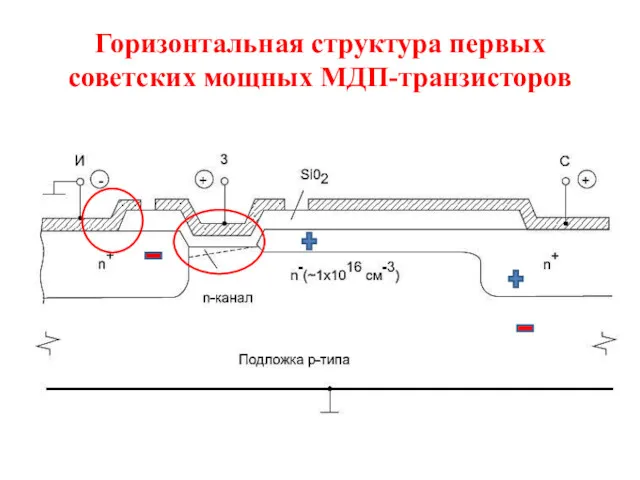
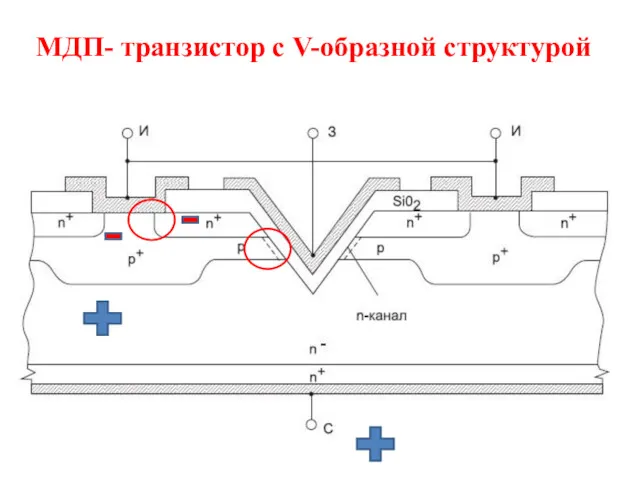

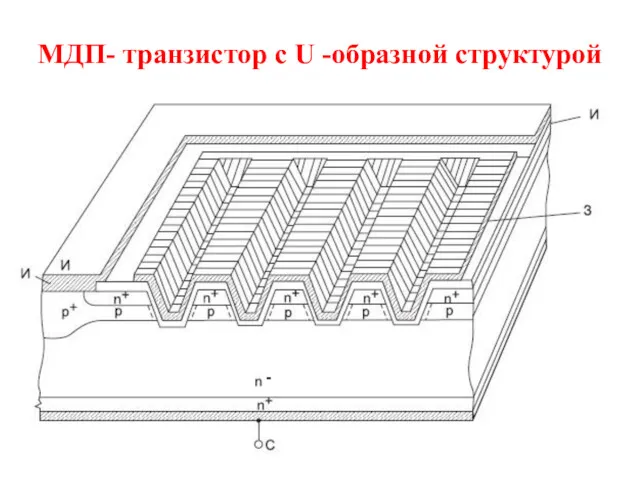
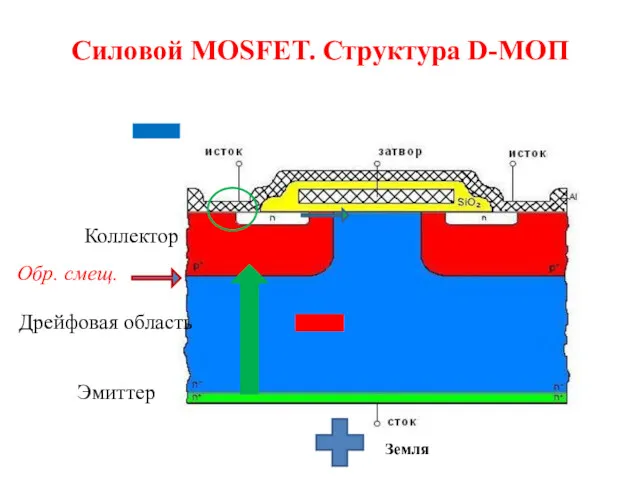








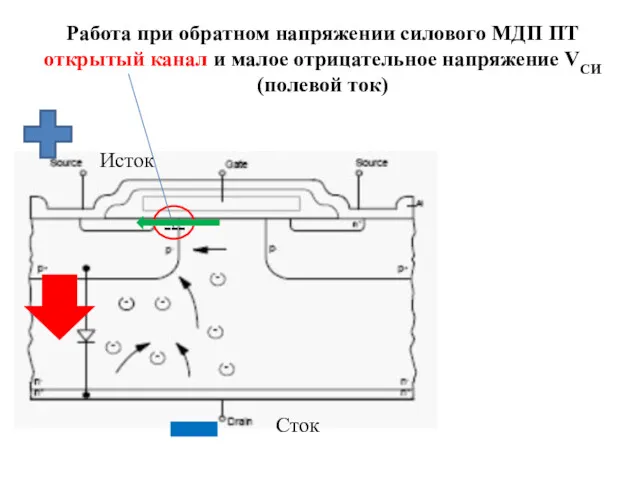



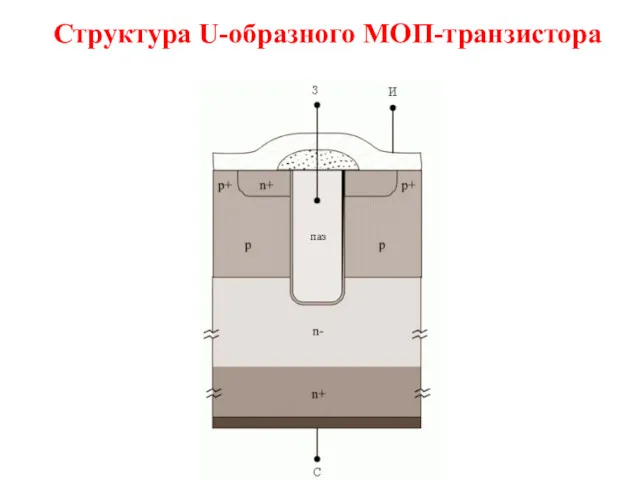


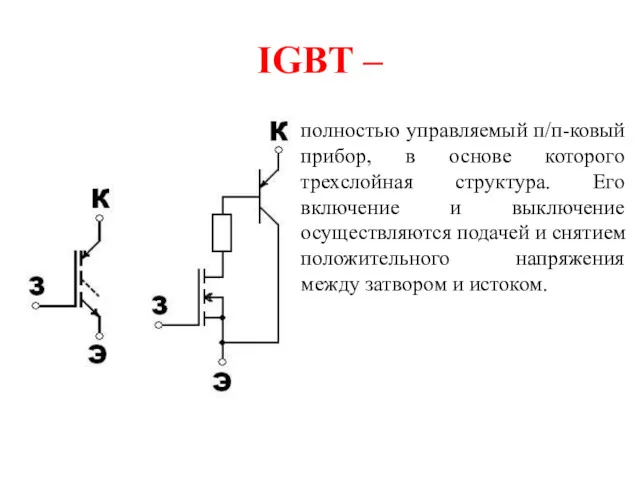


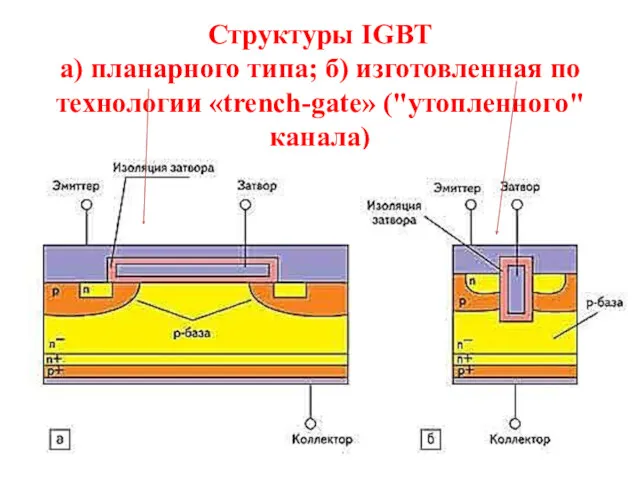
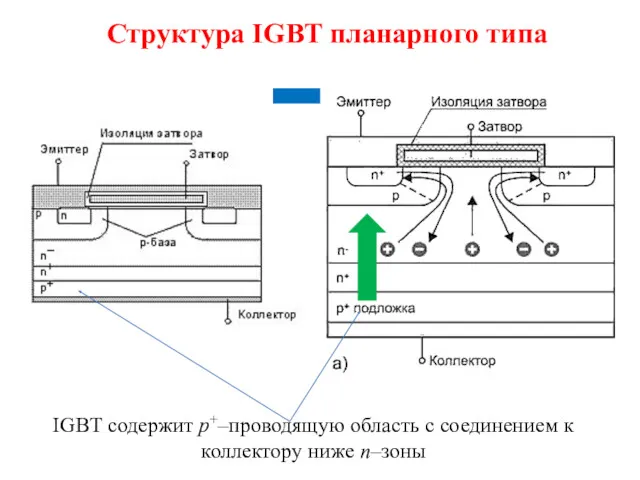
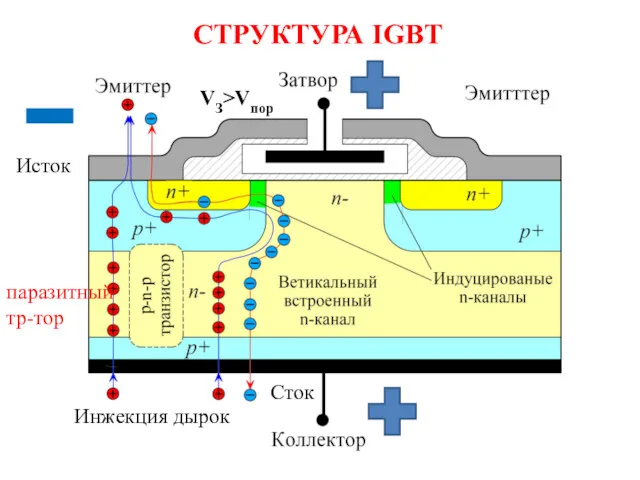

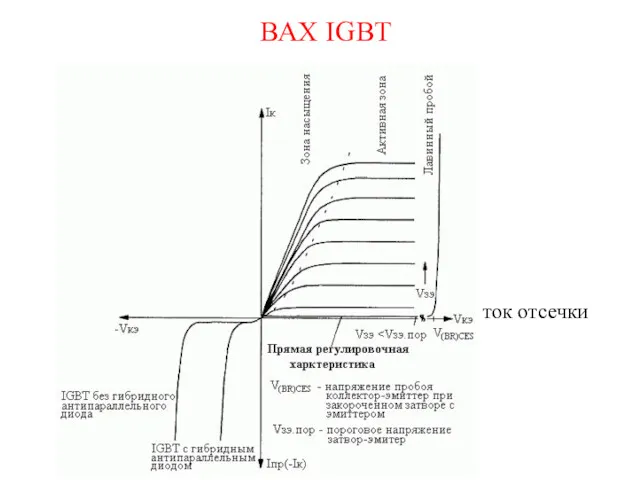



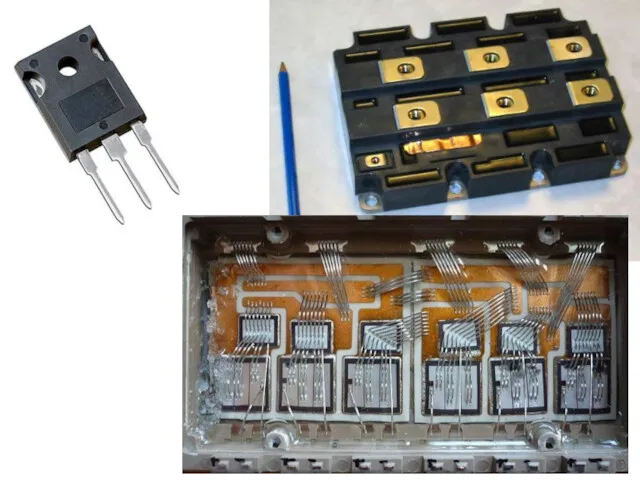
 Характеристика топливно-энергетической базы Крыма
Характеристика топливно-энергетической базы Крыма Вред курения
Вред курения Презентация. Летний оздоровительный лагерь.
Презентация. Летний оздоровительный лагерь. Анализ динамики экономических показателей России и США
Анализ динамики экономических показателей России и США Биосфера. Среды жизни
Биосфера. Среды жизни Аллергия. Аллергены
Аллергия. Аллергены Презентация Заповеди Блаженствпо предмету ОПК
Презентация Заповеди Блаженствпо предмету ОПК Облік, контроль і аналіз непрямих виробничих витрат
Облік, контроль і аналіз непрямих виробничих витрат Конспект внеклассного занятия на тему: Законы жизни класса.
Конспект внеклассного занятия на тему: Законы жизни класса. Внутренние воды РТ
Внутренние воды РТ Формирование культурной среды небольшого города/села
Формирование культурной среды небольшого города/села аналогічні-гомологічні органи
аналогічні-гомологічні органи Организаторская и воспитательная работа командира подразделения по укреплению воинской дисциплины. Тема № 5
Организаторская и воспитательная работа командира подразделения по укреплению воинской дисциплины. Тема № 5 О мерах по поддержки генерирующих объектов на основе ВИЭ. Законодательная база поддержки генерации ВИЭ
О мерах по поддержки генерирующих объектов на основе ВИЭ. Законодательная база поддержки генерации ВИЭ Интернет в жизни старшеклассника: за или против
Интернет в жизни старшеклассника: за или против Тольятти. История любимого города
Тольятти. История любимого города Пейзаж — поэтичная и музыкальная живопись
Пейзаж — поэтичная и музыкальная живопись Особенности рельефа территории России
Особенности рельефа территории России Направления реализации Национальной стратегии по обращению с ТКО и ВМР
Направления реализации Национальной стратегии по обращению с ТКО и ВМР ФЭМП 14.04.2020
ФЭМП 14.04.2020 Логические операторы
Логические операторы Обрезка яблони и груши
Обрезка яблони и груши Проектирование современного урока биологии, географии в соответствии с требованиями ФГОС
Проектирование современного урока биологии, географии в соответствии с требованиями ФГОС Правовое регулирование предпринимательской деятельности
Правовое регулирование предпринимательской деятельности Презентация для детей
Презентация для детей Миотоническая дистрофия Россолимо-Штейнерта-Куршманна-Баттена
Миотоническая дистрофия Россолимо-Штейнерта-Куршманна-Баттена Плотность
Плотность Праздники и календари. Основы мировых религиозных наук (4 класс)
Праздники и календари. Основы мировых религиозных наук (4 класс)