Содержание
- 2. Литография Литографией (греч. lithos - камень), применяемой в производстве ИИЭ, называют процесс формирования геометрического рисунка на
- 3. Получение топологического рисунка На первой стадии процесса изготовления ИС после завершения испытаний или моделирования с помощью
- 4. Формирование ИС Законченные ИС получают последовательным переносом топологического рисунка с каждого шаблона, уровень за уровнем на
- 5. Процесс литографического переноса изображения
- 6. Фотошаблоны. Основные термины Фотошаблон является основным инструментом литографии в планарной технологии. Для изготовления каждой ИС требуется
- 7. Фотошаблоны. Основные термины Маска – плоская пластина или плёнка, содержащая рисунок в виде сквозных окошек и
- 8. Генерация изображения методом микрофотонабора Полученная в результате проектирования ИС информация о топологии в цифровом виде преобразуется
- 9. Схема генератора изображения 1 – источник излучения; 2 – затвор; 3 – конденсор; 4 – блок
- 10. Работа генератора изображения Пучок света от источника направлен сверху вниз. Установка работает с остановками стола в
- 11. САПР 1 ЦНИ 2 Электронно-лучевая установка М1:1 3 Генератор изображения М1:10 (1:5) Комплект промежуточных фотошаблонов 5
- 12. Маршруты изготовления фотошаблонов Маршрут изготовления фотошаблонов выбирают исходя из степени сложности ИС. Чем короче маршрут генерации
- 13. Разновидности фотошаблонов По технологии изготовления фотошаблоны делятся на: - металлизированные – в качестве непрозрачных участков используются
- 14. Фигуры совмещения
- 15. Фоторезисты Фоторезисты – светочувствительные полимерные композиции, в которых под действием света протекают необратимые химические реакции, приводящие
- 16. Характеристики экспонирования резистов
- 17. Кинетика фотохимических реакций Особенностью фотохимических реакций является то, что фотон действует селективно,возбуждая одну молекулу и не
- 18. Реакции, протекающие в резистах 1. Фотолиз – возбуждение молекулы и её распад под действием света: 2.
- 19. Реакции, протекающие в резистах 3. Фотоприсоединение – присоединение активированной молекулой другой молекулы или молекул. 4. Фотосенсибилизация
- 20. Требования к фоторезистам 1. Высокая светочувствительность в требуемом диапазоне длин волн. 2. Высокая разрешающая способность (на
- 21. Схема технологического процесса фотолитографии Фоторезист Нанесение слоя фоторезиста Обработка подложки Подложка Сушка фоторезиста Совмещение и экспонирование
- 22. Обработка пластин Обработка подложек производится с целью: 1. Очистки подложек от загрязнений; 2. Повышения адгезии фоторезиста.
- 23. Удаление поверхностных загрязнений Поверхностные загрязнения удаляют: - механическим способом с помощью кистей и щёток под струёй
- 24. Обработка поверхности слоёв кремния SiO2 и Si3N4 Данные слои не обладают высокой химической активностью. Как правило
- 25. Обработка поверхности металла В технологии ИС для металлизированной разводки, как правило, используют алюминий и его сплавы
- 26. Обработка поверхности фосфоросиликатного стекла ФСС также обладает высокой химической активностью, особенно к щелочным средам. Скорость травления
- 27. Адгезия для фотолитографических процессов Адгезия – способность фоторезиста препятствовать проникновению травителя к подложке по периметру создаваемого
- 28. Обработка, повышающая адгезию фоторезиста Сразу после термического окисления плёнка SiO2 гидрофобна. Через некоторое время на ней
- 29. Нанесение фоторезиста Операция представляет собой процесс создания на поверхности подложки однородного слоя толщиной 1 – 3
- 30. Сушка фоторезиста Способствует окончательному формированию структуры слоя фоторезиста. В процессе сушки из фоторезиста удаляется растворитель и
- 31. Методы совмещения и экспонирования Совмещение и экспонирование Контактная фотолитография Бесконтактная фотолитография Фотолитография на микрозазоре Проекционная фотолитография
- 32. Контактная фотолитография схема совмещения 1 - предметный сто-лик; 2 - подложка; 3 - слой фоторезиста; 4
- 33. Контактная фотолитография схема экспонирования 1 - предметный столик; 2 – подложка; 3 - слой фоторезиста; 4
- 34. Фотолитография на микрозазоре 1 - предметный столик; 2 – подложка; 3 - слой фоторезиста; 4 –
- 35. Схема проекционного экспонирования со сканированием 1 - осветитель; 2 -дугообразная щель; 3 - фотошаблон; 4 -зеркало;
- 36. Проекционная фотолитография без изменения масштаба
- 37. Схема пошаговой мультипликации с уменьшением масштаба УФ 1 - фотошаблон; 2 – проекционный объектив: 3 –
- 38. Проявление фоторезиста Служит для окончательного формирования изображения схемы в плёнке фоторезиста. При этом в зависимости от
- 39. Задубливание Проводят при более высокой температуре, чем сушка. Задубливание обеспечивает: - повышение стойкости маски ФР к
- 40. Пути повышения разрешающей способности фотолитографии Минимальные размеры элементов современных ИИЭ составляют 32 – 65 нм. При
- 41. Эволюция источников УФ излучения
- 42. Фотолитография с фазосдвигающей маской Стекло Хром Фазосдвигающее покрытие На маске На подложке В фото-резисте
- 43. Схема иммерсионной фотолитографии
- 45. Скачать презентацию



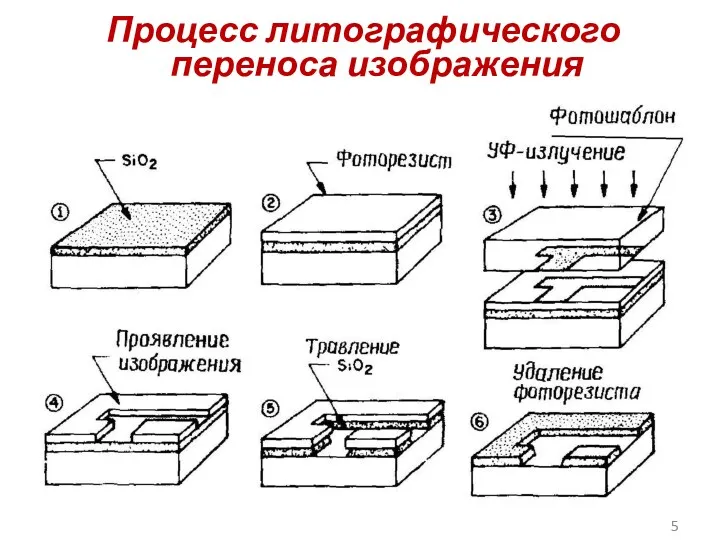


























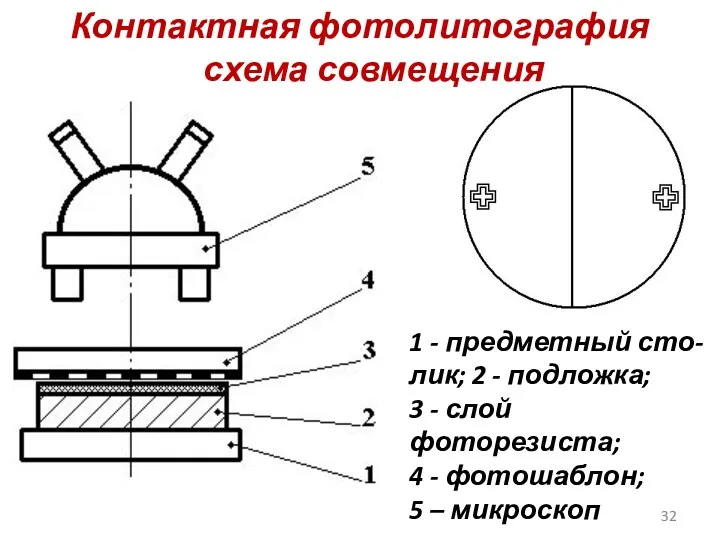
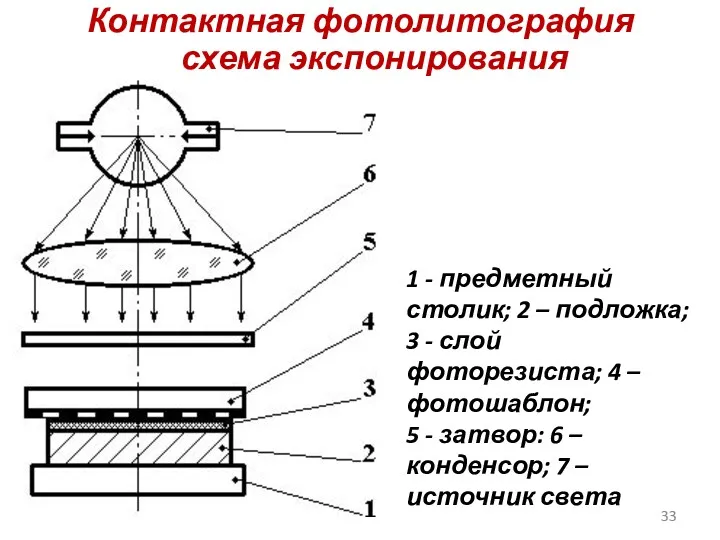



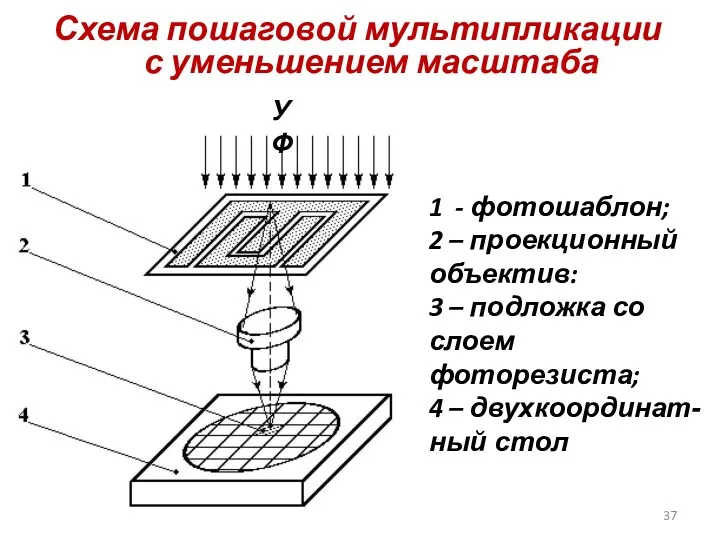




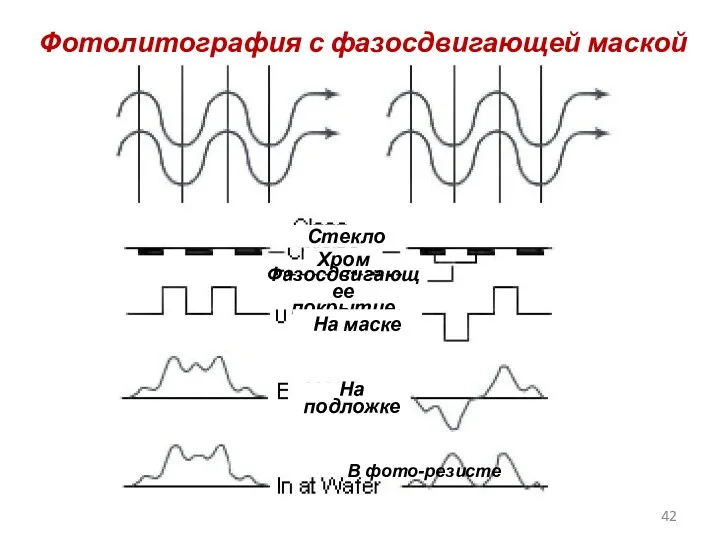

 Неисправности буксовых узлов
Неисправности буксовых узлов Расчет скорости, пути и времени механического движения.
Расчет скорости, пути и времени механического движения. Давление твёрдых тел, жидкостей и газов (решение задач). Физика, 7 класс
Давление твёрдых тел, жидкостей и газов (решение задач). Физика, 7 класс Физические основы механики. Физика в познании вещества, поля, пространства и времени
Физические основы механики. Физика в познании вещества, поля, пространства и времени Лампочка. Принцип работы лампы накаливания
Лампочка. Принцип работы лампы накаливания Следствия из уравнений Максвелла: распространение ЭМВ в пространстве, свойства ЭМВ
Следствия из уравнений Максвелла: распространение ЭМВ в пространстве, свойства ЭМВ Динамика вращательного движения (динамика абсолютно твёрдого тела)
Динамика вращательного движения (динамика абсолютно твёрдого тела) Формирование навыков технического конструирования при изучении простых механизмов как основ двигательных конструкций
Формирование навыков технического конструирования при изучении простых механизмов как основ двигательных конструкций История создания швейной машинки
История создания швейной машинки Механическая работа и мощность. Подготовка к ЕГЭ
Механическая работа и мощность. Подготовка к ЕГЭ Тема урока Последовательное соединение
Тема урока Последовательное соединение Занимательная астрофизика по Н.В. Левашову
Занимательная астрофизика по Н.В. Левашову Техническое обслуживание и текущий ремонт электрооборудования автомобилей Toyota Mark II
Техническое обслуживание и текущий ремонт электрооборудования автомобилей Toyota Mark II Термодинамика и статистическая физика. Явления переноса
Термодинамика и статистическая физика. Явления переноса Холодильные установки. Криогенные жидкости. Компрессоры
Холодильные установки. Криогенные жидкости. Компрессоры Урок по теме: Искусственные спутники Земли, 10 класс
Урок по теме: Искусственные спутники Земли, 10 класс Устройство механической части электровоза 2ЭС10
Устройство механической части электровоза 2ЭС10 Моделирование процессов термомодифицирования древесины
Моделирование процессов термомодифицирования древесины Смесители
Смесители Газовые законы. Урок физики в 10 классе
Газовые законы. Урок физики в 10 классе Гидравлика. Основные свойства жидкостей
Гидравлика. Основные свойства жидкостей Урок с презентацией ИК- и УФ-излучение
Урок с презентацией ИК- и УФ-излучение Капиллярлық құбылыстар
Капиллярлық құбылыстар Магнит тізбектері
Магнит тізбектері Расчет характеристик двигателей приводов
Расчет характеристик двигателей приводов Фотоэффект_ Давление света_ Химическое действие света_ Фотография_ Выполнил_
Фотоэффект_ Давление света_ Химическое действие света_ Фотография_ Выполнил_ Дифракция.
Дифракция. вов 2
вов 2