Содержание
- 2. Простейший полупроводниковый лазер Толщина l определяется через постоянную диффузии D электронов и временем рекомбинации tau: для
- 3. (а) Низкое напряжение дает только слабое световое излучение, б) более высокое напряжение генерирует излучение большей интенсивности.
- 4. Роберт Холл и первый GaAs лазер On the morning of Sunday, September 16, 1962, Robert Hall’s
- 5. Coherent Light Emission From GaAs Junctions R. N. Hall, G. E. Fenner, J. D. Kingsley, T.
- 6. Coherent infrared radiation has been observed from forward biased GaAs p -n junctions. Evidence for this
- 7. Простейший полупроводниковый лазер Показатель преломления GaAs составляет: n = 3,6, коэффициент отражения: R = [ (n
- 9. Зависимость энергии запрещенной зоны от постоянной кристаллической решетки двойных соединений AIII-BV и их растворов
- 10. Схемы лазерных гетероструктур на основе твердых растворов AlAs-GaAs (x1, x2, x3 – значения x в формуле
- 11. Зависимость энергии запрещенной зоны от постоянной кристаллической решетки двойных соединений и их растворов
- 12. Полупроводниковые лазеры с гетероструктурами
- 14. Волноводные свойства гетероструктур
- 15. Полупроводники, используемые в полупроводниковых лазерах, и спектральные диапазоны излучения
- 17. Типы полупроводниковых лазеров лазерные диоды с одной поперечной модой, волноводные лазеры ребристой структуры (англ. ridge wave
- 18. Гетеролазер с полосковым контактом Гетеролазер с полосковым контактом после обработки пучком протонов
- 19. Оптическая схема считывания информации в CD-ROM
- 20. Применявшаяся в первых LPU однолучевая схема довольно скоро была практически полностью вытеснена трехлучевой.
- 21. Локальная (побитовая) запись S~(λ/А)2 λ - длина волны излучения А – числовая апертура (A=n×sin Θ)
- 22. Лазерный видеодиск и CD-диск
- 24. Сравнительный анализ CD и DVD
- 25. Геометрия и плотность записи на CD, DVD и Blu-Ray дисках
- 26. Структурные типы DVD
- 27. Структура DVD-дисков
- 28. Запись информации
- 29. Стирание данных
- 30. Механизм записи
- 31. Метод Чохральского Обычно скорость роста составляет несколько мм в минуту, а вращение обеспечивает получение кристаллов цилиндрической
- 32. Химическая газофазная эпитаксия Эпитаксией называется процесс наращивания монокристаллических слоев на подложку, при котором кристаллическая ориентация наращиваемого
- 33. Схематическое изображение установки для металлоорганической газофазной эпитаксии (а). Двупоточная ГФЭМОС-установка, предложенная Накамурой с соавторами для роста
- 34. Молекулярно-пучковая эпитаксия Схематическое изображение эффузионной ячейки (ячейки Кнудсена)
- 35. Потенциальная яма возникает, когда слой GaAs выращивается между двумя более широкозонными барьерными слоями AlGaAs. Когда ширина
- 36. Изображение волновых функций для четырех нижних уровней энергии (п = 1, 2, 3, 4) одномерной прямоугольной
- 37. Количество электронов N(E) (слева) и плотность состояний D(E) (справа) в зависимости от энергии для четырех типов
- 38. Оптические переходы в КРС
- 39. Квантово-размерная структура
- 40. Многослойная КРС
- 43. Ступенчатый характер распределения плотности состояний, которая конечна даже при минимально возможной энергии, позволяет создать полупроводниковые лазеры
- 45. Зонная диаграмма при прямом смещении 0,66 В и волноводный спектр усиления TE моды (в) для квантовых
- 46. Принцип функционирования SEED-прибора. Под влиянием электрического поля носители освобождаются из квантовой ямы, например, за счет туннелирования
- 47. Генерация сверхкоротких импульсов
- 48. Электрооптические модуляторы света Ячейка Поккельса Минимальное время переключения ~ 1 пс
- 49. Синхронизация продольных мод в резонаторе ω ω
- 50. Методы синхронизации мод Активная синхронизация мод Пассивная синхронизация мод
- 51. Методы генерации сверхкоротких импульсов
- 52. Частота синхронизации мод в современных полупроводниковых лазерах
- 53. Структура лазера типа GRIN-SCH с многослойной квантоворазмерной структурой градиентные слои градиентные слои МКРС
- 55. Экспериментальные данные по получению цуга фемтосекундных импульсов в полупроводниковом лазере с синхронизацией мод (GRIN-SCH-MQW-CPM)
- 56. Временной цуг импульсов GRIN-SCH-MQW-CPM лазера с частотой 1 ТГц
- 57. В общем случае график jth(T) можно разбить на два или три участка: от предельно низких температур
- 58. Формирование квантово-размерных структур Квантовая яма из арсенида галлия на подложке; б) - квантовая проволока и квантовая
- 59. Схема уровней в различных структурах a – объемный материал; b – квантовая яма; c – квантовая
- 60. Структура уровней Дискретные уровни энергии: высокая плотность состояний, слабая зависимость от температуры. КТ КЯ
- 61. Структурная схема лазера на КТ Идеальный ЛКТ состоит из 3D-массива точек одинакового размера и формы. Окружен
- 62. ЛКТ MBE-технология Интеграция слоев квантовых точек в активную зону лазера с двойной гетероструктурой Плотность КТ >1010cm-2
- 63. Преимущества лазера на КТ Длина волны генерации определяется энергетическими уровнями, а не шириной ЗЗ: возможность управлять
- 64. Зависимость длины волны генерации ЛКТ и ЛКСР от температуры
- 67. 1.3 µm Quantum Dots
- 71. Вертикально излучающие полупроводниковые лазеры
- 72. Лазерная связь между чипами
- 73. Линейка выколотых гетеролазеров
- 74. Полупроводниковый лазер с распределенной обратной связью DFB – distributed feedback laser
- 76. Схематическое изображение лазерных структур: a - традиционный полосковый лазер, b - вертикально-излучающий лазер. DBR distributed Bragg
- 78. Вертикально-излучающий лазер (ВИЛ) на двух длинах волн с брэгговскими зеркалами (DBR)
- 79. Схемы электронного и оптического ограничения
- 81. Решетка ВИЛ лазеров
- 82. ВИЛ с плоскими брэгговскими зеркалами
- 83. ВИЛ на модах шепчущей галереи
- 84. Микролазеры
- 85. ВИЛ с активной областью на основе трех слоев квантовых точек InAs/InGaAs.
- 86. Фосфид индия Арсенид галлия Антимонид индия Германий кремний InP Si Кремний – непрямозонный материал Низкая эффективность
- 88. Кремниевый гибридный лазер
- 89. ЗОННАЯ СТРУКТУРА
- 90. ПРОФИЛЬ ПОКАЗАТЕЛЯ ПРЕЛОМЛЕНИЯ
- 92. РЕЗУЛЬТАТЫ ЧИСЛЕННОГО МОДЕЛИРОВАНИЯ
- 94. Литература О.Звелто. Принципы лазеров.-М.:Мир, 1984 Физика полупроводниковых лазеров.- М.:Мир, 1989 Laser Focus World, 2000, Vol. 36,
- 96. Скачать презентацию





























































































 Акустикалық резонанс
Акустикалық резонанс Презентация к уроку физики в 11 классе Модуль вектора магнитной индукции. Закон Ампера.
Презентация к уроку физики в 11 классе Модуль вектора магнитной индукции. Закон Ампера. Физика в профессии Слесарь по ремонту автомобилей
Физика в профессии Слесарь по ремонту автомобилей Световое давление
Световое давление Упругие волны. (Тема 5)
Упругие волны. (Тема 5) Устройство асинхронного двигателя с короткозамкнутым ротором
Устройство асинхронного двигателя с короткозамкнутым ротором Проверочная работа по разделу физики 11 класса Основы астрономии
Проверочная работа по разделу физики 11 класса Основы астрономии Кипение. Удельная теплота парообразования
Кипение. Удельная теплота парообразования Механические колебания
Механические колебания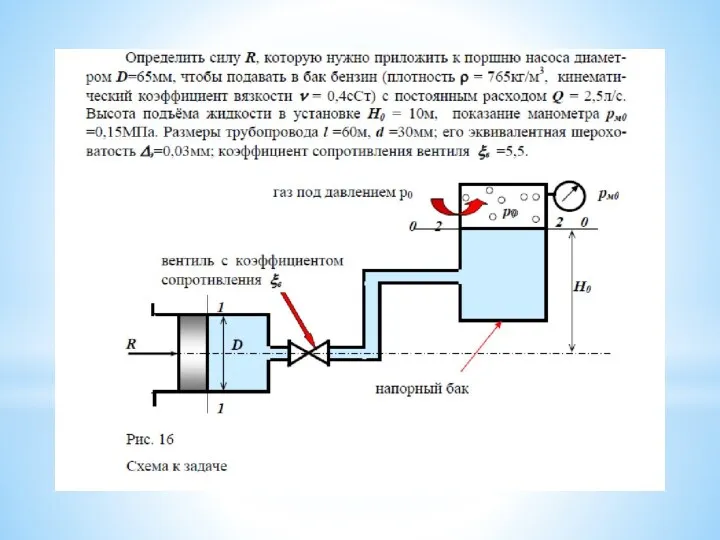 Сила R
Сила R Бұралған білік үшін беріктік шарты
Бұралған білік үшін беріктік шарты Кинематический анализ рычажных механизмов
Кинематический анализ рычажных механизмов Законы постоянного тока
Законы постоянного тока Урок-игра по волновой оптике
Урок-игра по волновой оптике Колебательное движение
Колебательное движение Физическая спартакиада. Игра-соревнование
Физическая спартакиада. Игра-соревнование МЕТОДИКА ИЗУЧЕНИЯ СВОЙСТВ ВЕЩЕСТВА В КУРСЕ ФИЗИКИ В СИСТЕМЕ СРЕДНЕГО ОБРАЗОВАНИЯ ПРИ РЕАЛИЗАЦИИ ФГОС
МЕТОДИКА ИЗУЧЕНИЯ СВОЙСТВ ВЕЩЕСТВА В КУРСЕ ФИЗИКИ В СИСТЕМЕ СРЕДНЕГО ОБРАЗОВАНИЯ ПРИ РЕАЛИЗАЦИИ ФГОС Тест по теме Тепловые явления 8 класс
Тест по теме Тепловые явления 8 класс Введение в физику низкоразмерных структур. Введение. Нанотехнология
Введение в физику низкоразмерных структур. Введение. Нанотехнология Типы оптических спектров. Спектральный анализ
Типы оптических спектров. Спектральный анализ Атомная энергетика. АЭС и ядерное оружие
Атомная энергетика. АЭС и ядерное оружие Развитие взглядов на природу света. Волновые и квантовые свойства света
Развитие взглядов на природу света. Волновые и квантовые свойства света Материальная точка. Система отсчета
Материальная точка. Система отсчета Определение плотности куска хозяйственного мыла. Домашняя лабораторная работа
Определение плотности куска хозяйственного мыла. Домашняя лабораторная работа Разработка комплекса ситуационных заданий по теме школьного курса физики Законы сохранения в механике на основе современных подходов к развитию интеллекта учащихся.
Разработка комплекса ситуационных заданий по теме школьного курса физики Законы сохранения в механике на основе современных подходов к развитию интеллекта учащихся. Зубчатые передачи
Зубчатые передачи Электростатика. Электродинамика
Электростатика. Электродинамика Равновесие в системе пар-жидкость. Перегонка
Равновесие в системе пар-жидкость. Перегонка