Основы технических знаний. Физические основы работы полупроводниковых приборов. Лекция №4 презентация
Содержание
- 2. ФИЗИЧЕСКИЕ ОСНОВЫ РАБОТЫ ПОЛУПРОВОДНИКОВЫХ ПРИБОРОВ
- 3. Энергетические уровни и зоны В соответствии с квантовой теорией энергия электрона, вращающегося по своей орбите вокруг
- 4. Каждой орбите соответствует строго определенная энергия электрона, или энергетический уровень. Энергетические уровни отделены друг от друга
- 5. Согласно принципу Паули на одном энергетическом уровне не может находиться более двух электронов. В невозбужденном состоянии
- 6. Проводники, полупроводники и диэлектрики В твердых телах атомы вещества могут образовывать правильную кристаллическую решетку. Соседние атомы
- 7. Соседние атомы в твердых телах так близко находятся друг к другу, что их внешние электронные оболочки
- 8. Разрешенная зона, в которой при температуре абсолютного нуля все энергетические уровни заняты электронами, называется валентной.
- 9. Разрешенная зона, в которой при температуре абсолютного нуля электроны отсутствуют, называется зоной проводимости. Между валентной зоной
- 10. Ширина запрещенной зоны является основным параметром, характеризующим свойства твердого тела.
- 11. Вещества с полупроводниковыми свойствами На фрагменте периодической таблицы элементы, образующие наиболее распространенные полупроводниковые материалы, выделены синим.
- 12. В полупроводниковой электронике широкое применение получили германий Ge ( ΔW = 0,67 эВ) и кремний Si
- 13. Электроны в твердом теле могут совершать переходы внутри разрешенной зоны при наличии в ней свободных уровней,
- 14. В металлах зона проводимости частично заполнена. Концентрация свободных электронов в металлах практически не зависит от температуры.
- 15. У диэлектриков и полупроводников при температуре абсолютного нуля валентная зона полностью заполнена, а зона проводимости совершенно
- 16. Собственная электропроводность полупроводников Атомы кремния (Si ) располагаются в узлах кристаллической решетки, а электроны наружной электронной
- 17. При температуре абсолютного нуля (T=0K) все энергетические состояния внутренних зон и валентная зона занята электронами полностью,
- 18. При температуре T > 0 К дополнительной энергии, поглощенной каким-либо электроном, может оказаться достаточно для разрыва
- 19. Электроны хаотически движутся внутри кристаллической решетки и представляют собой так называемый электронный газ. Электроны при своем
- 20. У атома полупроводника, от которого отделился электрон, возникает незаполненный энергетический уровень в валентной зоне, называемый дыркой.
- 21. Для простоты дырку рассматривают как единичный положительный электрический заряд. Дырка может перемещаться по всему объему полупроводника
- 22. Таким образом, в кристалле полупроводника при нагревании могут образовываться пары носителей электрических зарядов «электрон – дырка»,
- 23. Процесс образования пары «электрон – дырка» называют генерацией свободных носителей заряда. После своего образования пара «электрон
- 24. В течение времени жизни носители участвуют в тепловом движении, взаимодействуют с электрическими и магнитными полями как
- 25. При T = 0 К все энергетические уровни, находящиеся выше уровня Ферми, свободны.
- 26. При T > 0 К увеличивается вероятность заполнения электроном энергетического уровня, расположенного выше уровня Ферми. Ступенчатый
- 27. Примесная электропроводность полупроводников Электропроводность полупроводника может обусловливаться не только генерацией пар носителей «электрон – дырка» вследствие
- 28. Примеси бывают 1) донорного типа, 2) акцепторного типа.
- 29. Донорные примеси Донор – это примесный атом, создающий в запрещенной зоне энергетический уровень, занятый в невозбужденном
- 30. Пример донорной примеси – сурьма (Sb) (элемент V группы таблицы Менделеева). У атома сурьмы на наружной
- 31. Связь с ядром пятого электрона атома примеси слабее по сравнению с другими электронами. Под действием теплового
- 32. Атом примеси, потеряв один электрон, становится положительно заряженным ионом с единичным положительным зарядом. Он не может
- 33. Таким образом, полупроводник приобретает свойство примесной электропроводности, обусловленной наличием свободных электронов в зоне проводимости. Этот вид
- 34. Уровень Ферми будет смещаться вверх, к границе зоны проводимости Wп . Малейшее приращение энергии электрона приводит
- 35. Акцепторные примеси Акцептор – это примесный атом, создающий в запрещенной зоне энергетический уровень, свободный от электрона
- 36. Если в кристаллическую решетку полупроводника кремния ввести атомы примеси - индия (In) (элемент III группы таблицы
- 37. Одна из связей остается не заполненной. Заполнение этой свободной связи может произойти за счет электрона, перешедшего
- 38. Атом примеси, приобретая лишний электрон, становится отрицательно заряженным ионом, а дырка, образовавшаяся в атоме основного полупроводника,
- 39. Такой тип проводимости называется дырочным и обозначается буквой p (позитивный, положительный тип проводимости), а полупроводник называется
- 40. Орицательно заряженные ионы акцепторной примеси в полупроводнике р-типа не могут перемещаться внутри кристалла, так как находятся
- 41. Вероятность захвата электрона и перехода его в валентную зону возрастает в полупроводниках p-типа, поэтому уровень Ферми
- 43. Способы получения 1. Метод Чохральского SiO2 + 2C → Si + 2CO, Т ~2000°С
- 44. Вид слитка после процесса выращивания
- 45. Метод бестигельной зонной плавки 1-затравка; 2- кристалл; 3- расплавленная зона; 4- исходный материал; 5- стенки герметичной
- 47. Вид монокристалла Si диаметром 200 мм после извлечения из расплава
- 49. Промышленная установка для полировки кремниевых подложек диаметром 300 мм
- 53. а) выпрямительные, высокочастотные, СВЧ, импульсные и диоды Ганна; б) стабилитроны; в) варикапы; г) тоннельные диоды; д)
- 54. Основой плоскостных и точечных диодов является кристалл полупроводника n-типа проводимости, который называется базой. База припаивается к
- 55. Точечные диоды К базе точечного диода подводят вольфрамовую проволоку, легированную атомами акцепторной примеси, и через неё
- 60. Электрические переходы
- 61. Электрическим переходом в полупроводнике называется граничный слой между двумя областями, физические характеристики которых имеют существенные физические
- 62. Различают следующие виды электрических переходов: электронно-дырочный, или p–n-переход – переход между двумя областями полупроводника,имеющими разный тип
- 63. Электронно-дырочный переход Граница между двумя областями монокристалла полупроводника, одна из которых имеет электропроводность типа p, а
- 64. р–n-переход, у которого концентрации дырок и электронов практически равны Nакц = Nдон , называют симметричным. Если
- 65. Несимметричный p–n-переход Каждой дырке в области p соответствует отрицательно неподвижный заряженный ион акцепторной примеси, в области
- 66. Свободные носители электрических зарядов под действием градиента концентрации начинают перемещаться из мест с большой концентрацией в
- 67. Как только дырка из области p перейдет в область n, она оказывается в окружении электронов, являющихся
- 68. После рекомбинации дырки и электрона электрические заряды неподвижных ионов примесей остались не скомпенсированными. Вблизи границы раздела
- 69. Между этими зарядами возникает электрическое поле с напряжённостью E , которое называют полем потенциального барьера, а
- 70. Это электрическое поле начинает действовать на подвижные носители электрических зарядов. Таким образом, в узкой области δ,
- 71. Движение неосновных носителей через p–n-переход под действием электрического поля потенциального барьера обусловливает составляющую дрейфового тока Iдр
- 72. При отсутствии внешнего электрического поля устанавливается динамическое равновесие между потоками основных и неосновных носителей электрических зарядов,
- 73. При отсутствии внешнего электрического поля и при условии динамического равновесия в кристалле полупроводника устанавливается единый уровень
- 74. поскольку в полупроводниках p-типа уровень Ферми смещается к потолку валентной зоны Wвp , а в полупроводниках
- 75. Высота потенциального барьера зависит от концентрации примесей, так как при ее изменении изменяется уровень Ферми, смещаясь
- 76. Вентильное свойство p–n-перехода P–n-переход, обладает свойством изменять свое электрическое сопротивление в зависимости от направления протекающего через
- 77. Прямое включение p–n-перехода Рассмотрим p–n-переход, к которому подключен внешний источник напряжения Uвн, « + » к
- 78. Напряженность электрического поля внешнего источника Eвн будет направлена навстречу напряженности поля потенциального барьера E и, следовательно,
- 80. Высота потенциального барьера снизится, увеличится количество основных носителей, диффундирующих через границу раздела в соседнюю область, образующих
- 81. При увеличении внешнего напряжения прямой ток p–n-перехода возрастает. Основные носители после перехода границы раздела становятся неосновными
- 82. Введение носителей заряда через p–n-переход при понижении высоты потенциального барьера в область полупроводника, где эти носители
- 83. Инжектирующий слой с относительно малым удельным сопротивлением называют эмиттером; слой, в который происходит инжекция неосновных для
- 84. При прямом смещении p–n-перехода потенциальный барьер понижается и через переход протекает относительно большой диффузионный ток.
- 85. Если к р-n-переходу подключить внешний источник с противоположной полярностью «–» к области p-типа, «+» к области
- 86. Напряженность электрического поля источника Eвн будет направлена в ту же сторону, что и напряженность электрического поля
- 87. Ширина запирающего слоя δ увеличивается (δ''>δ), а его сопротивление резко возрастает.
- 89. Через р–n-переход будет протекать очень маленький ток, обусловленный перебросом суммарным электрическим полем на границе раздела, неосновных
- 90. При обратном смещении p–n-перехода потенциальный барьер повышается, диффузионный ток уменьшается до нуля и через переход протекает
- 91. Вольт-амперная характеристика р–n-перехода Вольт-амперная характеристика p–n-перехода – это зависимость тока через p–n-переход от величины приложенного к
- 92. где U - напряжение на p-n-переходе; I0 -обратный (или тепловой) ток, k – постоянная Больцмана, Т
- 93. При прямом напряжении внешнего источника (U > 0) экспоненциальный член быстро возрастает, что приводит к быстрому
- 95. При увеличении прямого напряжения ток р–n-перехода в прямом направлении вначале возрастает относительно медленно, а затем начинается
- 96. Если количество выделяемого при этом тепла будет превышать количество тепла, то могут произойти в полупроводниковой структуре
- 97. При увеличении обратного напряжения, приложенного к р–n-переходу, обратный ток изменяется незначительно, так как увеличение обратного напряжения
- 98. Виды пробоев p–n-перехода Возможны обратимые и необратимые пробои. Обратимый пробой – это пробой, после которого p–n-переход
- 99. Существуют четыре типа пробоя: лавинный, туннельный, тепловой, поверхностный.
- 100. Лавинный и туннельный пробои объединятся под названием – электрический пробой, который является обратимым. К необратимым относят
- 101. Лавинный пробой свойственен полупроводникам, со значительной толщиной р–n-перехода, образованных слаболегированными полупроводниками. Пробой происходит под действием сильного
- 102. Эти носители испытывают со стороны электрического поля р–n-перехода ускоряющее действие и могут разогнаться до такой скорости,
- 103. Происходит резкий рост обратного тока при практически неизменном обратном напряжении.
- 104. Туннельный пробой происходит в очень тонких р–n-переходах, что возможно при очень высокой концентрации примесей N »1019
- 105. Высокое значение напряженности электрического поля, воздействуя на атомы кристаллической решетки, повышает энергию валентных электронов и приводит
- 107. Если обратный ток при обоих видах электрического пробоя не превысит максимально допустимого значения, при котором произойдет
- 108. Тепловым называется пробой р–n-перехода, обусловленный ростом количества носителей заряда при повышении температуры кристалла. С увеличением обратного
- 109. Под действием тепла усиливаются колебания атомов кристалла и ослабевает связь валентных электронов с ними, возрастает вероятность
- 110. Если электрическая мощность в р–n-переходе превысит максимально допустимое значение, то процесс термогенерации лавинообразно нарастает, в кристалле
- 112. Ёмкость р–n-перехода Изменение внешнего напряжения на p–n-переходе приводит к изменению ширины обедненного слоя и, соответственно, накопленного
- 113. Различают барьерную (или зарядную) и диффузионную ёмкость р-n-перехода. Барьерная ёмкость соответствует обратновключенному p–n-переходу, который рассматривается как
- 114. где ε – относительная диэлектрическая проницаемость полупроводникового материала; ε0 – электрическая постоянная; S – площадь p–n-перехода;
- 115. При возрастании обратного напряжения ширина перехода увеличивается и ёмкость Сбар уменьшается.
- 116. Диффузионная ёмкость характеризует накопление подвижных носителей заряда в n- и p-областях при прямом напряжении на переходе.
- 117. Ёмкость Сдиф представляет собой отношение зарядов к разности потенциалов:
- 118. Диффузионная ёмкость значительно больше барьерной, но использовать ее не удается, т.к. она шунтируется малым прямым сопротивлением
- 119. Контакт «металл – полупроводник» Контакт «металл – полупроводник» возникает в месте соприкосновения полупроводникового кристалла n- или
- 120. Под работой выхода электрона понимают энергию, необходимую для переноса электрона с уровня Ферми на энергетический уровень
- 121. В результате диффузии электронов и перераспределения зарядов нарушается электрическая нейтральность прилегающих к границе раздела областей, возникает
- 122. Переходный слой, в котором существует контактное электрическое поле при контакте «металл –полупроводник», называется переходом Шоттки, по
- 123. Контактное электрическое поле на переходе Шоттки сосредоточено практически в полупроводнике, так как концентрация носителей заряда в
- 124. В зависимости от типа электропроводности полупроводника и соотношения работ выхода в кристалле может возникать обеднённый, инверсный
- 125. 1. Aм
- 126. Сопротивление этого слоя будет малым при любой полярности приложенного напряжения, и, следовательно, такой переход не обладает
- 127. 2. Aп
- 128. 3. Aм > Ап , полупроводник n-типа (а). При таких условиях электроны будут переходить из полупроводника
- 129. Создается сравнительно высокий потенциальный барьер, высота которого будет существенно зависеть от полярности приложенного напряжения. Если Aп
- 130. 4. Aп > Ам , полупроводник p-типа (б). Контакт, образованный при таких условиях обладает выпрямляющим свойством,
- 132. Скачать презентацию






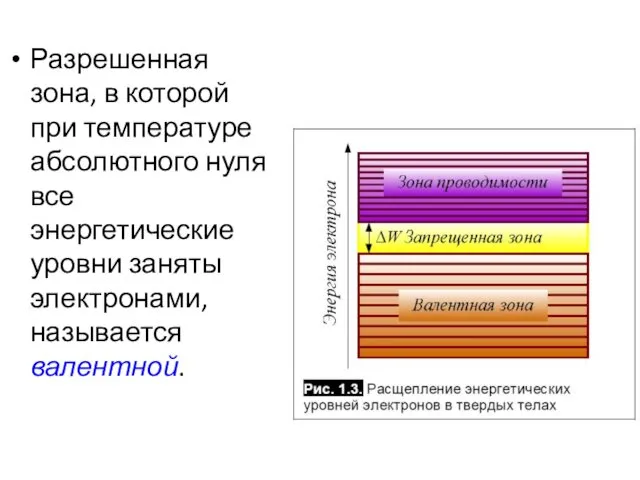
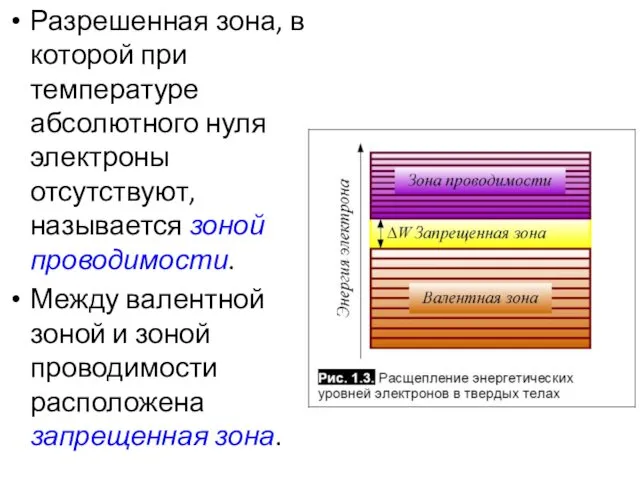















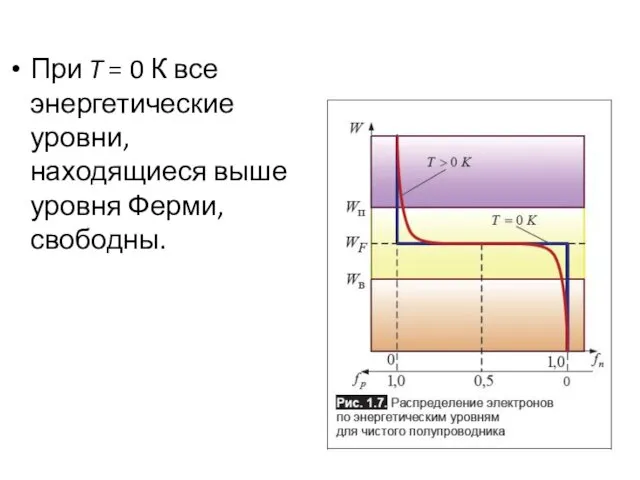



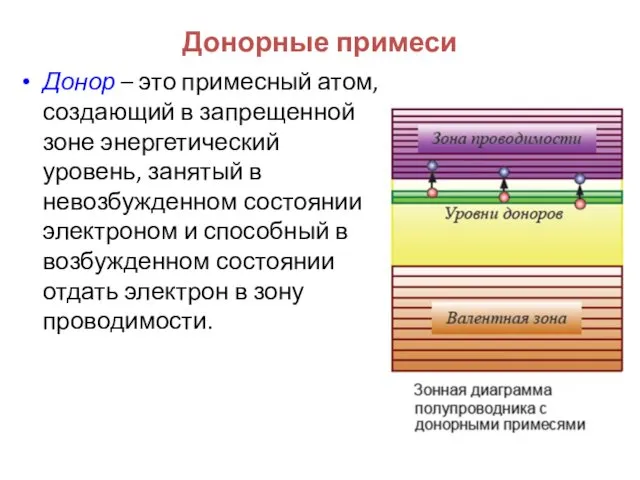











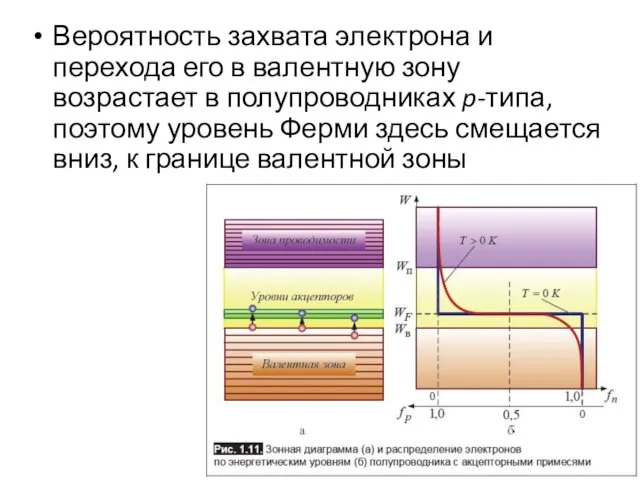






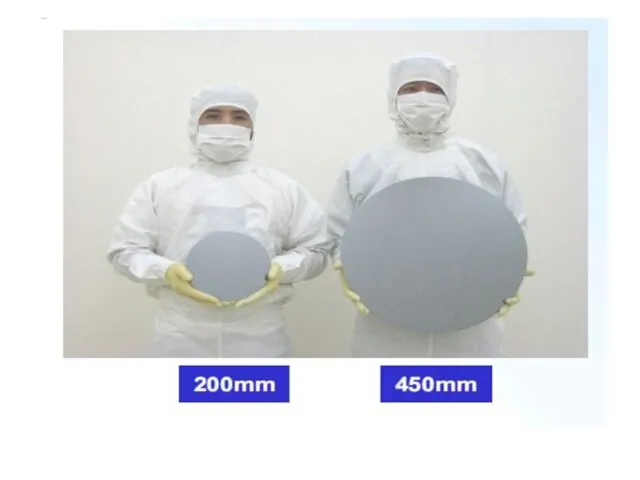




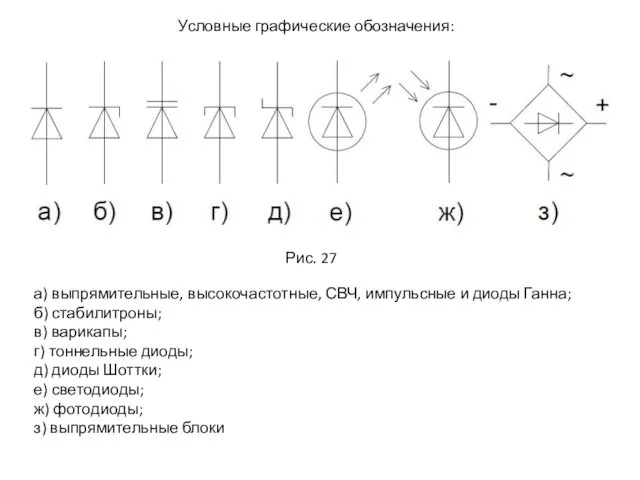
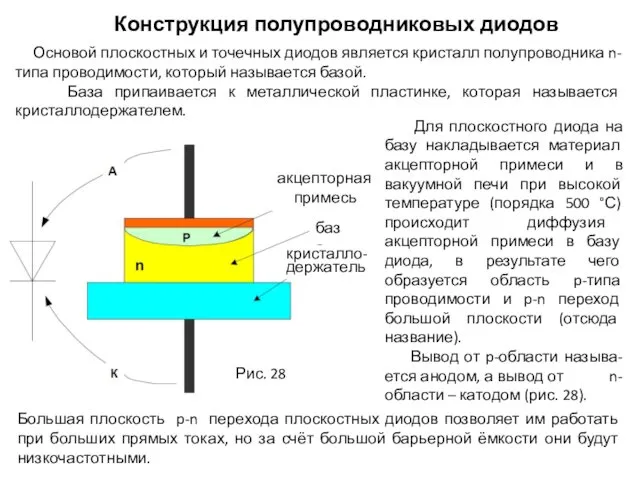




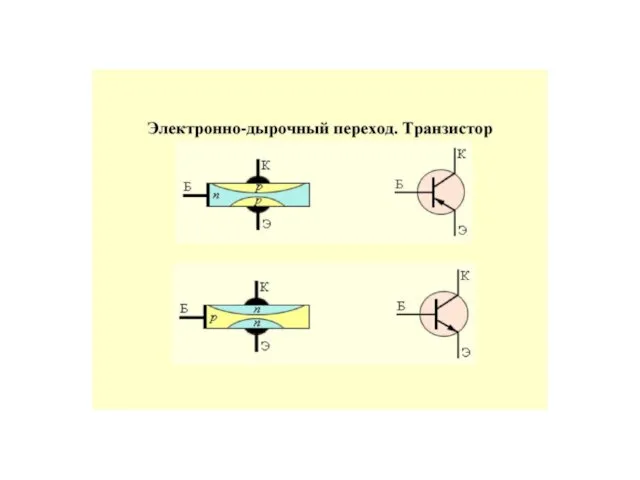








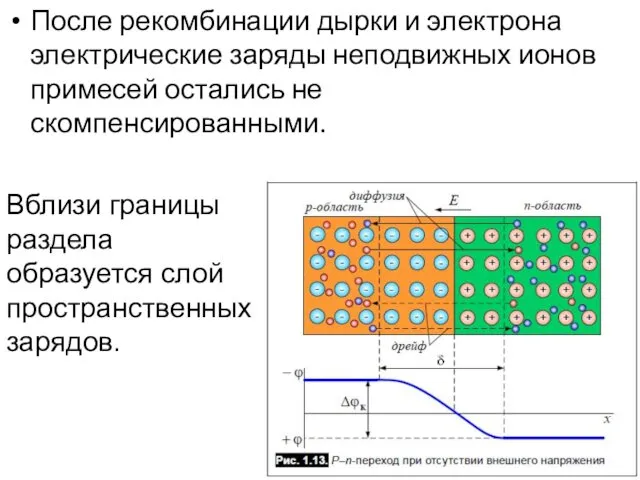
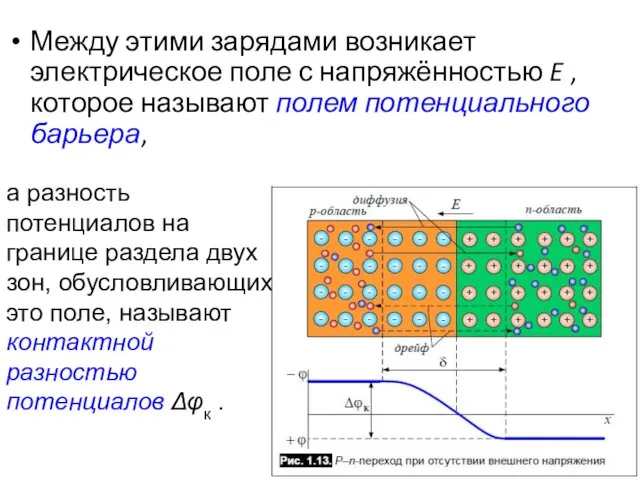

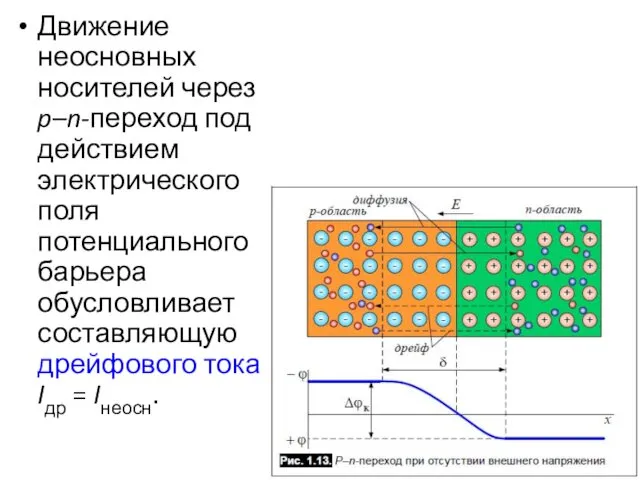

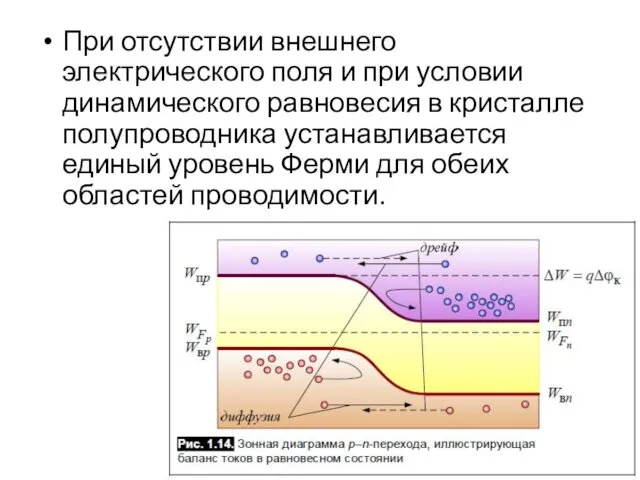



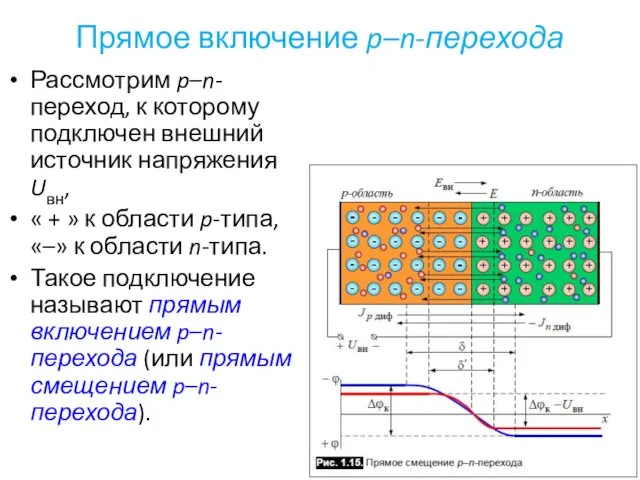
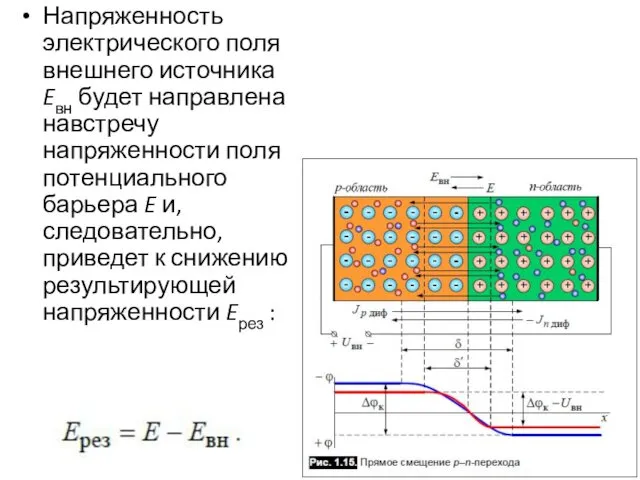
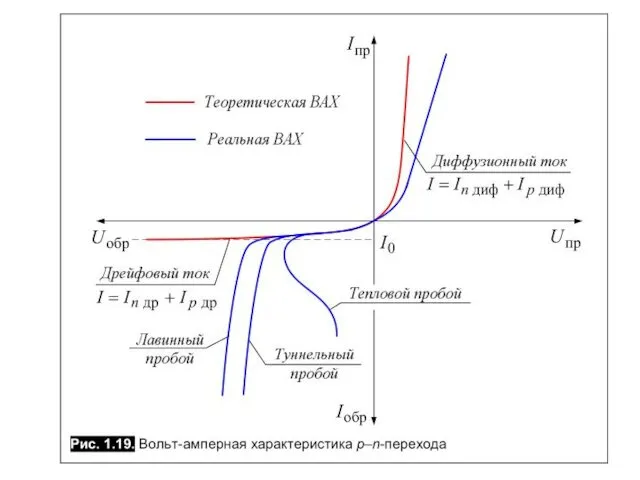





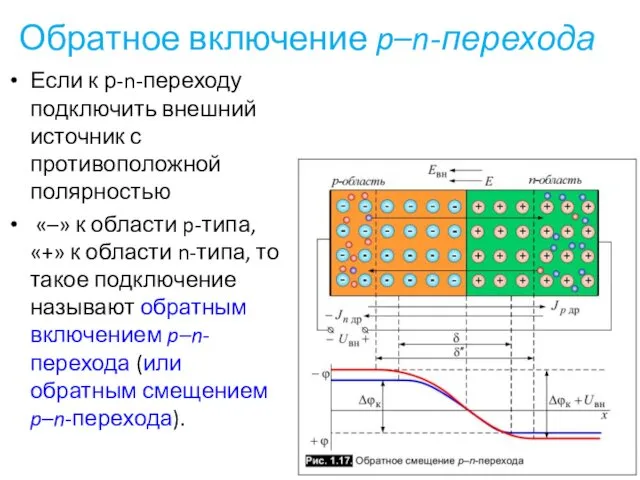

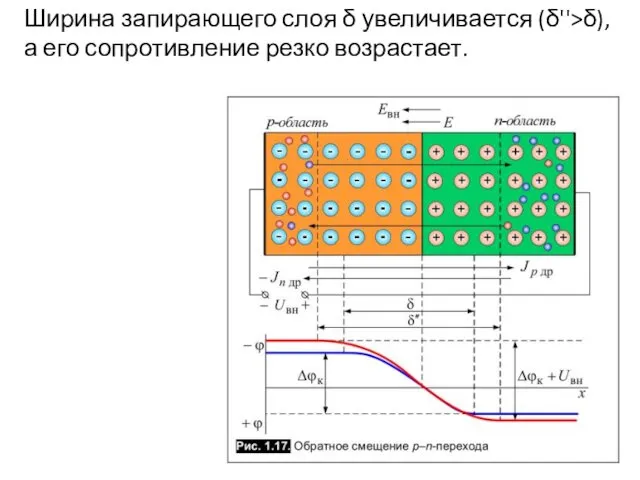
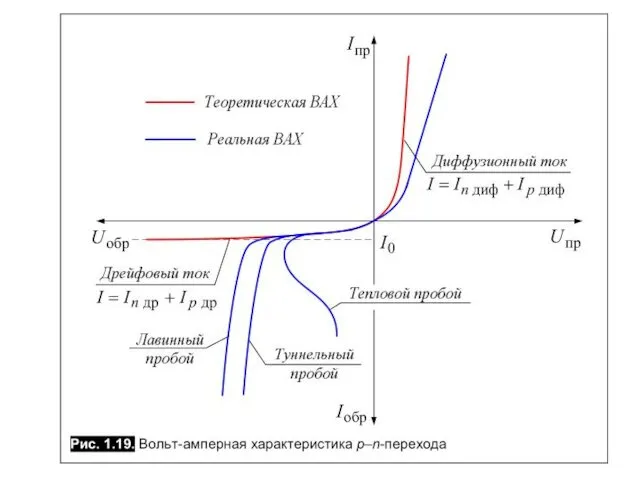

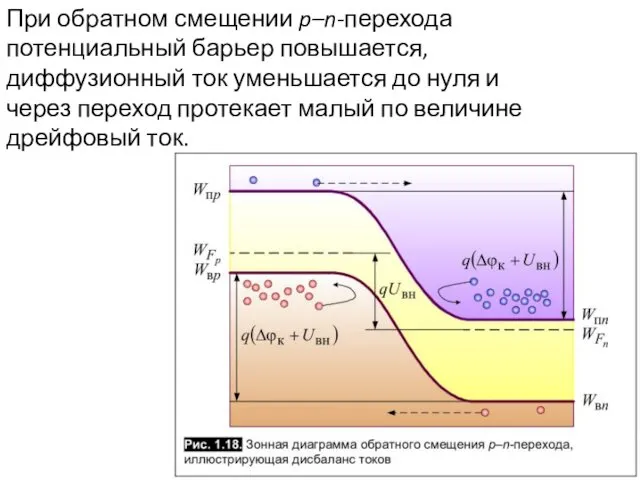



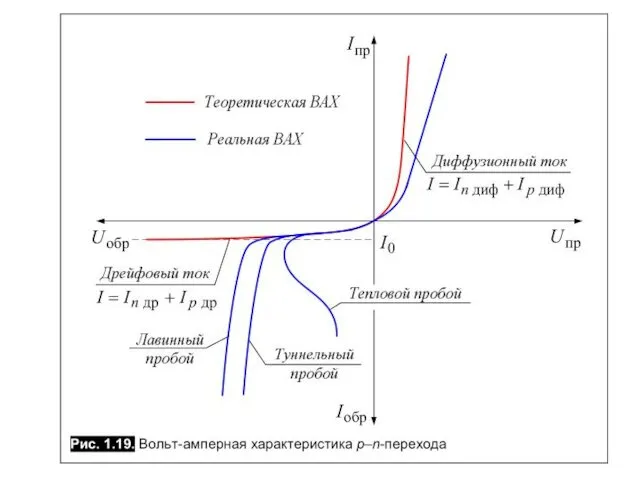











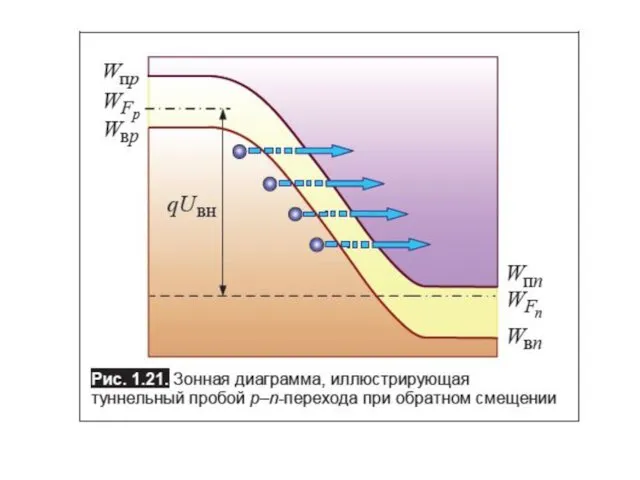
























 Металловедение. Основные типы диаграмм состояния двойных сплавов. (Лекция 4)
Металловедение. Основные типы диаграмм состояния двойных сплавов. (Лекция 4) Сила тока. Урок решения задач. 8 класс.
Сила тока. Урок решения задач. 8 класс. Динамика. Законы Ньютона
Динамика. Законы Ньютона Изобретение радио. Принцип радиосвязи.
Изобретение радио. Принцип радиосвязи. Электрические явления
Электрические явления Фотоаппарат. Виды линз
Фотоаппарат. Виды линз Определение плотности куска мыла. Домашняя лабораторная работа
Определение плотности куска мыла. Домашняя лабораторная работа Электростатическое поле в вакууме и его характеристики
Электростатическое поле в вакууме и его характеристики Сила трения. Силы в природе: сила тяжести и сила упругости
Сила трения. Силы в природе: сила тяжести и сила упругости Механика. Глава 1. Кинематика ---
Механика. Глава 1. Кинематика --- Electric cars
Electric cars Механическое движение
Механическое движение Решение задач по геометрической оптике
Решение задач по геометрической оптике Технология изготовления обтекателя-спойлера для грузового автомобиля Газель методом контактного формования
Технология изготовления обтекателя-спойлера для грузового автомобиля Газель методом контактного формования Презентация Вода
Презентация Вода Слайды. Полупроводниковые материалы. (Лекция 6)
Слайды. Полупроводниковые материалы. (Лекция 6) Механічна робота. Потужність
Механічна робота. Потужність Основні відомості про теорію машин та механізмів
Основні відомості про теорію машин та механізмів Дәріс Электротехника курсына кіріспе
Дәріс Электротехника курсына кіріспе ВКР: Анализ маслосистемы двигателя ПС-90А и её сравнительная характеристика с маслосистемой двигателя SaM-146
ВКР: Анализ маслосистемы двигателя ПС-90А и её сравнительная характеристика с маслосистемой двигателя SaM-146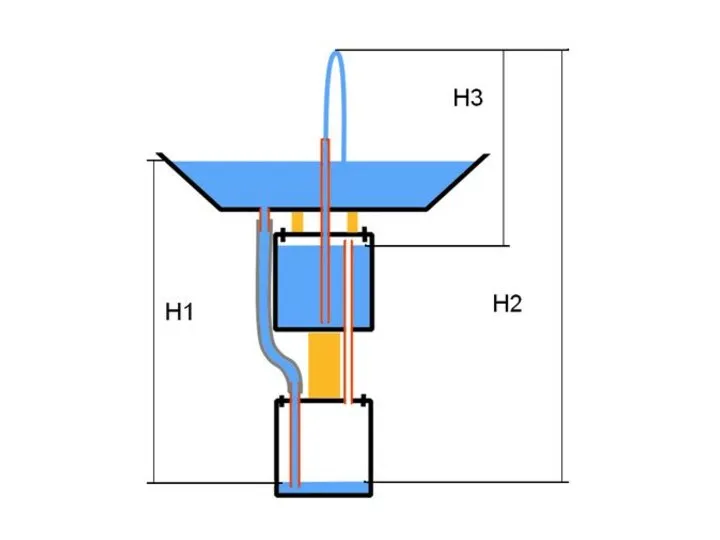 Гидродинамика. Режимы течения жидкости в трубах. Расчет простого трубопровода
Гидродинамика. Режимы течения жидкости в трубах. Расчет простого трубопровода 20240125_ya_i_moy_nastavnik_2_
20240125_ya_i_moy_nastavnik_2_ Закон Паскаля
Закон Паскаля Элективный курс Учимся мыслить 7-11 классы.
Элективный курс Учимся мыслить 7-11 классы. Инжекторный ДВС. Устройство и принцип работы инжекторной системы питания
Инжекторный ДВС. Устройство и принцип работы инжекторной системы питания Кванттық физика тарихы және тарихи деректерді физика пәнін оқытуда қолдану әдістемесін оқыту
Кванттық физика тарихы және тарихи деректерді физика пәнін оқытуда қолдану әдістемесін оқыту Световые явления
Световые явления Электрическое поле. Напряженность и потенциал электрического поля
Электрическое поле. Напряженность и потенциал электрического поля