Содержание
- 2. Содержание Определение понятия «ионное легирование»; Основные параметры процесса; Преимущества использования ионного легирования перед диффузией; Взаимодействие внедряемых
- 3. Ионное легирование Ионное легирование (имплантация) - способ введения атомов примесей в поверхностный слой пластины или эпитаксиальной
- 4. Основные параметры процесса ионного легирования Тип примеси; Доза ионов D, мкКл/см2; Энергия ионов E, кэВ; Угол
- 5. строгое задание количества примеси, определяемого током ионов во время внедрения; воспроизводимость и однородность распределения примеси; возможность
- 6. Взаимодействие ионов с кристаллом Механизмы соударения: А) соударение с электронами (неупругое столкновение); Б) соударение с ядрами
- 7. Основные характеристики процесса имплантации Процесс ионной имплантации - формирование ионных пучков из атомов или молекул, которые
- 8. Во многих случаях для получения необходимого профиля распределения легирующей примеси в подложке применяют метод, основанный на
- 9. Вычисление потерь энергии Средняя длина пробега равна: E0 – начальная энергия иона, Sn (E), Se (E)
- 10. Потери энергии на ядрах атомов При столкновении с ядром атома ион передает ему энергию Т. Тормозная
- 11. Энергия, переданная атому Максимальная энергия при столкновении частиц будет при этом равна: а начальная энергия иона
- 12. Основные положения теории ЛШШ 1 - Твердое тело, в которое внедряются ионы, однородно, изотропно, аморфно (приближение
- 13. Вычисление потерь на ядрах (продолжение) Универсальный вид потерь энергии: Параметр рассеяния: Сечение рассеяния в теории ЛШШ:
- 14. Вычисление потенциала взаимодействия и ядерной тормозной способности Для высоких энергий: Статистическая модель атома Томаса-Ферми: Аппроксимация потенциала
- 15. При малых энергия ионов ядерное торможение растет до максимальных значений: С ростом энергии уменьшается время взаимодействия
- 16. Потери энергии на электронах Теория Фирсова: образование квазимолекулы с непрерывным обменом электронами. Теория Линхарда-Шарфа: совокупность электронов
- 17. Характеристические энергии ионов в кремнии При сложении кривых потерь энергии за счет ядерного и электронного торможения
- 18. Вычисление пробега иона и его проекции Рассеяние только на ядрах (аппроксимация Гиббонсона): Полный пробег иона по
- 19. Связь энергии ионов с проекцией пробега и флуктуацией проекции пробега
- 20. Описание распределений примеси распределения примеси методом Гаусса (нормальное и асимметричное); распределение Пирсон-IV; метод Монте-Карло.
- 21. Нормальное распределение Гаусса Максимум распределения будет лежать при Распределение примеси может быть описано: Связь между длиной
- 22. Асимметричное распределение примеси Величины вычисляются по таблице, рассчитанной Гиббонсоном: Таблица – Значение сопряженных гауссовских функций. Расчет
- 23. Распределение Пирсона-IV Распределение концентрации:
- 24. Метод Монте-Карло Моделируются: траектория иона; пространственное распределение энергии, выделившейся при столкновении каждой частицы; пробеги вторичных ионов.
- 25. Профили распределения основных примесей в кремнии
- 26. Эффект каналирования d - расстояние между атомами вдоль канала. С ростом дозы примеси эффект уменьшается из-за
- 27. Распределение примеси в двухслойной мишени Допущения: -толщина маски большая; -распределение примеси по Гауссу; - пробеги ионов
- 28. Распределение примеси в двухслойной мишени Количество примеси в маскирующем слое: В системе маска / полупроводник кол-во
- 29. Следует отметить, что на границе маска-подложка концентрация примеси будет меняться не плавно, а скачком, т.к. тормозные
- 30. Распыление полупроводника Распыление возможно: -низкие энергии; -большие дозы. Чтобы поверхностный атом покинул решетку необходима энергия выше
- 31. Распыление полупроводника При низких (меньше 1 кэВ) энергиях ионов коэффициент распыления зависит от энергии и массы
- 32. Боковое уширение профиля легирования Маски - диэлектрики: Оксид кремния; Нитрид кремния; Фоторезист. Также поликремний и тугоплавкие
- 33. Радиационные дефекты - точечные дефекты (вакансии V, междоузельные атомы кремния I или примеси IA ); -
- 34. Модели образования аморфной области накопление и слияние мелких аморфных областей; накопление простых дефектов и их коагуляция;
- 35. Распределение дефектов по глубине Число смещенных атомов при энергии иона Е0 равно: При использовании в расчетах
- 36. Распределение примеси при термическом отжиге При не очень высокой дозе внедрения и температуре отжига не выше
- 37. Схема установки для ионного легирования: 1 - источник ионов; 2 - вытягивающий электрод; 3 - фокусирующие
- 39. Контрольные вопросы по четвертой теме: 1. Дайте определение понятию «ионное легирование»? 2. Какие основные параметры процесса
- 40. Список источников литературы по теме: 1. Королев М.А. Технология, конструкции и методы моделирования кремниевых интегральных микросхем:
- 42. Скачать презентацию




































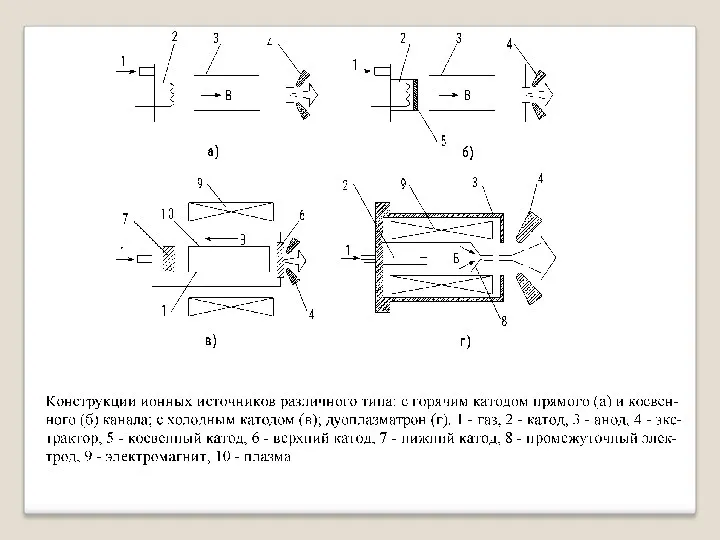


 Текстовая информация
Текстовая информация использование игр на уроке информатики в начальной школе
использование игр на уроке информатики в начальной школе Spatial Data Structures
Spatial Data Structures Применение ИКТ на уроках музыки
Применение ИКТ на уроках музыки Людина у світі інформації
Людина у світі інформації Организация вычислений в электронных таблицах. Обработка числовой информации в электронных таблицах. Информатика. 9 класс
Организация вычислений в электронных таблицах. Обработка числовой информации в электронных таблицах. Информатика. 9 класс Презентация Решение олимпиадных задач. Игра Баше
Презентация Решение олимпиадных задач. Игра Баше Социальные сети для бизнеса
Социальные сети для бизнеса Testing Throughout the Software Life Cycle: Test Levels. Types of Software Testing (Topic 4)
Testing Throughout the Software Life Cycle: Test Levels. Types of Software Testing (Topic 4) Включение системы. Настройка и контроль системы перед отправлением
Включение системы. Настройка и контроль системы перед отправлением Онлайн-кассы
Онлайн-кассы Шаблоны параллельного проектирования
Шаблоны параллельного проектирования 9 класс Презентации к урокам
9 класс Презентации к урокам Управление данными
Управление данными Инновационный проект
Инновационный проект Основы логики.
Основы логики. Общие и отличительные свойства объектов
Общие и отличительные свойства объектов Основы теории коммуникации
Основы теории коммуникации Киберспорт - это спорт?
Киберспорт - это спорт? HTML программалау тілі
HTML программалау тілі Графический редактор Paint
Графический редактор Paint Объекты JavaScript
Объекты JavaScript Ақпараттық қауіпсіздікті қамтамасыз ету комплексті тәсілі. Ақпараттық қауіпсіздік негізгі ұғымдары
Ақпараттық қауіпсіздікті қамтамасыз ету комплексті тәсілі. Ақпараттық қауіпсіздік негізгі ұғымдары Формализация понятия алгоритма
Формализация понятия алгоритма Культура использования информации. Библиографическое оформление результатов поиска информации
Культура использования информации. Библиографическое оформление результатов поиска информации Solid - принципы с примерами PHP
Solid - принципы с примерами PHP Организация интернет-СМИ
Организация интернет-СМИ Разработка информационного обеспечения для поддержки деятельности предприятия сферы услуг
Разработка информационного обеспечения для поддержки деятельности предприятия сферы услуг