Апробация
Гладких А.А. и др. Оптимизация плотности заполнения топологии слоев СБИС,
направленная на повышение стабильности технологического процесса химико-механической планаризации. – М.: НИИСИ РАН, Математическое и компьютерное моделирование систем: теоретические и прикладные аспекты, 2009. – стр. 50-55.
Гладких А.А. Моделирование процесса химико-механической планаризации диоксида кремния при формировании межслойной изоляции. Информатика и системы управления в XXI веке: Сборник трудов №7 молодых ученых, аспирантов и студентов – М.: МГТУ им. Н.Э. Баумана, 2009. – стр. 54-70. ISBN 978-5-7038-3427-5
Гладких А.А. Временная оптимизация модели ХМП с учетом распределения скорости планаризации по кремниевой пластине. – М.: МГТУ им. Баумана, 12-я Молодежная международная научно-техническая конференция «Наукоемкие технологии и интеллектуальные системы 2010», 2010. – стр. 214-223.
Гладких А.А. Алгоритм расчета локальной плотности заполнения топологии субмикронных СБИС для оптимального размещение dummy-структур. – М.: Издательство МГТУ им. Баумана, Сборник трудов Третьей Всероссийской Школы-семинара студентов, аспирантов и молодых ученых по направлению «Наноинженерия», 2010. – стр. 256-267. ISBN 978-5-7038-3453-4
Работа отмечена дипломом
I-степени на конференции «Наукоемкие технологии и интеллектуальные системы 2010»

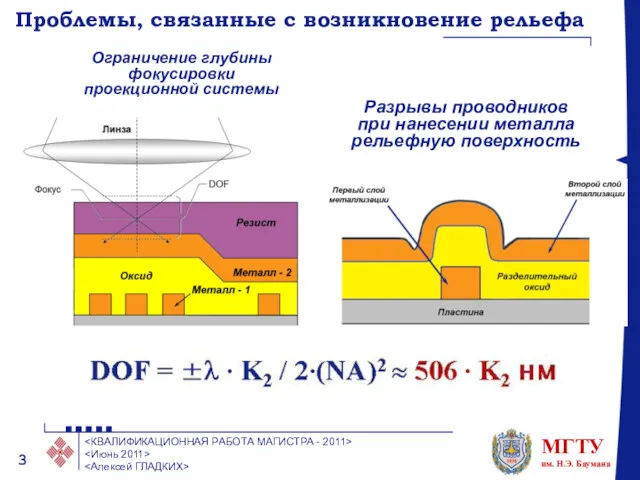
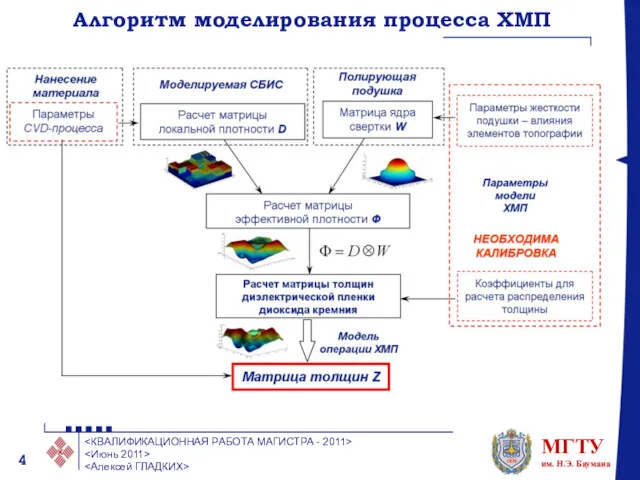


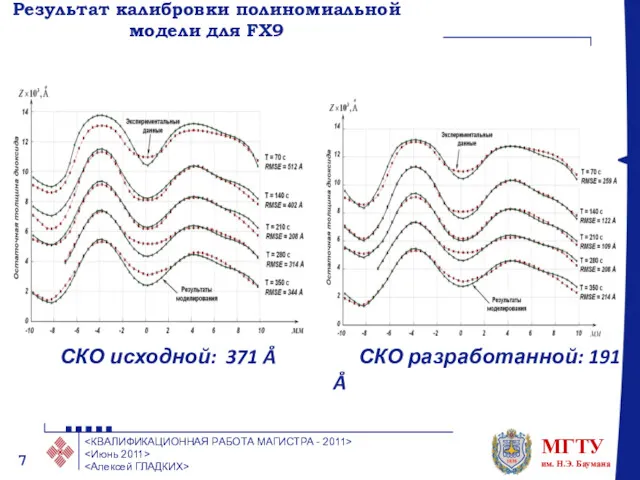
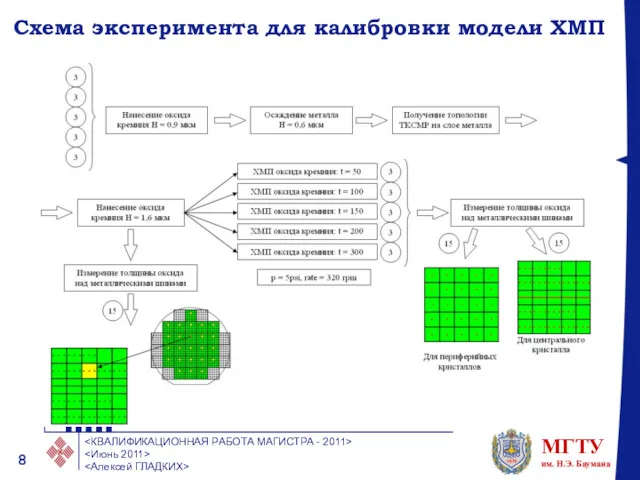

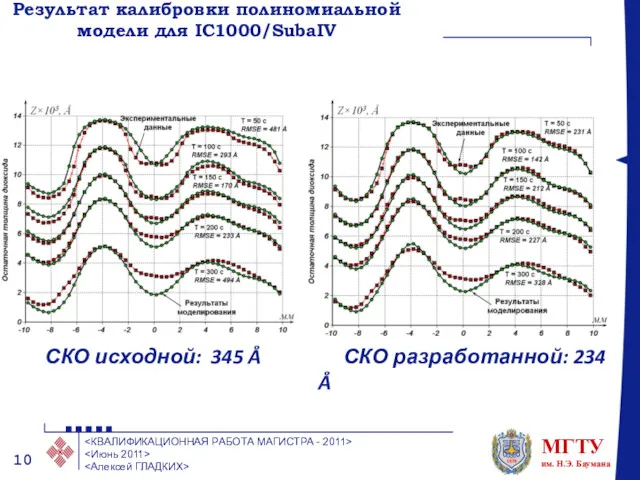




 Электронды есептеуіш машиналардың аналогтық және цифрлық. Ақпаратты өңдеудің ақпараттық және бағдарламалық тәсілдері
Электронды есептеуіш машиналардың аналогтық және цифрлық. Ақпаратты өңдеудің ақпараттық және бағдарламалық тәсілдері Виртуальное и реальное общение в современном мире
Виртуальное и реальное общение в современном мире Компьютерные технологии. Лекция №7. Web-программирование: Django. Часть 2
Компьютерные технологии. Лекция №7. Web-программирование: Django. Часть 2 Растровая и векторная графика
Растровая и векторная графика Создание списков различных видов в HTML документе
Создание списков различных видов в HTML документе Интеллектуальные информационные системы. Классификация интеллектуальных информационных систем
Интеллектуальные информационные системы. Классификация интеллектуальных информационных систем Использование ИКТ в учебно-воспитательном процессе
Использование ИКТ в учебно-воспитательном процессе Паблицитный капитал = капитал публичности
Паблицитный капитал = капитал публичности MS Word. Введение. Основы интерфейса
MS Word. Введение. Основы интерфейса Все на поиск терминов. Компьютерный турнир
Все на поиск терминов. Компьютерный турнир FLEX Application Instructions Program Year 2018-2019
FLEX Application Instructions Program Year 2018-2019 Урок играИнфостарты
Урок играИнфостарты Презентация по информатике 6 класс Компьютер - универсальная машина для работы с информацией
Презентация по информатике 6 класс Компьютер - универсальная машина для работы с информацией Составные типы данных
Составные типы данных Решения ЦРТ для промышленных предприятий
Решения ЦРТ для промышленных предприятий Ақпарат және ақпараттық үрдістер
Ақпарат және ақпараттық үрдістер САПР технологических процессов. Введение. Лекция 1
САПР технологических процессов. Введение. Лекция 1 Список литературы
Список литературы Табличные модели. Информационное моделирование на компьютере
Табличные модели. Информационное моделирование на компьютере Файлы. Функции для работы с файлами
Файлы. Функции для работы с файлами Использование проектного подхода и хакатонов в качестве инструментов ускорения внедрения новых технологий в учебный процесс
Использование проектного подхода и хакатонов в качестве инструментов ускорения внедрения новых технологий в учебный процесс Цветовые модели. Формирование цветовых оттенков на экране монитора и при печати изображений
Цветовые модели. Формирование цветовых оттенков на экране монитора и при печати изображений Методология IDEF1X. Методология IDEF3
Методология IDEF1X. Методология IDEF3 Справочно-библиографический аппарат Колмовской библиотеки, Великий Новгород
Справочно-библиографический аппарат Колмовской библиотеки, Великий Новгород Программирование ветвлений на паскале
Программирование ветвлений на паскале Алгоритмизация и программирование
Алгоритмизация и программирование Информационные системы на кластерах
Информационные системы на кластерах Кодирование звуковой информации
Кодирование звуковой информации