Содержание
- 2. Технологические операции Выращивание кристалла; Механическая обработка (резка, шлифовка, полировка); Выращивание слоев (химическое осаждение, толстопленочная и тонкопленочная
- 3. Интегральная микросхема (ИС) – конструктивно законченное микроэлектронное изделие, выполняющее определенную функцию преобразования или хранения информации, содержащее
- 4. Полупроводниковая (монолитная) микросхема – микросхема, все элементы и межэлементные соединения которой выполнены в объеме и на
- 5. В гибридной микросхеме пассивные элементы и межэлементные соединения изготавливаются на поверхности диэлектрической подложки по пленочной технологии,
- 6. Совмещенная микросхема. Активные элементы формируются в слое полупроводниковой пластины, а пассивные на ее поверхности по пленочной
- 7. Интегральные микросхемы
- 8. Пленочная микросхема – микросхема, все элементы и межэлементные соединения которой выполнены только в виде пленок проводящих
- 9. Структура гибридной ИС
- 10. Резисторы
- 11. Конденсаторы
- 12. Индуктивности
- 13. Структура биполярного транзистора с изоляцией обратносмещенным p-n переходом
- 14. Совокупность областей с одинаковыми электрофизическими свойствами, толщиной и расположением по отношению к поверхности подложки называют слоем
- 15. Резисторы
- 16. Конденсаторы
- 17. Биполярные транзисторы: а - изготовленный по изопланарной технологии; б – с изоляцией V-образными канавками
- 18. МДП-транзисторы
- 19. МДП-транзисторы
- 20. МДП-транзисторы
- 21. Три основные цели, на достижение которых направлены усилия разработчиков: Воспроизводимость (воспроизводимость процессов, качество материалов, чистота); Экономичность;
- 25. фотошаблоны структура
- 26. Изготовление биполярной ИС с изоляцией транзисторов p-n-переходом
- 27. Создание скрытого коллекторного слоя Обработка поверхности пластины кремния p -типа Окисление Фотолитография – формирование рисунка в
- 28. Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из источника неограниченной мощности) Окисление с разгонкой
- 29. Создание глубокого коллектора Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из источника неограниченной мощности)
- 30. Создание базы Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из источника неограниченной мощности) Окисление
- 31. Создание эмиттера Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из источника неограниченной мощности) Окисление
- 32. Создание металлизации Фотолитография – вскрытие окон в оксиде для создания контактов к областям Напыление алюминия с
- 33. Изготовление КМОП ИС
- 34. Формирование p-кармана Обработка поверхности пластины кремния n -типа Окисление Фотолитография – формирование рисунка в оксиде Загонка
- 35. Формирование затворов Фотолитография – формирование рисунка в оксиде Окисление – получение подзатворного диэлектрика Осаждение поликремния Фотолитография
- 36. Формирование стоков, истоков и охранных колец Удаление тонкого окисла Фотолитография – n-канальные транзисторы закрываются фоторезистом Загонка
- 38. Скачать презентацию





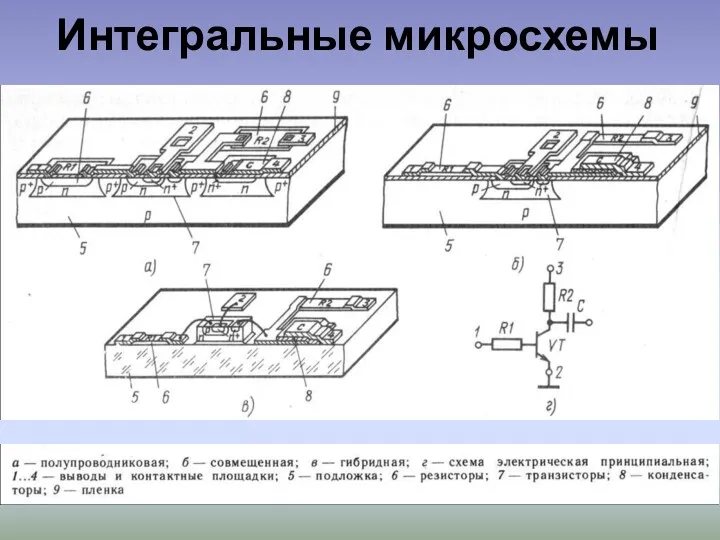



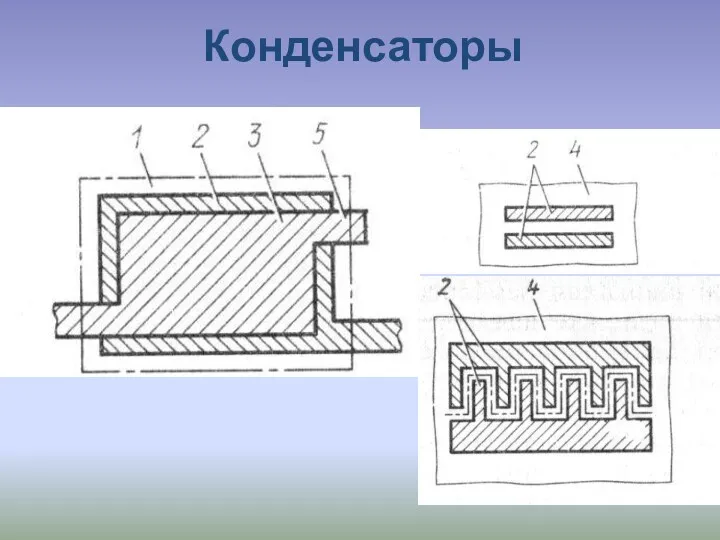



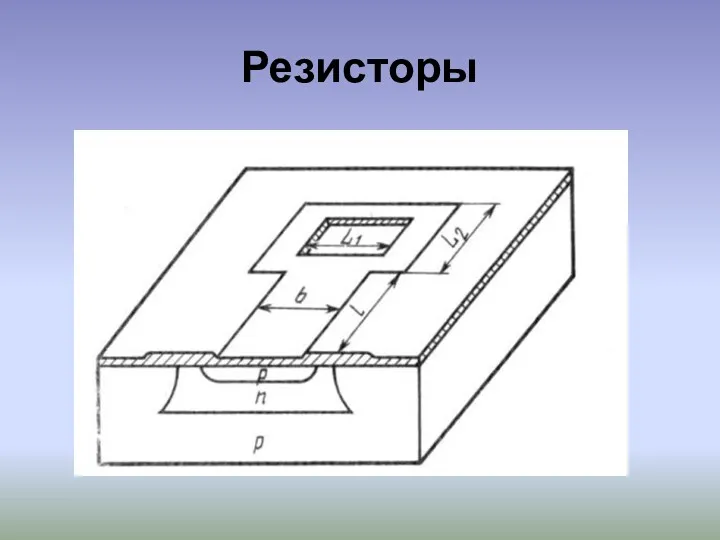
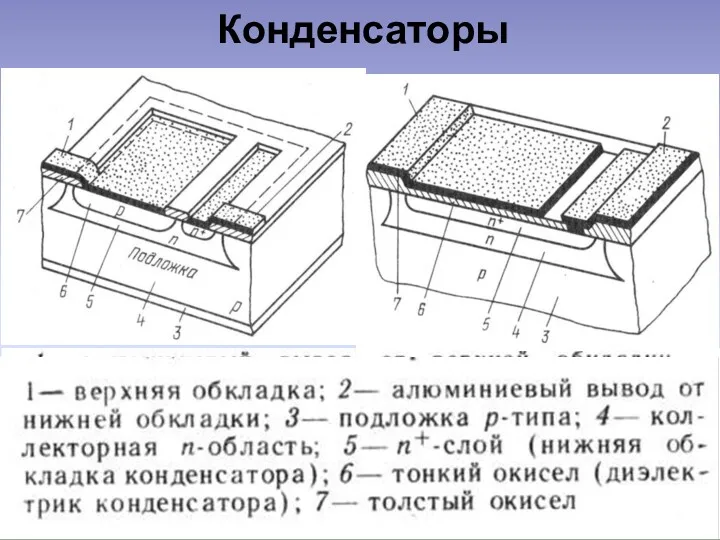
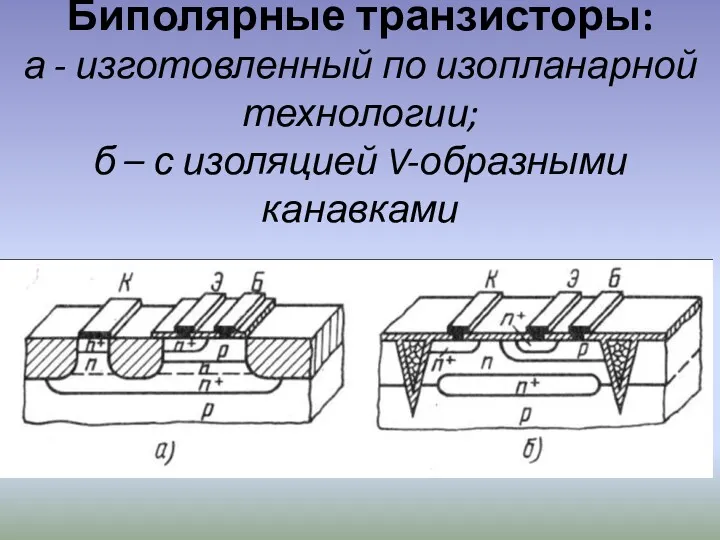


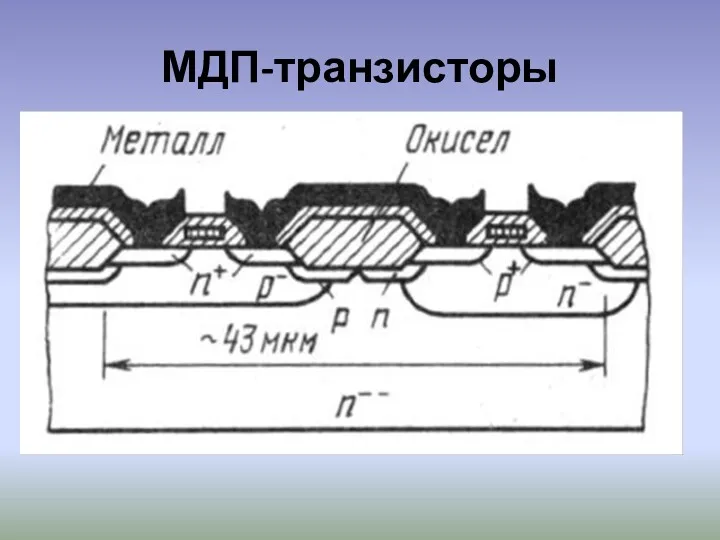


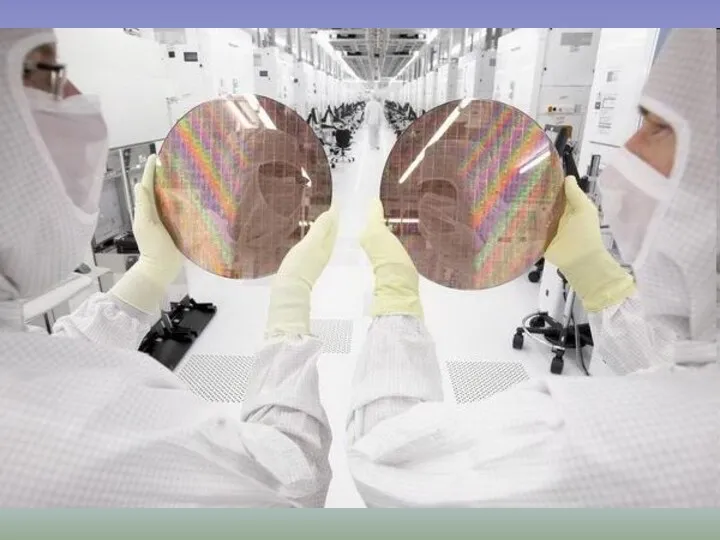
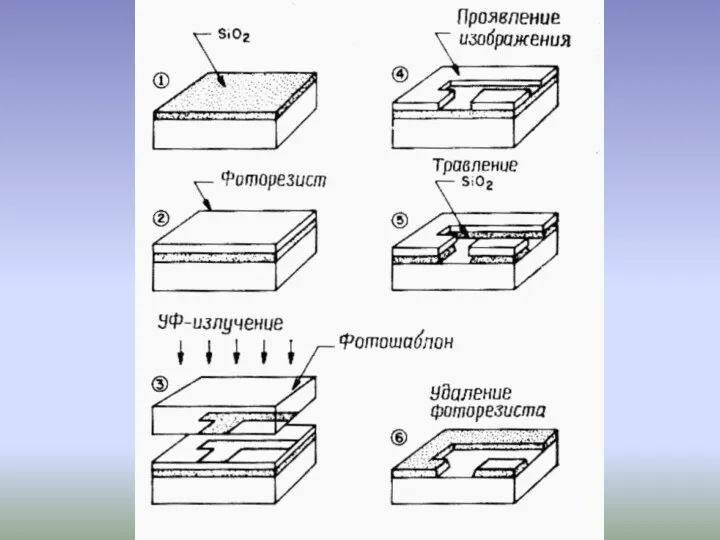
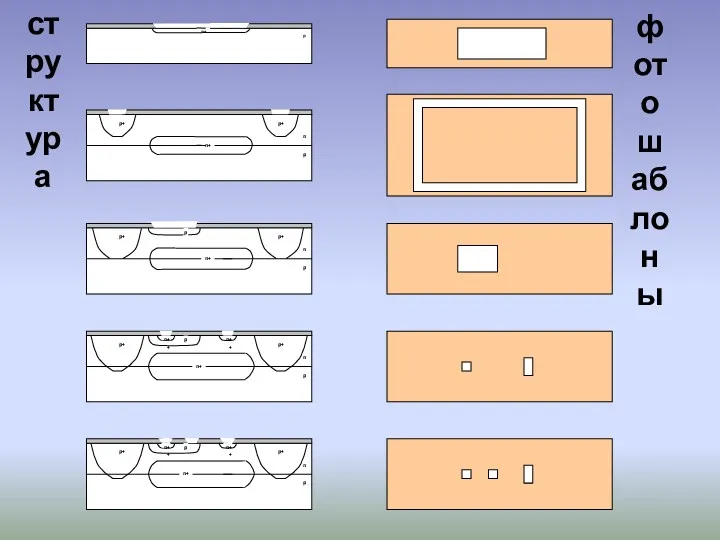


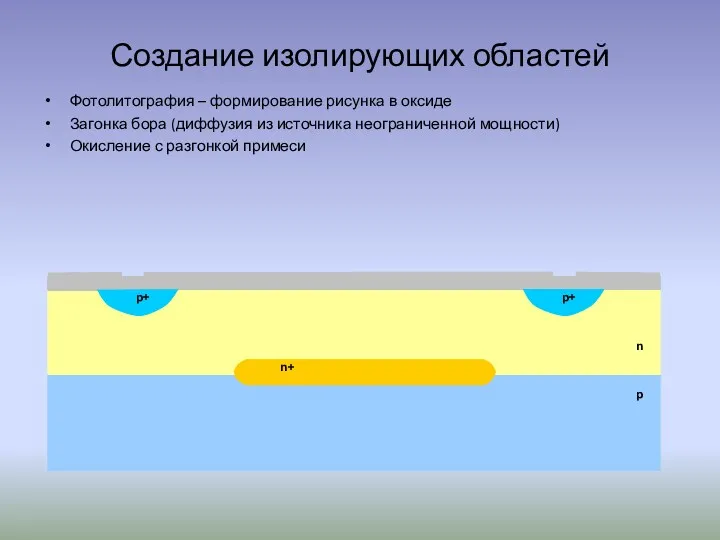
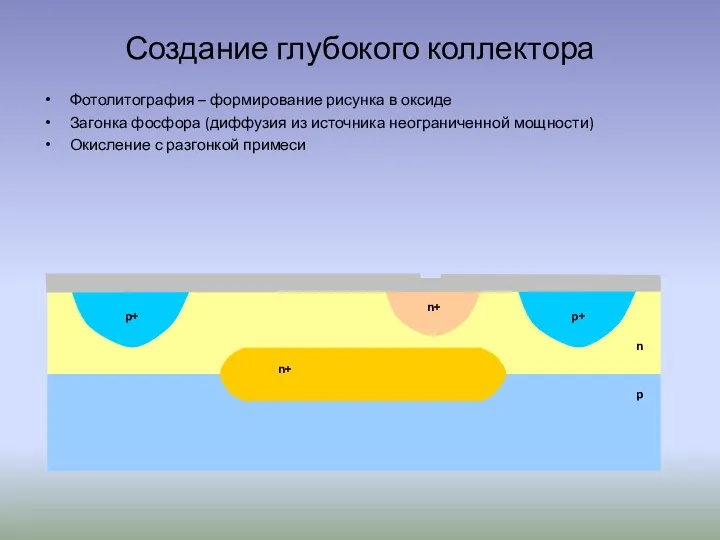
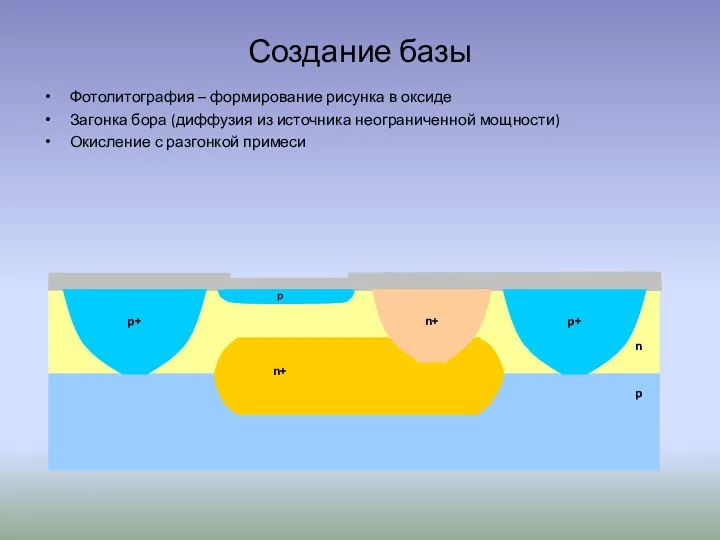
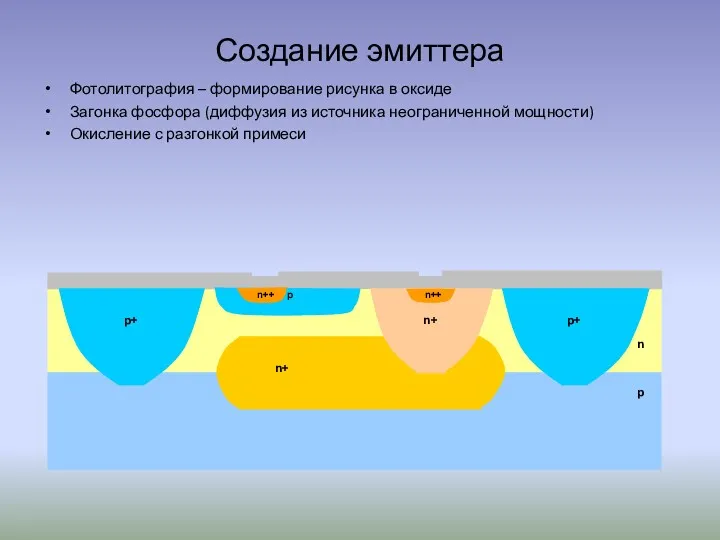
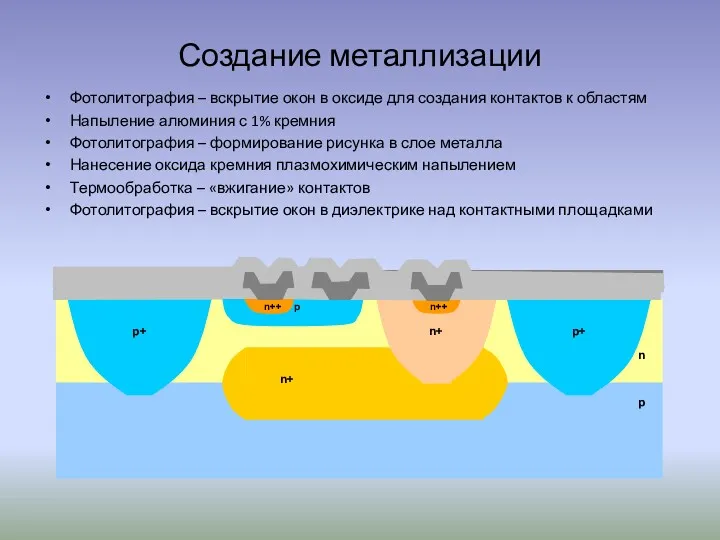




 Девятая и десятая заповеди закона Божия
Девятая и десятая заповеди закона Божия Основы работы с Hadoop
Основы работы с Hadoop Сказ о 5-Д классе
Сказ о 5-Д классе La lettre de mamie
La lettre de mamie Джон Дьюи и его идеи
Джон Дьюи и его идеи Публичная презентация учителя начальных классов Прокофьевой Марины Дмитриевны
Публичная презентация учителя начальных классов Прокофьевой Марины Дмитриевны Авиационный транспорт Украины
Авиационный транспорт Украины Конструктор сайтов
Конструктор сайтов Использование полисенсорной технологии в младшей группе детского сада
Использование полисенсорной технологии в младшей группе детского сада Инструкция
Инструкция Конкурс на лучшие атрибуты для сюжетно- ролевых игр, сделанных своими руками
Конкурс на лучшие атрибуты для сюжетно- ролевых игр, сделанных своими руками Язык программирования Programming language
Язык программирования Programming language Марокко: население, экономика, культура
Марокко: население, экономика, культура Caustic Soda
Caustic Soda Педагогические достижения за 2014-2015 уч.г.группы Звездочки (подготовительная группа)
Педагогические достижения за 2014-2015 уч.г.группы Звездочки (подготовительная группа) Конспект занятия кружка в 1 классе по теме Народная игрушка. Кукла из курса внеурочной деятельности Мой край и его традиции по духовно-нравственному направлению; презентация Народная игрушка
Конспект занятия кружка в 1 классе по теме Народная игрушка. Кукла из курса внеурочной деятельности Мой край и его традиции по духовно-нравственному направлению; презентация Народная игрушка Нотариальное производство. (Лекция 3)
Нотариальное производство. (Лекция 3) 1Б класс 2012 год (1часть) - презентация.
1Б класс 2012 год (1часть) - презентация. London
London Классный час Судьба и Родина Едины 2 класс
Классный час Судьба и Родина Едины 2 класс Острое повреждение почек при массивной кровопотере
Острое повреждение почек при массивной кровопотере Соль: вред или польза?
Соль: вред или польза? Машинобудування України
Машинобудування України Периодической системе химических элементов Д.И.Менделеева – 150 лет!
Периодической системе химических элементов Д.И.Менделеева – 150 лет! Успешная социализация обучающихся как результат совместной деятельности семьи и школы
Успешная социализация обучающихся как результат совместной деятельности семьи и школы Свойство медианы равнобедренного треугольника
Свойство медианы равнобедренного треугольника Буровые технологические жидкости. Утяжелители. (Лекция 6)
Буровые технологические жидкости. Утяжелители. (Лекция 6) Презентаия на тему: Кислоты. Определение, состав, классификаия, номенклатура (8 класс)
Презентаия на тему: Кислоты. Определение, состав, классификаия, номенклатура (8 класс)