Лекция 1. Моделирование технологических процессов. Ионная имплантация. Эффект каналирования презентация
Содержание
- 2. Познание и моделирование «Вся эволюция организмов и история человечества связана с информацией и моделями» Акад. Н.М.
- 3. Вопросы к экзамену Цель и задачи курса. Роль приборно-технологического моделирования в проектировании интегральных микросхем Типы и
- 4. Цель дисциплины формирование знаний в области математического моделирования технологических процессов микро- и наноэлектроники, позволяющих глубже понимать
- 5. IEDM2010.- 367-370 Математическое моделирование как часть технологического развития
- 6. Задачи дисциплины: изучение основных физических явлений, используемых в процессах формирования элементов интегральных схем; математическое описание этих
- 7. Задачи дисциплины (продолжение): формирование навыков по проведению численного моделирования процессов формирования основных интегральных структур, технологических маршрутов
- 8. Intel's 90nm nMOS
- 9. Intel's 90nm pMOS transistor
- 10. Суб 100 нм МОП транзисторы с механически напряженным кремнием n – МДП транзистор с механически напряженным
- 11. Трехмерная модель МДП-транзистора КНИ-типа (32 нм) IEEE TRANSACTIONS ON ELECTRON DEVICES, VOL. 58, NO. 8, AUGUST
- 12. Функция распределения порогового напряжения с учетом разброса фокуса и дозы в процессе литографии IEEE TRANSACTIONS ON
- 13. Моделирование базового технологического маршрута КМДП ИС активные островки P - карман осаждение поликремния осаждение титана Окончательное
- 14. Виртуальный эксперимент: автоматизированное рабочее место Sentaurus Workbench Варьируются длина канала n-МДП транзистора, определяемая параметром endGate, доза
- 15. Численное моделирование 1-3 часа Опытное производство 1/3 года
- 16. Литература: Технология, конструкции и методы моделирования кремниевых интегральных микросхем. М.А. Королев, Т.Ю. Крупкина. М.А. Ревелева. Под
- 17. Классификация моделей технологических операций по виду производственной операции ионная имплантация; окисление, силицидизация; эпитаксия; отжиг; травление /
- 18. Примеры различных типов моделей.
- 19. Функциональный состав моделей технологических операций
- 20. Теоретические основы процесса ионной имплантации В основе теории ионной имплантации лежит исследование и расчет потерь энергии
- 21. Механизмы торможения ионов Торможение является результатом столкновений быстрых заряженных имплантируемых частиц с твердым телом. Одновременно возникают
- 22. Энергетическая зависимость электронного и ядерного торможения. При высоких энергиях ионов преобладает электронное торможение – неупругие столкновения
- 23. Теория Линдхарда, Шарффа и Шиотта (ЛШШ) Ядерная тормозная способность рассматривается как результат последовательности независимых упругих двухчастичных
- 24. Электронная тормозная способность в теории ЛШШ вычисляется в приближении свободного электронного газа. Эффективность торможения пропорциональна скорости
- 25. Диффузионная модель Бирсака В теории Бирсака учитывается изменение направления движения иона после каждого столкновения. При торможении
- 26. Теория Бирсака позволяет вычислить длину проективного пробега, не рассчитывая явно функцию распределения для ψ или η.
- 27. Эффект каналирования Вследствие кристаллической природы полупроводников ионы могут проникнуть в них значительно глубже, если имплантация производится
- 28. Схематическое представление эффекта каналирования Критические углы каналирования в кремнии
- 29. Зависимость эффекта каналирования от угла поворота пучка
- 30. Системы координат при моделировании ионной имплантации Первая система координат – это система, привязанная к реальной установке
- 31. Система координат подложки Положение пластины в установке ионной имплантации и связь первой и второй координатных систем
- 32. Стандартное положение подложки Tilt=7º, Rotation= - 90º Наклон подложки - вращение вокруг направления базового среза задается
- 33. Определение углов Tilt и Rotation Угол Tilt может быть определен как угол между осями Z в
- 34. Примеры размещения подложки и сечений
- 36. Скачать презентацию



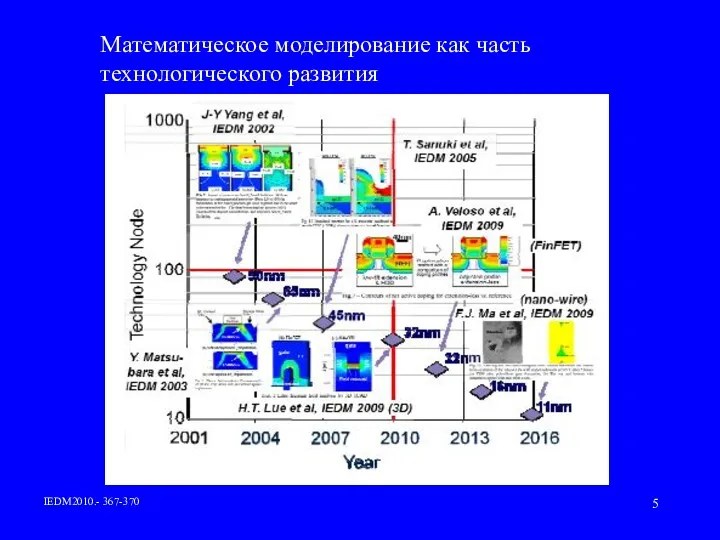


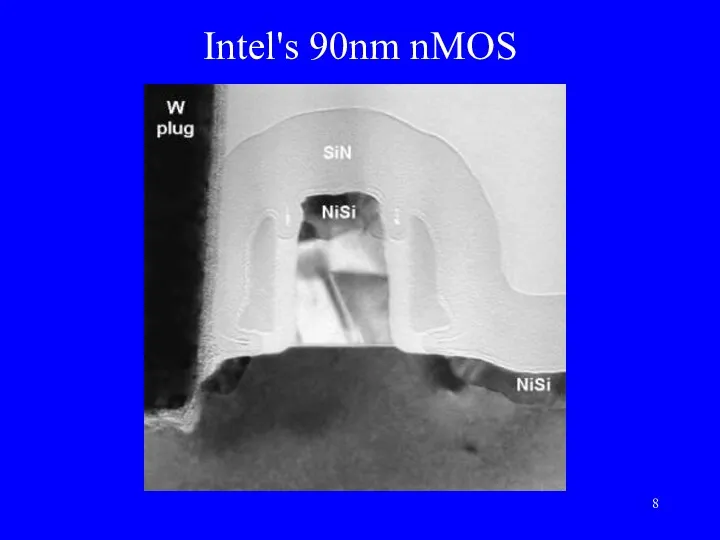
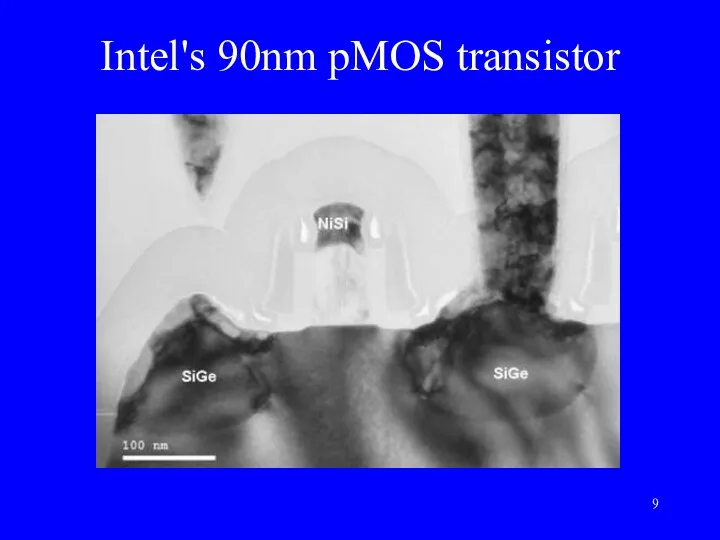

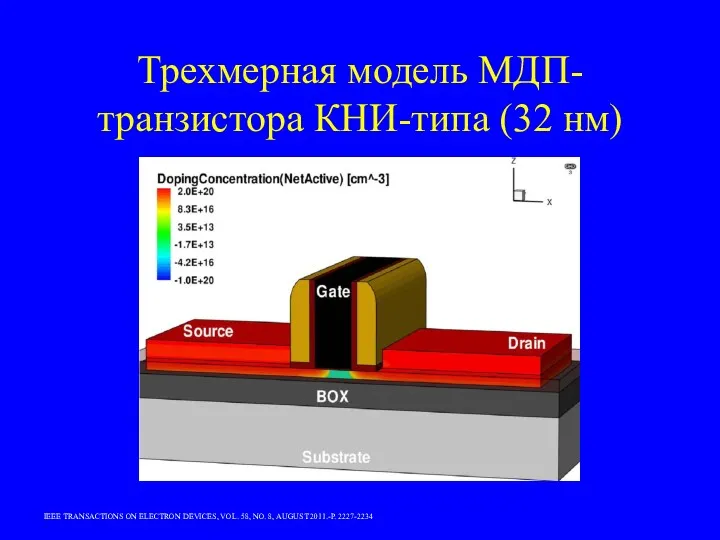

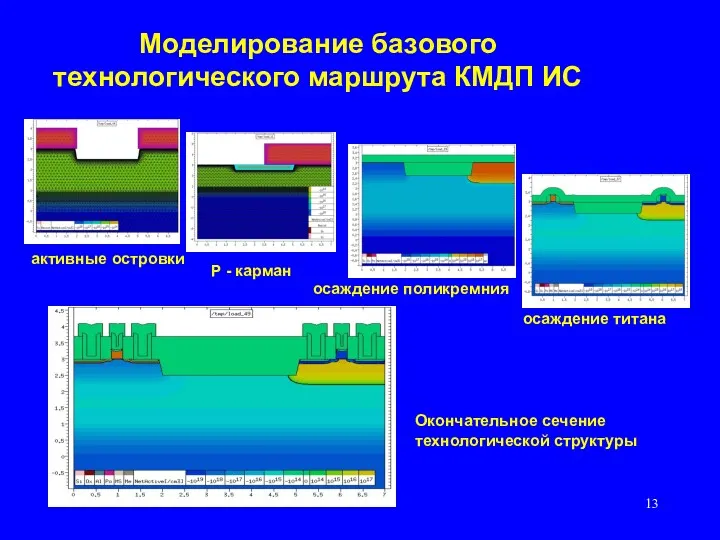

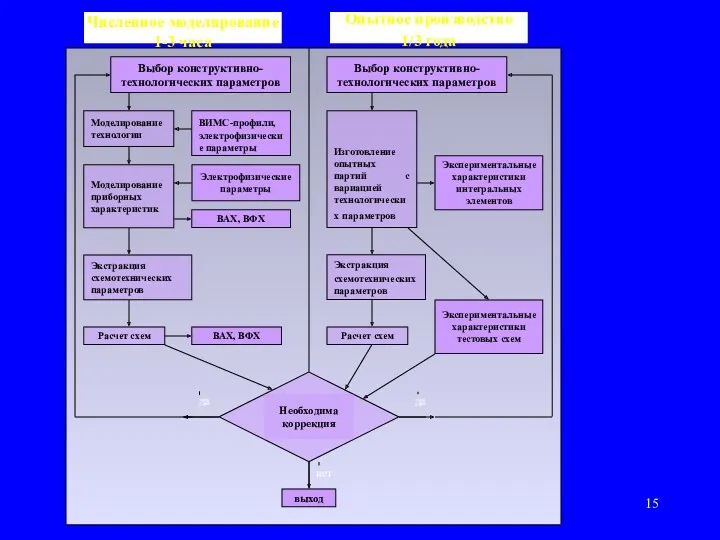


















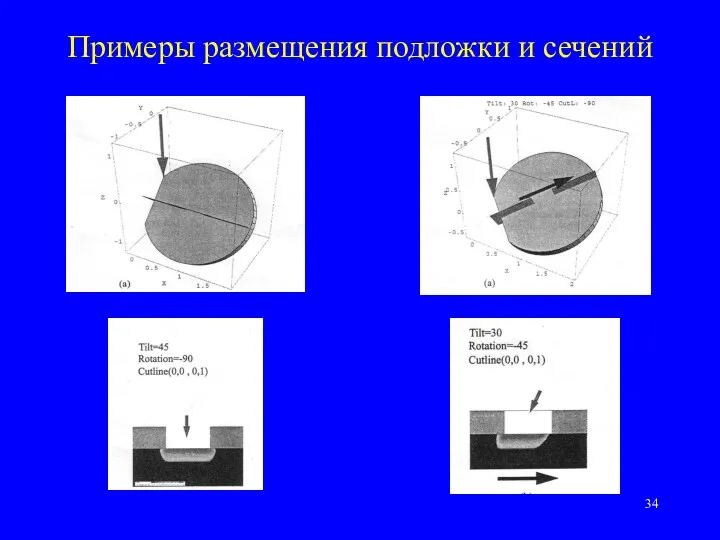
 Первый полет человека в космос
Первый полет человека в космос Жостовская роспись
Жостовская роспись Презентация История с.Спас-Угол и д. Ермолино
Презентация История с.Спас-Угол и д. Ермолино Петельный шов и его варианты (презентация к уроку технологии 4 класс)
Петельный шов и его варианты (презентация к уроку технологии 4 класс) Использование современных технологий
Использование современных технологий Первые люди на земле
Первые люди на земле Штучний інтелект
Штучний інтелект Усилители постоянного тока
Усилители постоянного тока Экологические проблемы планеты Земли. Земля
Экологические проблемы планеты Земли. Земля Параллелепипед
Параллелепипед родительское собрание 18.03.2021
родительское собрание 18.03.2021 Джо Коломбо (Joe Colombo) - человек, который придумал мебель заново
Джо Коломбо (Joe Colombo) - человек, который придумал мебель заново Презентация на тему Здоровое питание
Презентация на тему Здоровое питание презентация Сотрудничество ДОУ с семьей
презентация Сотрудничество ДОУ с семьей Равновесие денежного рынка. Финансовая система. Тема 9
Равновесие денежного рынка. Финансовая система. Тема 9 Мораль. Важнейший капитал нации – нравственные качества народа. Н.Г.Чернышевский
Мораль. Важнейший капитал нации – нравственные качества народа. Н.Г.Чернышевский Дыхательные пути. Дыхательные расстройства
Дыхательные пути. Дыхательные расстройства Разложение десятичных дробей по разрядам
Разложение десятичных дробей по разрядам Химиялық алғашқы ұғымдар тарауын қорытындылау
Химиялық алғашқы ұғымдар тарауын қорытындылау Как написать научную статью
Как написать научную статью Марина Ивановна Цветаева (1892-1941)
Марина Ивановна Цветаева (1892-1941) Развитие чувства времени у детей старшего дошкольного возраста
Развитие чувства времени у детей старшего дошкольного возраста Жизнь на материке Южная Америка.
Жизнь на материке Южная Америка. Введение в химию. Коллигативные свойства растворов
Введение в химию. Коллигативные свойства растворов Технология вышивания крестом
Технология вышивания крестом Сан-Марино Мәртебелі Республикасы
Сан-Марино Мәртебелі Республикасы Общие закономерности эволюции. Филогенез дыхательной и кровеносной систем человека
Общие закономерности эволюции. Филогенез дыхательной и кровеносной систем человека Сестринская помощь лицам пожилого возраста
Сестринская помощь лицам пожилого возраста