Содержание
- 2. Содержание Определения понятий травления и плазмы. Назначение и виды химического травления. Назначение физического травления. Классификация процессов
- 3. Определения травления и плазмы Под травлением понимают растворение и последующее удаление заданной части материала с поверхности
- 4. Назначение и виды химического травления Химическое травление основано на процессах растворения исходных материалов. Травление может осуществляться
- 5. Назначение физического травления К физическим процессам травления относятся процессы травления, в которых удаление ненужного материала происходит
- 6. Классификация процессов в зависимости от сочетания давления и энергии ионов плазмы К процессам травления предъявляются требования
- 7. Назначение и условие проведение ионного травления Ионное травление осуществляется ионами плазмы, не реагирующими с обрабатываемым материалом.
- 8. Недостатки процесса ионного травления Отсутствие селективности травления, к.с. ограничивается глубина травления, которая должна быть соизмерима с
- 9. Ионно-химическое травление Ионно-химическое травление (ИХТ) представляет собой физико-химический процесс, который происходит при достаточно высоком давлении газов
- 10. Плазмохимическое травление Плазмохимическое травление (ПХТ) происходит в результате химических реакций между химически активными частицами и поверхностными
- 11. Назначение ПХТ и конструкция реактора В плазменном травлении химически активные частицы (свободные атомы и радикалы) вступают
- 12. Лазерно-стимулированное травление Лазерно-стимулированное травление – перспективный метод травления поверхности, в котором используется лазерное излучение с энергией
- 13. Применение плазменных технологий в производстве УБИС Схема типичного 0,25 мкм щелевого конденсатора ячейки ДОЗУ Поперечное сечение
- 14. Плазмой называют квазинейтральный газ заряженных и нейтральных частиц, концентрация которых достаточна для того, чтобы создаваемый ими
- 15. Условия несамостоятельного и самостоятельного э.р. В г. Газы становятся электропроводными при их ионизации. Если электрический разряд
- 16. Зависимость тока заряда от напряжения (рис.1)
- 17. Когда ионизация газа происходит при непрерывном действии внешнего ионизатора и малом значении разности потенциалов между анодом
- 18. Кривые Пашена для различных газов Закон Пашена, устанавливает, что наименьшее напряжение зажигания газового разряда между двумя
- 19. Вольтамперная характеристика тихого разряда
- 20. Внешний вид и распределение параметров в нормальном тлеющем разряде Обозначения: 1 — астоново тёмное пространство; 2
- 21. ВЧ разрядом можно назвать любой разряд в переменных электромагнитных полях. Разряд относят к ВЧ, если длина
- 22. Системы возбуждения ВЧ - разрядов Конфигурация объемно-цилиндрического реактора использовалась для обработки поверхностей в случаях, где не
- 23. Конфигурация плоского диода
- 24. Емкостной источник и ВЧ-согласующая цепь
- 25. Геометрия плоского триода, в котором ВЧ напряжения приложены на два электрода и, в которой заземленная стенка
- 26. Один из вариантов СВЧ - системы
- 27. Типичный реактор индукционно связанной плазмы (ИСП)
- 28. Схемное решение CDE реактора
- 31. Остановка травления при травлении окисла в результате интенсивной полимеризации при травлении в смеси C4F8 во время
- 32. Контрольные вопросы по четвертой теме: 1. Дайте определения понятий травления и плазмы? 2. Укажите назначение и
- 33. Список источников литературы по теме: 1. Королев М.А. Технология, конструкции и методы моделирования кремниевых интегральных микросхем:
- 35. Скачать презентацию
























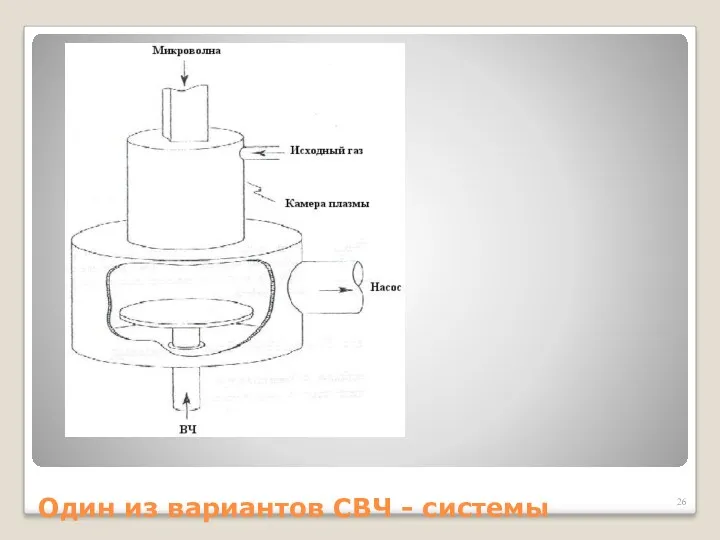
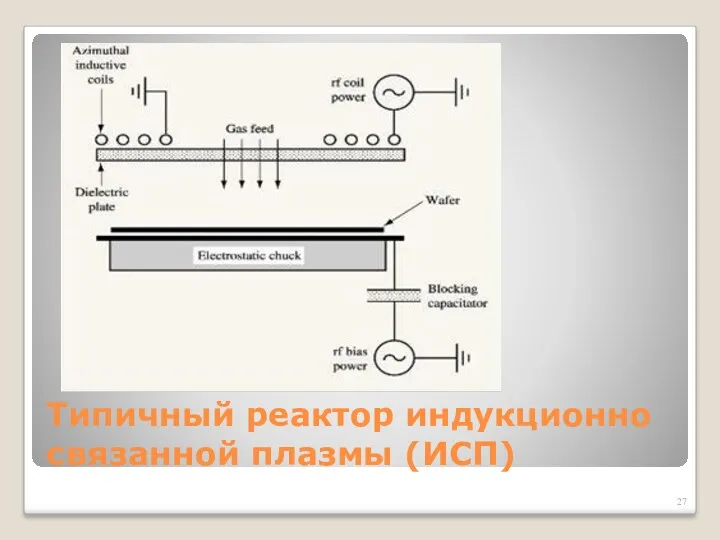

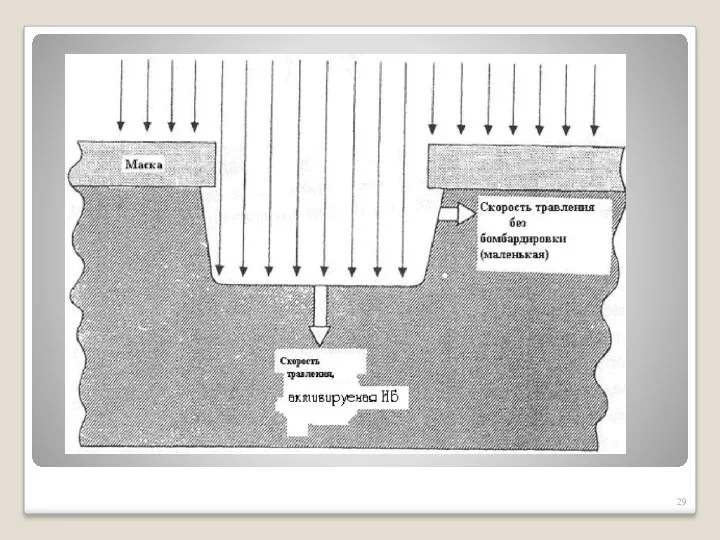

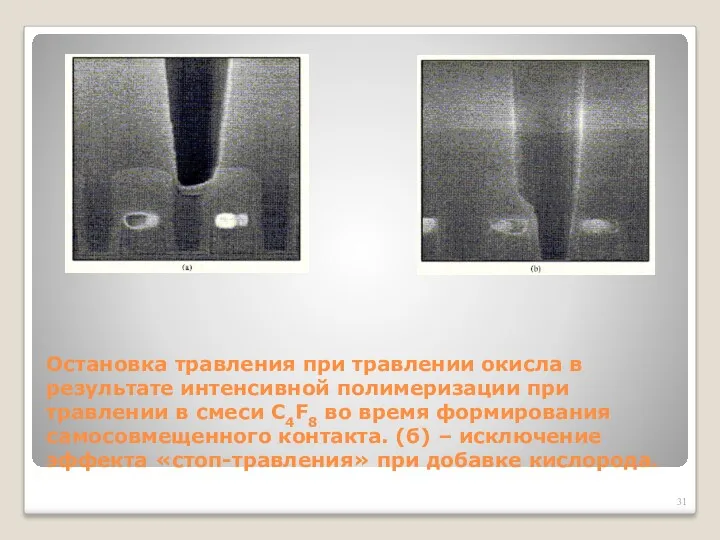


 Автоколебания. Генератор незатухающих электромагнитных колебаний
Автоколебания. Генератор незатухающих электромагнитных колебаний Електротехніка (Лекція 6. Частина 2)
Електротехніка (Лекція 6. Частина 2) Методи та системи неруйнівного контролю
Методи та системи неруйнівного контролю Современные типы космических двигателей
Современные типы космических двигателей Кинематика материальной точки и поступательного движения твердого тела
Кинематика материальной точки и поступательного движения твердого тела Релейная защита и автоматика
Релейная защита и автоматика Плоская система сходящихся сил. Техническая механика
Плоская система сходящихся сил. Техническая механика Раздел 4. Управление колебаниями. Импульсная модуляция
Раздел 4. Управление колебаниями. Импульсная модуляция Обобщение и уточнение Ньютоном законов Кеплера
Обобщение и уточнение Ньютоном законов Кеплера Эксплуатация оборудования для ТО и ТР приборов дизельных систем питания автомобиля (урок 19)
Эксплуатация оборудования для ТО и ТР приборов дизельных систем питания автомобиля (урок 19) Динамика кулисного механизма
Динамика кулисного механизма Техническая диагностика машин. Диагностирование дизельных двигателей
Техническая диагностика машин. Диагностирование дизельных двигателей Применение современных образовательных технологий в обучении физике учащихся с ограниченными возможностями здоровья.
Применение современных образовательных технологий в обучении физике учащихся с ограниченными возможностями здоровья. Зависимость скорости испарения воды от площади поверхности и от ветра. Экспериментальная работа по физике
Зависимость скорости испарения воды от площади поверхности и от ветра. Экспериментальная работа по физике Flexible pipelines
Flexible pipelines Научно-исследовательская работа Холодильник в дорогу. Способ поддержания определенной температуры хранения вне холодильника
Научно-исследовательская работа Холодильник в дорогу. Способ поддержания определенной температуры хранения вне холодильника Реостаты. Последовательное соединение проводников. Параллельное соединение проводников
Реостаты. Последовательное соединение проводников. Параллельное соединение проводников Линзы. Оптические приборы
Линзы. Оптические приборы Физика плазмы
Физика плазмы Влияние груза на посадку и остойчивость
Влияние груза на посадку и остойчивость Расчет установившихся режимов простейших электрических сетей. (Глава 6)
Расчет установившихся режимов простейших электрических сетей. (Глава 6) Презентация к уроку по теме Кристаллы (10класс).
Презентация к уроку по теме Кристаллы (10класс). Фізика в сучасному житті людини
Фізика в сучасному житті людини Электродинамика курсындағы қолданбалы материалдар
Электродинамика курсындағы қолданбалы материалдар Механикалық гармониялық тербелістер. Өшетін тербелістер. Еріксіз тербелістер. Толқындар
Механикалық гармониялық тербелістер. Өшетін тербелістер. Еріксіз тербелістер. Толқындар Основы физики атома. Теория атома водорода по Бору
Основы физики атома. Теория атома водорода по Бору Магнитооптические материалы. Магнитооптические эффекты
Магнитооптические материалы. Магнитооптические эффекты Газовые законы. Решение графических задач на газовые законы
Газовые законы. Решение графических задач на газовые законы