Содержание
- 2. Тенденции развития: уменьшение размера элемента (топологической нормы) Lg - длина затвора Xj - толщина легированных областей
- 3. Тенденции развития: увеличение степени интеграции 1 – ранняя стадия выпуска ИС (удвоение количества транзисторов каждые 12
- 4. Проекционная литография Предельное разрешение оптической литографии: где k1 – технологический параметр, λ – длина волны экспонирующего
- 5. Параметр k1 Параметр k1 был уменьшен с 0.8 в 1980 году до 0.4 сегодня. Величина k1
- 6. Фазосдвигающий шаблон Фазосдвигающие шаблоны, в которых сдвиг фазы световой волны на 180 градусов: а - реализуется
- 7. Принцип действия фазосдвигающего шаблона Фазосдвигающий шаблон Обычный шаблон
- 8. Коррекция эффекта близости Для того чтобы в фоторезистивной маске создать необходимый рисунок приходится усложнять рисунок фотошаблона,
- 9. Длина волны экспонирующего излучения Эволюция источников экспонирующего излучения: Ртутные дуговые лампы (λ = 436 (g-line), 405
- 10. Длина волны освещения и топологическая норма По мере уменьшения топологической нормы происходит и уменьшение длины волны
- 11. Иммерсионная литография: увеличение числовой апертуры (NA) NA = n sinθ, где n – коэффициент преломления среды
- 12. Установка иммерсионной литографии Микроскопические изображения резистивных масок, полученных с помощью иммерсионной литографии с полушириной линия-промежуток равной
- 13. Экстремальная ультрафиолетовая литография Длина волны излучения на уровне 10 нм обеспечивает прекрасное разрешение Оптика - отражательная
- 14. Источник импульсной лазерной плазмы CO2 лазер (основной импульс) Nd:YAG лазер (пред-импульс) Камера с мишенью светоделительная пластина
- 15. Импринтинг Импринтинг – это метод литографии, когда трёхмерный рисунок в резисте получается посредством вдавливания в него
- 17. Импринтинг: S-FIL технология
- 18. Импринтинг: технология 2-D рисунок 1-D рисунок Дифракционная микролинза
- 19. Обращенный импринтинг (S-FIL/R process) S-FIL/R процесс: после формирования отпечатка, поверхность покрывается планаризирующим слоем (6), который травится
- 20. Преимущества импринтинга Низкая стоимость оборудования и технологии, так как не используется дорогая оптика, источники излучения и
- 21. Применение наноимпринтинга
- 23. Скачать презентацию
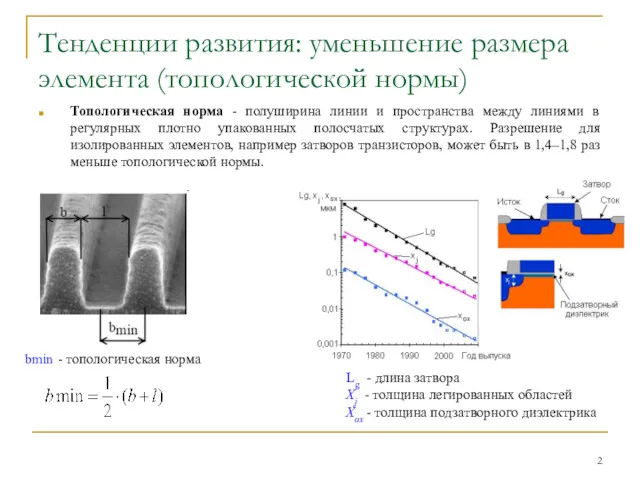










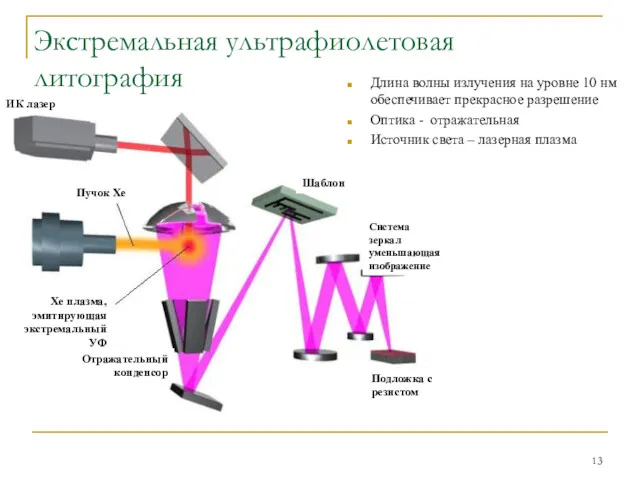
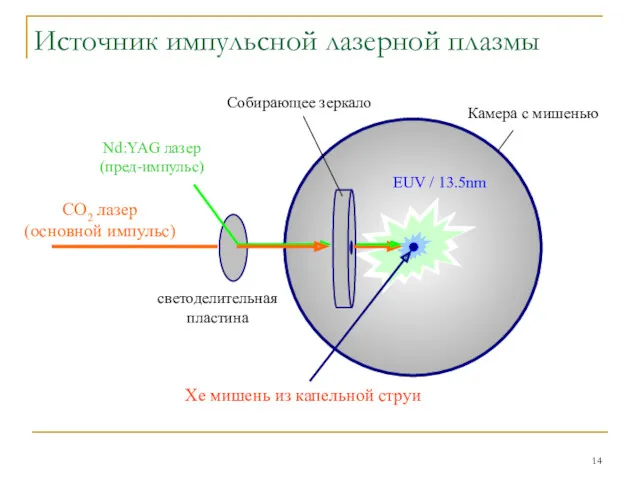


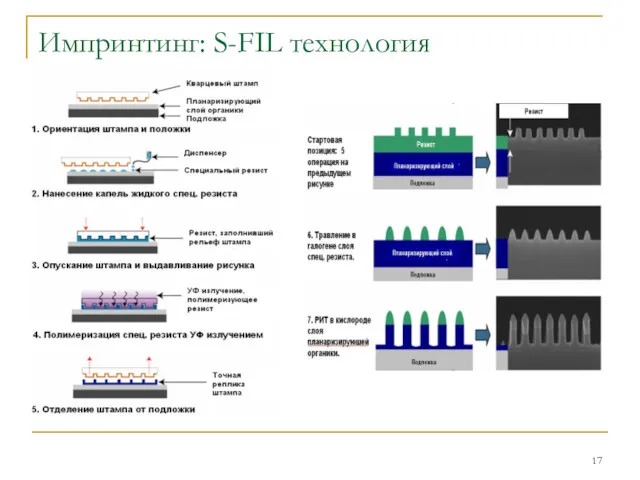
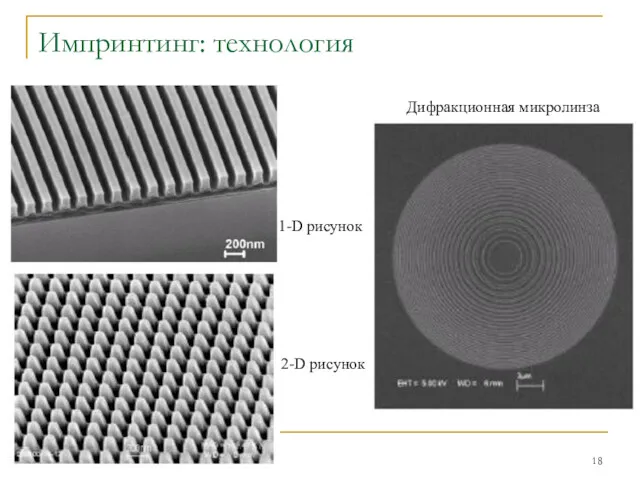
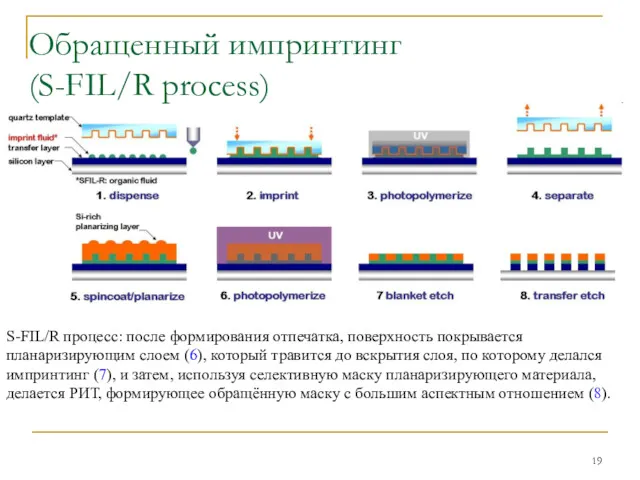


 Интегрирование уроков физики с другими школьными предметами
Интегрирование уроков физики с другими школьными предметами Сферические зеркала.Ход лучей в призме, плоскопараллельной пластине
Сферические зеркала.Ход лучей в призме, плоскопараллельной пластине к открытому уроку по теме: Простые механизмы
к открытому уроку по теме: Простые механизмы Bonds and Molecules
Bonds and Molecules Сдвиг и кручение. Закон Гука при сдвиге. Условие прочности при чистом сдвиге
Сдвиг и кручение. Закон Гука при сдвиге. Условие прочности при чистом сдвиге Паровая машина
Паровая машина Контроль параметрів радіовипромінювання. Радіоперешкоди
Контроль параметрів радіовипромінювання. Радіоперешкоди Контроль качества сварных соединений
Контроль качества сварных соединений Исследование прочностных характеристик сердечников крестовин стрелочных переводов после упрочняющей обработки
Исследование прочностных характеристик сердечников крестовин стрелочных переводов после упрочняющей обработки Bases of endoscopic surgery
Bases of endoscopic surgery Виды телескопов
Виды телескопов Условия плавания тел
Условия плавания тел Схема работы отопителя салона автомобиля
Схема работы отопителя салона автомобиля Рекомендации по выбору посадок
Рекомендации по выбору посадок The adequacy of analysis of linear periodically-time-variable circuits by the frequency symbolic method in the time domain
The adequacy of analysis of linear periodically-time-variable circuits by the frequency symbolic method in the time domain Газораспределительные механизмы в двигателе внутреннего сгорания
Газораспределительные механизмы в двигателе внутреннего сгорания Механік - моя спеціальність
Механік - моя спеціальність Структура механизмов. (Семинар 1)
Структура механизмов. (Семинар 1) Поверхностные явления. Уравнение Гиббса
Поверхностные явления. Уравнение Гиббса Система единиц СИ. Векторные и скалярные величины
Система единиц СИ. Векторные и скалярные величины Werkstoffkunde
Werkstoffkunde Несамостоятельный газовый разряд
Несамостоятельный газовый разряд Шарнирные, статически определимые балки
Шарнирные, статически определимые балки Компрессор холодильника
Компрессор холодильника Электр кедергілерін анықтау тәсілдері
Электр кедергілерін анықтау тәсілдері Сопротивление материалов. Наука о сопротивлении материалов
Сопротивление материалов. Наука о сопротивлении материалов Вантажопідйомні машини. Держгірпромнагляд
Вантажопідйомні машини. Держгірпромнагляд Расчет конической передачи редуктора
Расчет конической передачи редуктора