Содержание
- 2. Межатомное взаимодействие (силы Ван-дер-Ваальса) Потенциал Леннарда Джонса на больших расстояниях зонд испытывает притяжение со стороны образца
- 3. Принципы работы СЗМ Система обратной связи (ОС) контролирует расстояние между зондом и образцом, используя параметр взаимодействия
- 4. Принципы работы СЗМ Формирование СЗМ изображения сканирование в плоскости X,Y позволяет получить СЗМ изображение поверхности сканирующие
- 5. Принципы работы СЗМ Исследование рельефа поверхности и ее локальных свойств проводится с помощью специальных зондов –
- 6. Зондовые датчики АСМ Зондовый датчик - упругий кантилевер (консоль) с острым зондом на конце сила, действующая
- 7. Геометрические параметры зонда радиус закругления 1 ÷ 50 нм угол при вершине зонда 10 ÷ 20º
- 8. Типы АСМ кантилеверов V-образный кантилевер (контактная АСМ мода) I-образный кантилевер (бесконтактная АСМ мода) Si3N4 Si r
- 9. Вид зонда в электронном микроскопе Монокристаллический Si Натуральный алмаз PECVD Si3N4 Параметр Модуль Юнга Плотность Микротвердость
- 10. Различные типы зондов Вторично эмиссионное изображение зонда с использованием углеродной нанотрубки
- 11. Принцип действия АСМ Оптическая регистрация изгиба кантилевера лазер фокусируется на кантилевере отраженный пучок попадает в центр
- 12. Оптический силовой сенсор АСМ Параметры, регистрируемые оптической системой изгиб кантилевера под действием Z-компонент сил притяжения или
- 13. Интерферометрические схемы контроля отклонения кантилевера Интерференция возникает за счет разницы путей света опорного и отраженного. Использование
- 14. Система обратной связи АСМ Система ОС обеспечивает ΔLz=const Z-сканер поддерживает изгиб кантилевера ΔZ = ΔZ0, задаваемый
- 15. Роль обратной связи в АСМ VS Verr=V-VS VC=VP+VI+VD Пропорциональная компонента VP отвечает за отклик на резкие
- 16. Работа обратной связи АСМ Изменение сигнала ошибки и напряжения на Z-сканере при измерении ступеньки рельефа Медленная
- 17. Контактные АСМ методики Остриё зонда находится в непосредственном механическом взаимодействии с поверхностью Силы взаимодействия с образцом
- 18. Контактные АСМ методики Метод постоянной высоты Реализуется для образцов с малыми перепадами высоты ~ несколько Å
- 19. Исследование наноматериалов методами сканирующей зондовой микроскопии Примеры АСМ изображений 30 мкм х 30 мкм Аморфное металлическое
- 20. Метод постоянного рассогласования Сигнал Рассогласования системы обратной связи, возникающий в процессе сканирования с использованием Метода Постоянной
- 21. Микроскопия поперечных сил Регистрация кручения кантилевера под действием латеральных компонент сил различает области с различными коэффициентами
- 22. Микроскопия поперечных сил Для малых отклонений угол закручивания пропорционален поперечной (латеральной) силе. Торсионное закручивание кантилевера измеряется
- 23. Микроскопия поперечных сил Сегнетоэлектрические пленки PZT 30/70 +10 PbO размер скана 5х5 мкм
- 24. Микроскопия поперечных сил Гидратные пленки на основе Al размер скана 8х8 мкм
- 25. Микроскопия модуляции сил При сканировании на кантилевер подается переменная нагрузка частота 5 кГц амплитуда 2-20 Å
- 26. Микроскопия модуляции сил В процессе реализации Метода Модуляции Силы одновременно со сканированием образца в соответствии с
- 27. Микроскопия модуляции сил Полимерные пленки ПВХ топография микротвердость
- 28. Акустическая Микроскопия Основная идея Атомно-силовой Акустической Микроскопии (АСАМ) заключается в возбуждении колебаний находящегося в контакте с
- 29. Колебательные АСМ методики Полуконтактная (tapping) АСМ Бесконтактная АСМ Топография Фазовый контраст Слабая зависимость силы от расстояния
- 30. Вынужденные колебания кантилевера вблизи резонанса с амплитудой ~ 10 ÷ 100 нм кантилевер касается поверхности в
- 31. Сравнение с контактной АСМ Меньше риск повредить зонд Меньшее влияние на поверхность возможность работы с «мягкими»
- 32. Примеры АСМ изображений Коллоидное золото 20 мкм х 20 мкм Кристаллизация монослоя оксида полиэтилена 14 мкм
- 33. Примеры АСМ изображений 5 мкм х 5 мкм Трехфазная полимерная пленка (PMMA) Топография Фазовый контраст Полуконтактная
- 34. Микроскопия магнитных сил Зонд с ферромагнитным покрытием (Co) Двухпроходная методика 1 проход рельеф поверхности в полуконтактном
- 35. Микроскопия магнитных сил MFM nc-AFM Изменение МСМ сигнала при удалении от поверхности (тестовый образец)
- 36. Исследование наноматериалов методами сканирующей зондовой микроскопии Качество МСМ изображения Магнитостатическая сила зависит от доменной структуры
- 37. Исследование наноматериалов методами сканирующей зондовой микроскопии Примеры МСМ изображений 1.85 мкм х 1.85 мкм Пермаллоевые капли
- 38. Исследование наноматериалов методами сканирующей зондовой микроскопии Примеры МСМ изображений Магнитные биты 30 мкм х 30 мкм
- 39. Исследование наноматериалов методами сканирующей зондовой микроскопии Примеры МСМ изображений Магнитные частицы, покрытые тонкой пленкой 9 мкм
- 40. Исследование наноматериалов методами сканирующей зондовой микроскопии Примеры МСМ изображений 80 мкм х 80 мкм Магнитные домены
- 41. Электрические методики СЗМ Слабое взаимодействие – модуляционная техника для повышения чувствительности механическая модуляция – переменное напряжение
- 42. Электрические методики СЗМ Контактные электрические методики сканирующая микроскопия сопротивления растекания контактная сканирующая емкостная микроскопия силовая микроскопия
- 43. Электрические методики СЗМ Основные принципы работы Электростатическое взаимодействие между проводящим зондом и заряженными областями вблизи поверхности
- 44. Микроскопия Пьезоотклика Основная идея Силовой Микроскопии Пьезоотклика заключается в локальном воздействии на пьезоэлектрический образец переменного электрического
- 45. Исследование наноматериалов методами сканирующей зондовой микроскопии Силовая микроскопия пьезоотклика Исследование доменной структуры сегнетоэлектриков Домены разных знаков
- 46. Электрическая силовая микроскопия Независимое измерение топографии Механические колебания кантилевера на резонансной частоте при постоянной разности потенциалов
- 47. Отображение Сопротивления Растекания Отображение Сопротивления Растекания возможно при использовании проводящего зонда ССМ, находящегося в контакте с
- 48. Сканирующая микроскопия сопротивления растекания Контактная AFM мода При сканировании прикладывается разность потенциалов Vdc и измеряется ток
- 49. Электрическая силовая микроскопия Исследование наноматериалов методами сканирующей зондовой микроскопии Тестирование интегральных схем (SRAM) ЭСМ Топография
- 50. Метод зонда Кельвина Сила взаимодействия зонда с поверхностью приближенно описывается формулой: где Vtip – потенциал, создаваемый
- 51. Метод зонда Кельвина Независимое измерение топографии При измерении потенциала поверхности обратная связь осуществляется за счет изменения
- 52. Механическая разновидность зонда Кельвина Для исследования коррозии Зонд и образец образуют конденсатор. В условиях существующей разницы
- 53. Профиль высоты и потенциала измеренный с помощью зонда Кельвина на поверхности железа с каплей водного раствора
- 54. Метод зонда Кельвина Исследование наноматериалов методами сканирующей зондовой микроскопии Электрический потенциал на поверхности двухкомпонентной пленки Ленгмюра-Блоджетта
- 55. Сканирующая емкостная микроскопия Измерение производится аналогично методу зонда Кельвина Измеряемая величина – амплитуда сигнала второй гармоники:
- 56. Конденсатор MOS сформирован зондом SCM и полупроводниковым образцом
- 57. Зависимость емкости и дифференциальной емкости от напряжения DС для полупроводников n-типа и p-типа.
- 58. Положительные и отрицательные заряды в изоляторе и полупроводнике вызывают параллельный сдвиг в высокочастотной кривой C-V и
- 59. схема измерения dC/dV для полупроводникового образца p-типа. Переменное напряжение создает вариацию емкости при фиксированном постоянном напряжении.
- 60. Схема зонда XE SCM с переменной рабочей частотой
- 61. Резонансные кривые разных материалов Изменение емкости в паре «зонд-образец»
- 62. Сканирующая емкостная микроскопия Измеряемая величина локальной емкости определяется локальной диэлектрической проницаемостью пространственным распределением носителей заряда толщиной
- 63. (a) Топография и (b) SCM изображение полупроводниковой поверхности. Яркая область на топографическом изображении изображает серый силиконовый
- 64. изображения образца с имплантированными ионами Si
- 65. Сканирующая емкостная микроскопия Исследование наноматериалов методами сканирующей зондовой микроскопии Полевой транзистор СЕМ Топография
- 66. Сканирующая тепловая спектроскопия Использование зависимости фотолюминисценции от температуры Использование редкоземельных ионов в качестве излучающих частиц Er3+,
- 67. Сканирующая тепловая спектроскопия Исследование наноматериалов методами сканирующей зондовой микроскопии Температурная зависимость спектра излучения и интенсивности от
- 68. Сканирующая тепловая спектроскопия Исследование наноматериалов методами сканирующей зондовой микроскопии Схема установки для СТоМ Лазер на 975
- 70. Скачать презентацию

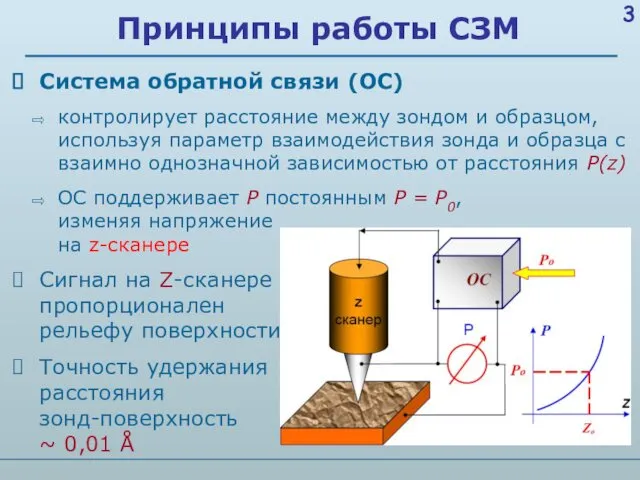

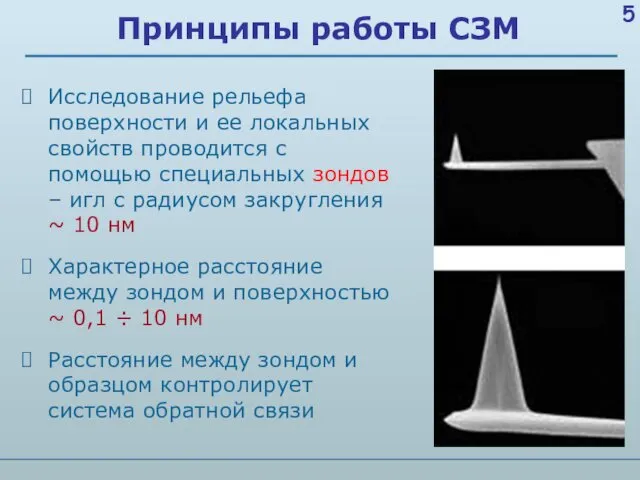
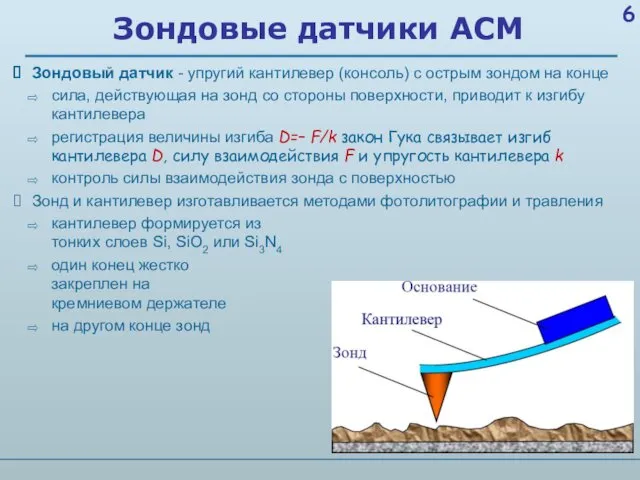

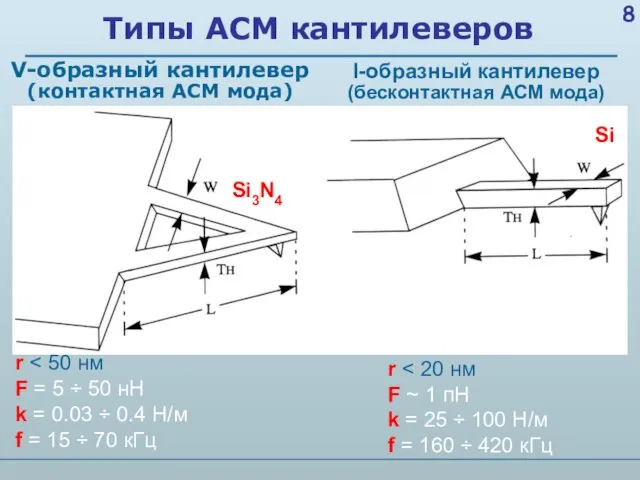


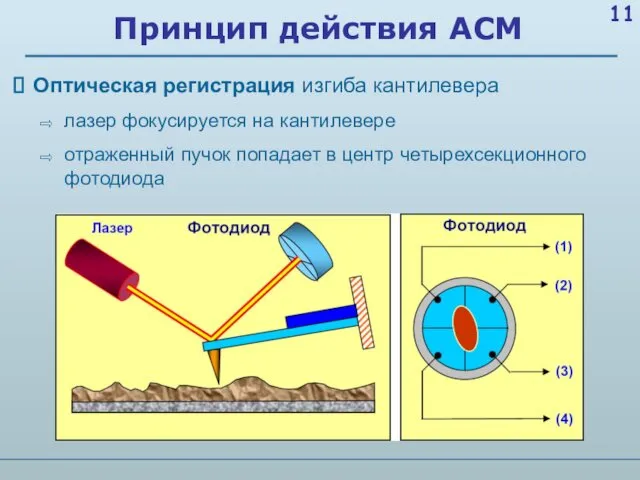

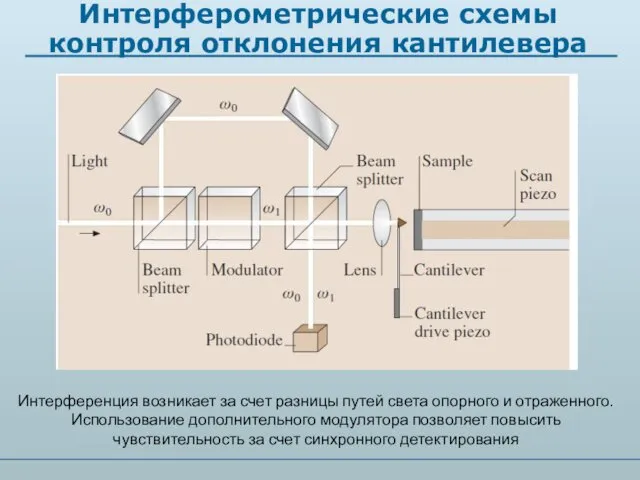
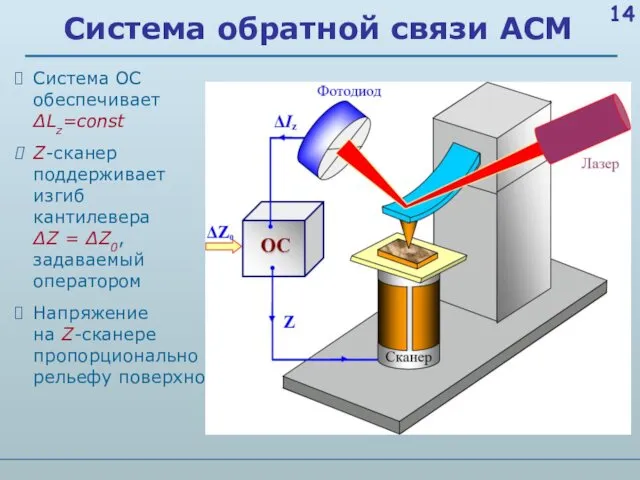
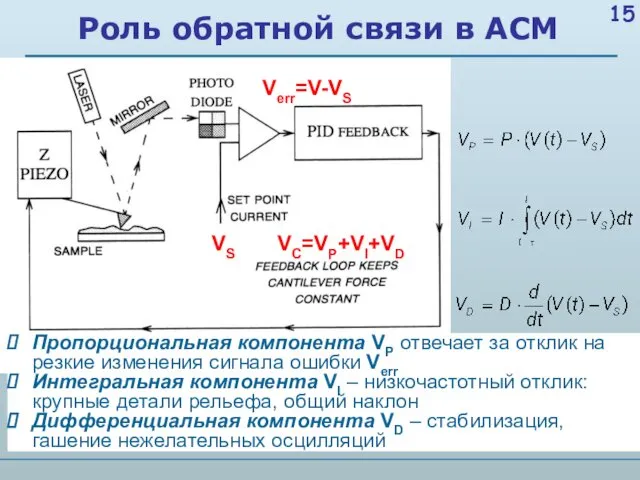

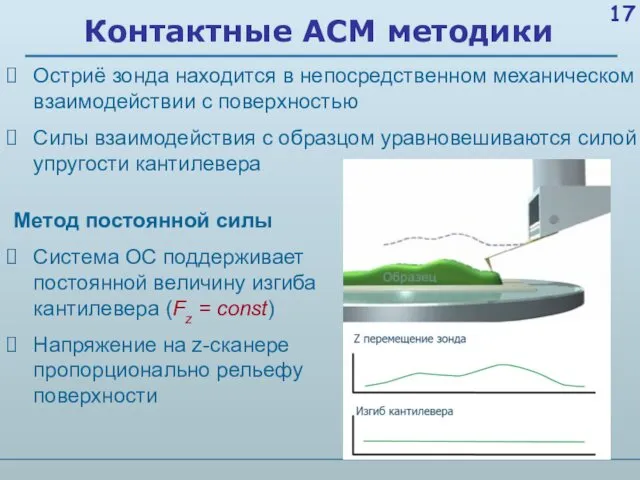
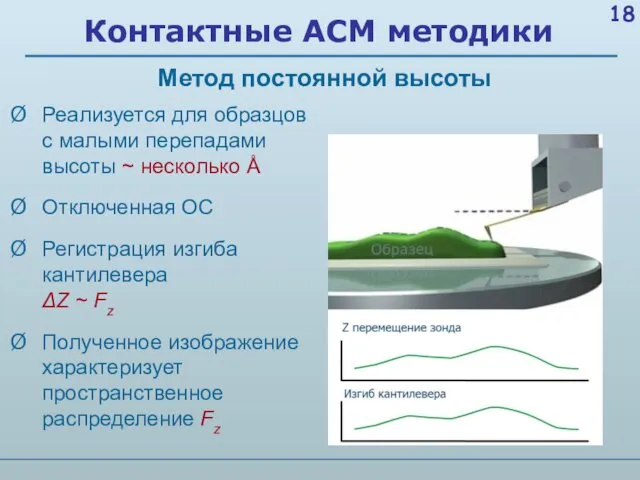
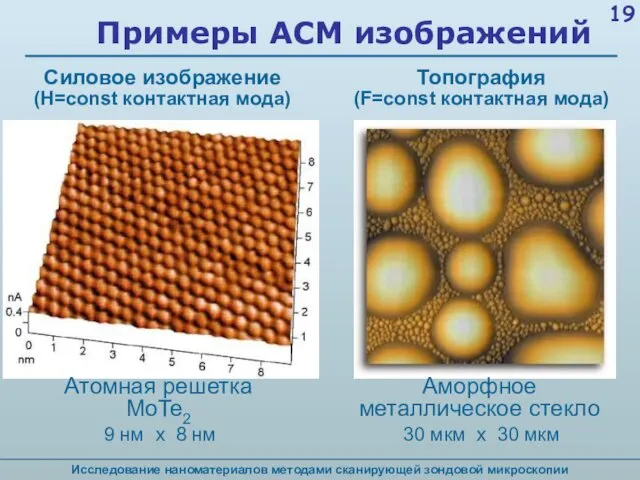



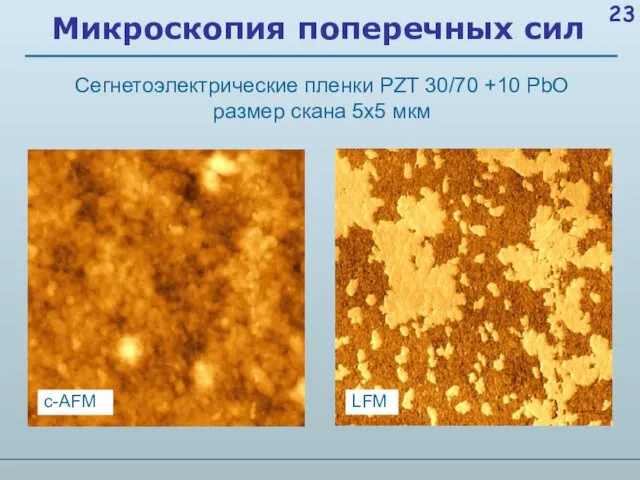

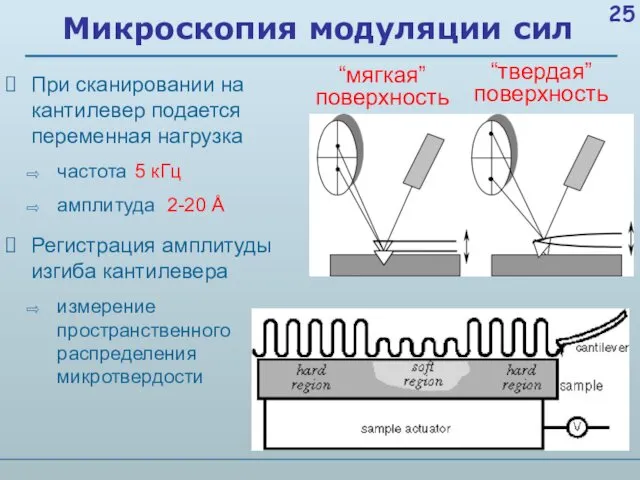

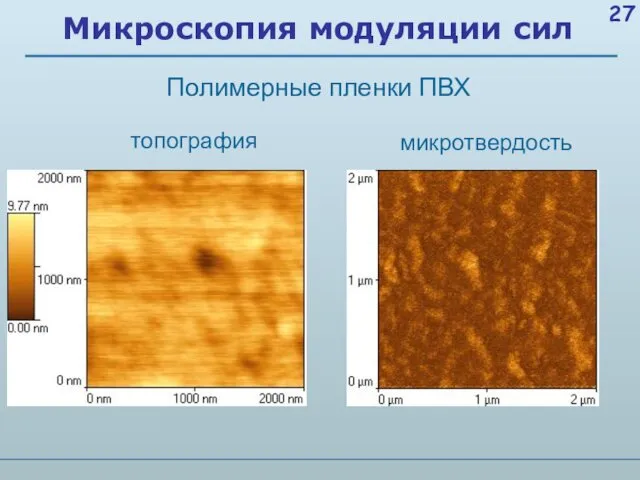
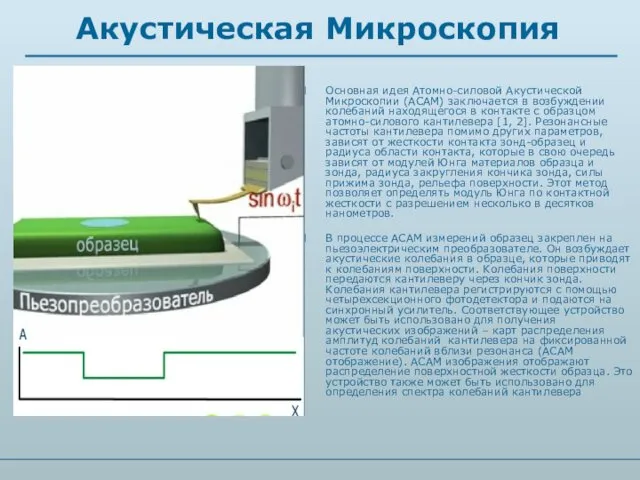





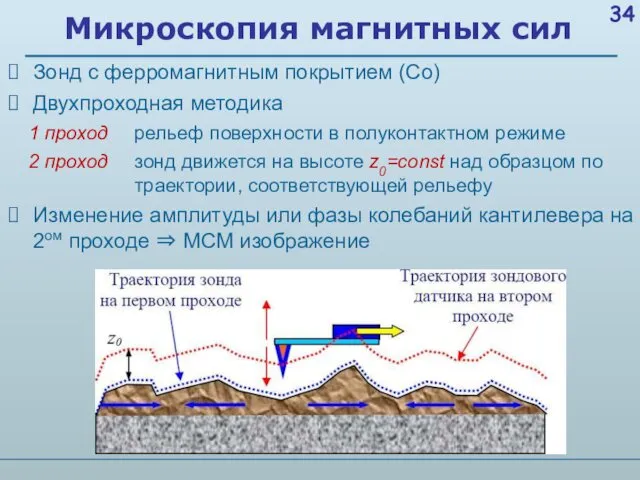


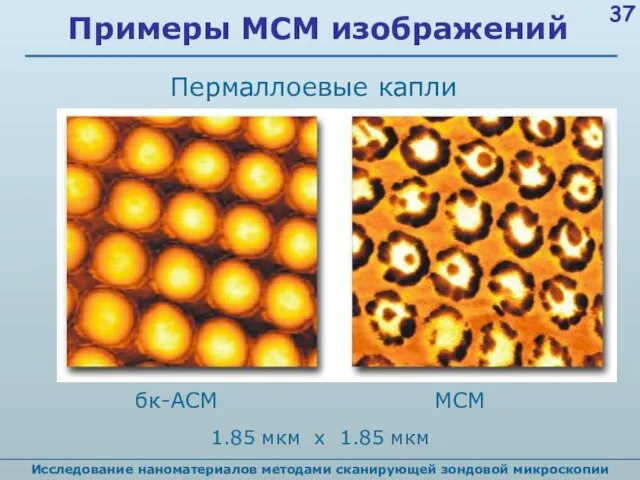
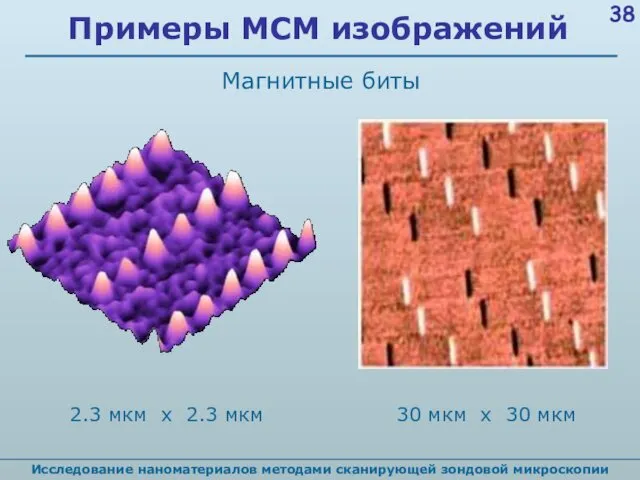

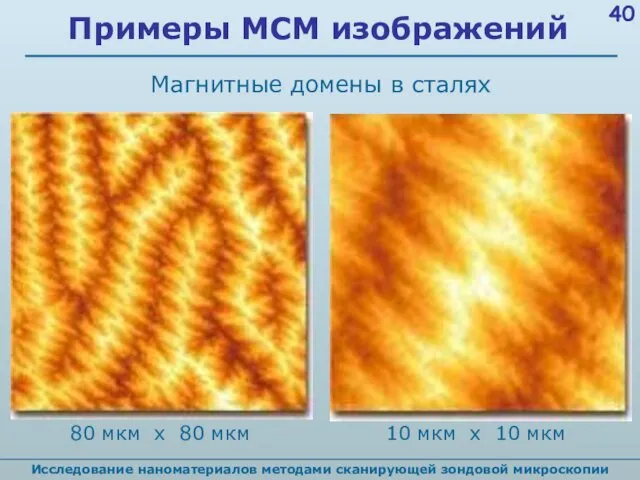



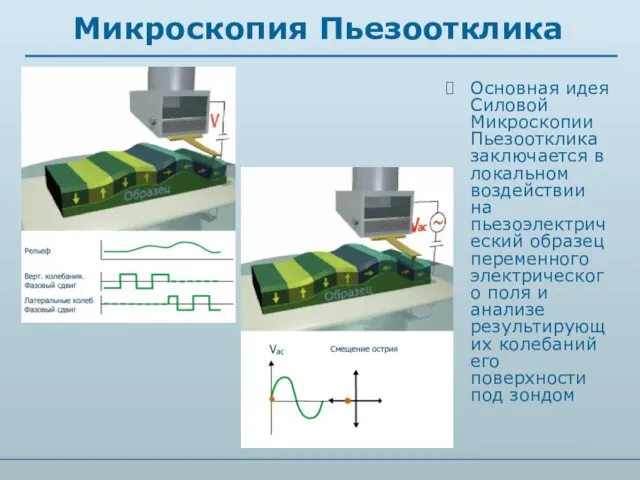
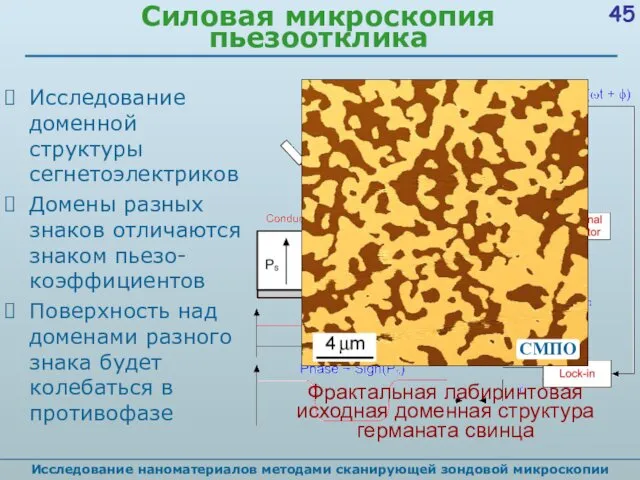










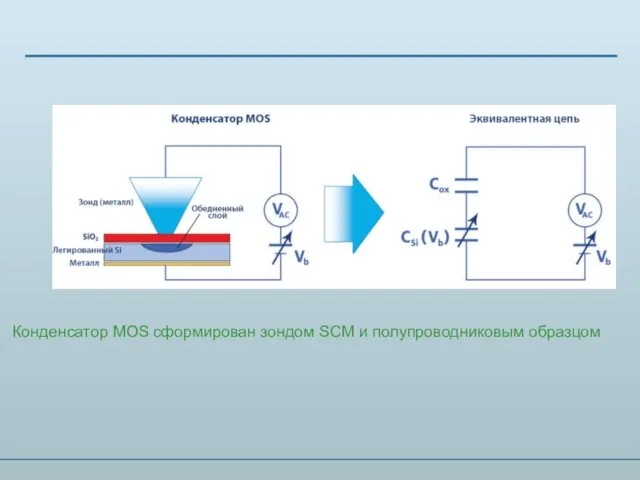
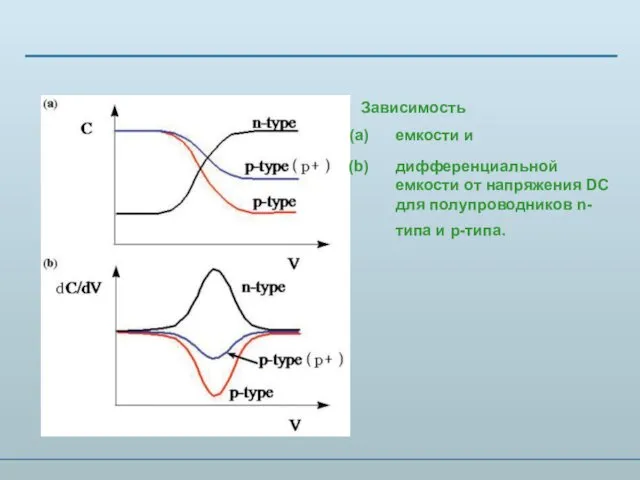
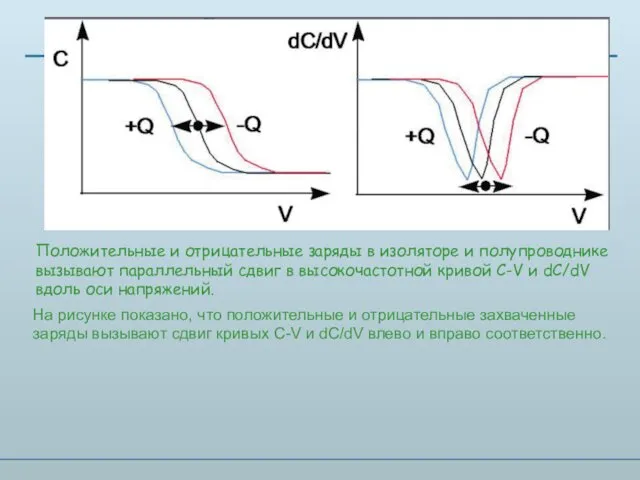
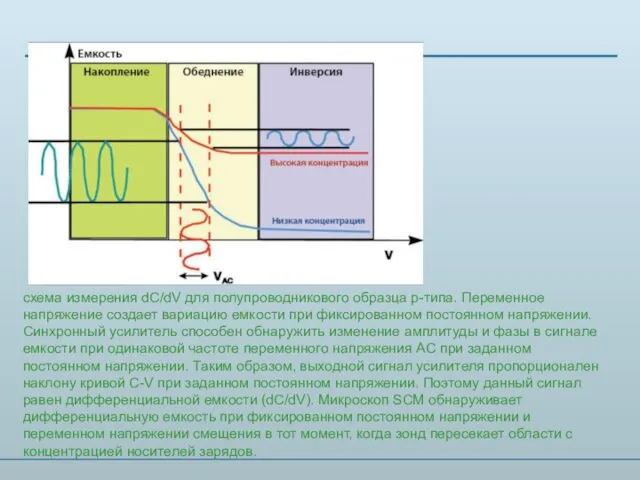

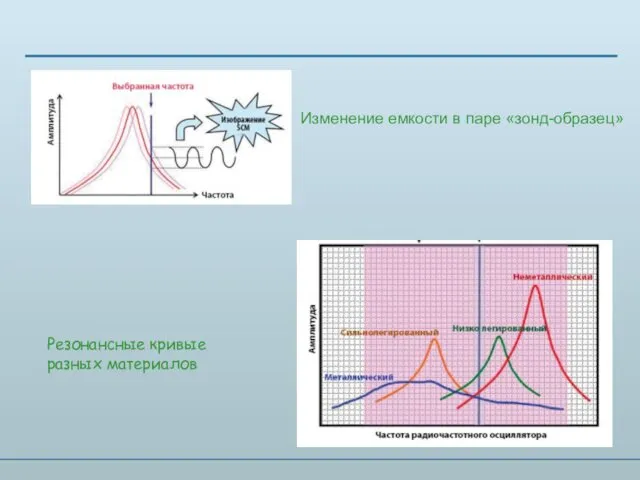

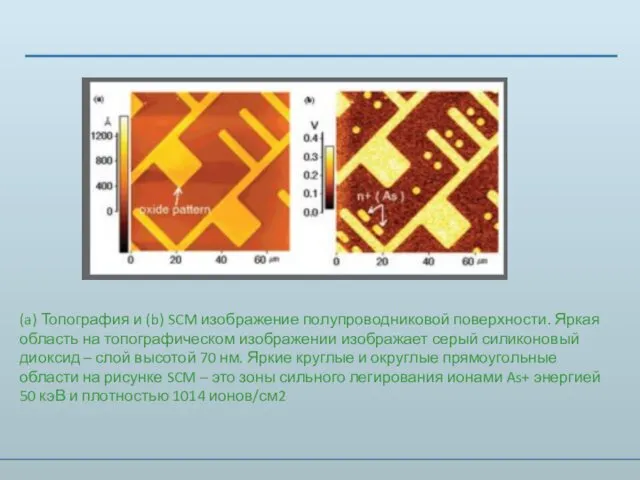
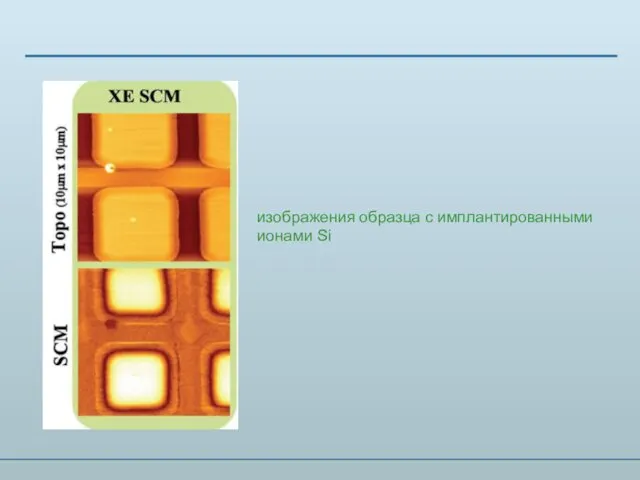
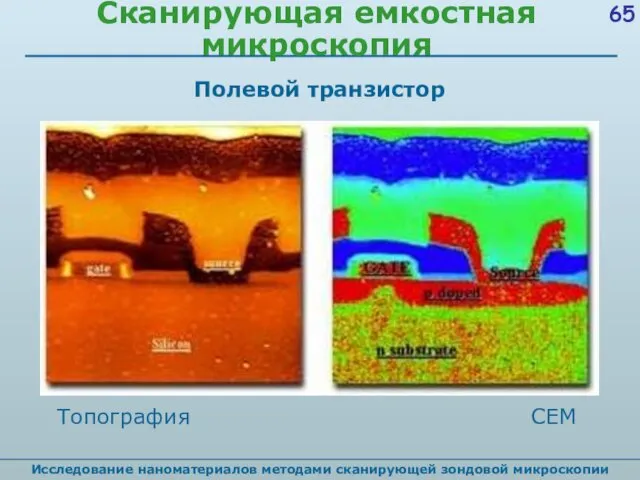

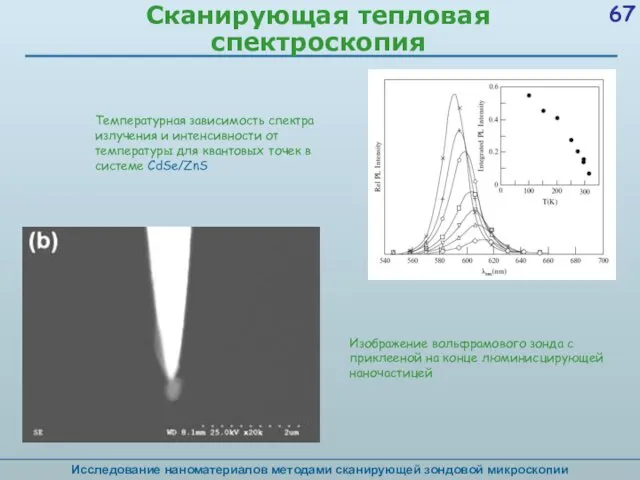

 Презентация. Осень
Презентация. Осень Связь имени прилагательного с именем существительным
Связь имени прилагательного с именем существительным Программа развития. Павлова А.А.
Программа развития. Павлова А.А. Глюкоза. 9 класс
Глюкоза. 9 класс Доктор Айболит: Если хочешь быть здоровым
Доктор Айболит: Если хочешь быть здоровым Общие вопросы организации микропроцессорных систем
Общие вопросы организации микропроцессорных систем Христианство. Протестантизм
Христианство. Протестантизм Анализ эмитента на примере ПАО ЛУКОЙЛ
Анализ эмитента на примере ПАО ЛУКОЙЛ Спорт в вузах России
Спорт в вузах России All about spiders
All about spiders Православные праздники
Православные праздники презентация на тему : Моя семья
презентация на тему : Моя семья Правила баскетбола
Правила баскетбола Excursion. Plan for Saturday
Excursion. Plan for Saturday Система крови. Состав и функция крови. Кровь и её компоненты
Система крови. Состав и функция крови. Кровь и её компоненты Германия (11 класс)
Германия (11 класс) Пищевые связи в экосистеме. Трофические уровни. Типы пищевых цепей
Пищевые связи в экосистеме. Трофические уровни. Типы пищевых цепей Использование результатов ВПР по русскому языку как инструмент диагностики профессиональных затруднений педагога
Использование результатов ВПР по русскому языку как инструмент диагностики профессиональных затруднений педагога Объект уголовного правонарушения
Объект уголовного правонарушения Как подготовить команду к игре Дебаты
Как подготовить команду к игре Дебаты Деление с числами 0 и 1
Деление с числами 0 и 1 Пряности. Значение пряностей для организма, их классификация
Пряности. Значение пряностей для организма, их классификация Закон Паскаля
Закон Паскаля Философия Иммануила Канта
Философия Иммануила Канта Составление букетов 1 часть
Составление букетов 1 часть презентации по ОРКСЭ (буддизм)
презентации по ОРКСЭ (буддизм) Организация образовательной деятельности по образовательной области Художественно-эстетическое развитие
Организация образовательной деятельности по образовательной области Художественно-эстетическое развитие Предварительно-напряженный бетон
Предварительно-напряженный бетон