Содержание
- 2. КМОП - структура
- 3. Варианты КМОП структур
- 4. Выбор кармана КМОП - структуры
- 5. Влияние температуры и среды на перераспределение примеси при окислении кремния (N в кремнии/N в оксиде) Коэффициент
- 6. Инверсионный канал по краю кармана р-типа [2] 1018 1017 1016 Латеральная диффузия бора Рабочая область транзистора
- 7. Зависимость подвижности от электрического поля, легирования и температуры
- 8. Зависимость подвижности носителей от концентрации примеси
- 9. Пороговое напряжение МОП-транзистора
- 10. Выбор кармана КМОП - структуры
- 11. Карманы в КМОП структуре Однокарманный вариант Двухкарманный вариант
- 12. Выбор кармана КМОП - структуры
- 13. Подгонка порогового напряжения в двухкарманной КМОП-структуре Uп п-канал +1В +0,5В 0В Uп п-канал +1В +0,5В 0В
- 14. Подгонка порогового напряжения в двухкарманной КМОП-структуре Uп п-канал +1В +0,5В 0В Uп п-канал +1В +0,5В 0В
- 15. Возникает ли инверсный канал по периферии р-кармана в случае двухкарманной технологии? 1018 1017 1016 Латеральная диффузия
- 16. Токи утечки в двухкарманной КМОП структуре
- 18. Преимущества р+- р подложки 1. Улучшение качества полупроводника 2. Уменьшение потока неосновных носителей из подложки в
- 19. Выращивание слитка кремния по методу Чохральского С - 1016 см-3 О – 1018 см-3 SiO +
- 20. Зависимость концентрации кислорода в кремнии от диаметра слитка
- 21. Дефекты кремния, вызванные преципитацией кислорода
- 22. Дефекты слитка кремния, вызванные преципитацией кислорода
- 23. Геттерирование примесей на границе раздела пленка-подложка
- 24. Зависимость подвижности носителей от концентрации носителей и ориентации подложки [4] Подвижность электронов, см2/Вс Подвижность дырок, см2/Вс
- 25. Создание КМОП структуры на гибридно-ориентированной подложке [4] Стадия 1. Окисление рабочего слоя монокремния на КНИ-пластине осаждение
- 26. Механизм гидрофобного сращивания HF (газ)
- 27. Формирование гибридно-ориентированной подложки методом аморфизации и рекристаллизации кремния Эпитаксия кремния + осаждение нитрида + фотолитография Аморфмзация
- 28. Конструкция и проблемы формирования наноразмерной КМОП структуры [1] Составной затвор: - разные величины работы выхода для
- 29. Эффект защелкивания в КМОП структуре [ 1 ]
- 30. Эффект защелкивания в КМОП структуре
- 31. КНИ КМОП структура [2]
- 32. КМОП-структура на основе КНС
- 33. Недостатки КНС - структуры 106 102 Кремний Сапфир ( Al2 O3 Nд см-2 толщина пленки кремния
- 34. Улучшение КНС - структуры Гетероэпитаксия Аморфизация ТО (11000С) - рекристаллизация и окисление кремния Аморфизация лишь дефектного
- 35. РЭМ - фото границы раздела КНС - структуры до и после рекристаллизации До рекристаллизации После рекоисталлизации
- 36. КНИ -структура
- 37. Преимущества КНИ КМОП структуры Резкое уменьшение ёмкостей стока и истока на подложку Уменьшенный эффект подложки при
- 38. Уменьшение емкости сток/исток - подложка
- 39. Уменьшение емкости сток/исток - подложка
- 40. Увеличение быстродействия и уменьшение потребляемой мощности ИС ЗУ в случае КНИ структуры
- 41. Увеличение порогового напряжения МОП-транзистора при последовательном соединении для объёмных КМОП ИС.
- 42. Образование электрон-дырочных пар при облучении полупроводниковой структуры
- 43. Повышение радиационной стойкости КНИ КМОП ИС
- 44. Температурная зависимость тока утечки КНИ и объемного МОП-транзисторов
- 45. Сращивание окисленных кремниевых пластин [2] Исходные структуры Термокомпрессия (бондинг) Утонение рабочего слоя
- 46. Бондинг-метод
- 47. Поверхность окисленной пластины кремния
- 48. Механизм гидрофильного бондинга
- 49. Механизм гидрофильного сращивания 2 H2O Si–OH + OH–Si Si–O–Si+H2O
- 50. Механизм гидрофильного сращивания H2 O
- 51. Метод сращивания со стоп-слоем [2] Vтр n+ = 10 Vтр n Подложка Эпитаксия кремния Бондинг Окисление
- 52. Smart-cut - метод сращивания пластин кремния
- 53. Smart-cut - метод сращивания пластин кремния [2] Окисление кремния Ионная имплантация водорода Бондинг низкотемпературный Образование пузырьков
- 54. Образование пузырьков водорода
- 55. Механизм газового расщепления Оксид кремния
- 56. ПЭМ изображение скрытого дефектного слоя (а) после облучения, (б); после предварительного отжига при 350 9C ;
- 57. Влияние пыли на ионную имплантацию водорода
- 58. ПЭМ –изображение КНИ – структуры перед расщеплением Заглубленный слой окисла (а) и отшелушивание части его в
- 59. Зависимость прочности сращивания от зазора между пластинами при бондинге 1 – предельная прочность кремния на растяжение
- 60. Формирование КНИ структуры методом имплантации кислорода ( SIMOX) [2] Исходная пдастина кремния Ионная имплантацитя кислорода Темообработка
- 61. Микрофотография косого шлифа первой SIMOX структуры (1976 год) Ток ионного пучка - 100 мкА, для облучения
- 62. Факторы, влияющие на параметры КНИ-структуры Доза ионов более 1018 см-2 Температура при облучении более 4000С Плотность
- 63. Изменение распределения кислорода в процессе термообработки после имплантации (шнурование)
- 64. Влияние искусственных центров преципитации на распределение кислорода – «шнурование»
- 65. Поперечное сечение структур КНИ SIMOX, полученное с помощью ПЭМ а) Сразу же после имплантации; б) после
- 66. Структура ITOX–SIMOX подложки на различных стадиях технологии а) ИИ кислорода: 180 кэВ, 3–4,5 1017 ион/см2 ,
- 67. ПЭМ–изображения поперечного сечения КНИ ITOX–SIMOX - структуры а) сразу после имплантации; б) после отжига при 13500C;
- 68. АСМ изображения поверхности кремния и границы раздела КНИ структур ITOX–SIMOX.
- 69. Трехмерная интегральная схема на основе КНИ - структуры Бондинг и SIMOX не применимы из-за высокотемпературных обработок!
- 70. Трехмерная КМОП –структура этажерочного типа
- 71. Трехмерная КМОП – структура мезонинного типа
- 72. ZMR - процесс Поликремний Оксид кремния Кремний Лазерный луч Монокристалл Жидкая зона Монокристалл Поликремний Скорость движения
- 73. Проблемы ZMR Кристаллографические дефекты вследствие взаимодействия лазерного луча с кремнием Изменение оптических свойств кремния в процессе
- 74. Требования к источнику лазерного излучения Мощность излучения - более 20 Вт/см2 Длина волны излучения - менее
- 75. Косвенный лазерный нагрев (КЛН) Антиотражающее покрытие Молибден Оксид кремния Поликремний Оксид кремния Кремниевая монокристаллическая подложка Луч
- 76. Структура пленки кремния после рекристаллизации Крупноблочная структура Поликреминй Направление движения луча лазера
- 77. Конфигурации островков из поликремния
- 78. Влияние направления движения лазера на равномерность толщины пленки кремния
- 79. Результат ZMR обработки пленки поликремния Поликремний Крупноблочная структура Островок монокристалл кремнияа Направление движения луча лазера
- 80. КНИ МОП - транзистор, сформированный ZMR - процессом
- 81. Трехмерная КНИ КМОП ИС преобразователя сигналов (106 транзисторов 2 уровня ,МИЭТ 1987 г )
- 82. Токовые потоки в КНИ МОП транзисторе A- нормальный верхний кана,, B – нижний канал C -
- 83. Биполярный эффект в КНИ МОП транзисторе
- 84. Принцип работы полевого транзистора ( из патента Лилиенфельда, 1926 год )
- 85. Принцип работы беспереходного ( БПТ) КНИ МОП - транзистора
- 86. Изменение области обеднения в БПТ
- 87. Микрофотографии КНИ МОП БПТ
- 88. Области канала в инверсионном и БП транзисторах
- 89. Подвижность носителей в разных областях инверсионного и БП транзисторов
- 90. Зависимость подвижности электронов от концентрации примеси в кремнии
- 91. «Нанопроволочный» КНИ МОП БПТ
- 92. «Нанопроволочный» КНИ МОП БПТ
- 93. Конструкция и проблемы формирования наноразмерной КМОП структуры [1] Составной затвор: - разные величины работы выхода для
- 94. Мелкая щелевая изоляция - ограниченные литографией размеры - независимость ширины от глубины - малая электрическая емкость
- 95. Неоднородно легированный канал - подавление короткоканальных эффектов - гало-области для подавления спада Vп при уменьшении Lк
- 96. Подзатворный диэлектрик - очень тонкий для подавления короткоканальных эффектов и увеличения тока стока - ограничения: плотность
- 97. Составной затвор - разные величины работы выхода для затворов n- или p- типов - низкое поверхностное
- 99. Скачать презентацию




![Инверсионный канал по краю кармана р-типа [2] 1018 1017 1016](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/170221/slide-5.jpg)










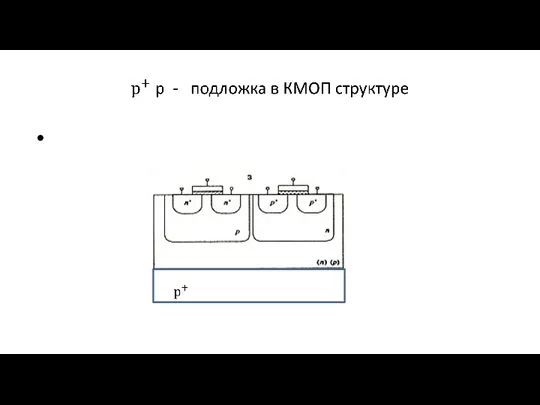






![Зависимость подвижности носителей от концентрации носителей и ориентации подложки [4] Подвижность электронов, см2/Вс Подвижность дырок, см2/Вс](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/170221/slide-23.jpg)
![Создание КМОП структуры на гибридно-ориентированной подложке [4] Стадия 1. Окисление](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/170221/slide-24.jpg)


![Конструкция и проблемы формирования наноразмерной КМОП структуры [1] Составной затвор:](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/170221/slide-27.jpg)
![Эффект защелкивания в КМОП структуре [ 1 ]](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/170221/slide-28.jpg)

![КНИ КМОП структура [2]](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/170221/slide-30.jpg)






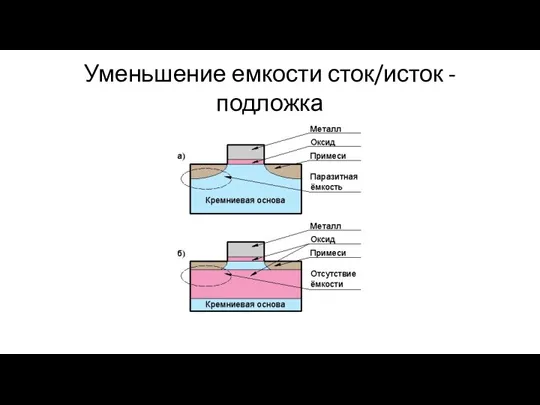






![Сращивание окисленных кремниевых пластин [2] Исходные структуры Термокомпрессия (бондинг) Утонение рабочего слоя](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/170221/slide-44.jpg)





![Метод сращивания со стоп-слоем [2] Vтр n+ = 10 Vтр](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/170221/slide-50.jpg)

![Smart-cut - метод сращивания пластин кремния [2] Окисление кремния Ионная](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/170221/slide-52.jpg)






![Формирование КНИ структуры методом имплантации кислорода ( SIMOX) [2] Исходная](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/170221/slide-59.jpg)
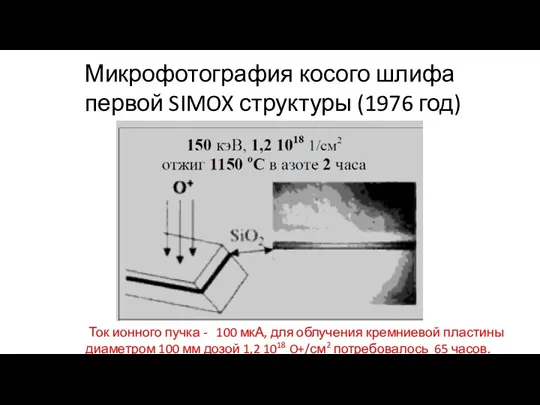




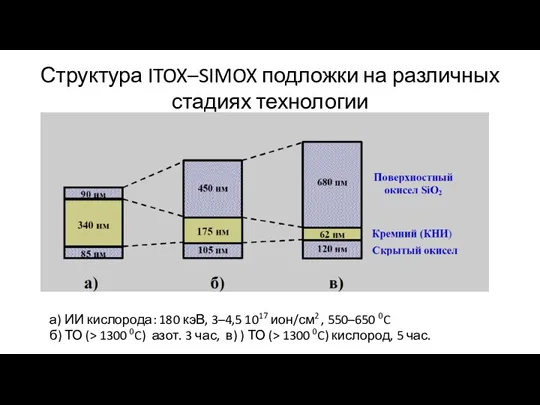
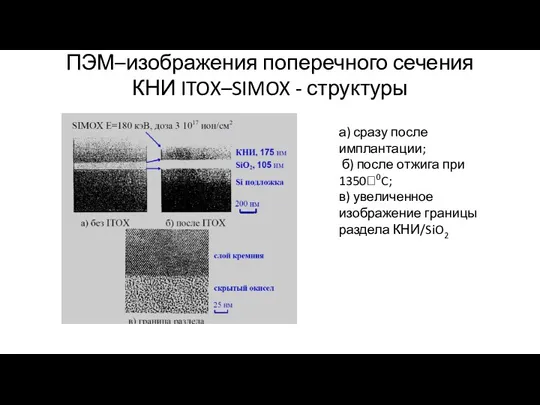




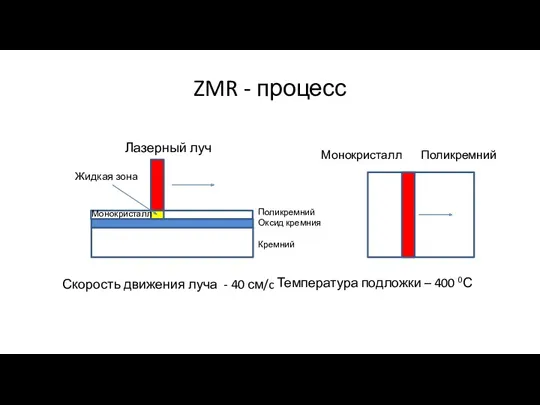






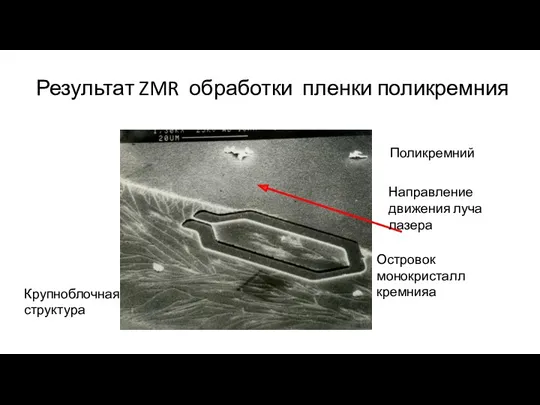








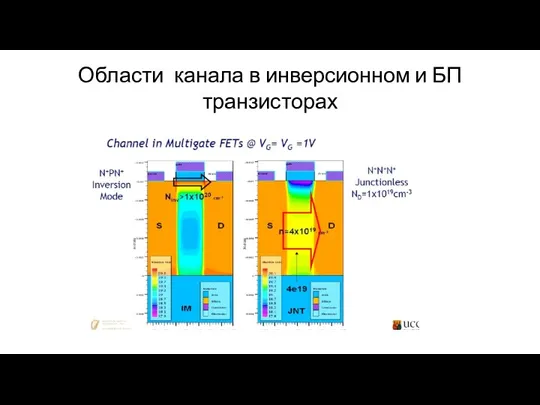
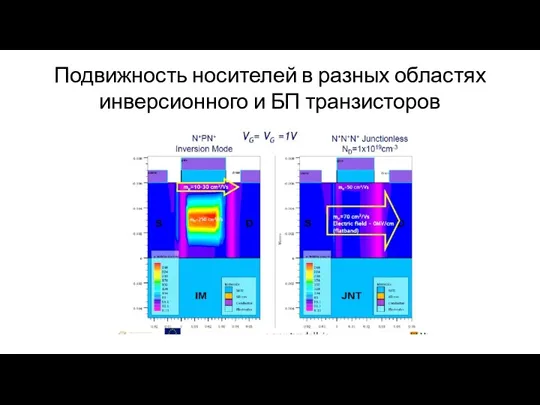


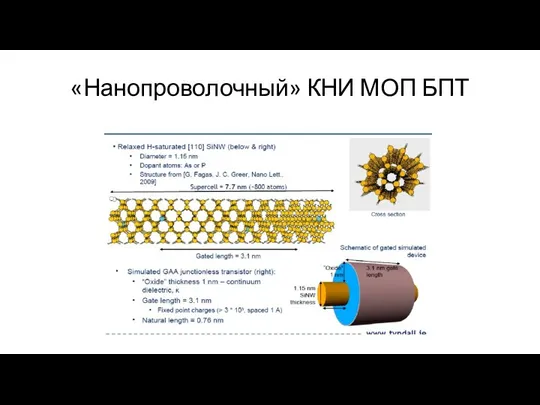
![Конструкция и проблемы формирования наноразмерной КМОП структуры [1] Составной затвор:](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/170221/slide-92.jpg)




 Изменения в порядок проведения обязательных медицинских осмотров,
Изменения в порядок проведения обязательных медицинских осмотров, Конструкция корпуса. Прочность
Конструкция корпуса. Прочность Проблема общественного прогресса
Проблема общественного прогресса prezentatsia
prezentatsia Столярные соединения деталей. Шиповые столярные соединения. Разметка и изготовление шипов и проушин
Столярные соединения деталей. Шиповые столярные соединения. Разметка и изготовление шипов и проушин Жёлтый цвет
Жёлтый цвет Презентация Декупаж разделочной доски
Презентация Декупаж разделочной доски Схема устройства и принцип действия центробежного насоса
Схема устройства и принцип действия центробежного насоса Предраковые заболевания матки
Предраковые заболевания матки Развивающая предметно-пространственная среда во второй младшей группе Диск
Развивающая предметно-пространственная среда во второй младшей группе Диск Региональная научно-техническая конференция молодых специалистов ОАО УДМУРТНЕФТЬ
Региональная научно-техническая конференция молодых специалистов ОАО УДМУРТНЕФТЬ Итоговое родительское собрание в 4Б классе.2012 -2013 уч.год.Презентация.
Итоговое родительское собрание в 4Б классе.2012 -2013 уч.год.Презентация. Arduino. Представители семейства
Arduino. Представители семейства Обустройство и озеленение детской зоны в парке
Обустройство и озеленение детской зоны в парке Виртуальная экскурсия в Эрмитаж. 6А класс
Виртуальная экскурсия в Эрмитаж. 6А класс Презентация к консультации с воспитателями Темперамент
Презентация к консультации с воспитателями Темперамент Economics and Economy
Economics and Economy Круглые черви
Круглые черви Attractions in Scotland
Attractions in Scotland Проект Соуправление в классном коллективе как условие успешной социализации школьников
Проект Соуправление в классном коллективе как условие успешной социализации школьников Разработка Веб - сайта Интернет- провайдера
Разработка Веб - сайта Интернет- провайдера Архитектурные конструкции общественных зданий (часть 2 - структура как архитектура)
Архитектурные конструкции общественных зданий (часть 2 - структура как архитектура) Презентация Нам на улице не страшно
Презентация Нам на улице не страшно Количество вещества. Молярная масса
Количество вещества. Молярная масса DSC-928 switcher
DSC-928 switcher Формирование знаний по пожарной безопасности у детей старшего дршкольного возраста
Формирование знаний по пожарной безопасности у детей старшего дршкольного возраста Семья – источник воспитания ребёнка
Семья – источник воспитания ребёнка Introduction to private equity
Introduction to private equity