Содержание
- 2. Ionimplantáció alapok Alapelv: A kívánt adalék atomokat felgyorsított ionokként (B+, P+, As+) bombázzuk a félvezető szelet
- 3. Az ionimplanter felépítése I. Varian 350D ionimplanter, 4 és 6 inches szeletekhez
- 4. Az ionimplanter felépítése II.
- 5. Az ionimplanter felépítése III. A becsapódó ion energiája jól szabályozható a gyorsító feszültséggel (keV-MeV) Mágneses térrel
- 6. Ionimplanter B szelet Ionforrás előgyorsító 10 kV apertúra utógyorsító eltérítő Utógyorsító: 100 kV-2.5 MV = ionenergia
- 7. Tömegszeparátor A mágneses tér és az ionok sebességvektora merőlegesek egymásra -> az ionok körpályára kerülnek A
- 8. Belőtt ionok és a szubsztrát kölcsönhatása Az ionimplantáció porlasztással jár kis és közepes energiák esetén is
- 9. Elektronfékeződés Belépő ionok és a szubsztrát atomjainak elektronfelhői közti kölcsönhatás A fékeződés mechanizmusa az ion pillanatnyi
- 10. Nukleáris fékeződés Kisebb energiákon a magok közti Coulomb kölcsönhatás dominál „Rugalmas” ütközés, azaz képes rácsatomokat kiütni
- 11. Fékező hatások összehasonlítása http://www.gs68.de/tutorials/implant.pdf
- 12. Becsapódás R – az ion által megtett út Rp – a hordozó felületétől való távolság R
- 13. Alapfogalmak Összes belőtt adalék: Dózis: Energia –> Gyorsító feszültség [eV] Gummel -szám
- 14. Adalékeloszlás A folyamatokat az implantált ion rendszáma a gyorsító energia és a szubsztrátot alkotó elem rendszáma
- 15. Rp és ΔRp meghatározása I. LSS elmélet (Lindhard, Scharff, Schiøtt) Mitől áll meg az ion és
- 16. Rp és ΔRp meghatározása II. M1: Implant atomtömege M2: Target atomtömege Z1: Implant rendszáma ρ: Target
- 17. Bór ionok eloszlása Si hordozóban Si-ba irányból lőnek, mivel innen tűnik a legrendezetlenebbnek Amorf Si Si-ba
- 18. Csatorna hatás I. Az ionimplantációval pontos adalékeloszlás hozható létre, azonban egyes adalék ionok eltévedhetnek, és esetleg
- 19. Csatorna hatás II.
- 20. Csatorna hatás elkerülése A szelet pozicionálása (döntés és csavarás) Amorf vékony oxid réteg növesztése (200-250Å) A
- 21. Több implant egymás után
- 22. Kaszkádok, sérült tartományok és amorfizáció Hőkezelés: „szilárd fázisú epitaxia”
- 23. Hőkezelés Alkalmas az implantáció okozta roncsolás (kristályhibák) kijavítására Már 700-800°C-on is újra rendeződik az egykristály szerkezet
- 24. Maszkolás I. Fotoreziszt használható maszknak Szemben a diffúzióval, ahol a felület közelében mindig nagyobb a koncentráció,
- 25. Maszkolás II. A legnagyobb koncentráció nem a felszínen van Következő lépésként diffúzióval beljebb hajthatjuk az adalékot
- 26. Ionimplantáció félvezető-technológiai alkamazása Az egyéb alkalmazások - mint pl. a fémek, kerámiák kopásállóságának javítása – a
- 27. Ionimplantáció félvezető-technológiai alkamazása
- 28. Mellékjelenség: nem minden implantált atom aktív elektromosan Következmények: később jönnek elő
- 29. Előnyök Nagyon pontos Kis oldalirányú szóródás Tömeg szeparáció lehetséges Utólag is lehetséges új réteg létrehozása Meredek
- 30. Hátrányok A rácsszerkezet rongálódik Nehéz atomokkal csak sekély implantáció valósítható meg Alacsonyabb termelékenység, mint diffúzióval Drága,
- 31. RBS spektroszkópia Rutherford backscattering Egy hordozóban különféle elemek meghatározása a mélység függvényében 2-4 MeV-os kis tömegű
- 32. Források Dr. Mojzes Imre: Mikroelektronika és elektronikai technológia http://www.vsea.com/pubs.nsf/home http://www.casetechnology.com/links.html http://en.wikipedia.org/wiki/Ion_implantation http://www.gs68.de/tutorials/implant.pdf http://en.wikipedia.org/wiki/Rutherford_backscattering
- 33. Adalékolás neutronsugárzással NTD (neutron transmutational doping) IGBT, teljesítmény eszközök: kicsi adalékolás, de pontos -> nagy letörési
- 34. Teljesítmény MOS tranzisztorok A DMOS (TMOS) szerkezet S D G
- 35. IGBT (Insulated Gate Bipolar Transistor) Szigetelt vezérlőelektródájú bipoláris tranzisztor S D C E B G
- 36. Implantálás plazma immerzióval direct ion implantation from a plasma ambient
- 38. Скачать презентацию











![Alapfogalmak Összes belőtt adalék: Dózis: Energia –> Gyorsító feszültség [eV] Gummel -szám](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/393790/slide-12.jpg)














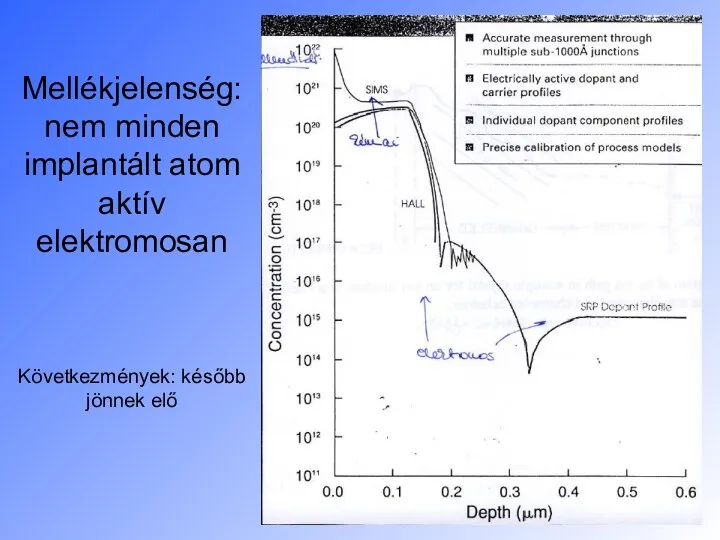





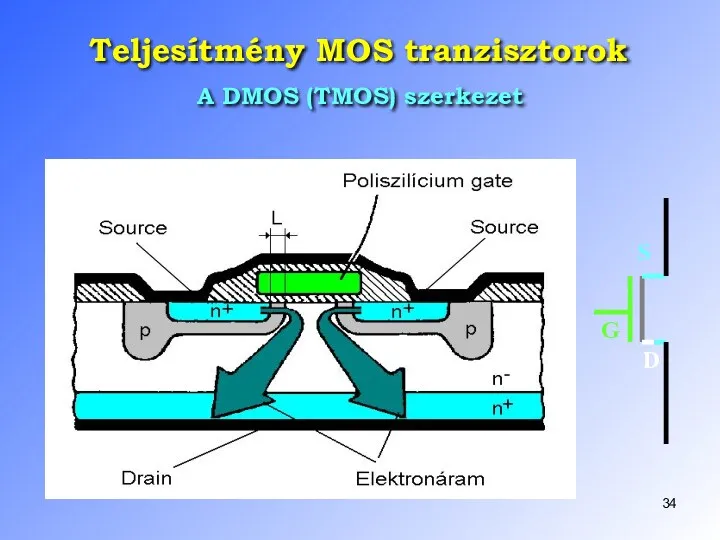
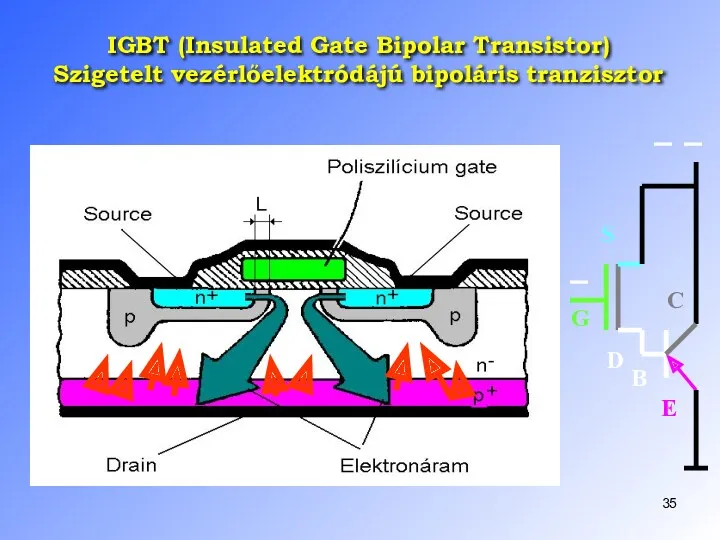

 Железо и его соединения
Железо и его соединения Аллотропия
Аллотропия ФОСФОР и его соединения
ФОСФОР и его соединения Взрывоопасные грузы
Взрывоопасные грузы Химические свойства карбоновых кислот
Химические свойства карбоновых кислот Кремний и его соединения. 9 класс
Кремний и его соединения. 9 класс Строение атома. 10 ен
Строение атома. 10 ен Термодинамика химических процессов
Термодинамика химических процессов Подгруппа серы и ее соединения
Подгруппа серы и ее соединения Генетическая связь
Генетическая связь Первая группа периодической системы Менделеева. Щелочные металлы
Первая группа периодической системы Менделеева. Щелочные металлы Токсичні характеристики найбільш розповсюджених небезпечних хімічних речовин і симптоми ураження
Токсичні характеристики найбільш розповсюджених небезпечних хімічних речовин і симптоми ураження Романенко
Романенко Окислительно-восстановительные реакции. Готовимся к ЕГЭ
Окислительно-восстановительные реакции. Готовимся к ЕГЭ Анализ качества лекарственных веществ, определяемых методом комплексонометрии
Анализ качества лекарственных веществ, определяемых методом комплексонометрии Вещества и их превращения Роль химии в нашей жизни
Вещества и их превращения Роль химии в нашей жизни Химия в продуктах питания
Химия в продуктах питания Метод МО
Метод МО Химическая технология ситаллов и композитов
Химическая технология ситаллов и композитов Неметаллические и композиционные материалы
Неметаллические и композиционные материалы Химические реакции
Химические реакции Вcтуп до курсу Класифікації отрут і отруєнь. Токсикометрія
Вcтуп до курсу Класифікації отрут і отруєнь. Токсикометрія Вода. Физические и химические свойства воды
Вода. Физические и химические свойства воды Топливо, его классификация
Топливо, его классификация Роль химии в жизни человека
Роль химии в жизни человека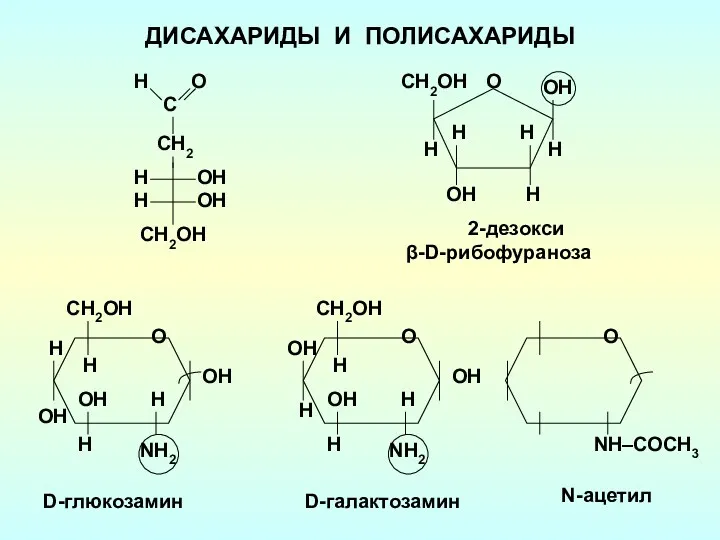 Дисахариды и полисахариды
Дисахариды и полисахариды Сера — представитель VIA-группы. Аллотропия серы. Свойства и применение
Сера — представитель VIA-группы. Аллотропия серы. Свойства и применение Фенол. 10 класс
Фенол. 10 класс