Содержание
- 2. а) б) в) г) СЭМ-изображение поверхностей слоев ПК, полученных в одинаковых технологических условиях на пластинах марок:
- 3. а) б) в) СЭМ-изображение поверхностей слоев ПК, полученных в одинаковых технологических условиях на пластинах марок: а)
- 4. Расчет диаметров пор в n- и р-Si 3 4 Экспериментальные (1,3) и расчетные (2,4) зависимости радиальных
- 5. Закономерности порообразования в Si n- и р- типов проводимости Влияние типа проводимости Si на плотность распределения
- 6. изменение плотности распределения зародышей пор в кремнии КЭФ в зависимости от удельного сопротивления
- 7. Гистограмма распределения расстояния между порами в образце КДБ КДБ 0,005 , где частота это количество значений
- 8. Гистограмма распределения расстояния между порами в образце КДБ КДБ 0,5 , где частота это количество раз
- 9. Гистограмма распределения расстояния между порами в образце КДБ КДБ 20 , где частота это количество раз
- 10. Распределения расстояния между порами в образцах КДБ 0,005-100 Ом см
- 11. Гистограмма распределения расстояния между порами в образце КДБ КДБ 10 , где частота это количество раз
- 12. Гистограмма распределения расстояния между порами в образце КДБ и КЭФ КДБ 0,5 , где частота это
- 13. Порообразование в р-Si СЭМ- изображение поверхности слоя ПК на КДБ 20 Изменение разности потенциалов на ячейке
- 14. Типичная зависимость изменения напряжения в процессе электрохимического травления кремния U, В Время 30 мин КДБ –
- 15. Типичный вид кривой пульсации напряжения (дано с сильным увеличением)
- 16. Типичная зависимость изменения напряжения в процессе электрохимического травления кремния Время U, В R = 4,5 Ом.см
- 17. Типичная зависимость изменения напряжения в процессе электрохимического травления кремния U, В U, В U, В U,
- 18. Типичная зависимость изменения напряжения в процессе электрохимического травления кремния U, В U, В U, В U,
- 19. Типичная зависимость изменения напряжения в процессе электрохимического травления кремния U, В Время 30 мин Травитель HF:C2H5OH
- 20. Типичная зависимость изменения напряжения в процессе электрохимического травления кремния U, В Время КДБ – 8 Травитель
- 21. Порообразование в р-Si Зарождение и рост пор
- 22. Порообразование в р-Si Зарождение и рост пор
- 23. Схема образования и пробоя защитной пленки на р-типе кремния. 1-монокристалл, 2-первостадино образовавшаяся пленка, 3-пленка увеличивающейся толщины,
- 25. Скачать презентацию

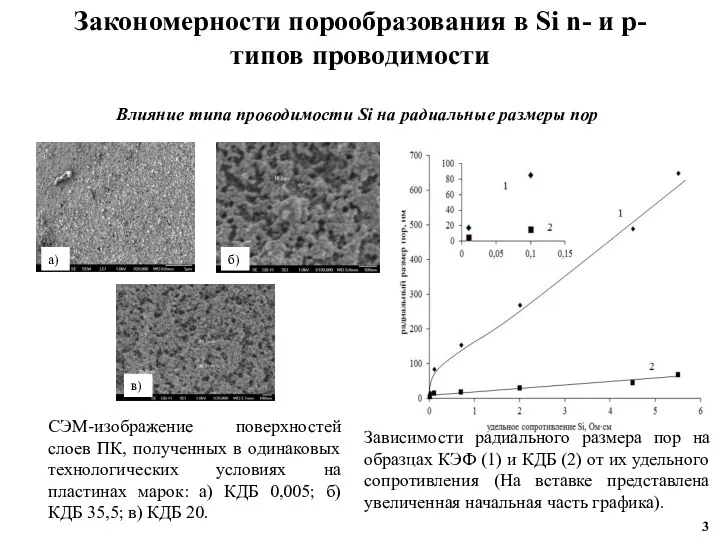


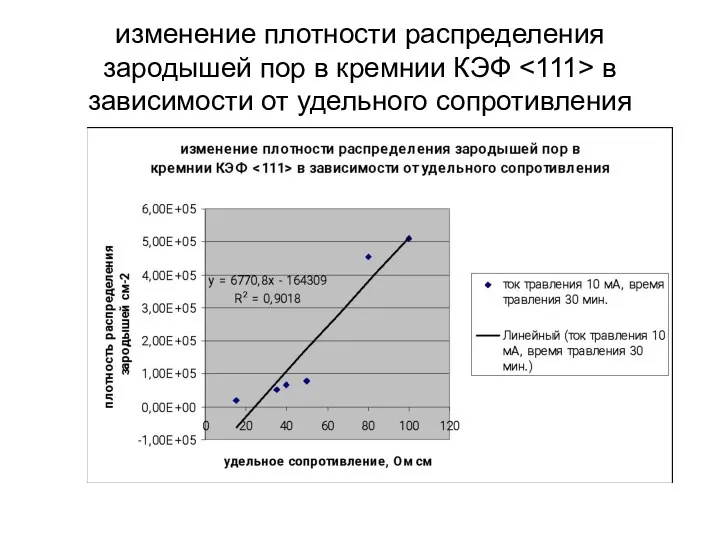














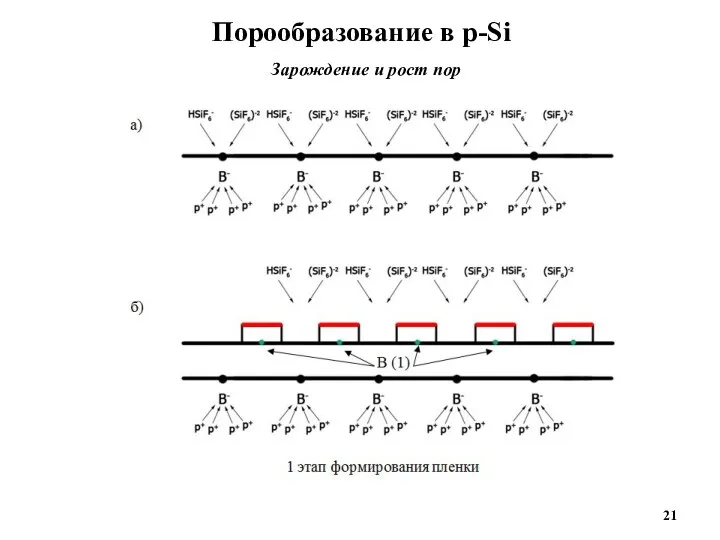

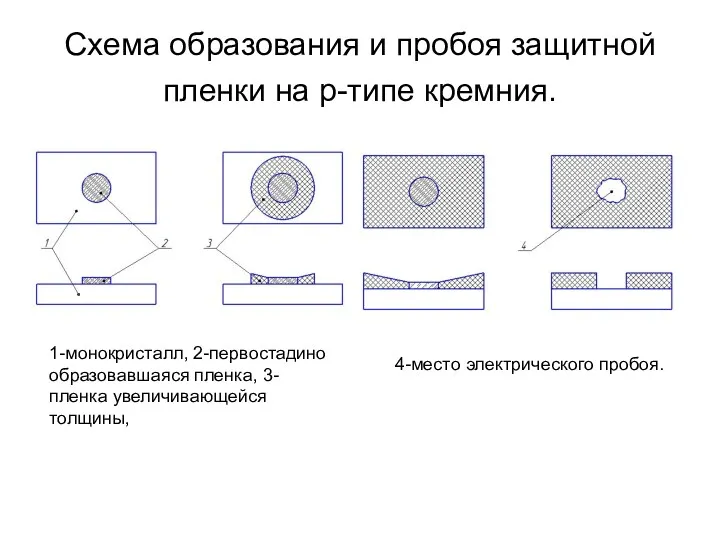
 Общая характеристика неметаллов
Общая характеристика неметаллов Химия и повседневная жизнь человека
Химия и повседневная жизнь человека Силикаты. Слюды. Тальк. Фосфаты. Апатит. Крокоит
Силикаты. Слюды. Тальк. Фосфаты. Апатит. Крокоит Аморфные сплавы
Аморфные сплавы Электролиз. Классификация
Электролиз. Классификация Химическая термодинамика. Экзаменационные вопросы
Химическая термодинамика. Экзаменационные вопросы Диаграмма железо - углерод
Диаграмма железо - углерод Хром. Химиялық қасиеттері
Хром. Химиялық қасиеттері Анализ 3% раствора водорода пероксида
Анализ 3% раствора водорода пероксида Alkynes
Alkynes Металлическая связь
Металлическая связь Аминокислоты алифатического ряда и их производные
Аминокислоты алифатического ряда и их производные Комплексные соединения
Комплексные соединения Історія відкриття періодичної системи хімічних елементів
Історія відкриття періодичної системи хімічних елементів Основные вулканические породы. Основные плутонические породы
Основные вулканические породы. Основные плутонические породы Утворення асимілятів та їхнє перетворення
Утворення асимілятів та їхнє перетворення Технология промышленных газов
Технология промышленных газов Кислотно-основное титрование
Кислотно-основное титрование Химические свойства алкенов
Химические свойства алкенов Алкалоидтар. Алкалоидтар туралы түсінік. Жіктелуі
Алкалоидтар. Алкалоидтар туралы түсінік. Жіктелуі Элементы пятой-А группы. Азот и фосфор
Элементы пятой-А группы. Азот и фосфор Анілін. Фізичні властивості
Анілін. Фізичні властивості Тағамдық қоспалар. Тағамдық бояулар. Антиоксиданттар. Эмульгаторлар
Тағамдық қоспалар. Тағамдық бояулар. Антиоксиданттар. Эмульгаторлар Анализ анионов. Анализ смеси солей
Анализ анионов. Анализ смеси солей Жиры. История открытия, строение, классификация, свойства
Жиры. История открытия, строение, классификация, свойства Активные формы кислорода. Антиоксиданты их физиологическая роль
Активные формы кислорода. Антиоксиданты их физиологическая роль Д.И. Менделеев Мощь и сила науки во множестве фактов, цель – в обобщении этого множества
Д.И. Менделеев Мощь и сила науки во множестве фактов, цель – в обобщении этого множества 20230419_oksidy
20230419_oksidy