Cross-section sample preparation using focused ion beam system (FIB) for transmission electron microscopy (TEM) презентация
Содержание
- 2. What is TEM? TEM Hitachi HT 7700 What can be observed by TEM: Thin films and
- 3. Supporting grid for TEM specimens TEM specimen holder
- 4. Examples Ni nanoparticles (catalysts) and carbon nanotubes Ni-Ti thin foil Neonothopanus nambi (lat.) biological specimen Co-Al2O3
- 5. What is “cross-section”? cross-section is basic method of observation multi layers structures cross-section method allows to
- 6. Classic method of cross-section sample preparation Four pieces of specimens on the silicon substrate are glued
- 7. 3 sawing disc of 100 um thickness 4 Thinning the disk up to 10 microns by
- 8. 5 Thinning the disk up to 10 nm by Precision Ion Polishing System (PIPS)
- 9. Modern method of cross-section sample preparation Focused Ion Beam System (FIB) Hitachi FB 2100
- 10. Basic steps of cross-section sample preparation by FIB 1. Deposition of protective tungsten coating on the
- 11. 2. Cutting half-finished (lamella)
- 12. 2. Cutting lamella (continuation)
- 13. 3. Fixing microprobe
- 14. 4. Cutting left side and removing lamella
- 15. 5. Fixing lamella on the toothed semicircle
- 16. 6. Cutting and removing microprobe
- 17. 7. Thinning specimen to 50-100 nm
- 18. Finish result Область просмотра в ПЭМ Disadvantages of FIB method Damaging top layer during deposition tungsten
- 19. Some features sample preparation with thin layers (thickness less than 300 nm)
- 22. Pre-sputtering of Ge protective layer
- 23. substrate (Si) Ge (protection layer) Mn (epitaxial layers) Examples
- 24. substrate (Si) Ge (protection layer) Co Pt
- 25. comparison of the two methods Classic method FIB method
- 27. Скачать презентацию

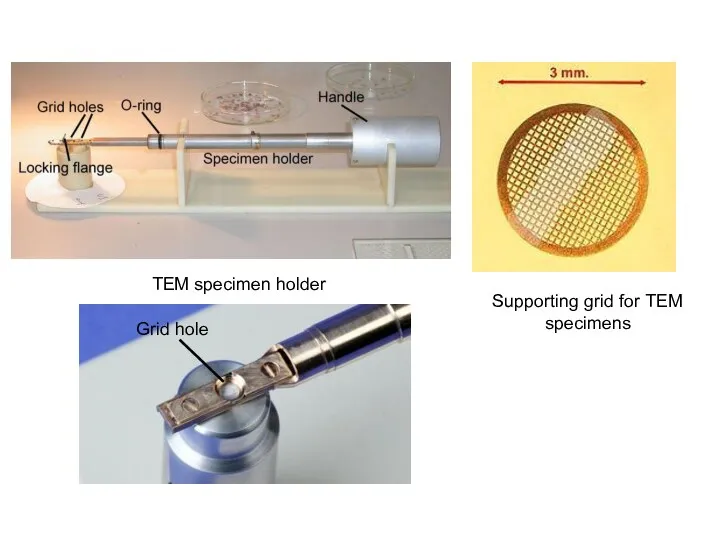
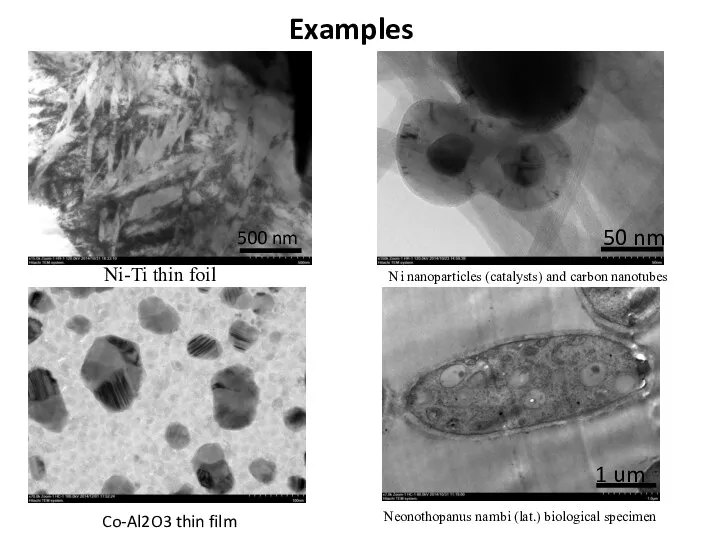
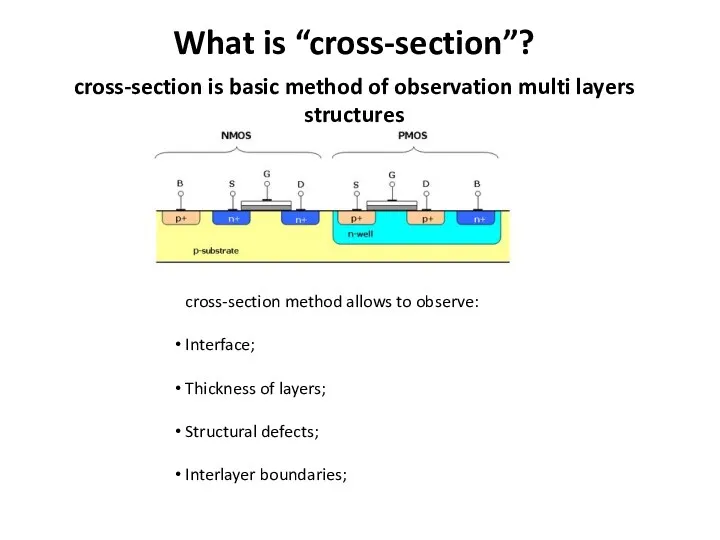
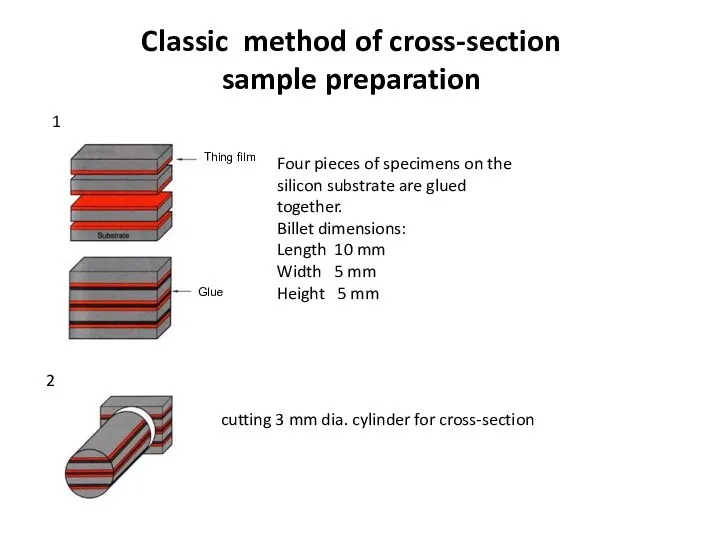
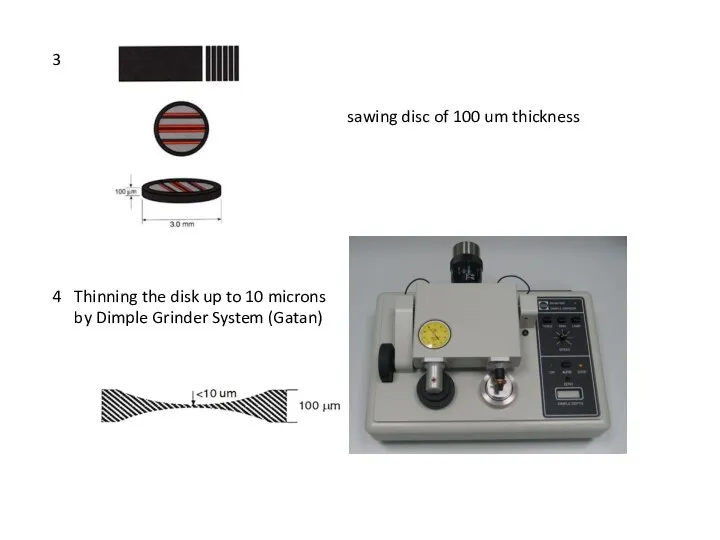
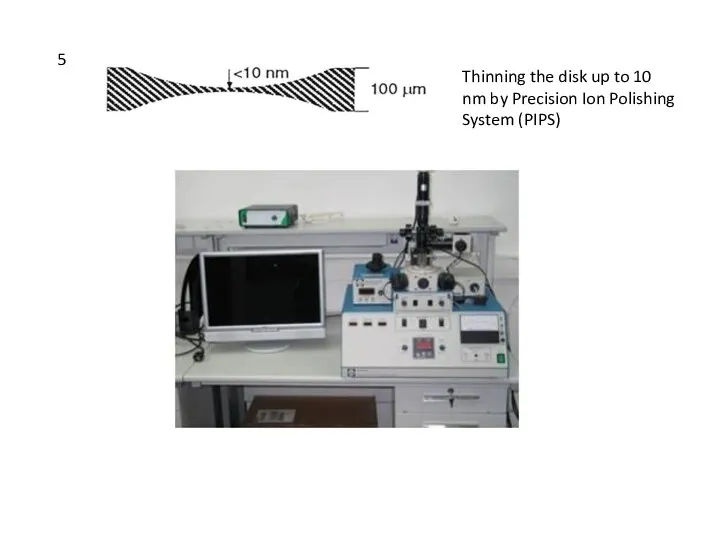
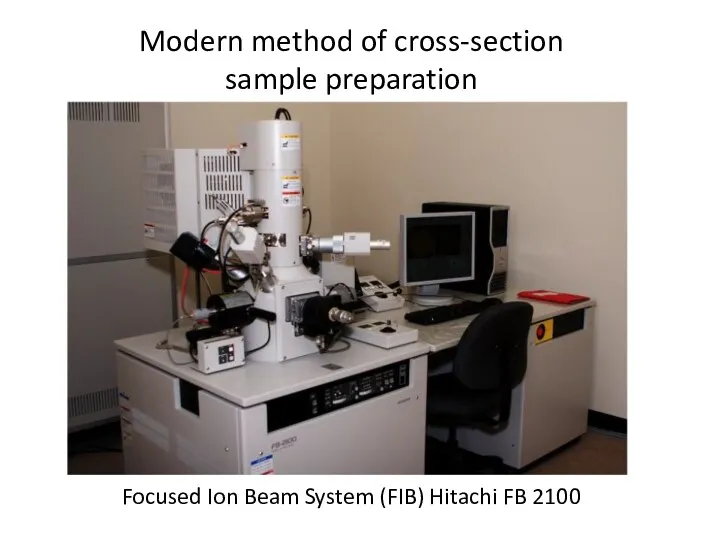

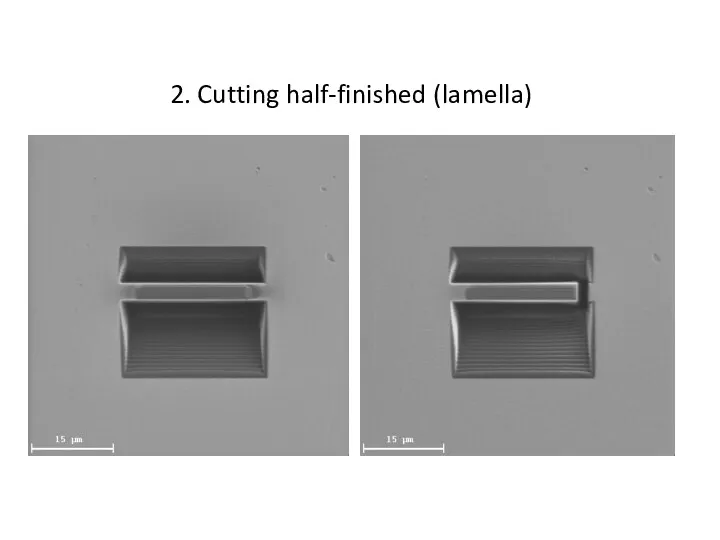
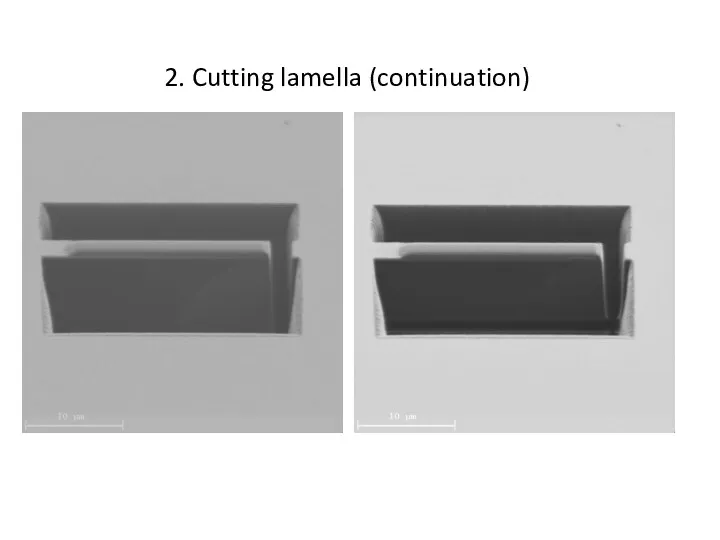
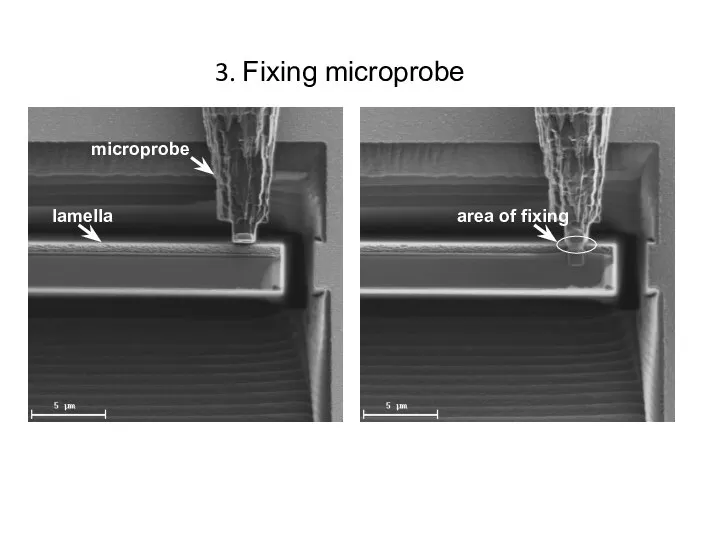
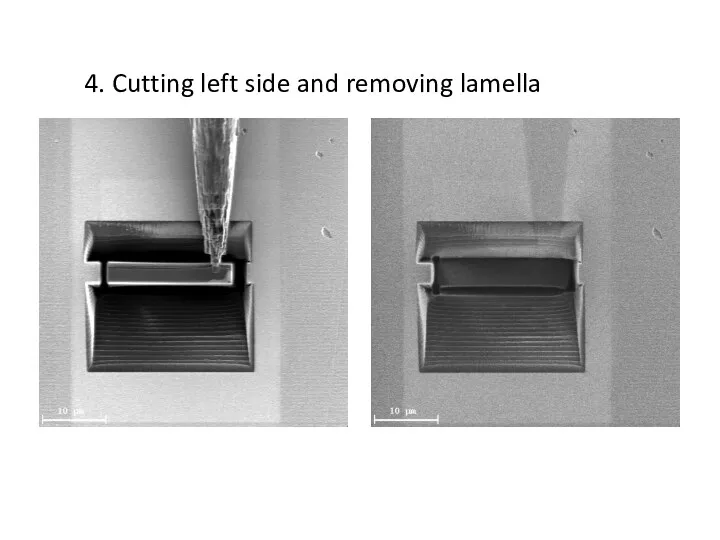
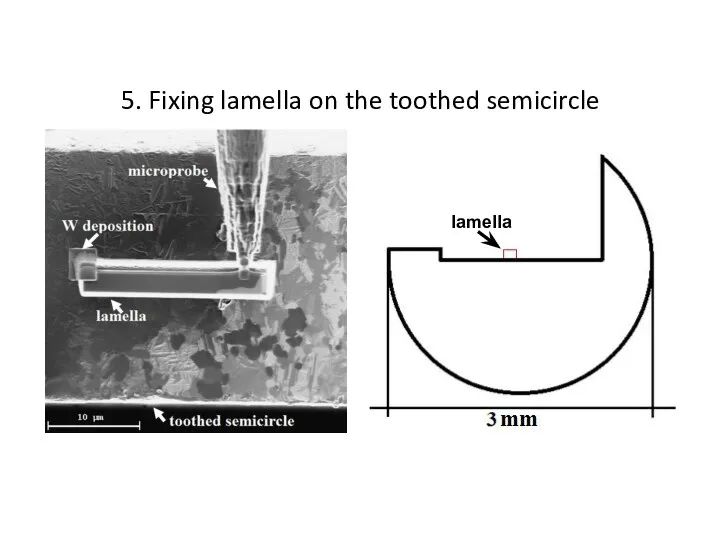
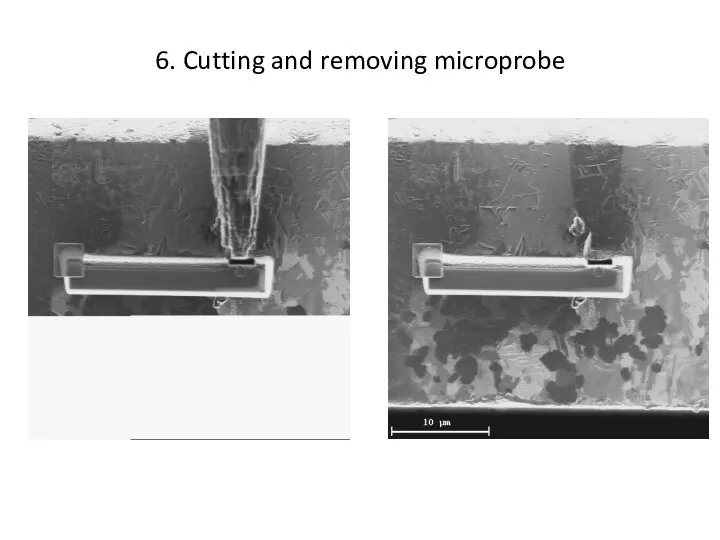

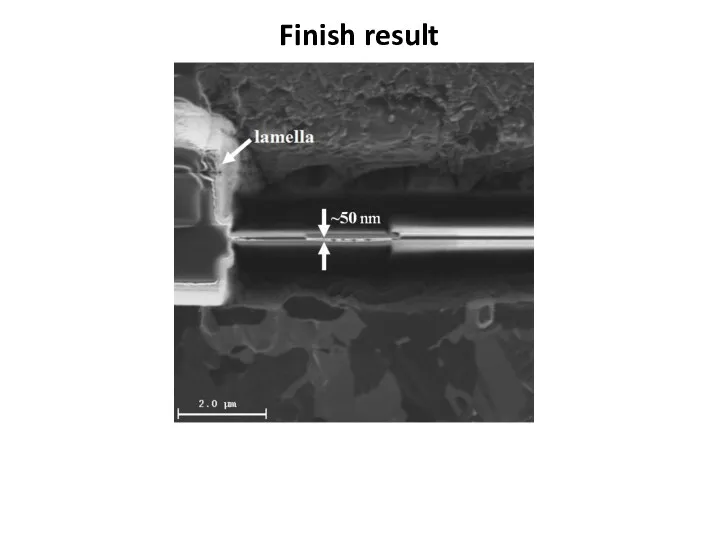
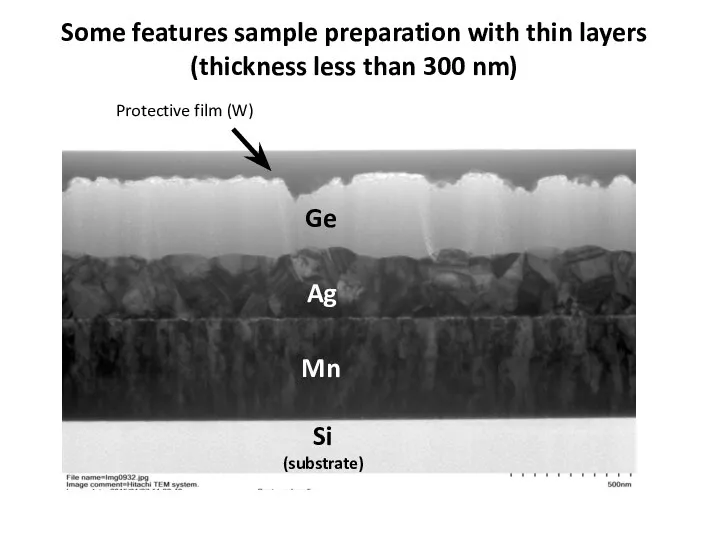
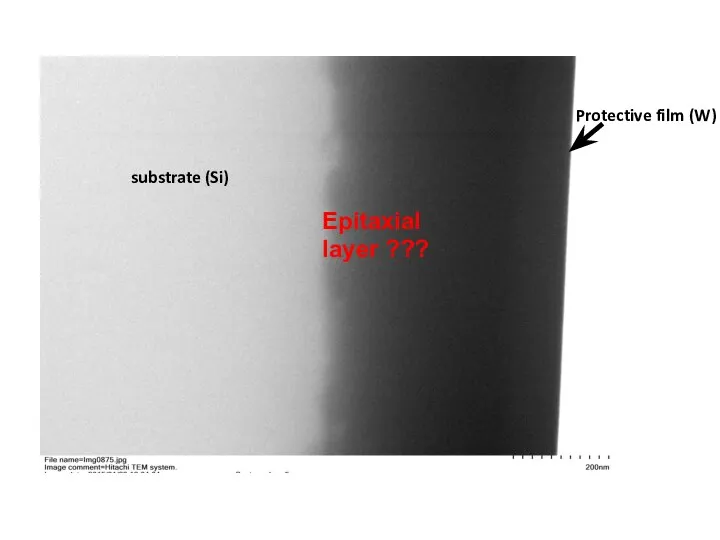
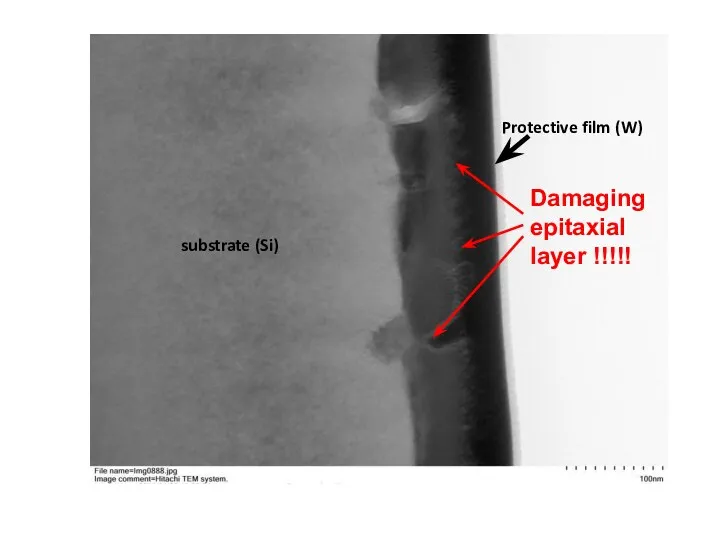
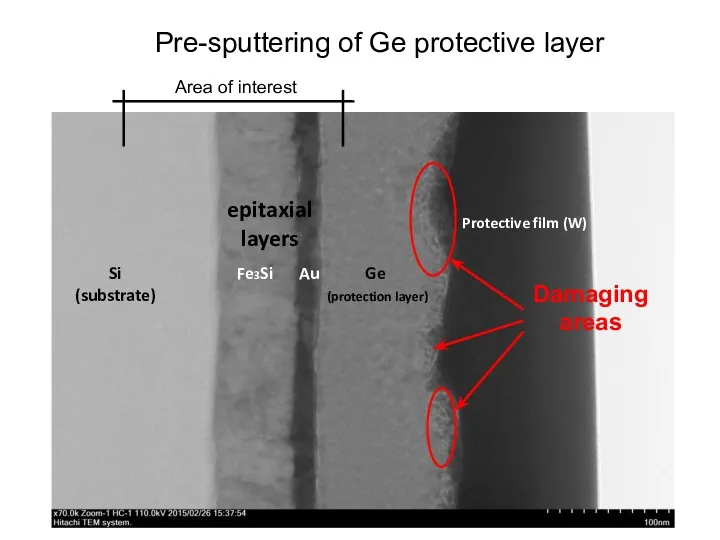
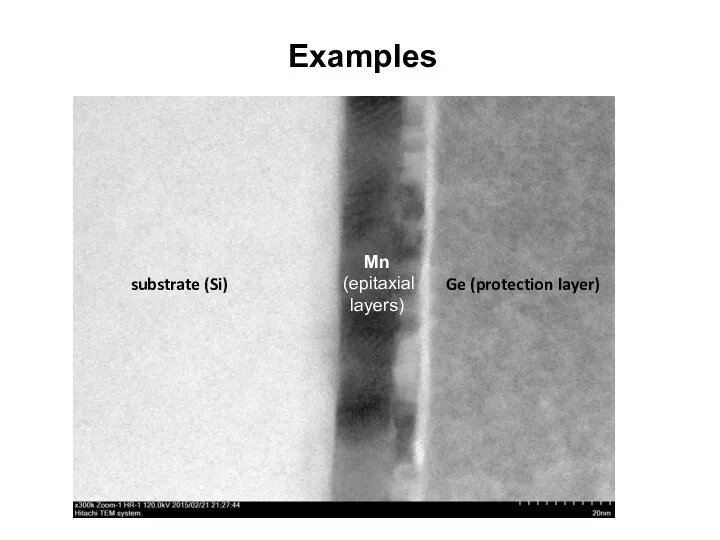
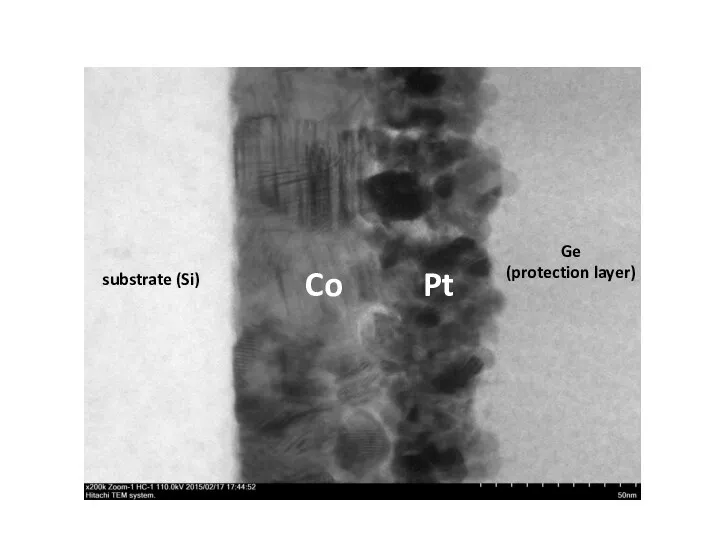
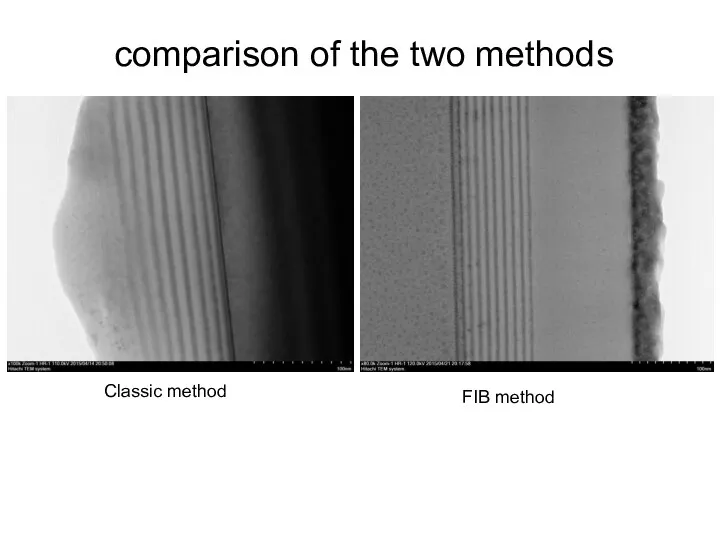
 Непредельные углеводороды этиленового ряда (олефины, алкены)
Непредельные углеводороды этиленового ряда (олефины, алкены) Класифікація неорганічних сполук. Оксиди
Класифікація неорганічних сполук. Оксиди Изучение физико-химических свойств мицеллярных растворов индивидуальных ПАВ, композиций различных ПАВ
Изучение физико-химических свойств мицеллярных растворов индивидуальных ПАВ, композиций различных ПАВ Строение атомов. Понятие о квантовой механике
Строение атомов. Понятие о квантовой механике Водород. Распространенность в природе
Водород. Распространенность в природе Решение задач по теме: «Электролиз»
Решение задач по теме: «Электролиз» Элементы триады железа: Fe, Co, Ni. (Лекция 16)
Элементы триады железа: Fe, Co, Ni. (Лекция 16) Аминокислоты. Белки
Аминокислоты. Белки Properties of Atoms and the Periodic Table
Properties of Atoms and the Periodic Table Синтетические волокна
Синтетические волокна Методы составления уравнений окислительно-восстановительных реакций. Лекция №20
Методы составления уравнений окислительно-восстановительных реакций. Лекция №20 Химия. Дисперсные системы. Растворы
Химия. Дисперсные системы. Растворы Углеводы. Общая формула углеводов Сn(H2O)m
Углеводы. Общая формула углеводов Сn(H2O)m Петрология. Классификации магматических горных пород
Петрология. Классификации магматических горных пород Неметаллы: общая характеристика. 9 класс
Неметаллы: общая характеристика. 9 класс Непредельные углеводороды. Этилен. 9 класс
Непредельные углеводороды. Этилен. 9 класс Figure
Figure Лекция 7. Электрофильное замещение в ароматических системах
Лекция 7. Электрофильное замещение в ароматических системах Кристаллическое строение и свойства металлов
Кристаллическое строение и свойства металлов Классификация химических реакций в органической химии
Классификация химических реакций в органической химии α-Аминокислоты. Белки
α-Аминокислоты. Белки Реакции ионного обмена. Теория химического строения органических соединений. 9 класс
Реакции ионного обмена. Теория химического строения органических соединений. 9 класс Газовые гидраты
Газовые гидраты Виведення молекулярної формули речовини за загальною формулою гомологічного ряду та густиною або відносною густиною
Виведення молекулярної формули речовини за загальною формулою гомологічного ряду та густиною або відносною густиною Склад і основні фізико-хімічні властивості молочного білку
Склад і основні фізико-хімічні властивості молочного білку Методы определения механических свойств полимерных композиционных материалов
Методы определения механических свойств полимерных композиционных материалов Решение задач на определение массовой и объемной доли вещества для смесей и растворов
Решение задач на определение массовой и объемной доли вещества для смесей и растворов Основные классы неорганических соединений
Основные классы неорганических соединений